Ag/SiOx:Ag/TiOx/p++-Si 忆阻器器件的模拟开关和人工突触行为
摘要
在本研究中,通过插入 TiOx 缓冲层 SiOx 之间 :Ag层和底部电极,我们开发了一种简单结构的Ag/SiOx的忆阻器器件 :Ag/TiOx /p ++ -Si 通过物理气相沉积工艺,在模拟切换过程中可以有效控制灯丝的生长和断裂。通过实施正或负脉冲序列,具有大范围电阻变化的忆阻器装置的突触特性已被广泛研究。同时实现了多种学习和记忆功能,包括增强/抑制、成对脉冲促进(PPF)、短期可塑性(STP)和由重复脉冲控制的 STP-to-LTP(长期可塑性)转变。比排练操作,以及尖峰时间依赖可塑性(STDP)。基于对数 I-V 特性的分析,发现导电银丝在介电层上的受控演化/溶解可以提高测试忆阻器器件的性能。
介绍
2008年,Strukov等人提出了Chua教授的忆阻器理论概念[1]。首次发表了基于TiO2的双紧凑型终端器件中磁通量与电荷关系的研究[2],引发了全球研究人员的兴趣。除了从逻辑运算和可重构射频系统到非易失性存储器应用 [2,3,4] 的各种潜在应用之外,还研究了忆阻器以模拟生物突触功能,因为它们具有相似的结构和工作动力学。如今,人们普遍认为,在电子设备中直接模拟突触功能对于开发受大脑启发的神经形态计算系统至关重要 [5,6,7]。然而,传统设计的电子突触基于互补金属氧化物半导体(CMOS)技术,在复杂的计算执行过程、集成密度和能量耗散方面受到冯诺依曼瓶颈效应的影响。因此,由于忆阻器具有非易失性、纳米级尺寸、低功耗、响应速度快等独特特性,可调两端器件的使用为开发新的电子突触结构注入了许多有希望的机会。 . [8, 9]。
最近,各种材料(例如,金属氧化物如 ZnO2、WOx , SnOx [10, 11],硫族化物如 Cu2S、Ag2S [12, 13] 和铁电材料如 La2O3、Pb0.8Ba0.2ZrO3 [14, 15]) 已被研究用于忆阻器器件的设计和制造。对于许多器件,电阻的变化归因于氧空位或金属离子(例如,Ag + , 铜 2+ , 和 Al 3+ ) 并形成高导电路径。忆阻器中的导电路径通常称为“导电灯丝 (CF)”,随后可能会在开关操作期间断开。通常,在忆阻器中观察到两种类型的开关行为,即突然(数字开关)和渐进(模拟开关)。电阻的突变与数字信号(0或1)一致,有利于信息的存储[16, 17]。
与数字开关相反,忆阻器中的连续电导可调性与生物突触有一些相似之处,生物突触是人脑中学习和记忆功能的基本细胞单元 [18]。在几个忆阻器设备中,用于模拟生物突触权重调制的模拟电导变化已经实现 [19, 20]。具有 Pt/a-Si:Ag/Pt 和 Pt/SiOx 的 a-Si 和氧化物基忆阻器中的扩散 Ag 否y :Ag/Pt 结构已成功模拟 Ca 2+ 或 Na + 生物突触的动力学 [21, 22]。同样,基于金属氧化物的忆阻器中的氧离子/空位细丝也被提议用于实现突触功能,包括短期增强 (STP) 和成对脉冲促进 (PPF) [23, 24]。然而,生物学习规则是多种多样的,到目前为止,忆阻器模型中还没有涉及到所有的突触功能[16]。
除了材料的选择外,通过在“金属/忆阻层/金属”结构中插入额外的介电层来控制灯丝生长和断裂,为模拟突触功能提供了一定的优势,包括 STP 和 LTP 以及低功耗。最近,为了控制导电丝形成/断裂的速率,Wang 等人。 [25] 通过在 TaOx 中插入 SiO2 层证明了模拟开关行为 基于忆阻器。万等人。 [26] 还通过在 Ag/SrTiO3/FTO 忆阻器结构中插入还原氧化石墨烯层来控制银丝过度生长,实现了模拟开关和仿真 STP 和 STDP 功能。此外,据报道 [27, 28] 基于 TiOx 具有高介电常数 (~40) 和低带隙 (~3 eV) 的材料,通过插入具有 HfO2 忆阻层的 TiO2 薄层,忆阻器器件在循环耐久性和均匀性方面的性能得到显着提高。除此之外,据报道 [24] 由于低离子迁移率和低氧化还原反应速率,TiOx 薄膜还可以作为缓冲层,防止导电细丝过度生长,从而实现更好的突触行为,并在阻变过程中保持导电细丝的良好接触。
在这篇文章中,我们报道了一种新的 Ag/SiOx 结构 :Ag/TiOx /p ++ -Si 忆阻器器件及其模拟开关行为。与早先报道的单层器件相比 [22, 29],发现插入 TiOx 如上结构所示的层在扩大电导窗口和在开关过程中保持稳定状态方面确实影响忆阻器器件的开关行为。此外,忆阻器器件的电导可以分别在正脉冲和负脉冲序列下轻松调整。我们最近的结果表明,我们已经成功获得了可靠的模拟切换和尽职尽责地模拟生物突触功能,例如短期和长期可塑性(STP 和 LTP)、成对脉冲促进 (PPF) 功能、尖峰时间依赖性可塑性。 STDP) 以及 STP 到 LTP 在 Ag/SiOx 中的转变 :Ag/TiOx /p ++ -Si忆阻器。
方法
- i.
器件制造:如图 1a 所示,我们的忆阻器设计为 Ag/SiOx :Ag/TiOx /p ++ -Si结构。 p ++ -Si 基板 (15 × 15 mm 2 ) 电阻率约为 0.01 Ω cm 的情况下,通过标准方法清洁,然后在其上制造器件。以下所有过程均在室温下在高真空系统中进行。首先,在 p ++ 上沉积约 10 nm 厚的氧化钛层 -使用高纯度陶瓷 TiO2 靶材通过射频磁控溅射的硅衬底。然后,约 95 纳米厚的 SiOx :Ag 层是通过 RF 共溅射沉积的,使用 SiO2 靶材,在磁性溅射路径上放置小银片。在沉积过程中,Ar 流速和压力分别保持在 50 sccm 和 20 mTorr,而 RF 功率保持在 80 W。最后,对 ~30 nm 厚的 Ag 层的顶部电极 (TE) 进行图案化通过光刻和剥离技术,其中使用直流磁控溅射沉积薄金属层。单个电极直径约为150 μm。
- ii.
表征方法:通过透射电子显微镜 (TEM) 测量和 X 射线光电子能谱 (XPS) 分析来分析 SiOx 的微观结构 :Ag 和 TiOx 分别是层和 Ag 原子的化学状态,其中首先使用聚焦离子束(FIB,FEI Nova Nano Lab 200)制备 TEM 样品,然后在 FEI Phillips CM10-Supra TEM 系统下观察。电气特性是使用与探针台挂钩的半导体分析仪 (Keithley 2636B) 进行的。在电气测量期间,正负偏压由顶部电极和底部电极之间流动的电流定义。所有电气测量均在室温空气中进行。

Ag/SiOx 的示意图 :Ag/TiOx /p ++ -Si 忆阻器器件及其横截面 TEM 分析。 一 该装置的示意图以及生物突触和电子突触之间的类比。 b 单个 Ag/SiOx 忆阻器单元的横截面 TEM 视图 :Ag/TiOx /p ++ -Si结构。 SiOx :Ag 和 TiOx 夹在 Ag TE 和 p ++ 之间的薄膜 -Si BE 电极。 c 器件截面的元素映射
结果与讨论
图 1a 中描述了设备和测量配置的示意图。该器件结构简单,由SiOx组成 :Ag 和 TiOx 夹在 Ag TE 和 p ++ 之间的薄层 -Si BE 由图 1b 和 c 所示的忆阻器单元的横截面 TEM 和元素映射证实。 SiOx表面Ag原子的化学状态 由 XPS 分析,如附加文件 1:图 S1 所示。 Ag 的 Ag3d 光谱被解卷积为单个双峰,Ag3d5/2 的结合能为 368.0 eV,Ag3d3/2 的结合能为 374.0 eV,它们精确地分配给 Ag 金属态。附加文件 1 中的 HRTEM 图像:图 S2 显示了无定形 TiOx 的横截面 层,而小的 Ag 纳米团簇在 SiOx 中可见 :Ag 层,这可能是由 TEM 样品制备过程中 Ag 的外扩散引起的,以最大限度地减少材料系统的总界面能 [22]。此外,快速傅里叶变换 (FFT) 证实嵌入 SiOx 中的 Ag 纳米团簇 在结构上是多晶的,例如Ag(111)和Ag(002)纳米晶体。在 Ag/SiOx :Ag/TiOx /p ++ -Si 忆阻器,Ag/SiOx :Ag 和 TiOx /p ++ -Si 分别作为突触前膜和突触后膜,如图 1a 所示。通过释放 Ca 2+ 改变突触权重 或 Na 2+ 当接收到神经脉冲时,突触前膜和突触后膜之间的间隙中的离子被突触前膜称为“裂缝”。同样,Ag/SiOx 的电导 :Ag/TiOx /p ++ -Si忆阻器可以通过电压脉冲下Ag离子的迁移被人工调制为电子突触。
图 2a 显示了 Ag/SiOx 的电流-电压 (I-V) 曲线 :Ag/TiOx /p ++ -半对数标度的Si忆阻器装置。在 0 V → +4.0 V → -4.0 V → 0 V 的扫频偏置下,测得的 I-V 曲线呈现出收缩的磁滞回线,这是忆阻器的指纹。当对 Ag TE 施加正偏压时,电流会逐渐增加,直至达到顺从电流限制 (Icc),器件的电阻状态从高电阻状态 (HRS) 变为低电阻状态(LRS),称为“SET”过程。而当向 Ag TE 施加负偏压时,电流会减小,电阻状态从 LRS 返回到 HRS,这称为“RESET”过程。这表明器件电导率可以通过正或负扫描偏置进行相应调制,表现出双极电阻开关行为。与在高压状态下 SET 和 RESET 过程中电流的突然增加或减少不同,非常有趣的是,器件电流在 0 V → +2.1 V 或 0 V → -2.1 V 的重复电压扫描下连续增加或减少,如图2b所示。电流和电压与时间的关系 (I-V-t) 也绘制在图 2b 的插图中,以更清楚地显示电导的变化。与生物突触一样,在分别执行 I-V 曲线的连续正 (1st-5th) 和负 (6th-10th) 部分后,观察到电流的向下或向上演变的明显器件响应。在正(或负)电压扫描期间电流的连续增加(或减少)表明器件电阻可以通过直流扫描模式进行调制。还观察到,在随后的每次正扫描或负扫描期间,I-V 曲线会选择最后一条停止的位置,显示了忆阻器器件的典型模拟开关特性。忆阻器器件的耐久性能可以通过在+0.3 V的读出电压下实施更宽的双极扫描电压来评估,如图2c所示,表明该器件可以在设置/复位期间在LRS和HRS之间稳定一致地运行操作超过 10 3 循环。
<图片>
Ag/SiOx 的 I-V 特性 :Ag/TiOx /p ++ -Si忆阻器装置。 一 双极开关行为b 通过重复电压扫描增强或抑制。插图显示了电压和电流与时间的关系 (V-I-t),展示了增强或抑制期间的电导状态。 c 10 3 读出电压为 -0.3 V 时的耐久循环性能测试 从 0 到 +4.0 V(用于设置)和 0 到 -4.0 V(用于复位)的更广泛双极扫描周期。 d 电导调制的重复特性
忆阻器装置也可以在脉冲信号而不是直流偏置扫描电压下工作。图 2d 显示了在实施重复增强(正偏置)和抑制(负偏置)脉冲后以增强或抑制形式出现的器件响应。升压脉冲幅值分别为+1.2 V和-1.2 V,所有脉冲宽度和间隔均固定为5 ms。在这里,无论正或负脉冲偏置如何,都可以观察到器件中的电导调制,这类似于分别在增强和抑制刺激下以增强或抑制形式出现的突触反应。很明显地发现,设备响应可以根据刺激脉冲的数量逐个周期地进行调整,这表明可以使用超出施加偏置极性的稳定和均匀的增强和抑制来模拟权重调整和记忆电子突触的增强[30].
为了理解开关行为,通过拟合 I-V 特性来分析传导机制。为此,一个独立的 SiOx :Ag/SiOx结构的基于Ag薄膜的忆阻器 :Ag/p ++ -Si也被制造。如图 3a 所示,器件对准直流电压扫描的响应表明了典型的阈值切换行为,如之前报道的 [29, 31]。箭头方向表明该器件可以作为易失性存储器在两种状态之间循环。然而,Ag/SiOx 的 I-V 曲线 :Ag/TiOx /p ++ -Si 忆阻器器件表明情况与独立的 SiOx 大不相同 :Ag 基忆阻器器件。图 3b 显示该器件在 I-V 曲线的正负部分下的 LRS 和 HRS 方面表现出双极开关行为,而工作电压相对较高。图 3c 展示了 Ag/SiOx 的 I-V 曲线 :Ag/TiOx /p ++ -Si 忆阻器装置,它被拟合为 HRS 和 LRS 的正区域数据的 Ln(I) 与 Ln(V)。这些拟合结果表明,HRS 的电荷传输行为与经典的陷阱控制空间电荷限制传导 (SCLC) 机制一致,该机制由欧姆区 (I/V)、儿童定律区 (I/V) 三个部分组成。 V 2 ),以及陡峭的电流增加区域 [32]。而 LRS 处的线性行为,其中斜率 =1,表明具有出色的欧姆行为,如图 3c 所示。 HRS 和 LHR 处的不同导电行为由 LRS 处导电银丝的形成证明 [32]。图 3d 进一步支持电阻转换是由传导灯丝形成/破裂引起的。可以看出,虽然设备的LRS与设备小区大小无关,但设备的HRS与小区大小成正比。 LRS 的这种与尺寸无关的特性通常在进行基于灯丝的存储设备时被观察到 [33]。因此,可以得出结论,Ag/SiOx 中的电阻转换现象 :Ag/TiOx /p ++ -Si忆阻器装置通常源自在正/负偏压下导电丝的受控形成/断裂。电导的逐渐变化可能是由于电场下 TE 和 BE 之间的横截面间隙的变化引起的,与其他报告类似 [34]。因此,根据等效电路,器件的总电阻可以描述为 R =Rij =V/I,其中 Rij 定义为与 TE 和 BE 之间 CF 的横向间隙大小相关的电阻。因此,如果可以通过使用适当编程的偏置来调节 TE 和 BE 之间的 Ag CF 尺寸来调整该间隙,则可以逐渐调整忆阻器件的导通或电阻。
<图片>
Ag/SiOx的导电机理分析 :Ag/p ++ -Si和Ag/SiOx :Ag/TiOx /p ++ -Si 器件。 一 Ag/SiOx的线性I-V曲线 :Ag/p ++ -Si 和 b Ag/SiOx :Ag/TiOx /p ++ -Si 装置。 c Ag/SiOx 的传导机制对应于 HRS 的 SCLC 和 LRS 的欧姆 :Ag/TiOx /p ++ -Si 器件根据 (b 中 I-V 曲线正区域的拟合结果 )。 d LRS或HRS电导的细胞面积依赖性
图 4 中还给出了相应的物理模型来解释独立 SiOx 中的开关机制 :Ag和SiOx :Ag/TiOx 基于忆阻器设备。 Ag纳米粒子在SiOx中的行为 基于双极电极之间的电化学反应(Ag 离子和 Ag 原子的迁移和积累)可以解释为基础电池,与之前报道的类似 [22, 35]。当施加扫描电压时,Ag纳米颗粒进一步生长以桥接电极之间的间隙,导致电流突然增加到顺应水平,并且忆阻器在LRS中导通(如图1中的中间面板所示)。 4a)。去除电偏压后,早期形成桥的细长 Ag 纳米团簇现在迅速收缩 [22],并且设备返回到 HRS(如图 3a 的最后一个面板所示)[35],表明双极阈值切换可以在两种状态之间循环的忆阻器的行为,如易失性存储设备。
<图片>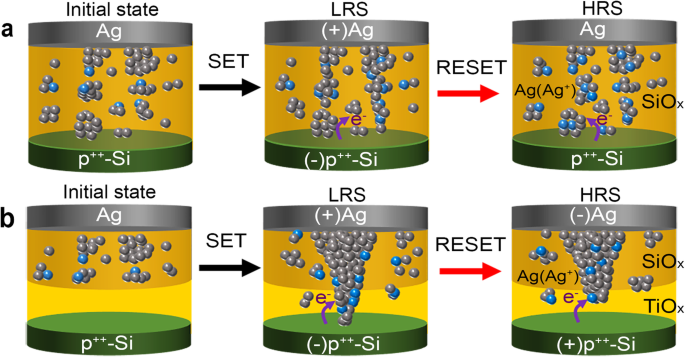
切换行为的物理模型示意图。 一 Ag/SiOx :Ag/p ++ -Si忆阻器; b Ag/SiOx :Ag/TiOx /p ++ -Si忆阻器
SiOx 的情况则完全不同 :Ag/TiOx 基于忆阻器器件,其中 SiOx 薄层具有高带隙 (~9 eV) 和较低的介电常数 (~3),但 TiOx 层具有低带隙 (~3 eV) 和高介电常数 (~40),这使得 SiOx 上的电场 层高于 TiOx 层,在转换层中溶解更多的 Ag 原子 [28]。正是氧化钛的低离子迁移率和低氧化还原反应速率控制着 Ag 原子和 Ag 离子穿过界面层的迁移和积累 [36]。如上所述,这两个事实可以导致从 TE 到 BE 形成纳米锥形细丝 [37]。以从 TE 到 BE 的纳米锥形式有效限制长丝生长形式的浓缩金属区域可以在循环操作期间提供对电阻状态的控制 [38]。当顶部 Ag 电极在双层上有足够的正偏置时,介电层上的电场足以将 Ag 离子从 Ag TE 驱动到 p ++ -Si BE 通过界面层,导致电极之间的有效间隙减小(如图 4b 的中间面板所示)。除非施加负电压,否则银丝不会溶解,并且即使去除偏置电压也趋于保持其原始形状。当施加负电压时,开始正常的 RESET,并且由于热辅助电化学过程 [39],Ag CF 会部分地荒凉(通常在最薄的位置)。忆阻器器件关闭并返回到 HRS(图 4b 的最后一个面板),然后作为非易失性存储器件在两个状态之间可逆循环(如图 3b 所示)。图 4b 的左侧面板表示此处形成的细丝应该比图 4a 中间面板中的细丝粗,除非施加负电压,否则它们不能溶解和破裂。 SiOx中的细丝部分 层仍然比 TiOx 中的纳米锥部分薄得多 层,整个灯丝的形状有点像一个纳米锥。因此,当施加负偏压时,施加负电压时灯丝将迅速断裂(图 3b),而电压将进一步增加,电流再次增加,表明在高偏压下存在负 SET 的风险BE 表面附近存在残留的 Ag 原子。
实际上,HRS 处的忆阻器总电阻仅与灯丝纳米锥尖端和底部电极之间的间隙有关,可以通过调节偏压来增加或减小该间隙[33]。这种改变忆阻器中 HRS 的趋势可以在图 2b 中看到,其中电流可以在从 0 V 到 +2.1 V 和从 0 V 到 -2.1 V 的重复扫描偏置下连续增加或减少。另一方面,在 +2.1 V 以下的电压的恒定扫描不足以在 TE 和 BE 之间形成导电细丝。相反,导电银丝可以逐渐积累银原子,导致电极之间的有效间隙减小,如附加文件 1:图 S3 所示。因此,通过使用合适的编程偏置,可以实现典型阈值切换到逐渐切换的过渡,并且可以通过调整电极之间的有效间隙来调整存储单元的总电阻,就像在生物突触中观察到的那样。
与生物突触类似,具有适当脉冲编程的输入刺激可以改变忆阻器设备的电导状态以执行多项神经任务。 PPF 是另一种关键特征,它可以通过输入刺激的时间总和来调整电导,并执行一些短期神经任务,包括突触过滤和适应 [40, 41]。生物突触中的 PPF 函数的工作原理如下:在两次连续的尖峰刺激期间,第二个突触后反应变得高于第一个,使尖峰的间隔时间小于恢复时间 [22]。图 5a 显示了设备响应,在实施一对幅度为 +2.0 V 的促进脉冲后进行监测,该脉冲具有固定的宽度和间隔,称为 0.08 s 的标度。观察到作为第二个脉冲响应的电流比第一个显着增加,表明在实施合适的脉冲编程后电导状态发生了明显变化。在两个后续脉冲之间的间隔期间,观察到电流衰减,这可归因于器件中存在易失性特征。电导衰减可能对应于去除增强脉冲后 Ag 原子的扩散 [42]。只有当两个连续脉冲之间的时间间隔小于 Ag 原子的扩散弛豫时间时才能执行成功的 PPF 功能,导致更多的 Ag 原子被推入 SiOx :Ag/TiOx 层。此外,当器件被多个幅度为 +2.0 V 且具有固定宽度和间隔(称为 0.08 s 的标度)的促进脉冲连续刺激时,就会达到饱和状态,如图 5b 所示。结果表明,当施加高频脉冲时,会在SiOx中泵出更多的Ag原子 层,直到在 TE 和 BE 之间形成导电桥,达到饱和水平 [22]。这种现象与赫布学习规则非常相似,其中突触权重变化必须具有饱和值,以避免神经元过度兴奋,并施加脉冲序列的未染色尖峰[43]。
<图片>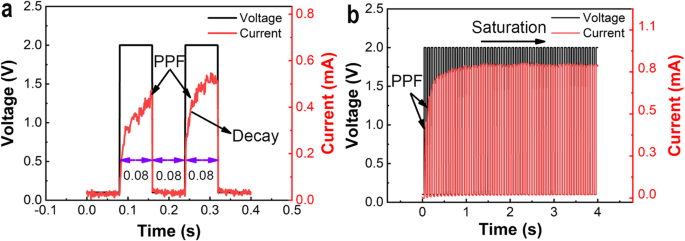
成对脉冲易化 (PPF) 的实验结果. 一 在 Ag/SiOx 上实现 PPF :Ag/TiOx /p ++ -Si 器件使用 +2.0 V 脉冲高电平和 0.08 s。 b 使用幅度为+2.0 V、宽度相同、间隔为0.08 s的脉冲串演示饱和的突触权重运动
此外,与生物突触一样,忆阻器在执行增强尖峰后会随着电流的突然下降而出现记忆丧失,这可以归因于忆阻器中存在 STP [44, 45]。在神经生物学中,STP 和 LTP 通常被归为短期记忆 (STM) 和长期记忆 (LTM) [46]。已经确定 STP 到 LTP 的转变可以通过重复刺激(即排练过程)发生 [46, 47]。为了验证这种行为并将其与在生物突触中观察到的行为进行比较,我们对我们的 Ag/SiOx 实施了一系列电压脉冲 :Ag/TiOx /p ++ -Si忆阻器器件。图 6a 显示了在执行 15 个连续脉冲(幅度 +1.4 V,宽度和间隔 5 ms)后,电流从初始状态的 0.05 mA 增加到 1.8 mA。归一化电流衰减 ((It-Io)/Io × 100%) 在施加随时间 (t ),如图 6b 所示。归一化电流衰减和时间之间的关系很好地拟合了方程中给出的关系。 (1) [48]:
$$ {\Delta I}_t/{\Delta I}_o\times 100\%=\exp \left[-{\left(t/\tau \right)}^{\beta}\right] $$ ( 1)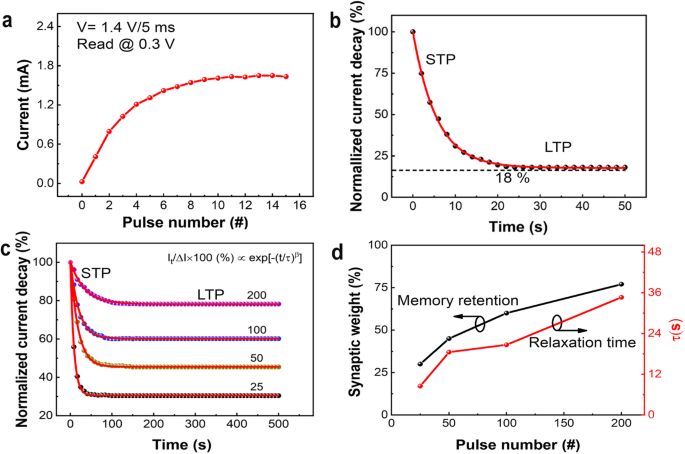
Ag/SiOx 中的电流衰减和记忆保持 :Ag/TiOx /p ++ -Si忆阻器。 一 连续执行 15 个相同的增强脉冲后电流增加。 b 在激励器件后,在 +0.3 V 的读数电压下监测电流衰减。 c 归一化电流衰减与时间的关系显示了在实施刺激次数的脉冲序列后从 STP 到 LTP 的转变。 d 记忆保持和松弛时间(τ ) 脉冲数
在这里,τ 称为弛豫时间,β 称为拉伸指数 (0 <β <1)。通常,这种关系用于描述具有随机能量分布的无序材料中的弛豫过程。曲线表明,突触权重的衰减类似于心理学中的人类记忆“遗忘曲线”[49],其特点是开始快速衰减,可称为STP,然后逐渐达到可称为LTP的稳定水平在设备中。然而,在很短的时间间隔 (t ),然后在低电导状态下达到饱和水平(在 50 s 内达到 16%)。在这种情况下,在脉冲参数没有任何其他变化的情况下,我们用重复的脉冲数进行了进一步的模拟过程。在对每组脉冲序列从相同的初始状态施加不同数量的脉冲(即 25、50、100 和 200)之后,立即在 +0.3 V 的读取电压下测量电流。图 6c 显示了在每组测量中归一化电流随时间衰减的关系符合方程 1 中给出的关系。 (1).图 6d 表明,随着刺激次数的增加,弛豫时间 (τ ) 增加,表明遗忘过程缓慢消退。同时,观察到电流水平的明显升高,这意味着突触权重(电导)的正变化,如图 6d 中的黑线所示。图 6 中显示的这些结果清楚地证明了我们的设备中存在 STP 和 LTP。较少数量的刺激只能在设备中引起 STP,在饱和水平时电导略有上升。因此,通过增加重复刺激的次数,排练过程不仅提高了电导水平,而且实现了持久的记忆保留现象,如图6d红线所示。
The conventional digital-type memories require the non-volatility to store the information, while in bio-synapse, information processes and accordingly reconfigures the memory status. It can be seen in Fig. 6 that the transition from STP to LTP is realized, and the synaptic weight is adjusted accordingly, while the unimportant ones with small synaptic weight are temporarily stored and then diminished with time. This phenomenon is quite similar to the “multi-store model” presented by Atkinson and Shiffrin [50]. In this model, first input information is analyzed, then stored in different hierarchy levels, according to the importance of “synaptic weight” through the rehearsal process. Therefore, an increase in synaptic weight and resultant prolonged relaxation time (τ ) in our device as a function of stimulation numbers has best verified the rehearsal scheme.
Besides the pulse repetition process, the transition of the STP to the LTP phenomenon is further examined as a function of pulse strength. The device response is monitored after implementation of different pulse amplitudes, i.e., +1.2 V, +1.6 V, +2.0 V, and +2.8 V with similar width and interval scale of 3 ms, as shown in Fig. 7a. The current is monitored with a readout voltage of +0.3 V after imposing each pulse train consisting of 50 pulses. The fitted results with the stretched exponential relaxation model in Fig. 7a shows that the relaxation time is increased as a function of pulse strength (as shown in Fig. 7b red line). Meanwhile, as shown in Fig. 7b, an elevation of the synaptic weight of about 90% is observed at a larger τ of 43 s and +2.8 V amplitude, which is much higher than the synaptic weight of about 25% at a smaller τ of 10 s and +1.2 V amplitude (as shown in Fig. 7b black line), indicating the formation of LTP. Based on these results, it is easy to find that the formation and persistence of LTP in our device are highly dependent on both pulse numbers or pulse amplitude. These results coincide with the facts that the memory states, i.e., STM and LTM, and their stabilities in bio-synapses are related to the input stimulus characteristics.
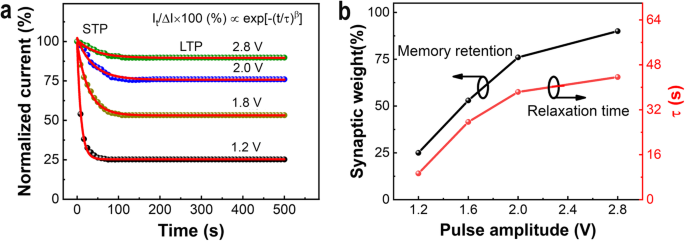
Experimental results of current decay in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device after the stimulation process. 一 The normalized current decay versus time showing the transformation from STP to LTP; b The memory retention and relaxation time (τ ) as a function of the pulse amplitude
The spike-time-dependent-plasticity (STDP) is another fundamental character for learning and memory function [51] in a biological synapse. It has been reported [52] that in the electronic synapse, the weight can be modulated by a relative timing of pre- and post-synaptic pulses. The Hebbian STDP rule works as follows:if the pre-spike precedes the post-spike (Δt> 0), it could reinforce the connection strength between two neurons. In contrast, if the post-spike heads the pre-spike (Δt <0), it could weaken the connection strength between two neurons. Such kinds of reinforcement and weakening of connection strength between two neurons are also called LTP and LTD, respectively [45]. In the whole process, the order of pre- and post-spikes with respect to time determines the weight change (ΔW) polarity. In order to emulate the STDP rule in our device, a pair of pulses (+1.2 V, 5 ms, and −1.2 V, 5 ms) as pre- and post-spiking signals are implemented, as shown in Fig. 8a. It can be seen that there will emerge a more considerable conductance change (synaptic weight) with the decrease of Δt (in both cases when Δt> 0 and Δt <0). The percentage change in synaptic weight is defined as ΔW =(Gt−G0)/G0 × 100%. Here, G0 is the conductance measured before stimulation and Gt is the conductance measured after the stimulation using pre- and post-spiking pairs, respectively. A plot is shown in Fig. 8b, that can explain the relationship between ΔW and Δt before and after the simulation process. It can be seen that when the pre-synapse (positive) appears before the post-spike (negative) (Δt> 0), the conductance is enhanced with an increase in ΔW along with the decrease in Δt. On the contrary, when the pre-synapse (positive) appears after the post-spike (negative) (Δt <0), the net conductance of the device is decreased (depressed) in ΔW along with the increase in Δt. These results have demonstrated that our Ag/SiOx :Ag/TiOx /p ++ -Si memristor device has successfully emulated the Hebbian STDP learning rule in the form of an artificial synapse.
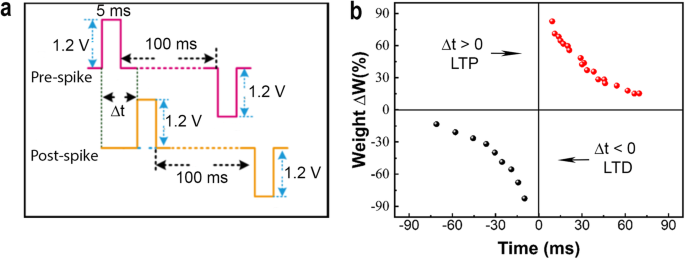
Experimental results for implementation of STDP rule in Ag/SiOx :Ag/TiOx /p ++ -Si memristor device. 一 The schematic illustration of implementing electrical programming bias comprising the pair of pulses at amplitudes +1.2 V and −1.2 V fixed with the same width of 5 ms. The approaching time difference between stimulus pulses is Δt ms (t =±10n, n =1, 2, …, 10); b The synaptic weight (ΔW) as a function of spike timing (Δt), demonstrating well on the potentiation and depression behaviors in the memristor device
结论
In summary, a new kind of memristor device with the simple structure of Ag/SiOx :Ag/TiOx /p ++ -Si has been fabricated by a physical vapor deposition process. The synaptic characteristics of the memristor with a wide range of resistance change for synaptic weight modulation by implementing positive or negative pulse trains have been investigated extensively. Several crucial learning and memory functions have been demonstrated simultaneously in such a single fabricated memristor device, including short-/long-term potentiation and depression (STP/STD, LTP/LTD), PPF and the STP-to-LTP transition as well as STDP, which are adjusted and controlled by repeating pulses more than a rehearsal operation. Furthermore, the analysis of logarithmic I-V characteristics with corresponding physical model indicates that the controlled formation/dissolution of Ag-filaments across the Ag and p ++ -Si electrodes could improve the performance of the new Ag/SiOx :Ag/TiOx /p ++ -Si memristor device with a buffer layer of TiOx between the SiOx :Ag layer and the bottom electrode. This developed device, as an artificial synapse, might bring a potential research prospect in the design and hardware implementation of new-generation biomimetic neural networks and computing systems.
数据和材料的可用性
所有数据完全可用,不受限制。
缩写
- BE:
-
底部电极
- HRS:
-
高阻态
- I-V:
-
电流-电压
- LRS:
-
低阻态
- LTM:
-
Long-term memory
- LTP:
-
Long-term plasticity
- PPF:
-
Paired-pulse-facilitation
- SCLC:
-
Space-charge limited conduction
- STDP:
-
Spike-time-dependent-plasticity
- STM:
-
Short-term memory
- STP:
-
Short-term plasticity
- TE:
-
顶部电极
- TEM:
-
透射电子显微镜
- XPS:
-
X射线光电子能谱
纳米材料
- 模拟和数字信号
- 具有应用程序的模拟和数字传感器的类型
- V/SiOx/AlOy/p++Si 器件作为选择器和存储器的双重功能
- 蚀刻变化对 Ge/Si 沟道形成和器件性能的影响
- 双层 CeO2−x/ZnO 和 ZnO/CeO2−x 异质结构和电铸极性对非易失性存储器开关特性的影响
- 增强型近红外吸收体:两步制造结构化黑硅及其器件应用
- Ag/BiPbO2Cl 纳米片复合材料的增强型可见光响应光催化性能
- 在太赫兹范围内具有可切换吸收和偏振转换功能的多功能设备
- 被动直接甘油燃料电池中的纳米结构 Pd 基电催化剂和膜电极组装行为
- 原子层沉积基于 Hf0.5Zr0.5O2 的具有短/长期突触可塑性的柔性忆阻器
- 人工智能预测量子系统的行为
- 人工智能的优缺点


