双异质结硅衬底上的 AlGaN/GaN 肖特基势垒二极管的理论和实验研究
摘要
在 GaN/AlGaN/GaN/Si-sub 上对具有双异质结的 AlGaN/GaN 肖特基势垒二极管 (SBD) 进行了理论和实验研究。二维空穴气 (2DHG) 和电子气 (2DEG) 分别形成在 GaN-top/AlGaN 和 AlGaN/GaN 界面处。在关断状态下,2DEH 和 2DHG 部分耗尽,然后完全消失。保持固定的正负极化电荷,形成极化结。因此,获得了漂移区中的平坦电场和高击穿电压(BV)。此外,阳极凹入以降低导通电压(V 在)。低损伤 ICP 蚀刻工艺改善了肖特基接触,以及低漏电流和低 V 获得 ON。制造的 SBD 在阳极到阴极距离 (L AC) 为 11 μm。制造的 SBD 实现了低 V ON 0.68 V,均匀性好,开/关电流比高~ 10 10 在室温下,低比导通电阻 (R ON,SP) 为 1.17 mΩ cm 2 ,以及 1051 MW/cm 2 的高 Baliga 品质因数 (FOM) .
介绍
由于二维电子气 (2DEG) 的高电子迁移率、高电子饱和速度和高击穿电场,基于 AlGaN/GaN 异质结构的横向二极管是一种有吸引力的器件 [1,2,3]。已作出广泛努力以实现低导通电压 (V ON)、低反向漏电流和高击穿电压 (BV),用于电源和功率因数校正的转换器和逆变器中使用的 GaN 二极管 [4,5,6,7,8,9,10,11,12 ]。已经提出了各种方法来解决电场的非均匀分布。其中之一是场板 (FP) 技术 [5, 13]。具有双场板的全凹入阳极 SBD 在 25 μm L 下实现了 1.9 kV 的高击穿电压 交流 [5]。它还可以显着降低导通电压,同时保持高击穿电压。此外,硅技术中常用的传统减少表面场 (RESURF) 概念已在 GaN HEMT 中得到证明 [14]。此外,为了改善比导通电阻 (R ON,SP) 和 BV [15,16,17,18]。基于PJ概念的GaN基器件已经在蓝宝石和SiC衬底上进行了演示,而SiC衬底上GaN的高成本和小直径不利于大规模商业应用。由于成本低,具有大直径的 GaN-on-Si 被认为是一种有前途的选择 [19,20,21,22]。因此,PJ二极管在硅衬底上的性能值得研究。
在这项工作中,我们提出并实验证明了一种具有双异质结 (DJ) 的 GaN/AlGaN/GaN-on-Si 肖特基势垒二极管。通过模拟和实验证实了极化结效应。实现了阳极和阴极电极之间的平坦电场(E 场)。蚀刻肖特基沟槽的ICP工艺经过优化,可实现低反向漏电流和低V ON 具有出色的蚀刻均匀性。欧姆接触工艺也经过优化,以基于定制的外延层(具有 45 nm GaN 顶部)实现低接触电阻(对于 2DEG)。因此,对于具有 11 μm L 的 SBD,实现了 1109 V 的击穿电压 AC 和 Baliga 的品质因数 (FOM) 为 1051 MW/cm 2 .温度依赖性和动态 R 还研究了 ON、SP 性能。
方法与实验
外延层通过金属有机化学气相沉积在 6 英寸 p 型硅上生长,由 3.5 微米 GaN 缓冲层、150 纳米 GaN 沟道层、1 纳米 AlN 中间层、45 纳米 Al0.25Ga0 组成。 75N 势垒层和 45-nm GaN 顶层从下到上。 GaN 顶层包括 35-nm p-GaN 层和 10-nm 未掺杂 GaN 层。对于 45 nm 的给定 AlGaN 厚度,2DHG 密度随着 GaN 顶部厚度的增加而增加 [22]。厚的 GaN 顶层对于高密度 2DHG 至关重要,但它有悖于低欧姆接触电阻(对于 2DEG)。所提出的双异质结肖特基势垒二极管(DJ SBD)的示意图如图 1a 所示。 SBD 制造始于通过基于 Cl2/BCl3 的电感耦合等离子体 (ICP) 蚀刻至 300 nm 深度的台面隔离。然后,通过低损伤ICP蚀刻工艺形成欧姆沟槽和肖特基阳极沟槽。欧姆沟槽和肖特基阳极沟槽的深度分别为50 nm和90 nm,这通过使用原子力显微镜(AFM)得到证实。引入四甲基氢氧化铵 (TMAH) 溶液在 85 °C 下保持 15 分钟,以去除蚀刻后的残留物并在完成蚀刻工艺后修改沟槽侧壁 [23]。然后,在 N2 环境中在 400 °C 下退火 10 分钟。随后通过电子束蒸发的 Ti/Al/Ni/Au (20/140/55/45 nm) 形成欧姆阴极,在 870 °C 下在 N2 环境中退火 35 s,接触电阻 (R C) 0.49 Ω·mm。最后,阳极金属和互连由 Ni/Au 沉积以完成制造流程。这些设备具有各种 L AC 从 7 到 11 μm。图1b为阳极ICP和金属沉积后的高分辨率截面TEM图,层状结构清晰可见。
<图片>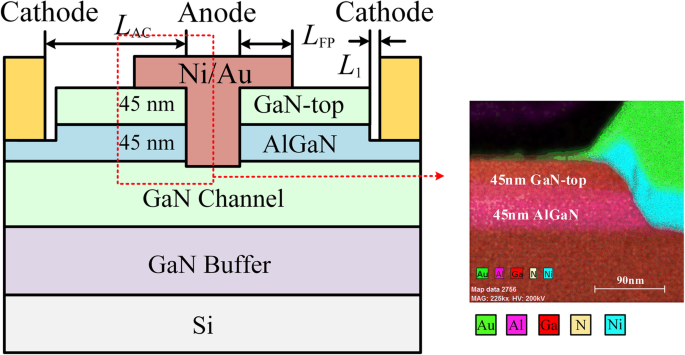
一 提出的双异质结 AlGaN/GaN SBD 和主要制造工艺的横截面。 L AC 是阳极到阴极的长度。 L FP 和 L 1 分别为 1 μm 和 2 μm。 b ICP和金属沉积后阳极的HR-TEM图像
2DEG 是由沿 AlGaN/GaN 界面的正极化电荷引起的。上部 GaN/AlGaN 界面具有负极化电荷,因此在上部界面处产生 2DHG [15]。漂移区和阴极之间的间隙 (L 1) 用于切断空穴电流路径,如图 2 所示。我们只研究了 L 的影响 1 由于原始版图设计的限制,在正向和反向阻塞特性上从 2 到 3 μm。 V ON 和 R ON,SP 没有变化,因为 L 1 不影响肖特基接触和电子电流路径。此外,随着L的增加,BV略有下降 1 因为缩短了漂移区。 DJ SBD 在正向偏压下的运行机制与传统 SBD 几乎相同,这意味着 2DHG 几乎不会影响从阴极到阳极的电子电流路径。随着反向偏置电压的增加,2DEG 和 2DHG 被完全耗尽。保持固定的正负极化电荷,形成极化结。结果,在阴极和阳极之间获得了平坦的电场分布(图3)。
<图片>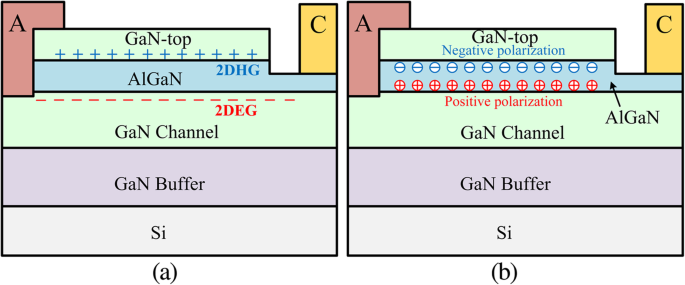
DJ SBDa运行机理分析 零偏差和 b 反向偏置
<图片>
通过 TCAD 模拟沿 AlGaN/GaN 沟道异质界面的电场分布。 Al分数定义为0.25。缓冲层中的净受体(深能级)密度设置为 1.5 × 10 16 厘米 −3 能级比导带最小值低 0.45 eV。 AlGaN/GaN界面的受主密度设置为6×10 12 厘米 −3 能级低于导带最小值 0.23 eV
如图 3 所示,击穿特性和极化结机制由 Synopsys 的 2-D Sentaurus TCAD 确认。我们在模拟中考虑了几个重要的物理现象,包括带隙变窄、极化、电子/空穴迁移率、碰撞电离和 SRH 复合。
采用霍尔效应测量来确定 2DHG 或 2DEG 密度和迁移率值 [22]。测量在室温下通过范德堡法进行。根据参考测量 2DHG。 [17],霍尔测量样品是用 Ni/Au 欧姆接触制造的。 2DHG的密度和迁移率为9×10 12 cm −2 和 15 cm 2 /V s,分别。 2DEG 是通过具有凹陷 GaN 顶部和部分 AlGaN 的样品测量的,这些样品由 Ti/Al/Ni/Au 欧姆接触(对于 2DEG)制造。 2DEG 的密度和迁移率为 8.5 × 10 12 cm −2 和 970 cm 2 /V s,分别。霍尔测量表明空穴迁移率仍然远低于体迁移率超过 100 cm 2 /V s。迁移率的下降归因于MOCVD生长过程中Mg从p-GaN扩散到未掺杂的GaN。
结果与讨论
测量的 I-V 具有各种 L 的 SBD 的前向特性 AC 绘制在图 4a 和 b 中。导通电压 (V ON) 为 0.68 V,有 0.02 V 的小变化。SBD 的理想因子和势垒高度分别计算为 1.44±0.15 和 0.76±0.04 eV。图 4a 显示了 183 mA/mm 和 144 mA/mm 的高正向电流密度(@2.5 V 的正向偏置)和 0.642 和 1.17 mΩ cm 2 的导通电阻 达到 L AC 分别为 7 和 11 μm。此外,出色的开/关电流比 ∼ 10 10 获得如图 4b 所示。亚阈值斜率(SS)为63.0 mV/dec,接近理想的SS(59.6 mV/dec)。
<图片>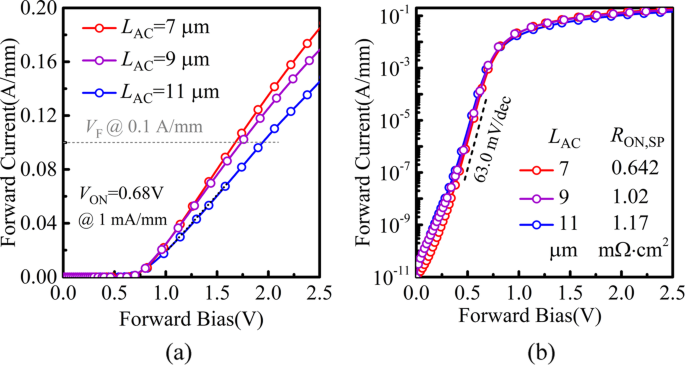
测量的正向偏置 I-V a 中 DJ SBD 的特征 线性和b 具有不同 L 的半对数标度 交流
图 5a 显示了测得的反向阻塞 I-V 具有各种 L 的 SBD 的特性 AC at 300 K. 不同L器件的击穿电压 AC分别为803 V、940 V和1109 V,漏电流为1 mA/mm。在模拟过程中,假设 2DEG 和 2DHG 的密度相同。然而,实验结果表明 2DHG (9 × 10 12 cm −2 ) 略高于 2DEG (8.5 × 10 12 cm −2 )。断态期间固定的正负极化电荷之间的差异会影响电荷平衡,从而降低击穿电压。 L 的影响 BV 和 R 上的 AC ON,SP 如图 5b 所示。 BV 和 L 之间的近似线性关系 获得了交流电,这意味着漂移区中的横向电场相对平坦。由于极化结效应,该器件表现出很高的 Baliga 品质因数 (FOM =BV 2 /R ON,SP) 为 1051 MW/cm 2 (@L AC =11 μm).
<图片>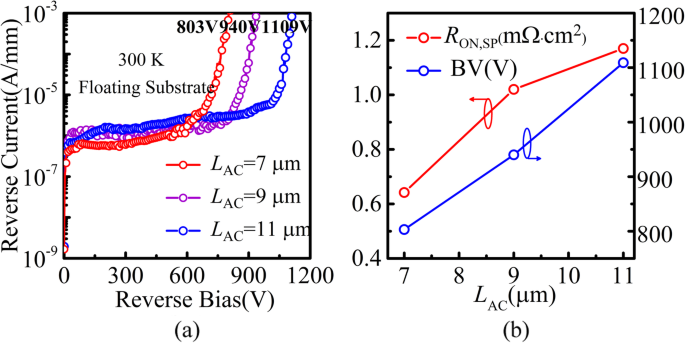
一 测量反向阻塞 I-V 不同L的DJ SBD的特点 交流 (b ) R ON、SP 和 BV 作为 L 的函数 交流
蚀刻工艺对于高质量肖特基界面和欧姆接触至关重要。图 6a 显示了 ICP 蚀刻(@ 5 °C)和 TMAH 溶液后凹槽的表面形貌。蚀刻速率约为 4.9 nm/min,最终选择的配方为 Cl2 为 4sccm,ICP 功率为 50 W,RF 功率为 15 W。均方根 (RMS) 粗糙度为 0.244 nm,扫描面积2×2 μm 2 .
<图片>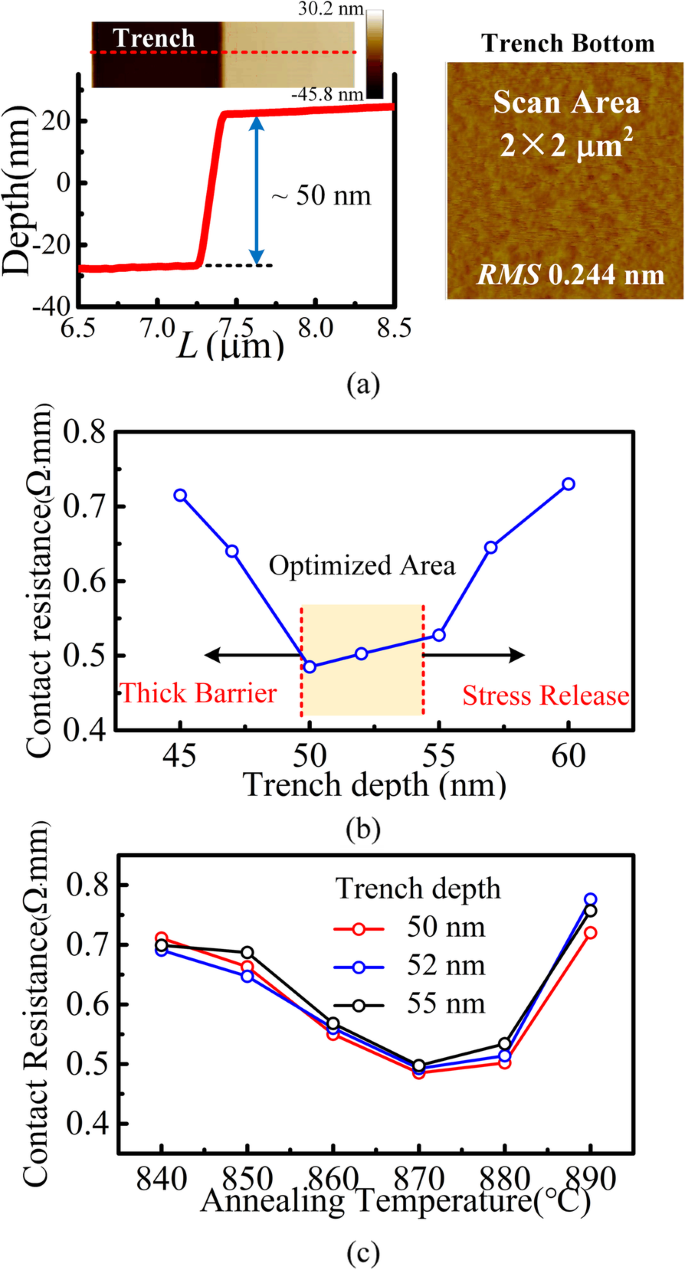
一 ICP蚀刻后沟槽的AFM形貌。 b 通过 TLM 测试,蚀刻深度对欧姆接触电阻的影响。 c 接触电阻与退火温度的函数关系,沟槽深度为 50 至 55 nm。退火时间为35 s
由于定制的外延层包括 45 nm GaN 顶层和 45 nm AlGaN 层,因此欧姆接触(用于 2DEG)工艺与传统 SBD 不同。由于欧姆金属和 2DEG 之间的势垒,在不使 GaN 顶部和 AlGaN 势垒层都凹陷的情况下,很难通过退火实现低接触电阻。然而,如果屏障过度凹陷,应力释放会导致 2DEG 浓度降低。采用额外的工艺来降低欧姆接触电阻。样品的表面在沉积前用 HCl 溶液处理以去除天然氧化层。此外,采用等离子体表面处理(ICP 功率 50 W BCl3 10 sccm 3 min)引入表面施主态 [24]。图 6b 展示了接触电阻对沟槽深度的依赖性。优化的深度是从 50 到 55 nm。图 6c 研究了 Ti/Al/Ni/Au 接触的高温快速热退火 (RTA)。退火温度为 840 至 890 °C,870 °C 导致接触电阻最低。在高温下退火,即 870 °C,有利于在 Ti/氮化物界面形成 TiN。然而,较高的温度(例如890 °C)会增加Au和Al的相互扩散,这不利于形成良好的欧姆接触。
图 7a-c 展示了包括 V 在内的静态特性的统计图 开,V F 和 BV。数据是从 72 个带有 L 的 SBD 中提取的 7、9 和 11 μm 的 AC 在 3 个独立的工艺运行中制造。器件显示稳定的正向导通特性和 V ON与L无关 AC,因为 V ON 主要由肖特基接触决定。低损伤的 ICP 蚀刻工艺、精确控制的沟槽深度和高质量的肖特基界面有助于 V 的出色均匀性 ON 和 V F.另外,随着L的增加 AC(从 7 到 11 μm),在提议的结构中观察到的 BV 单调增加(~100 V/μm)。图 7d 显示了 V 的直方图统计 72个器件ON,平均值为0.68 V,小标准导数为0.02 V。
<图片>
a 的统计图 导通电压、b 正向电压和 c 从具有 L 的 72 个 SBD 中提取的击穿电压 7、9 和 11 μm 的 AC 在 3 个独立的工艺运行中制造。 d V 的分布 72台设备开启
图 8 评估了反向和正向特性的温度依赖性。如图 8a 所示,环境温度从 300 增加到 475 K 导致 R 的增加 ON,SP 乘以 1.94。
<图片>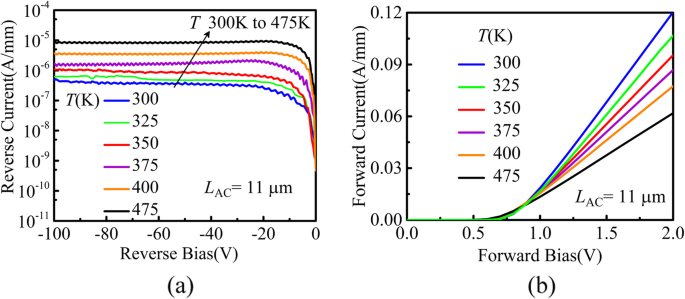
一 反向漏电流和b DJ SBD在不同温度下的前向特性
DJ SBD 的动态特性由Agilent B1505A 功率器件分析仪测量。阳极脉冲静态偏置点设置为- 10 V、- 20 V、- 30 V、- 40 V、- 70 V和- 100 V,阳极脉冲宽度和周期为0.50 毫秒/毫秒图 9b 显示了动态 R ON,SP 作为应力电压的函数。动态 R ON,SP 即使在 100 V 储备应力电压下也只是没有反向应力时的 1.18 倍,与 Ref. [8]。动态 R 的有限增加 ON,SP 有助于降低界面态。动态R的退化 ON,SP需要进一步工作。
<图片>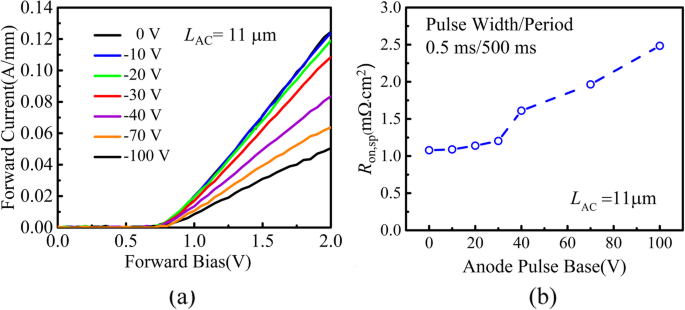
一 I-V 脉冲测量下的特性。 b 提取的 R ON,SP vs 阳极脉冲基数,脉冲宽度/周期 =0.5 ms/500 ms
图 10 显示了 BV 与 R 的基准图 硅/碳化硅/蓝宝石衬底上 GaN 功率二极管的 ON,SP [8, 10, 22, 25,26,27,28,29,30,31]。建议的带有 L 的设备 AC 为 11 μm 表明 BV 为 1109 V 并具有相应的 R ON,SP 为 1.17 mΩ cm 2 ,导致 1051 MW/cm 2 的高 Baliga FOM .该值是Si衬底上横向GaN功率二极管中最好的结果。
<图片>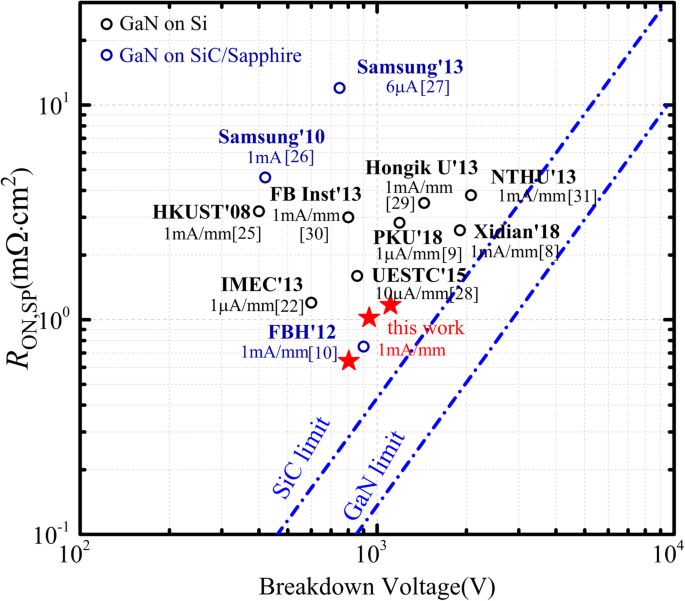
BV 与 R 的基准图 SiC/蓝宝石/Si 衬底上 GaN 功率二极管的 ON,SP。还给出了用于定义击穿的反向泄漏
结论
制造了具有高品质因数的双异质结 GaN/AlGaN/GaN-on-Si SBD。低损伤 ICP 蚀刻工艺为所提议的器件带来了优化的欧姆和肖特基接触。因此,低 V ON 为 0.68 V,具有良好的均匀性和低 R ON,SP 为 1.17 mΩ cm 2 在带有 L 的设备中获得 AC 11 μm。高 Baliga 的 FOM 为 1051 MW/cm 2 是由于极化结效应实现的。高性能加上低成本的GaN-on-Si技术为未来的电源应用展示了巨大的潜力。
数据和材料的可用性
本研究中生成或分析的所有数据均包含在本文中。
缩写
- SBD:
-
肖特基势垒二极管
- 2DEG/2DHG:
-
二维电子/空穴气
- MOCVD:
-
金属有机化学气相沉积
- ICP:
-
电感耦合等离子体
- TEM:
-
透射电子显微镜
- 原子力显微镜:
-
原子力显微镜
- BV:
-
击穿电压
- R 开,SP:
-
比导通电阻
- V 开 :
-
开启电压
- FOM:
-
品质因数
纳米材料
- 表面状态和铝摩尔分数对 AlGaN/GaN HEMT 中表面电位和 2DEG 的影响
- 不同旋转角度外壳中TiO2-水纳米流体稳定性和自然对流的实验研究
- 通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
- RGO 和三维石墨烯网络共同修饰的高性能 TIM
- TiO2-水纳米流体在螺旋槽管中的流动和传热特性的实验研究
- 具有超弹性和高电容的石墨烯/聚苯胺气凝胶作为高抗压超级电容器电极
- 5-氟尿嘧啶封装 Ethosomes 联合 CO2 点阵激光治疗增生性瘢痕的实验研究
- 用于电力电子应用的基于超宽带隙 Ga2O3 半导体的肖特基势垒二极管概述
- Mo/Au 肖特基接触在机械剥离 β-Ga2O3 薄膜上的实验和理论研究
- Ge 掺杂垂直 GaN 肖特基势垒二极管的恢复性能
- 具有混合沟槽阴极的高精度 AlGaN/GaN 反向阻断 CRD (RB-CRD)
- 高低螺旋角的优缺点


