源自非易失性存储器非晶膜中氧空位偶极子的类铁电行为
摘要
传统的铁电器件缺乏可扩展性。掺杂的 HfO2 薄膜有望解决结垢问题,但面临高漏电流和多晶性质引起的均匀性问题的挑战。稳定的类似铁电的行为首先在 3.6 nm 厚的非晶 Al2O3 薄膜中得到证明。非晶 Al2O3 器件具有高度可扩展性,可实现具有纳米级鳍片间距的多栅极非易失性场效应晶体管 (NVFET)。它还具有低工艺温度、高频率 (~GHz)、宽存储窗口和长寿命等优点,表明在 VLSI 系统中具有巨大潜力。可切换极化 (P ) 由电压调制的氧空位偶极子引起。
背景
基于传统钙钛矿铁电体(例如 PZT)的铁电随机存取存储器 (FeRAM) 一直是商业非易失性存储器 (NVM) 之一 [1],尽管它无法缩放且不兼容 CMOS。在各种不同的材料中广泛观察到铁电性,例如猪主动脉壁 [2]、Sb2S3 纳米线 [3]、GaFeO3 薄膜 [4]、掺杂聚 HfO2 薄膜 [5]、纳米晶羟基磷灰石薄膜 [6] 和 LaAlO3 -SrTiO3 薄膜 [7]。在这些材料中,掺杂 HfO2 薄膜因其 CMOS 工艺兼容性而引起了 NVM 应用的特殊兴趣。但多晶结构不可避免地会在掺杂的 HfO2 中产生铁电性,这给器件应用带来了以下障碍需要克服:1) 就形成正交晶系所需的 500°C 热预算而言,它与后栅极工艺不兼容。晶相[8]; 2)功耗是由沿晶界的不希望的漏电流引起的,随着铁电体厚度的缩小而呈指数增加。最近,一项理论研究提出,厚聚 HfO2(> 5 nm)中的额外铁电性可能来自氧空位产生的电偶极子组装中的长程相关性 [9]。观察到缺陷电荷俘获/去俘获机制在 5 nm 厚的非晶 Al2O3 中产生类似铁电的行为,用于多态存储器,然而,其俘获/去俘获频率非常低(例如,~500赫兹)[10]。
在这项工作中,在 3.6 nm 厚的非晶 Al2O3 薄膜中证明了稳定的类铁电行为,其中可切换的极化 (P ) 被提议由电压调制的氧空位偶极子感应。非晶 Al2O3 薄膜具有工艺温度低和工作频率高达 ~GHz 的优点,这使得具有纳米级鳍片间距的多栅非易失性场效应晶体管 (NVFET) 成为可能。具有 100 ns 脉冲宽度编程/擦除 (P/E) 电压和超过 10 6 的 Al2O3 NVFET 存储器 证明了 P/E 循环耐久性。电极和薄膜厚度对P的影响 在 Al2O3 电容器中也进行了研究。非晶非易失性器件在超大规模集成电路存储器中显示出广阔的前景。
方法
通过原子层沉积 (ALD) 在 Si(001)、Ge(001) 和 TaN/Si 衬底上生长非晶 Al2O3 薄膜。 TMA 和 H2O 蒸气分别用作 Al 和 O 的前体。在沉积过程中,基板温度保持在 300 °C。不同的顶部金属电极,包括 TaN/Ti、TaN 和 W,通过反应溅射沉积在 Al2O3 表面上。通过光刻图案化和干法蚀刻制造具有不同电极的电容器。在 350 °C 下进行了 30 秒的快速热退火 (RTA)。在 Ge(001) 上制造具有 TaN/Al2O3 栅极堆叠的 NVFET。栅极形成后,通过BF2 + 注入源/漏(S/D)区 剂量为 1 × 10 15 厘米 -2 然后通过剥离工艺形成 20 keV 能量和 20 nm 厚的镍 S/D 金属电极。图 1a 和 b 显示了制造的 Al2O3 电容器和 p 沟道 NVFET 的示意图。在电极和 Al2O3 薄膜之间有一个界面层 (IL)。图1c和d显示了不同非晶Al2O3厚度(t)的TaN/Al2O3/Ge叠层的高分辨率透射电子显微镜(HRTEM)图像 Al2O) 在 350 °C 下进行 RTA。
<图片>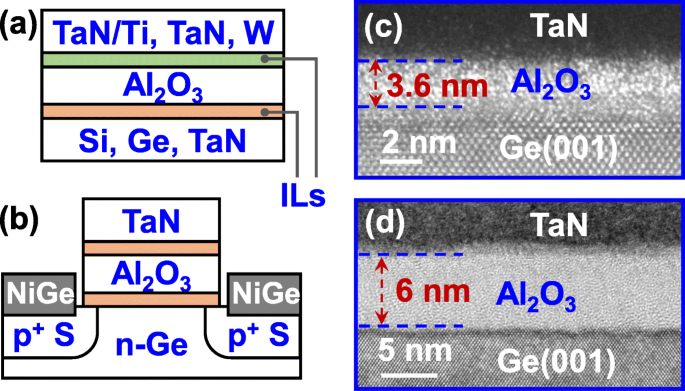
制造的a的示意图 具有各种电极和 b 的 Al2O3 电容器 Al2O3 NVFET。 c 和 d 不同 t 制备的 TaN/Al2O3/Ge 叠层的 HRTEM 图像 Al2O,显示在 350 °C 下 RTA 后的非晶 Al2O3 薄膜
结果与讨论
图 2 显示了测得的 P 对比. 电压 V 不同t的非晶Al2O3电容器的特性 Al2O 和各种顶部和底部电极。测量频率为 1 kHz。如图 2a-c 所示,t 固定为 3.6 nm AlO、TaN/Al2O3/Ge 电容器达到更高的饱和度 P (P sat) 与具有 TaN/Ti 和 W 顶部电极的器件相比。类铁电行为与界面密切相关,推测 TaAlOx 的形成 TaN 和 Al2O3 之间的 IL 产生更多的氧空位,有助于更强的转换 P , 与 TiAlOx 相比 和 WAlOx IL。 P-V 图 2d 中的曲线表明 TaN/Al2O3/TaN 电容器具有更高的 P 与 TaN/Al2O3/Ge 相比,这归因于双 TaAlOx ILs 提供更高的氧空位浓度。而 P 与 Ge 电极相比,sat 明显低于 Si 底部电极(图 2e)。该结果表明,与基于 Ge 衬底的器件相比,Al2O3/Si 界面质量更好,即更少的氧空位。图 2f 显示了 P-V TaN/Al2O3(6 nm)/Ge 电容器的曲线,表现出更高的 V c 和一个几乎相同的 P 与图 2b 中具有 3.6 nm Al2O3 薄膜的器件相比,饱和。需要注意的是,未关闭 P 的原因 -V 循环是因为确实存在泄漏。据报道,零电场处的大偏移总是随着大场而发生,随着V的扫描范围变小,它总是逐渐消失。 [11, 12]。
<图片>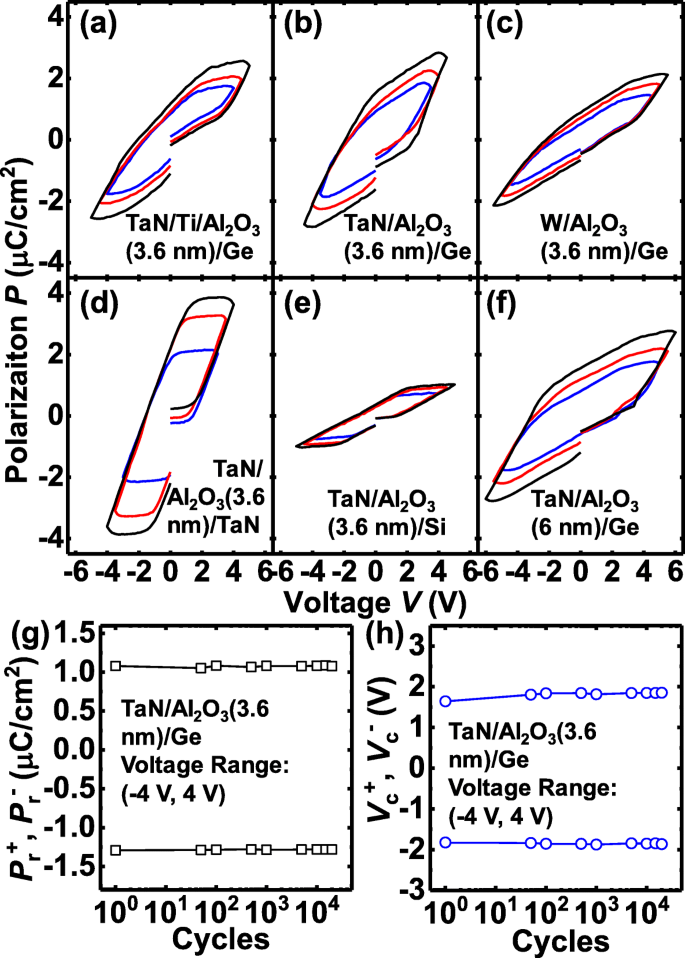
测量的 P 对比 V 不同电极的 Al2O3 电容器的特性。 一 , b , 和 c 显示 P -V TaN/Ti/Al2O3/Ge、TaN/Al2O3/Ge 和 W/Al2O3/Ge 的曲线分别为 3.6 nm t 氧化铝。 d 和 e 表明 P 通过使用 TaN(Si) 作为底部电极而不是 Ge 来增强(减少)sat。 f TaN/Al2O3(6 nm)/Ge 电容器具有更高的 V c 和类似的 P sat 与 b 中 3.6 纳米厚的设备相比 . g 和 h 耐久性测量显示 P 没有降解 r 和 V c 在 10 4 后观察 TaN/Al2O3(3.6 nm)/Ge电容器的扫描周期
图 2g 和 h 显示了正负残差 P 的提取演化 (P r) 和强制 V (V c) 值分别超过 10 4 TaN/Al2O3/Ge 电容器的扫描周期。没有观察到唤醒、印记或疲劳效应。 V 器件的 c 为 ~1.8 V,表明 E 在 Al2O3 薄膜中为 4~6 MV/cm,在 ILs 中可以超过 8 MV/cm,这足以驱动氧空位 [13, 14]。 P 器件的饱和度范围从 1 到 5 μC/cm 2 , 对应于 3~15×10 12 范围内的合理氧空位浓度 厘米 -2 假设他们有加二的费用。
讨论了与 Al2O3 器件中氧空位相关的类铁电行为的潜在机制。电压驱动的氧空位的迁移已在电阻随机存取存储器件中得到广泛证明 [15, 16]。图 3 显示了可切换 P 的原理图 在 TaN/Al2O3/Ge 中,它源于电压调制的氧空位和负电荷的分离以形成电偶极子。可以合理地推断出可移动的氧空位主要来自于 TaAlOx 的形成 IL 和位于初始状态的顶部界面附近(图 3a)。图 3b 和 c 表示正负 P 分别通过在施加电压下调制氧空位和负电荷偶极子而形成。测量了 Al2O3/Ge 和(Ti、TaN 和 W)/Al2O3/Ge 样品的 X 射线光电子能谱 (XPS),如图 4 所示。对于所有的金属/Al2O3/Ge 样品,在金属和 Al2O3 之间形成了金属氧化物 IL,被认为是氧离子和空位的储存库,这与参考文献一致。 [17].
<图片>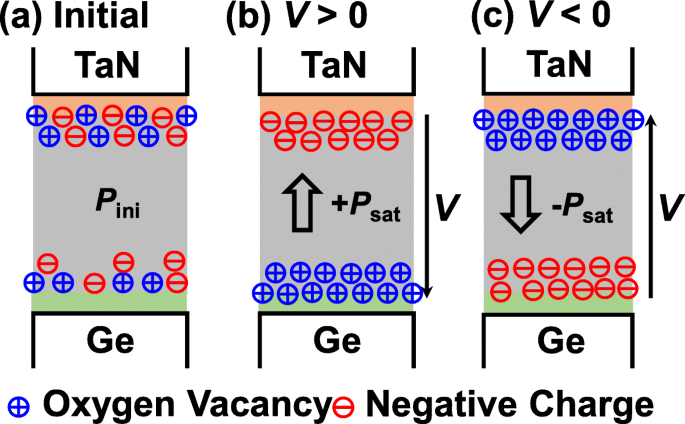
Al2O3 电容器中类似铁电行为的机制示意图。可切换 P 是由于氧空位和负电荷的迁移形成偶极子
<图片>
a 的核心级 XPS 光谱 Al2O3/Ge, b TaN/Al2O3/Ge, c Ti/Al2O3/Ge 和 d W/Al2O3/Ge样品
为了将 Al2O3 NVFET 的电气性能表征为 NVM,编程(擦除)操作是通过向栅极施加正(负)电压脉冲来提高(降低)其阈值电压 (V TH)。图 5a 显示了 Al2O3 NVFET 的线性区域转移特性如何相对于初始 I DS-V GS 曲线使用 ±4 V 编程(擦除)电压和 100 ns 脉冲宽度测量。在这里,V TH 定义为 V GS 为 100 nA⋅W/L,而 MW 定义为 V 的最大变化 泰。 Al2O3 NVFET 获得 0.44 V 的 MW,尽管非晶 Al2O3 膜具有较小的 P r 比报道的掺杂 HfO2 薄膜 [5, 8]。值得注意的是,Al2O3 NVFET 存储器的工作频率高达 10 MHz,这表明可切换 P Al2O3 中的 源自电压驱动的氧空位迁移以形成偶极子,而不是来自缺陷电荷俘获/释放。交替的编程和擦除脉冲应用于 Al2O3 器件以进一步研究器件的耐用性。图 5b 显示了 V 的图 TH vs. P/E 循环数,表明可以保持稳定的 MW 超过 10 6 3.6 nm 厚的 Al2O3 NVFET 的 P/E 循环。
<图片>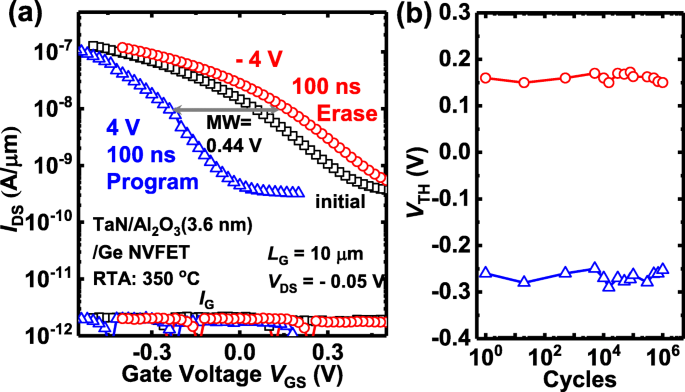
一 测量 I DS-V 3.6 nm 厚的 Al2O3 NVFET 的初始和两个偏振态的 GS 曲线。获得 0.44 V 的 MW。 b 耐久性测量表明,在 10 6 后未观察到 MW 衰减 市盈率周期
值得注意的是,在非晶Al2O3器件中观察到的类铁电行为可以扩展到通用的非晶氧化物,例如氧化铪(HfO2)和氧化锆(ZrO2)。
结论
稳定的类似铁电的行为首先在具有薄非晶 Al2O3 绝缘体的电容器中实现。可切换 P P-V 证明了在非晶 Al2O3 电容器中 循环和 NVFET 测试。提出类似铁电的行为源自界面氧空位和离子偶极子。 3.6 纳米厚的 Al2O3 NVFET 实现了 0.44 V 的 MW 和超过 10 6 100 ns P/E 条件下 ±4 V 下的循环耐久性。总而言之,这项工作为非晶氧化物铁电器件开辟了一个新世界,这些器件有望用于 VLSI 系统中具有潜在纳米级鳍间距的多栅极(鳍状、纳米线或纳米片)NVFET。
数据和材料的可用性
本文包含支持本文结论的数据集。
缩写
- Al2O3:
-
氧化铝
- ALD:
-
原子层沉积
- BF2 + :
-
硼氟离子
- E :
-
矫顽电场
- 哥:
-
锗
- GeOx :
-
氧化锗
- HRTEM:
-
高分辨透射电子显微镜
- I DS :
-
漏电流
- MOSFET:
-
金属氧化物半导体场效应晶体管
- MW:
-
内存窗口
- Ni:
-
镍
- NVFET:
-
非易失性场效应晶体管
- P r :
-
剩余极化
- P 坐:
-
饱和极化
- RTA:
-
回热退火
- TaAlOx :
-
钽氧化铝
- t 阿罗:
-
氧化铝厚度
- TaN:
-
氮化钽
- V 高:
-
栅极电压
- V :
-
阈值电压
- XPS:
-
X射线光电子能谱
纳米材料


