基于 Epsilon 近零氧化铟锡的对极化不敏感的表面等离子体极化电吸收调制器
摘要
在电信波长下工作的 CMOS 兼容等离子体调制器对于各种片上应用具有重要意义。依靠对金属-电介质界面上激发的横向磁 (TM) 模式的操纵,之前的大多数演示设计为仅响应特定的极化状态。在这种情况下,当偏振敏感调制器集成到具有随机偏振状态的光纤时,将导致高偏振相关损耗。在此,我们提出了一种等离子体调制器,它利用包裹在硅波导周围的金属氧化物铟锡氧化物 (ITO),并通过用场诱导调节 ITO 的电吸收来研究其对垂直和水平偏振导向光的光学调制能力。载流子注入。具有在 ITO/氧化物界面处积累的电子的电偏置调制器允许根据引导光的偏振状态在界面的顶部或横向部分激发 epsilon-near-zero (ENZ) 模式。由于 ENZ 模式的高度局部化特性,可以在器件的“关闭”状态下实现有效的电吸收,从而导致我们提出的调制器中两种极化的消光比 (ER) 大。此外,偏振不敏感调制是通过在两个不同的堆叠方向上适当调整氧化物的厚度来实现的,因此匹配在垂直和水平偏振模式下工作的器件的 ER 值。对于优化的几何配置,两种偏振模式的 ER 值之间的差异,即 ΔER,小至 0.01 dB/μm,并且在耦合效率高于 74% 的同时,在波长为1.55 微米。所提出的等离子体组合调制器在引导和处理来自随机偏振态光纤的光方面具有潜在的应用价值。
背景
在过去的几十年中,随着光通信、传感和成像领域应用的发展,光子集成电路 (PIC) 取得了显着进展 [1, 2]。目前,人们对缩小规模和降低光子器件的功耗以生产先进的 PIC 给予了相当大的关注。硅光子学被认为是未来高速片上/片外光互连的有前途的解决方案。典型的硅波导调制器利用电改变材料的折射或吸收特性来调制光通过设备的传输。由于 Si 的弱等离子体色散效应和 Si 波导的衍射极限,Si MZI 调制器的占位面积大,约为 10 3 –10 4 μm 2 .具有高 Q 谐振的环形调制器通常具有更紧凑的封装~ 10 2 –10 3 μm 2 但光带宽较低,并且往往对温度变化更敏感。等离子体学提供了一种将光学器件小型化到衍射极限之外的方法 [3]。或者,最近展示了使用 Si 作为活性材料的完全 CMOS 兼容的槽调制器或等离子体调制器 [4, 5],并且可以实现调制器中光场的高度定位。然而,由于Si层(波导/结构)中的自由载流子色散效应较小,Si基等离子体调制器的性能仍然受到限制。
最近,透明导体氧化物 (TCO),例如氧化铟锡 (ITO)、氧化铝锌和氧化镓锌,由于它们的电可调介电常数,正成为用于集成电吸收 (EA) 调制器的有吸引力的活性材料 [6] ,7,8,9,10]。类似于 Si 基场效应 MOS 器件,在施加的偏压下形成载流子积累,载流子密度 (N ITO) 可以在 ITO/电介质界面处通过施加偏压进行调谐。在 1310 nm 的自由空间波长下实验报道了 ITO 累积层折射率的明显变化,实部 Δn =0.092 和虚部 Δk =0.27 [10]。当 ITO 的介电常数的实部在某个 N 处,材料被调谐到接近零 ITO 被称为“epsilon-near-zero”(ENZ)状态,由于导模的强限制,它具有最大的吸收损耗 [11]。为了形成 MOS 电容器结构并增强光场和活性材料层之间的重叠,之前采用了缝隙波导 [9, 12] 和混合等离子体波导 [10],目的是强烈限制 ITO 中的导模和介电层。包括混合等离子体调制器在内的传统等离子体调制器仅支持横向磁 (TM) 模式,因为表面电荷的产生需要垂直于金属-电介质界面的电场,并且具有强光场限制的狭缝波导仅支持横向电( TE) 模式在具有低折射率的狭缝区域。对于光纤通信应用,来自光纤的光通常具有随机偏振态,因此,当它耦合到偏振敏感光调制器时,信噪比会降低。在等离子体和槽 ITO 波导的情况下,偏振相关损耗可能非常高。因此,需要将极化分集系统(例如极化旋转器 [13,14,15])集成到电路中。但是,它通常在马戏团中具有较大的耦合损耗。因此,需要考虑一些具有低极化依赖性的基于 ITO 的等离子体调制器。具有沉积在带状波导上的 TiN/HfO2/ITO/Cu 堆栈的紧凑型 EA 调制器支持 TE 和 TM 模式 [11],但 TE 和 TM 的消光比之间的差异达到 0.9 dB/um,导致 4调制效率的百分比。因此,需要一种支持两种偏振模式且ΔER最小的等离子体调制器来实现对偏振不敏感的亚波长光导和处理。
在本文中,通过数值模拟研究了包覆有 Au/SiO2/ITO 多层膜的硅波导中的模式特性和光调制。对于两种极化,在硅核的顶部或侧壁的 Au/SiO2/ITO/Si 堆栈中都支持高度集中的等离子体模式。 ITO层中的载流子色散效应用于调制,由堆叠形成的MOS电容器结构进行调谐。通过调整这种亚波长波导中的载流子累积和模式场分布,可以实现 1.43 dB/μm 以上的调制消光比,ΔER(两种偏振模式的消光比之间的差异)低于 0.01 dB/μm。该结果有望降低光子集成电路中的偏振相关损耗。
方法
在本文中,ITO 被用作所提出的调制器中的活性材料。自由载流子积累效应已被认为是实现高速等离子体切换的一种有前途的方法。在之前的工作中,已经证实,通过在 MOS 电容器结构中的 ITO/电介质界面处的电荷载流子积累,可以显着改变 ITO 的折射率 [6, 16]。 ITO的介电常数可以用Drude模式处理为
$$ \varepsilon ={\varepsilon}_{\infty }-\frac{N_{ITO}{e}^2}{\varepsilon_0{m}^{\ast }}\bullet \frac{1}{\omega ^2+ i\omega \Gamma} $$ (1)其中 ε ∞ 是高频介电常数,Г 是电子阻尼因子,ω 是光的角频率,N ITO为ITO材料的电子浓度,m * 是有效质量,e 是电子电荷,ε 0 是自由空间的介电常数。已经表明,累积电子的浓度在 ITO/电介质界面处达到最大值,并随着与界面距离的增加而迅速降低 [11]。图 1 绘制了计算出的实部 (ε 1) 和虚部 (ε 2) ITO 的介电常数与特定 N 处波长的函数关系 伊藤。人们看到,根据 N ITO =6.0 × 10 20 cm − 3 , ε 1 在 1.55 μm 处接近零。从物理上讲,这代表了对入射光表现出介电响应和金属响应的材料之间的过渡;该介电常数点称为 ENZ 点。 ENZ 材料在光场和吸收层中导致非常大的增强重叠。同时,载流子浓度的增加也引起ε的相应增加 2,这增加了载流子积累层的吸收损耗。稍后,我们将比较各种ITO EA调制器的光调制性能。
<图片>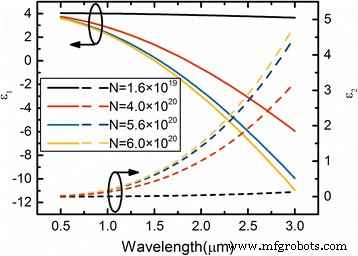
计算出的实部 (ε 1) 和虚部 (ε 2) 具有不同平均电子浓度N的ITO介电常数与波长的函数关系 伊藤。波长的 ENZ 点定义为其中 ε 1 过零
为了设计一种支持和调制 TE 和 TM 导模的等离子体调制器,至少需要两个金属介电界面,一个在 x y 中的方向和另一个 方向。在这种情况下,提出了一种由垂直和水平方向的混合等离子体波导组成的等离子体波导。如图 2 所示,所提出的调制器由宽度为 W 的 Si 核心组成 Si 和 H 的高度 Si,厚度为D的透明导电ITO层 ITO,侧壁宽度为W的SiO2中间层 p 和 H 的高度 p,以及 100 nm 厚(比光穿透深度厚得多)的 Au 包覆层。由于可以通过电子束光刻和深反应离子蚀刻 (DRIE) 制造 Si 波导,因此可以使用成熟的脉冲激光沉积 (PLD) 将薄 ITO 和 SiO2 共形沉积在波导上方法和PECVD方法;建议的调制器与 CMOS 后端兼容。 HSPP波沿SiO2和ITO层之间的低折射率层激发,可以有效降低插入损耗。由于这两种等离子体波导的模式特性完全不同,光调制本质上是不同的,但可以通过优化模式场分布和有源层的位置将它们设计为偏振无关。
<图片>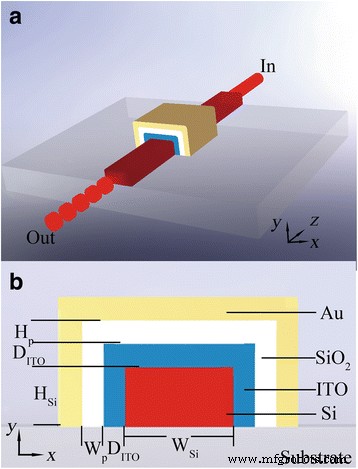
一 3D 视图和 b 所提出的与条纹介质波导集成的 EA 等离子体调制器的横截面
使用有限差分时域 (FDTD) 方法对传播特性进行数值建模。使用最小空间尺寸为 0.2 纳米的非均匀网格。完美匹配层 (PML) 边界用于在所有边界处衰减场而没有背反射。该设备设计用于在 1.55 μm 的波长下工作。硅和二氧化硅的折射率分别为 3.48 和 1.44,假设 Au 包层的介电常数在 1.55 μm 处为 - 116.62 + 11.46i [17]。在该器件中,金属/绝缘体/硅 (MIS) 波导具有优异的传播特性,例如波导中的低损耗和超出衍射极限的强光限制。我们之前在全包层硅等离子体波导方面的工作表明,这种类型的波导可以支持两种极化的模式传播,并且传播常数差异很小[18]。
结果与讨论
为了理解由 NITO 变化引起的混合等离子体波导的这种变化,它被定义为 ITO 层中的平均电子浓度,电场分布 E x 和 E EA 调制器的 y 如图 3 所示。如图 3a、b、N ITO =1.6 × 10 19 厘米 −3 , E TE 模式的 x 被限制在 SiO2 层和 E 的两个侧壁 TM 模式的 y 被限制在 SiO2 层的顶部,这提供了明显低于光的衍射极限的强光学限制和相对低的光传播损耗 [18, 19] 的组合,定义为“ON”状态。如图 3c、d 所示,在 MOS 电容器结构两端施加电压,在 SiO2/ITO 界面处感应出载流子积累层,N ITO =5.6 × 10 20 厘米 −3 .由于载流子密度的增加,两个载流子积累层的介电常数实部均减小,低于SiO2层,光场将被推入载流子积累层。同时,由于两个载流子积累层中介电常数虚部的增加作为 N ITO增加,光传播损耗随着载流子积累层吸收损耗的增加而增加,在ENZ点达到最大值,即“OFF”状态。
<图片>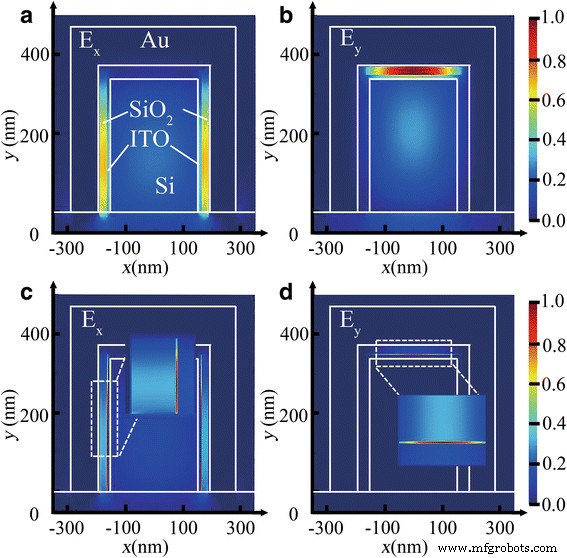
电场分布E x 和 E a 的调制器的 y –b “ON”状态,N ITO =1.6 × 10 19 厘米 −3 , 和 c –d “关闭”状态,N ITO =5.6× 10 20 厘米 −3 , 分别。 一 和 c 用于 TE 模式。 b 和 d 用于 TM 模式。插图显示了“OFF”状态下 ITO 层中电场密度的放大。 W Si =310 nm,H Si =340 nm,H p =20 纳米,W p =25纳米
对于光调制器,ER 和 IL(插入损耗)是两个最重要的性能参数。我们定义
$$ \mathrm{ER}=\frac{P_{\mathrm{out}}\left({V}_b={V}_{\mathrm{OFF}}\right)}{P_{\mathrm{out} }\left({V}_b={V}_{\mathrm{ON}}\right)} $$ (2) $$ \mathrm{IL}=\frac{P_{\mathrm{in}}-{ P}_{\mathrm{out}}\left({V}_b={V}_{\mathrm{ON}}\right)}{P_{\mathrm{in}}} $$ (3)其中 P 输出 (P in) 是器件输出(输入)处的光功率,V b 是“ON”状态下的外加电压 (V ON)和“OFF”状态(V 离开)。此外,光传播损耗(α ) 定义为 α =4πκ/λ , λ 是工作波长,κ 是混合等离子体模式的复有效指数的虚部。根据计算,α 主要取决于载流子积累层中的光吸收。混合等离子体波导中的光场主要局限在低介电常数层(SiO2 和 ITO 层);因此,传播损耗会随着 SiO2 层的变化而变化。为了研究 SiO2 层尺寸对调制性能的影响,已经讨论了作为 SiO2 层函数的 ER 和 ΔER,如图 4 所示。根据图 4,TE 模式的 ER 随着 <我>W p 由于导模和载流子积累层之间的重叠减少,导致载流子积累层中的吸收很小。当W时ΔER达到最小值 p 比 H 稍厚 p,由于具有矩形横截面的Si芯和两个侧壁的光吸收。
<图片>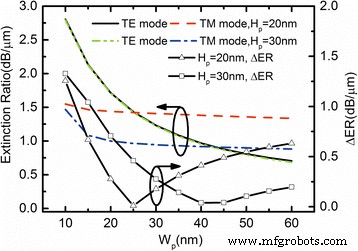
EA 调制器的 ER 和 ΔER 与 W H 处的 p p =20 和 30 nm
图 5 绘制了具有不同 N 的 EA 调制器的 ER 和 ΔER 作为波长的函数 伊藤。可以看出,EA调制器的ERs和ΔER随着波长的增加而增加,在某一波长处达到最大值,然后随着波长的进一步增加ER减小,ΔER随着波长的进一步增加而在某一波长处减小并达到最小值。 N 最大 ER 的 ITO 靠近 ENZ 点和 N 最大 ER 的 ITO 位于 ENZ 点,例如 N ITO =6.0× 10 20 cm − 3 ,两种模式的最大 ER 在 1.50 μm 波长处分别为 1.65 和 1.56 dB/μm,最小 ΔER 在 1.55 μm 波长处为 0.009 dB/μm,这是我们的工作波长。对于 EA 应用,当 α 最大时的条件 达到可以定义为“OFF”状态,当α 小得多可以定义为“ON”状态。此外,对于EA偏振不敏感调制器,应注意达到最小ΔER时的条件。
<图片>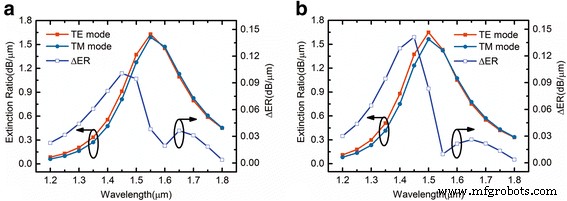
对于具有 a 的 EA 调制器,ER 和 ΔER 作为波长的函数 N ITO =5.6 × 10 20 厘米 −3 和 b N ITO =6.0 × 10 20 厘米 −3
人们看到 N 载流子积累层中的ITO随着施加电压的不同而变化,导致吸收和电场分布的变化。为了了解载流子累积层对 EA 调制性能的影响,在工作波长下计算了所提出的调制器的 ER 和 ΔER。如图 6 所示。EA 调节剂的 ER 和 ΔER 随 N 增加 ITO增加,在某个N达到最大值 ITO,然后以 N 递减 ITO进一步增加。 TE 和 TM 模式的最大 ER 分别为 1.62 和 1.59 dB/μm。 ΔER首先随着N的增加而增加 ITO,然后在达到最大值后减小。可以看到,在 ENZ 点,两种模式的 ERs 接近最大值,ΔER 小于 0.01 dB/μm。
<图片>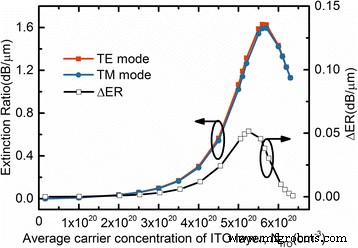
ERs 和 ΔER 作为 N 的函数 EA 调制器的 ITO。 H Si =340 nm,W Si =310 nm,H p =20 纳米,W p =25 纳米,D ITO =10 纳米,H Au =100 nm
为了演示器件性能,对 14 μm 长的 EA 调制器进行了 3D-FDTD 模拟。具有 TE 和 TM 偏振的 1.55-μm 光被发射到 Si 输入波导,然后通过调制器传播,最后耦合到输出 Si 波导。图 7a、b 显示了沿 y 的横向电场分布 -在“ON”状态和“OFF”状态下在 Si 波导的中心切割。图 7c、d 显示了沿 x 的横向磁场分布 -在“ON”状态和“OFF”状态下在 Si 波导的中心切割。对于“OFF”状态,由于出色的 ΔER 为 0.009 dB/μm,TE 和 TM 模式的输出光均以 14 μm 长的调制长度平衡。
<图片>
E的场分布 x 代表 TE 模式 a –b 和 E y c –d 对于沿 y 的 TM 模式 -cut 和 x - 在 Si 波导的中心切割。 一 和 c 处于“ON”状态。 b 和 d 处于“关闭”状态。 H Si =340 nm,W Si =310 nm,H p =20 纳米,W p =25 纳米,D ITO =10 纳米,H Au =100 nm
对于PIC中使用的HSPP调制器的设计,Si波导宽度W (高度H =H Si =340 nm) 已被优化。通过在支持 TE 和 TM 模式的范围内改变波导宽度,计算耦合有效 (CE)。从图 7 可以看出,由于这两个波导中的模式不匹配,在耦合界面处观察到一些反射光,从而导致耦合损耗。具有较大n的Si条纹波导之间的模式失配 eff 和等离子体组合波导变大,导致耦合效率降低。图 8 显示了等离子体组合波导 (H p =20 nm 和 W p =25 nm) 和 Si 波导作为 TE 和 TM 模式的宽度的函数。可以看出,当 W 增加,ΔCE(两种偏振模式耦合效率之间的差异)减小,在输入Si波导的一定宽度处达到最小值,然后随着输入Si波导宽度的上升潮而增加。因此,最小 ΔCE 为 5.63%(“ON”状态)和 6.38%(“OFF”状态);因此,耦合效率几乎对偏振不敏感,在“ON”状态下,TE模式为80.46%,TM模式为74.83%。
<图片>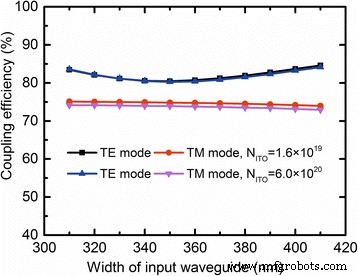
等离子组合波导和 Si 波导之间的 CE 作为 TE 和 TM 模式在“ON”状态和“OFF”状态下的宽度的函数。 H Si =340 nm,W Si =310 nm,H p =20 纳米,W p =25 纳米,D ITO =10 纳米,H Au =100 nm
结论
总之,我们提出了一种 EA 偏振不敏感等离子体波导调制器。波导结构由两个x中的混合波导组成 和 y 方向,其中存在双偏振模式。混合等离子体波导形成 MOS 电容器,当掺杂的 Si 电极以低于金属电极的电压偏置时,载流子积累发生在电介质-ITO 界面处。通过调整载流子密度来研究光调制。仿真证明在 1.55 μm 波长处的最小 ΔER 为 0.009 dB/μm。正如我们所知,这个 ΔER 是有记录以来最低的。此外,使用馈电硅波导获得了高于 74% 的两种极化的耦合效率。这些 ITO EA 等离子体波导调制器可能是超紧凑光子集成的重要组成部分。在未来的工作中,为了便于制造,应考虑优化具有较大公差的非对称涂层的几何形状。
纳米材料
- 基于局部表面等离子体共振的金纳米生物传感器能够诊断人类布鲁氏菌病,介绍一种快速且经济的方法
- 局部表面等离子体共振依赖于错位截断的银纳米棱镜二聚体
- 通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
- 超材料中表面等离子体激元和磁偶极子共振的耦合效应
- 基于介电纳米棱镜的等离子体传感器
- 用于薄膜晶体管的氧化铟纳米膜的原子层沉积
- 基于带 AgNWs 电极的纹理表面的 PEDOT:PSS/n-Si 太阳能电池的高性能
- 基于混合全介电-石墨烯超表面的可控双折射偏振转换器
- 增强对散装狄拉克半金属-绝缘体-金属波导中太赫兹表面等离子体激元的限制
- 在氧化铟锡涂层二氧化硅上直接生长单晶 GaN 纳米线
- 基于可见区域全介电超表面的高效偏振分束器
- 基于氧化锰的超级电容器


