使用富氢 Al2O3 电介质的具有极低热预算的高性能 a-InGaZnO 薄膜晶体管
摘要
通过在不同温度下使用 O2 等离子体增强原子层沉积 Al2O3 电介质,比较了非晶 In-Ga-Zn-O (a-IGZO) 薄膜晶体管 (TFT) 的电气特性。高性能 a-IGZO TFT 在室温下沉积的 Al2O3 电介质被成功证明,其场效应迁移率为 19.5 cm 2 V − 1 s − 1 , 160 mV/dec的小亚阈值摆幅,0.1 V的低阈值电压,4.5 × 10 8 的大开/关电流比 ,以及卓越的负和正栅极偏置稳定性。这归因于与较高沉积温度相比,在室温下沉积的富氢 Al2O3 电介质,从而有效地钝化了 a-IGZO/Al2O3 的界面态和氧空位,并通过产生额外的电子来提高 a-IGZO 通道的导电性因为在 IGZO 溅射过程中增强了氢掺杂。高性能a-IGZO TFT的这种极低的热预算对于柔性电子应用非常有吸引力。
背景
基于非晶 In-Ga-Zn-O (a-IGZO) 的薄膜晶体管 (TFT) 因其高迁移率、良好的均匀性、高可见光透明度和低工艺温度而在过去十年中备受关注 [1, 2,3]。这些优点使其成为下一代电子产品应用的有希望的候选者,例如透明显示器、柔性设备或可穿戴电子产品。特别是,对于柔性电子产品的应用,TFT 通常是在低热稳定性聚合物基板上制造的。因此,有必要减少 a-IGZO TFT 制造的热预算。为此,许多研究人员专注于具有室温制造栅极绝缘体的 a-IGZO TFT,例如溅射 [4,5,6]、溶液工艺 [7,8,9]、电子束蒸发 [10] 和阳极氧化[11]。然而,这些介电薄膜通常会受到高密度陷阱和强介电/a-IGZO界面散射的影响,从而导致场效应迁移率有限、亚阈值摆动大和开/关电流比小[4,5,6 ,7,8,9,10,11]。
另一方面,原子层沉积 (ALD) 是一种很有前途的技术,它可以提供高质量的薄膜、薄膜厚度的精确控制、大面积的良好均匀性和低工艺温度 [12,13,14]。郑等人。 [15] 报道称,具有 ALD SiO2 电介质的 a-IGZO TFT 表现出优异的电气性能,而无需进行后退火。然而,SiO2 薄膜的 ALD 需要 250 °C 的高基板温度 [15],这高于大多数柔性塑料基板的玻璃化转变温度。有趣的是,据报道,即使在室温 (RT) 下也可以实现 Al2O3 薄膜的 ALD [16, 17];同时,在室温下沉积的 Al2O3 薄膜含有大量的氢 (H) 杂质 [17]。然而,据我们所知,上述富含 H 的 Al2O3 薄膜从未被用作 a-IGZO TFT 中的栅极绝缘体。因此,有必要探索具有RT ALD Al2O3栅极绝缘体的a-IGZO TFT。
在这封信中,使用室温沉积的 Al2O3 栅极电介质成功制造了高性能 a-IGZO TFT。通过比较不同温度下沉积的各种Al2O3栅极绝缘体的a-IGZO TFTs的特性,揭示了其潜在机制。
方法
高度掺杂的 p 型硅晶片 (<0.0015 Ω cm) 通过标准 RCA 工艺清洁并用作栅电极。使用三甲基铝 (TMA) 和 O2 等离子体分别作为前体和反应物在商业 ALD 系统 (Picsun Ltd.) 中沉积 40 纳米 Al2O3 薄膜。一个生长周期由 0.1 s TMA 脉冲、10 s N2 吹扫、8 s O2 等离子体脉冲和 10 s N2 吹扫组成。 TMA 保持在 18 °C 以获得稳定的蒸气压和剂量,O2 气体流速固定在 150sccm,等离子体发生器功率为 2500 W。随后,通过 RF 溅射沉积 40-nm a-IGZO 薄膜使用原子比为 In:Ga:Zn:O =1:1:1:4 的 IGZO 陶瓷靶。在溅射过程中,工作压力和 Ar 和 O2 气体流速分别固定在 0.88 Pa 和 48 和 2 sccm。有源区通过光刻和湿蚀刻形成。之后,通过电子束蒸发和剥离方法制备 30-nm Ti/70-nm Au 双层的源/漏电极。这些器件没有进一步的退火工艺。
在室温下,在暗箱中使用半导体器件分析仪(Agilent Tech B1500A)表征 a-IGZO TFT 的电性能。分别在正和负栅极偏置应力下测量器件稳定性。分别采用二次离子质谱(SIMS)和X射线光电子能谱(XPS)测量了元素和化学成分的深度分布。
结果与讨论
图 1a 比较了在不同温度下沉积的 Al2O3 薄膜的介电常数作为频率的函数(即从 10 Hz 到 10 5 赫兹)。随着沉积温度从 100 增加到 150 °C,薄膜的介电常数逐渐降低。之前的文献中也报道了类似的趋势,沉积温度从 RT 变为 150 °C [18, 19]。这是因为 RT Al2O3 膜包含最高浓度的 OH 基团形式的氢 (H)。因此,由于更多 OH 基团在电场中旋转,相应的介电常数得到提高 [20]。就10 Hz的测量频率而言,RT、100 °C和150 °C的Al2O3薄膜的提取介电常数分别等于8.6、7.9和7.4,用于提取场-效应迁移率 (μ FE) 和界面陷阱密度 (D 它)制造的 TFT 器件。图 1b 显示了不同 Al2O3 薄膜的漏电流特性。发现RT Al2O3薄膜的漏电流密度很小,为2.38 × 10 − 8 A/cm 2 在 2 MV/cm 和 5.3 MV/cm 的击穿电场下。此外,击穿电场随着沉积温度从100增加到150 ℃而逐渐增加。
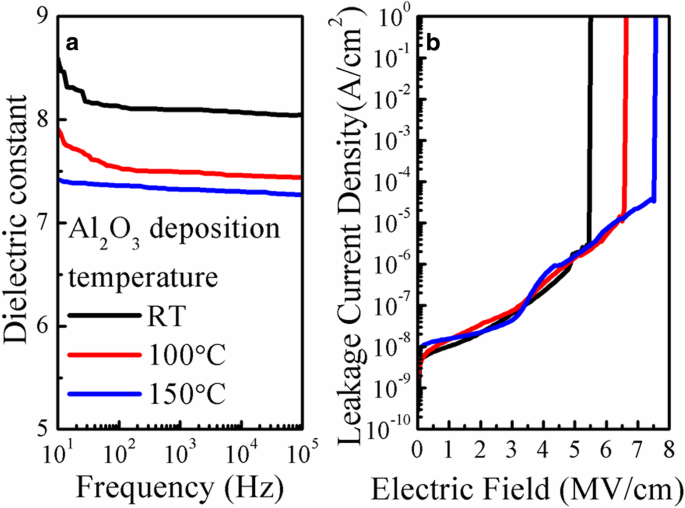
在不同温度下沉积的 Al2O3 薄膜的电学特性。 一 介电常数与频率的关系。 b 漏电流密度与电场的关系
图 2 显示了具有不同 Al2O3 栅极绝缘体的 a-IGZO TFT 的典型转移曲线。 RT Al2O3 TFT 表现出最佳性能,例如高 μ FE 为 19.5 cm 2 V − 1 s − 1 , 160 mV/dec 的小亚阈值摆幅 (SS),小阈值电压 (V T) 为 0.1 V,且开/关电流比 (I 开/关)4.5 × 10 8 .然而,具有在 100 和 150 °C 下沉积的 Al2O3 栅极绝缘体的 a-IGZO TFT 表现出更差的性能,即降低的导通电流 (10 − 7 和 3 × 10 − 9 A) 和退化的 SS。 D 其在Al2O3/a-IGZO界面处的计算公式[21]:
$$ {D}_{\mathrm{it}}=\left(\frac{\mathrm{SS}\times \lg e}{kT/q}-1\right)\frac{C_{ox}}{ q^2} $$ (1)其中 e , k , T , 和 q 分别代表欧拉数、玻尔兹曼常数、绝对温度和单位电子电荷。 C ox 是每单位面积的栅极介电电容。对于 RT Al2O3 TFT,D 它等于 1.1 × 10 12 eV − 1 cm − 2 ,这比在 100 和 150°C 下沉积的具有 Al2O3 栅极绝缘体的 TFT 低一到两倍以上。

具有ALD Al2O3栅极绝缘体的a-IGZO TFT在不同温度下沉积的转移曲线以及提取的器件参数
通过施加负电压和正电压进一步测量器件的栅极偏置稳定性。图 3 显示了 V 不同 TFT 的 T 偏移作为偏置应力时间的函数。在负栅极偏置应力 (NGBS) 方面,RT Al2O3 TFT 的 V 可以忽略不计 在 - 10 V 下施加压力 40 分钟后,T 偏移 - 0.04 V。然而,较高温度的 Al2O3 栅极绝缘体会产生更大的 V T 尤其在 150 °C 时发生变化。 RT Al2O3 的如此高的 NGBS 稳定性应归因于低浓度的氧空位 (V O) 在 a-IGZO 通道中 [22]。对于正栅极偏置应力 (PGBS),RT Al2O3 TFT 显示 V T 位移为 1.47 V,远小于 100 和 150 °C Al2O3 TFT 的那些(8.8 V 和 12.1 V)。此外,还考察了存储时间对器件性能的影响,如图4所示。虽然背沟道没有钝化层覆盖,但器件在柜内(20% RH)保存后仍保持优异的性能在 30 °C 下持续 60 天;同时,μ 没有显着变化 观察到 FE 和 SS。这表明没有任何钝化层的RT Al2O3 TFTs在电流环境下具有良好的存储时间依赖性。

V 对于在不同温度下沉积 Al2O3 绝缘体的 TFT,在 NGBS =− 10 V 和 PGBS =10 V 下,T 位移随偏置应力时间的变化而变化

RT Al2O3 TFT 在 30 °C 的柜子 (20% RH) 中保存后的时间依赖性稳定性。 一 转移曲线。 b 流动性和亚阈值摆动
表 1 比较了我们的 RT Al2O3 TFT 与其他报告的性能。发现我们的设备在 V 附近表现出零 T,较小的 SS,较大的 I 在具有可比流动性的情况下开/关 [4, 23]。虽然使用 Ta2O5 栅极绝缘体可以获得更高的迁移率 61.5 cm 2 V − 1 s − 1 , SS 和 I 开/关显着恶化[10]。总之,与 100 和 150 °C Al2O3 TFT 相比,我们的 RT Al2O3 TFT 具有更优越的综合性能。由于除了 Al2O3 的沉积步骤外,所有工艺步骤都相同,因此电气性能的显着差异应该源于 Al2O3 栅极绝缘体。
<图>为了理解潜在机制,通过 SMIS 分析了 a-IGZO/Al2O3 堆叠薄膜中元素的深度分布。图 5a 显示了 H 浓度对 IGZO/Al2O3 堆叠深度的依赖性,其中 Al2O3 薄膜分别在 RT 和 150 °C 下沉积。为了比较,还分析了沉积在裸硅衬底上的 IGZO 膜。沉积在裸硅上的 IGZO 膜含有 ~ 3 × 10 21 cm − 3 ,源自溅射系统中的残留气体,并在 Si 表面吸附了 H2/H2O 分子。沉积在 Al2O3 薄膜上的两种 IGZO 薄膜都含有比裸硅衬底上更高的 H 浓度。这表明 H 浓度的增加应该来自于溅射 IGZO 期间底层 Al2O3 薄膜中 H 杂质的释放。此外,观察到在 RT Al2O3 薄膜顶部的 IGZO 薄膜中的 H 浓度高于界面附近区域的 150 °C 薄膜中的 H 浓度,这可以提供更有效的界面态钝化。因此,这通过减少界面载流子俘获来提高 RT Al2O3 TFT 的 SS 和 PGBS 稳定性。此外,分析了 IGZO/Al2O3 界面附近的 a-IGZO 薄膜的 O 1s XPS 光谱,如图 5b 所示。拟合峰位于 530.2 ± 0.1 eV、530.9 ± 0.1 eV 和 531.6 ± 0.1 eV,对应于 O 2− 与金属结合的离子 (O1),V O (O2) 和 OH 基团 (O3),分别 [13, 24]。在裸硅顶部的 a-IGZO 层中,O2 的百分比为 26.3%;然而,对于 150 °C 和 RT Al2O3 底层薄膜,它分别降低到 12.3% 和 6.8%。这表明更多的 V IGZO 通道中的 O 可以被来自底层 Al2O3 薄膜的额外 H 杂质有效钝化,特别是对于具有较高 H 浓度的 RT Al2O3 薄膜。据悉,当V O和H都存在于a-IGZO薄膜中,它们可以结合形成一个稳定的状态,其中H被困在V O (V OH),以及由此产生的 V OH 是浅层施主 [25,26,27]。因此,增强的 H 掺杂到 RT Al2O3 顶部的 IGZO 通道中,通过提供额外的电子来提高通道的电导率。此外,小的 V RT Al2O3 TFT在NGBS下的T位移也可归因于V的有效H钝化 哦[28]。据文献报道,在NGBS下TFT的不稳定性源于中性V的电离 O (V O → V O 2+ +2e − ) [17, 29]。此外,RT Al2O3 上的 a-IGZO 膜的 O3 百分比为 6.9%,分别高于 150 °C Al2O3(5.3%)和裸硅(4.6%)。 OH 基团可能来源于反应 O 2- + H → OH − + e − 在 IGZO 薄膜的沉积过程中 [30]。因此,增强的H掺杂到RT Al2O3薄膜顶部的IGZO沟道中会产生更多的OH基团,也有助于提高沟道电导率。

一 在室温和 150 °C 条件下沉积的 Al2O3 中氢浓度的 SIMS 曲线。 b 沉积在 RT Al2O3、150 °C Al2O3 和裸 Si 上的 IGZO 通道的高分辨率 O1s XPS 光谱
结论
使用由 O2 等离子体增强 ALD 制备的富含 H 的 Al2O3 栅极电介质,在 RT 的极低热预算下成功制造了高性能 a-IGZO TFT。这归因于这样一个事实,即在室温下沉积的 Al2O3 电介质比在更高温度下沉积的介质含有更多的氢杂质。因此,在 IGZO 溅射过程中释放的 H 杂质产生了更多的电子,并有效地钝化了 a-IGZO/Al2O3 和 V 的界面态 O在a-IGZO频道。
缩写
- a-IGZO:
-
非晶In-Ga-Zn-O
- ALD:
-
原子层沉积
- D 它:
-
界面陷阱密度
- H:
-
氢气
- I 开/关:
-
通断电流比
- NGBS:
-
负栅偏压
- PGBS:
-
正栅极偏置应力
- RT:
-
室温
- SIMS:
-
二次离子质谱
- SS:
-
亚阈值摆动
- TFT:
-
薄膜晶体管
- V :
-
氧空位
- V 哦:
-
氧空位捕获的氢
- V :
-
阈值电压
- XPS:
-
X射线光电子能谱
- μ 费:
-
场效应迁移率
纳米材料


