在 SiNx 钝化层中注入氟离子的高击穿电压和低动态导通电阻 AlGaN/GaN HEMT
摘要
在这项研究中,我们提出并通过实验证明了高击穿电压 (BV) 和低动态导通电阻 (R ON, D) AlGaN/GaN 高电子迁移率晶体管 (HEMT),通过在栅极和漏极之间的厚 SiNx 钝化层中注入氟离子。代替在薄的 AlGaN 势垒层中注入氟离子,在厚钝化层中注入氟离子的情况下,峰值位置和空位分布远离二维电子气(2DEG)通道,有效抑制了直接电流 (DC) 静态和脉冲动态特性退化。钝化层中的氟离子还扩展了耗尽区并增加了栅极和漏极之间的平均电场(E 场)强度,从而导致 BV 增强。所提出的 HEMT 的 BV 从具有相同尺寸参数的传统 AlGaN/GaN HEMT(Conv. HEMT)的 680 V 增加到 803 V。测量的 R 在 100 V 的高漏极静态偏置下,所提出的 HEMT 的 ON、D 仅增加了 23%,而 R 在薄AlGaN势垒层中注入氟离子的HEMT的ON、D提高了98%。
背景
近几十年来,新型半导体材料,如 GaN、金属氧化物和二维材料,由于其优异的材料和器件性能,被广泛研究以进一步提高能量转换和存储效率 [1,2,3,4, 5,6,7,8]。其中,GaN基AlGaN/GaN高电子迁移率晶体管(HEMT)因其高临界击穿场和高电子迁移率而成为高功率、高频和低损耗应用的良好候选者[9,10,11,12,13 ,14]。击穿电压 (BV) 是最重要的设计目标之一,报告的值仍远低于理论极限 [15, 16]。因此,进一步提高 BV 非常重要,尤其是不要以增加器件尺寸为代价。已经提出了几种终止技术来改善 BV,例如场板 [17,18,19]、氟离子注入 [20,21,22] 和凹陷的栅极边缘终止 [23, 24]。氟离子注入薄的 AlGaN 势垒层 (FBL) [22] 具有简单的制造工艺,不会引起额外的寄生电容;然而,氟分布和空位分布的峰值位置靠近二维电子气(2DEG)通道,这将不可避免地导致显着的静态和动态特性劣化。
在这项工作中,高击穿电压和低动态导通电阻 (R ON, D) 实验研究了在 SiNx 钝化层 (FPL HEMT) 中注入氟离子的 AlGaN/GaN HEMT。与在薄AlGaN势垒层中注入氟离子的情况不同,在厚钝化层中注入氟离子可以使氟和空位分布的峰值位置远离2DEG沟道,从而有效抑制静态和动态特性退化.钝化层中的氟离子作为终止技术也用于优化表面电场(E 场)分布,从而实现增强的 BV。综上所述,FPL HEMT表现出优异的静态特性和动态特性。
制作方法
图 1 是 FPL HEMT、FBL HEMT 和 Conv 的三维示意图。 HEMT,分别。所有器件的栅极长度为 L G为2.5 μm,栅源距离L GS 为 1.5 μm,栅漏距离 L GD 为 10 μm。用于制造 FPL HEMT 的外延 AlGaN/GaN 异质结构通过金属有机化学气相沉积 (MOCVD) 在 6 英寸 (111) 硅衬底上生长。外延层由 2-nm GaN 帽盖、23-nm Al0.25Ga0.75N 势垒、1-nm AlN 中间层、150-nm GaN 通道和 3.5-μm GaN 缓冲层组成。 2DEG 的霍尔效应测量密度和迁移率分别为 9.5 × 10 12 cm −2 和 1500 cm 2 /V s,分别。提议的 FPL HEMT 从台面隔离开始,该隔离是通过基于高功率 Cl2/BCl3 的电感耦合等离子体 (ICP) 蚀刻实现的。然后,在 780 °C/300 mTorr、280 sccm 的 NH3 流量和 70 sccm 的 SiH2Cl2 流量下沉积 40 纳米厚的低压化学气相沉积 (LPCVD) SiNx 层,沉积速率为 3.7 sccm,沉积速率为 3.7 sccm分钟用椭偏仪测得的折射率为 1.978,SiNx 的 N/Si 比为 1.31 [25]。 LPCVD SiNx 的结晶度是无定形的,高分辨率透射电子显微镜 (HR-TEM) 显微照片证实了这一点(见图 1a 的插图)。通过 SF6 等离子体干法蚀刻打开源极和漏极接触窗口后,沉积 Ti/Al/Ni/Au(20/150/45/55 nm)欧姆接触,并在 N2 环境中在 890 °C 下退火 30 s。通过线性传输线方法提取1 Ω mm的接触电阻和400 Ω/平方的薄层电阻。接下来,通过Ni/Au (50 nm/150 nm)沉积和剥离工艺形成栅极金属电极。然后用AZ5214光刻胶形成氟离子注入窗(Length of window =3 μm),采用SEN NV-GSD-HE离子注入机注入氟离子,能量为10 keV,剂量为1 × 10 12 cm −2 .最后,样品在 N2 环境中在 400 °C 下退火 15 分钟,以完成晶体管制造流程 [26]。
<图片>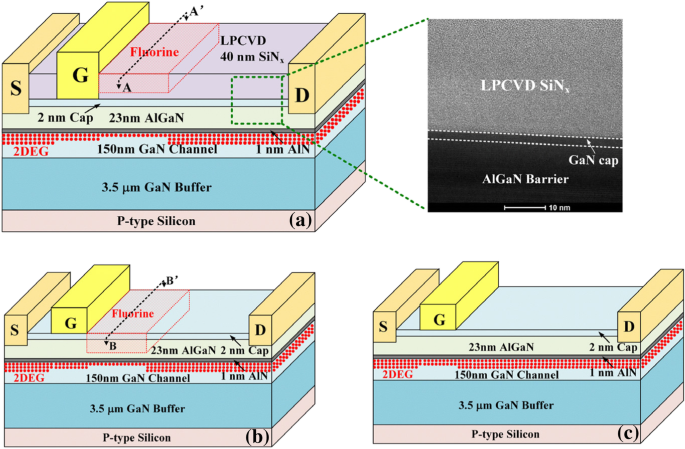
a的三维示意图 FPL HEMT(插图:LPCVD SiNx 的 HR-TEM 显微照片),b FBL HEMT 和 c 转化次数HEMT
结果与讨论
图 2 显示了通过 TRIM 沿切割线测量的氟离子浓度和模拟空位浓度的二次离子质谱 (SIMS) 分布图:(a) A-A' FPL HEMT 和 (b) B-B' 分别为 FBL HEMT。在相同的氟离子注入能量和剂量下,两种结构从表面测得的峰值位置和氟分布的最大浓度几乎相同。在薄的 AlGaN 势垒层中注入氟离子的情况下,由氟引起的空位延伸到 2DEG 沟道区。由于每种材料的键能不同,空位浓度在每个界面上的分布是不连续的 [27]。然而,在厚SiNx钝化层中注入氟离子的情况下,空位分布位于SiNx钝化层内,远离2DEG沟道。离子注入引起的空位将捕获 2DEG 通道,如果空位分布接近 2DEG,则 2DEG 很容易被捕获 [28]。综上所述,在厚SiNx钝化层中注入氟离子可以显着降低离子注入对2DEG沟道的影响,有效抑制静态和动态特性劣化。
<图片>
沿切割线通过 TRIM 测量氟离子浓度的 SIMS 分布和模拟空位浓度。 一 A-A'。 b B-B'
图 3 显示了测量的 I-V 传输特性和直流 (DC) 输出特性。与 Conv 相比。 HEMT,FPL HEMT 和 FBL HEMT 均显示 I 下降 DS 和静态导通电阻的增加 (R ON),因为氟离子导致漂移区中 2DEG 的辅助耗尽,从而降低 2DEG 密度 [29]。此外,离子注入还降低了 2DEG 迁移率。霍尔效应测量的 FPL 和 FBL HEMT 的 2DEG 迁移率为 228 cm 2 /V s 和 203 cm 2 /V s 分别在离子注入后。由于相同剂量的氟离子,输出特性和R FPL HEMT 和 FBL HEMT 的 ON 在低漏极电压(例如,V DS <3 V)。然而,当 V DS> 3 V,FBL HEMT 发生饱和漏电流崩溃,因为氟的空位分布延伸到 2DEG 沟道区,当漏电压大于临界漏极电压(例如,V DS> 3 V) [30],从而降低漏极电流。 FPL HEMT的空位分布远离2DEG沟道,有效抑制了饱和漏电流崩塌。
<图片>
测量 a I-V 传输特性,以及b 三个HEMT的直流输出特性
图 4 显示了测量的 I-V 阻塞状态下的特性和模拟表面电场分布。 FPL/FBL/Conv 的 BV。 HEMT 分别为 803/746/680 V。 BV 定义为漏极电流 (I DS) 为 1 μA/mm,V GS =− 4 V。栅极和漏极之间的氟离子作为终止技术降低了栅极边缘的电场峰值,并在离子注入区的末端导致新的电场峰值,因此,FPL HEMT 和FBL HEMT 实现了比 Conv 更均匀的表面电场分布和更高的 BV。赫姆特。与 FPL HEMT 相比,FBL HEMT 具有增强的电场调制效果,因为氟离子剖面靠近 2DEG 通道。然而,对于 FBL HEMT,离子注入不可避免地会在 AlGaN 势垒中引起额外的损伤 [31, 32],导致 gate-barrier layer-2DEG 的连续栅极漏电流路径;因此,FBL HMET 的 BV 略小于 FPL HEMT。
<图片>
一 测量的关断状态 I-V 具有-4 V 栅极电压的特性,保持衬底浮动。 b V 处的模拟表面电场分布 DS =150 V
脉冲I DS-V 在慢速开关下进行 DS 测量 [33] 以表征动态导通电阻 (R ON, D) 制造的 AlGaN/GaN HEMT。图 5a 是描述在脉冲 I 期间施加应力电压的示意图 DS-V DS 测量。在脉冲I-V 测量,GaN HEMT 的栅极和漏极在每个 I-V 之前经受短电压脉冲 测量以确保设备处于关闭状态。脉冲宽度为 3 ms,周期为 5 ms。图 5 b-d 显示了器件在 (V GS0, V DS0) 的 (0 V, 0 V) 和 (0 V, 100 V)。可以看出,Conv. 的动态导通电阻有最轻微的下降 (12.3%)。 HEMT,由于没有氟离子注入工艺。与 FBL HEMT 相比,FPL HEMT 具有较低的动态导通电阻退化。由于钝化层,空位分布远离 2DEG 通道并位于钝化层内,这抑制了 FPL HEMT 中的电荷俘获。图 6 总结了 R 的比率值 开,D/R (V 下的三个 HEMT 为 ON GS0, V DS0) 从 (0 V, 0 V) 和 (0 V, 100 V) 在 20 V 的步长。对于 FBL HEMT,测量的 R ON,D 在 (V GS0, V DS0) 的 (0 V, 0 V) 和 (0 V, 100 V),而 R 在 100 V 的高漏极静态偏置下,FPL HEMT 的 ON、D 仅增加 23%。
<图片>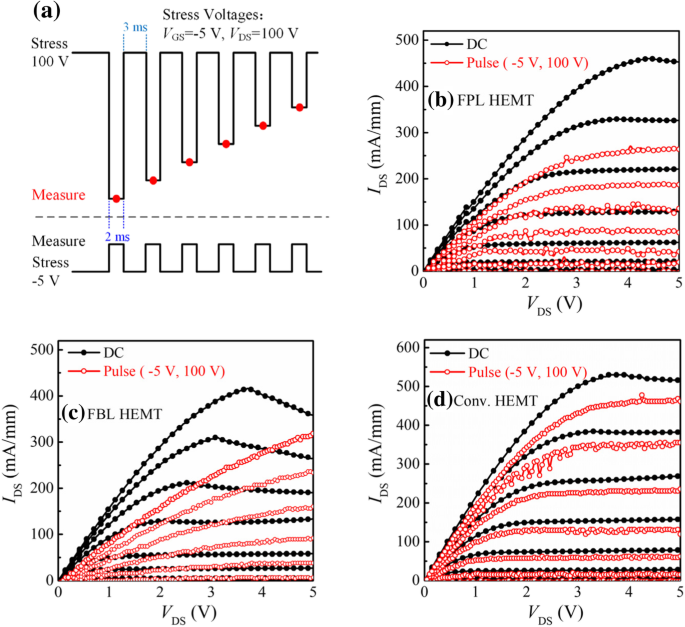
一 在脉冲I期间施加应力电压的示意图 DS-V DS 测量。脉冲I DS-V 制备的具有 b 的 AlGaN/GaN HEMT 的 DS 特性 FPL HEMT,c FBL HEMT 和 d 转化次数HEMT (V GS =− 4~0 V;步长:0.5 V)
<图片>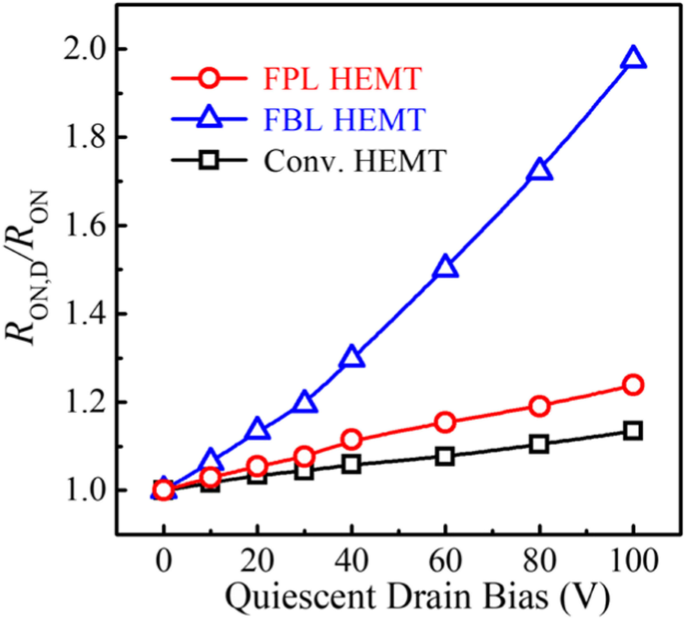
R 的比例 开,D/R 在不同静态漏极偏置点处制造的 HEMT 的 ON。脉冲宽度和周期分别为3 ms和5 ms
结论
总之,我们提出了一种具有高击穿电压和低动态导通电阻的新型 AlGaN/GaN HEMT。它的特点是在厚的 SiNx 钝化层中注入氟离子。在钝化层中注入氟离子可以有效抑制电特性劣化。断态V后动态导通电阻仅为静态导通电阻的1.23倍 DS 应力为 100 V,而 FBL HEMT 为 1.98 倍。此外,钝化层中的氟离子还对电场分布进行调制,使耗尽区扩散;因此,所提出的HEMT的BV从传统AlGaN / GaN HEMT的680 V增加到803 V。
数据和材料的可用性
本研究期间生成或分析的所有数据均包含在这篇已发表的文章中。
缩写
- 2DEG:
-
二维电子气
- HEMT:
-
高电子迁移率晶体管
- ICP:
-
电感耦合等离子体
- LPCVD:
-
低压化学气相沉积
- MOCVD:
-
金属有机化学气相沉积
- SIMS:
-
二次离子质谱
- TEM:
-
透射电子显微镜
纳米材料
- 什么是故障维护以及如何处理
- 表面状态和铝摩尔分数对 AlGaN/GaN HEMT 中表面电位和 2DEG 的影响
- 通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
- RGO 和三维石墨烯网络共同修饰的高性能 TIM
- 具有超弹性和高电容的石墨烯/聚苯胺气凝胶作为高抗压超级电容器电极
- 在 c 面 GaN 上沉积的 AlN 原子层中界面和电特性的厚度依赖性
- 具有低工作电压的基于原子层沉积的 HfAlOx 的 RRAM,用于计算内存应用
- 具有增强型双栅极和部分 P 埋层的超低导通电阻横向双扩散金属氧化物半导体晶体管
- 具有高 PSRR 的纳米级低功耗无电阻电压基准
- 具有混合沟槽阴极的高精度 AlGaN/GaN 反向阻断 CRD (RB-CRD)
- 具有高开/关比和极性可切换光电导性的 SnSe2 场效应晶体管
- 高压PCB材料和设计


