生长序列中量子势垒的最佳硅掺杂层形成八周期 In0.2Ga0.8N/GaN 蓝色量子阱的软限制势LED
摘要
探索了在蓝光发光二极管 (LED) 生长序列的前两到五个量子势垒 (QB) 中掺杂硅 (Si) 的八周期 In0.2Ga0.8N/GaN 量子阱 (QW) 的特征. QW 结构的外延层通过低压金属有机化学气相沉积 (LP-MOCVD) 在 20 对 In0.02Ga0.98N/GaN 超晶格上生长,用作图案化蓝宝石衬底 (PSS) 上的应变消除层 (SRL)系统。温度相关的光致发光 (PL) 光谱,电流与电压 (I -V ) 曲线,光输出功率与注入电流 (L -我 ) 曲线,测量了外延层的高分辨率透射电子显微镜 (HRTEM) 图像。结果表明,具有四个 Si 掺杂 QB 的 QW 具有更大的载流子定位能量 (41 meV)、更低的开启 (3.27 V) 和击穿 (- 6.77 V) 电压,以及更高注入时蓝光 LED 的光输出功率更高电流高于其他样品。四硅掺杂 QB 样品中 QB 的低势垒高度导致 QW 的软限制电位和二极管的较低导通和击穿电压。 HRTEM 图像证明该样品具有相对扩散的 QW 界面。载流子在八个 QW 之间的均匀分布和每个阱中载流子的优越定位是提高光输出功率的原因,特别是对于四硅掺杂 QB 样品中的高注入电流。结果表明,带有 Si 掺杂的八个 In0.2Ga0.8N/GaN QW 的四个 QB 不仅降低了量子限制斯塔克效应 (QCSE),而且改善了 QW 中载流子的分布和定位,从而获得更好的蓝光 LED 光学性能。
背景
GaN 量子势垒 (QB) 中的硅 (Si) 掺杂可以激发极化场的库仑屏蔽,并抑制 InGaN/GaN 量子阱 (QW) 中的量子限制斯塔克效应 (QCSE)。 InGaN/GaN QW 中激子的辐射复合可以通过 Si 掺杂的 QB 得到显着增强 [1,2,3,4]。由于 GaN 和 InN 固有的固相混溶间隙,在三元合金 InGaN 中会出现铟 (In) 的成分波动和旋节线相分离。富 In 簇的形成可以作为强载流子定位,防止非辐射复合中心 (NRC) 的陷阱并促进 InGaN/GaN QW 中激子的辐射复合 [5,6,7,8,9,10]。 InGaN/GaN QW 中铟成分的波动对器件的行为有重大影响,例如内部量子效率 (IQE)、外部量子效率 (EQE) 和电流-电压特性。应考虑 InGaN/GaN QW 中的铟波动,以便更好地解释器件的性能 [11]。由于 QW 层的螺旋生长 [12],具有 Si 掺杂 QB 的 InGaN/GaN QW 显示出材料纳米结构的改性和纳米级岛的形成,促进 InGaN/GaN QW 的热稳定性 [13],随着 QBs 中掺杂浓度的增加,LED 的光输出功率和静电放电 (ESD) 行为得到改善 [14],容易阻止空穴载流子传输,导致 p 型 GaN (p-GaN )和掺杂势垒[15]等
据报道,InGaN/GaN QW 的有利周期和厚度在高注入电流(超过几十 mA)的蓝光 LED 下具有高亮度和高 EQE [16,17,18]。在报告中,在图案化蓝宝石衬底 (PSS) 上生长的九个周期的 InGaN/GaN QW 显示出 EQE 的发光功率和下垂特性的显着改善 [16]。如果有源区由 12 个周期的 InGaN/GaN QW 组成,注入电流为 42 A/cm 2 ,则证明了蓝光 LED 的最佳光学和电学性能 [17]。在 InGaN/GaN LED 的模拟结果中,QB 的厚度从 24.5 纳米减少到 9.1 纳米,证明了 EQE 下降的明显减少和 IQE 的增强 [18]。在 InGaN/GaN QW 中以适当的厚度和数量的 QB 掺杂 Si 对于进一步提高在高注入电流下运行的 InGaN 蓝色 LED 的亮度和效率至关重要。在本报告中,我们介绍了八周期 In0.2Ga0.8N/GaN QW 的光学、电学和材料特性,其中前两到五个 QB 在蓝色 LED 的生长序列中具有 Si 掺杂。研究结果更深入地了解了载流子定位机制、限制电位和QWs的QCSE对高注入电流下蓝光LED发光行为的影响。
实验方法
图 1 描绘了蓝色 LED 样品的材料层结构示意图。外延层由低压金属有机化学气相沉积 (LP-MOCVD) 系统的卧式反应器沉积在 (0001) 取向 (c 面) PSS 上。 PSS 上规则金字塔结构的直径、高度和间隔分别为 2、1.5 和 1 μm。 PSS 的厚度为 3 μm,并在外延层生长之前在氢气环境中在 1150°C 下预热。三甲基镓 (TMGa)、三甲基铟 (TMIn)、三甲基铝 (TMAl) 和气态 NH3 分别用作元素镓 (Ga)、In、铝 (Al) 和氮 (N) 的气相前驱体。硅烷 (SiH4) 和双环戊二烯基镁 (Cp2Mg) 分别是 n 型和 p 型物质中掺杂剂 Si 和镁 (Mg) 的前体。前驱体的载气为氢气(H2)和氮气(N2)的比例为1:1的混合物,不具有化学反应性。
<图片>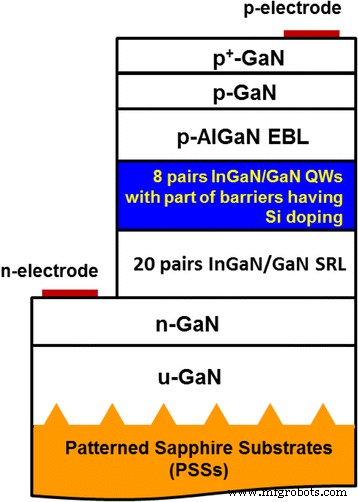
制造的蓝色 LED 芯片的层结构示意图。这些外延层厚度示意图为清晰起见被夸大,未按比例绘制
在 PSS 上生长未掺杂的 GaN (u-GaN) 缓冲层,然后是厚度为 3 μm 和 3.3 μm 的 Si 掺杂 n 型 GaN (n-GaN)。 n-GaN的掺杂浓度为10 19 厘米 −3 .随后将 20 对厚度为 2/2 nm 的 In0.02Ga0.98N/GaN 超晶格沉积在 n-GaN 上。它起到应变消除层(SRLs)的作用,用于减少应变从PSSs上的外延层延伸。
蓝色 LED 的有源层包含八周期 In0.2Ga0.8N/GaN QW。 QW 和 QB 的厚度分别为 2.5 和 8 nm,生长温度分别为 750 和 900 °C。 Si 掺杂浓度约为 3 × 10 17 厘米 −3 在生长序列中的前两个、三个、四个和五个 QB 中,分别命名为样本 A、B、C 和 D。 p 型 Al0.16Ga0.84N 电子阻挡层 (EBL) 的厚度为 20 nm,在 950 °C 下生长,掺杂了 Mg。 p-GaN 窗口层和 p + -GaN 接触层在 950°C 下生长,厚度为 100 和 20 nm,掺杂浓度为 10 19 和 10 20 厘米 −3 .
外延层通过电感耦合等离子体 (ICP) 系统选择性蚀刻到 n-GaN 层,以形成台面结构 LED。氧化铟锡 (ITO) 透明接触层 (TCL) 沉积在 p + -GaN 表面通过电子束蒸发器。随后将铬/铂/金 (Cr/Pt/Au) 多金属接触电极层蒸发到 p + -GaN 和 n-GaN 层可实现良好的欧姆接触。 LED 晶圆被研磨并抛光至约 120 微米以进行芯片切割。方形芯片尺寸为 1 mm 2 的标准台面型 LED 设备 生产。
电流对电压 (I -V ) 曲线和光输出功率 (P out) 与注入电流 (L -我 ) 测量二极管在室温 (RT) 下从 20 到 300 mA 的曲线。检查了八周期 In0.2Ga0.8N/GaN QW 的温度相关光致发光 (PL) 光谱。 PL 的激发光源是 He-Cd 激光器(325 nm),平均功率为 45 mW。高分辨率透射电子显微镜 (HRTEM) 图像取自 EM-3000F 场发射透射电子显微镜 (FE-TEM),加速电压为 300 kV,分辨率为 0.14 nm。
结果与讨论
图 2 绘制了样品在 10 到 300 K 不同温度下的 PL 光谱。可以观察到 PL 峰强度随温度升高而单调下降。这是由于非辐射复合过程随着温度的升高而升高。所有 PL 光谱曲线都通过高斯线形函数拟合,以找出峰值最大能量随温度的变化,如图 3 所示。未掺杂 In0.2Ga0.8N/GaN QW 的 PL 发射峰值最大能量在室温下为 2.68 eV温度。这意味着,与未掺杂的样品相比,具有 Si 掺杂的前两到五个 QB 的样品的 PL 峰值能量表现出蓝移。前两到五个掺杂 Si 的 QB 可以有效降低 QW 中的 QCSE。需要指出的是,在外延层结构中使用PSSs和SRLs可以减少In0.2Ga0.8N/GaN QWs中压电(PZ)场和QCSE的部分。
<图片>
样品在 10 到 300 K 的不同温度下的温度相关 PL 光谱
<图片>
PL 峰值最大能量随样品温度的变化。使用 Varshni 方程的最佳拟合曲线用粗黑实线表示
在图 3 中,可以显示所有样品的 PL 峰值最大能量随温度变化的 S 形曲线。 S形曲线随着温度的升高呈先红后蓝再红移。这种行为归因于 QW 中强局域激子的温度依赖性集体发光。下图所示的 Varshni 经验方程可用于拟合 S 形变化从蓝移到红移的范围 [19,20,21]。
$$ {E}_{\mathrm{g}}(T)={E}_{\mathrm{g}}(0)-\frac{\alpha {T}^2}{\left(T-\ beta \right)}-\frac{\sigma^2}{k_{\mathrm{B}}T} $$ (1)其中 E g(0), α , β , 和 σ 是拟合参数。 E g(0) 是 QW 在绝对温度 0 K 时的带隙能量。α 和 β 是与材料相关的参数的热系数。 σ 是高斯展宽参数,它在物理上反映了带尾局域态内载流子的热分布程度。等式中的第二项。 (1)表明半导体的带隙能量随着温度的升高而降低,由于原子振动幅度的增加,这被称为能隙收缩。第三项用于在非简并载流子分布和类高斯局域态密度的假设下表征载流子局域化程度随温度的变化。由于电子和空穴波函数之间重叠的改善,强载流子定位是实现 InGaN QW 中辐射复合和 IQE 提高的关键方面。由于载流子分布的强简并性,Varshni方程不适用于低温下PL峰值能量的红移范围。样本的最佳拟合结果如图 3 中的粗线和黑色实线所示。样本 A、B、C 和 D 的定位能量分别为 24、28、41 和 13 meV。样本C拥有最大的定位能量,σ (41 兆伏特)。具有四个 Si 掺杂 QB 的 QW 中的载流子定位比其他的强。最小定位能量(σ ) 发生在样本 D 中,值为 13 meV。
电流-电压 (I -V ) 蓝色 LED 正向和反向偏置下的特性如图 4 所示。在该图中,样品 A、B、C 和 D 的开启电压在正向电流下分别为 3.41、3.47、3.27 和 4.03 V分别为 20 mA。在反向电流为 1 μA 时,样品 A、B、C 和 D 的击穿电压分别为 - 8.85、- 9.99、- 6.77 和 - 11.55 V。样品 C 具有最小的导通电压和击穿电压。样品 D 具有最大的开启和击穿电压。因此,在样品 C 中建议 QB 的势垒高度较低。在具有 Si 掺杂的前四个 QB 的样品中,预计 QW 具有软(平滑)限制电位。软限制电位分布意味着 QW 的传导和价带偏移不被视为尖锐的阶跃函数,即不是矩形限制电位。平滑的限制电位可以在很大程度上抑制俄歇复合,并防止大量载流子在 InGaN/GaN QWs 注入方向的前几个阱中积累[22,23,24]。通过沿 InGaN/GaN QW 的生长方向线性减少 In 成分,也可以实现平滑的限制电位。这可以有更好的载流子在QWs之间的传播和空穴的传输,从而改善EQE和光输出功率的快速下降[25,26,27,28,29,30]。
<图片>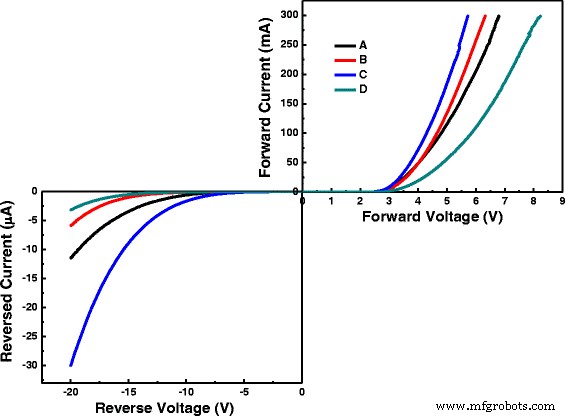
电流-电压 (I -V ) 二极管正向和反向偏置下的曲线
图 5 显示了光输出功率 (P 输出)与注入电流 (L -我 ) 由芯片测试仪从 0 到 300 mA 的曲线。 P 的增加 随着 L 注入电流的升高 -我 可以观察曲线。最高和最低 P 高注入电流的输出分别显示在样品 C 和 D 中。 P 的饱和度 除样品 C 外,所有样品均显示了在注入电流 300 mA 时的输出。P 的饱和效应 out 是指溢出 QW 的电流。溢出 QW 的电流较少发生在 QW 的软限制电位和 QW 样本内的强载流子定位中。含有Si掺杂的4个QB的样品显示了8个QW之间载流子更好的扩散和QW内部载流子的强辐射复合。
<图片>
光输出功率 (P out) 与注入电流 (L -我 ) 二极管从 0 到 300 mA 的曲线
样品的横截面高分辨率透射电子显微镜(HRTEM)的暗场、明场和放大的明场图像如图1和图2所示。 6、7 和 8。在图 6 中,明暗对比对应于 InGaN 和 GaN 外延层。可以观察到 8 个周期的 QW 和 20 对超晶格。在图 7 中,暗对比度变化代表 QW 中局部 In 含量的波动和富铟簇的形成 [31,32,33,34]。富铟簇作为载流子的相对较深的局部状态,导致高辐射激子复合。在这些富铟簇周围注意到晶格畸变和堆垛层错缺陷,表明应变能在 InGaN 层中部分松弛,如图 8a 中红色方块的放大图片所示。与放大的明场图像相比,样品 C 和 D 中 QW 的更多扩散(非突变)界面如图 8c、d 所示。该试剂来自众所周知的 In 和 Ga 原子在阱/势垒界面处的相互扩散。在样品 D 中发生了非常弱的 QW 限制和载流子定位,这与该样品的最差光电行为一致。在图像中,并非所有样品都形成螺纹位错 (TD)。 NRC 主要发生在 TD 站点。由于采用了 PSS 和 SRL [35,36,37],这些样品中的外延层质量如预期的那样更好。在八周期QW中掺杂Si的四个QB是改变限制电位以获得InGaN / GaN QW的软限制电位的有利条件,从而导致蓝光LED的最佳光电性能。
<图片>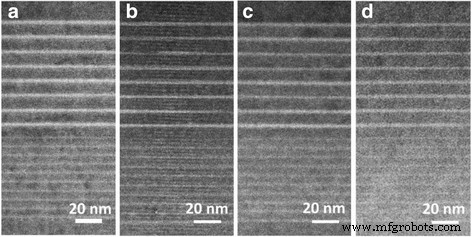
样品的暗场图像。 一 示例 A。b 示例 B。c 示例 C。d 样品 D
<图片>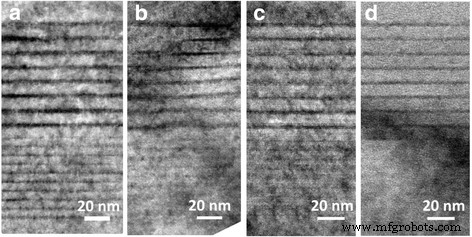
样品的明场图像。 一 示例 A。b 示例 B。c 示例 C。d 样品 D
<图片>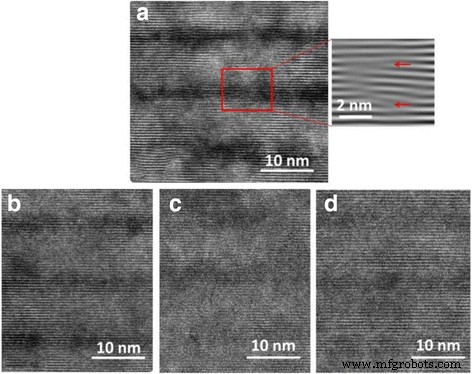
放大的样品明场图像。 一 示例 A。b 示例 B。c 示例 C。d 样品 D
结论
温度相关 PL 光谱,I -V 曲线,L -我 曲线,以及具有八周期 In0.2Ga0.8N/GaN QW 的蓝色 LED 的 HRTEM 图像,该 QW 在沉积序列中的前两到五个 QB 含有 Si 掺杂。结果表明,前四个 QB 含有 Si 掺杂的样品具有相对较低的势垒高度和较大的载流子定域能,这由 HRTEM 图像中 QW 的扩散界面证明。 QWs 的软限制潜力伴随着 QWs 内更强的载流子定位,导致了该样本中载流子在 8 个 QWs 之间更均匀的分布和更高的载流子辐射复合。在高注入电流下,具有四个 Si 掺杂 QB 的蓝色 LED 发生俄歇过程和载流子泄漏的减少以及 QW 辐射复合的增加。结果通过分析载流子定域性、限制电位、PZ场和材料纳米结构对蓝色LED的In0.2Ga0.8N/GaN QWs发光性能的影响,提供了Si掺杂QBs的最佳条件。
缩写
- Al:
-
铝
- Cp2Mg:
-
双环戊二烯基镁
- EBL:
-
电子阻挡层
- EQE:
-
外量子效率
- FE-TEM:
-
场发射透射电子显微镜
- Ga:
-
镓
- HRTEM:
-
高分辨透射电子显微镜
- ICP:
-
电感耦合等离子体
- 在:
-
铟
- IQE:
-
内量子效率
- ITO:
-
氧化铟锡
- I -V :
-
电流对电压
- L -我 :
-
光输出功率与注入电流的关系
- LP-MOCVD:
-
低压金属有机化学气相沉积
- Mg:
-
镁
- N:
-
氮气
- n-GaN:
-
n型氮化镓
- NRC:
-
非辐射复合中心
- PL:
-
光致发光
- PSS:
-
图案化蓝宝石基板
- PZ:
-
压电式
- QB:
-
量子势垒
- QCSE:
-
量子限制斯塔克效应
- QW:
-
量子阱
- RT:
-
室温
- Si:
-
硅
- SiH4 :
-
硅烷
- SRL:
-
应变消除层
- TCL:
-
透明接触层
- TMAl:
-
三甲基铝
- TMGa:
-
三甲基镓
- TMIn:
-
三甲基铟
- u-GaN:
-
未掺杂的氮化镓
纳米材料
- 5G 和 GaN:从 LDMOS 到 GaN
- H2/NH3 混合气体中基于 GaN 的多量子阱的原子重排以改善结构和光学性能
- 表面状态和铝摩尔分数对 AlGaN/GaN HEMT 中表面电位和 2DEG 的影响
- 具有半极性 InxGa1−xN/GaN 多量子阱的紫外 GaN 基光子准晶纳米锥结构的多色发射
- 在蓝宝石上生长的外延 n 型掺杂 GaN 层的红外反射分析
- 退火 GaAsBi/AlAs 量子阱中的铋量子点
- 通过对通孔长度的调制,突破常关型 GaN HEMT 的多台面沟道宽度限制
- 通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
- 了解机械剥离石墨上 GaN 外延层的生长机制
- 采用后沉积蚀刻的浸渍法制备周期性聚苯乙烯纳米球阵列及其在提高 InGaN/GaN 光提取效率中的应用LED
- 基于石墨烯量子点装饰的 ZnO 纳米棒/GaN 薄膜同种型异质结的高性能紫外光电探测器
- 硅衬底上 InGaN/GaN 多量子阱中的应变控制复合


