退火 GaAsBi/AlAs 量子阱中的铋量子点
摘要
据报道,在 330°C 衬底温度下通过分子束外延生长并在 750°C 下生长后退火,在 GaAsBi 层中形成铋纳米晶体。在半绝缘 GaAs 衬底上生长包含交替的 10 nm 厚 GaAsBi 和 AlAs 层的超晶格。 AlAs 层作为 Bi 原子的扩散阻挡层,样品退火后成核的纳米团簇的尺寸与铋化物层的厚度相关。能量色散光谱和拉曼散射测量已经证明纳米颗粒主要由铋原子构成。退火后观察到强光致发光信号,光子波长范围为 1.3 至 1.7 μm;其振幅随着 GaAsBi 层数的增加而按比例增加。观察到的光致发光带可能是由于 Bi 纳米晶体的发射。进行的理论估计支持该假设。他们表明,由于量子尺寸效应,Bi纳米颗粒经历了向直接带隙半导体状态的转变。
背景
GaAsBi 基异质结构在从近红外到中红外区域的宽光谱范围内具有巨大的光电应用潜力。 GaAsBi 是一种 III-V 族半导体化合物,正在积极研究用于基于 GaAs 的红外辐射发射器 [1] 和检测器 [2,3,4,5]。 Lewis 等人描述了具有 GaAsBi 活性层的发光二极管,其辐射波长约为 987 nm(Bi 含量为 1.8%)。 [6];在参考文献中报道了在 GaAsBi/GaAs 多量子阱 (MQW) 中具有~6% Bi 的电注入双胺激光器。 [7]。该领域的主要困难是非辐射复合中心密度的增加,这是由于 Bi 含量高于 5% 的 GaAsBi 层的分子束外延 (MBE) 生长所需的低衬底温度。允许降低非辐射复合率的标准技术程序之一是在高于 MBE 生长温度的温度下进行生长后退火。然而,在 GaAsBi 的情况下,退火的效果并不明确。我们小组之前已经表明 [8, 9] 在高于 600 °C 的温度下退火会导致几个新特征,其中最重要的是一些相当强的光致发光 (PL) 样品的开始在 1.35 到 1.5 μm 的波长范围内,这一过程伴随着 GaAsBi 外延层的显着变化——晶格中 Bi 含量的减少和纳米级簇的出现[9]。
纳米结构(纳米线、应变量子阱或量子点 (QD))的生长是消除衬底与其上生长的外延层之间晶格失配的常用方法。基于 III-V 族化合物的量子点研究最广泛的例子是通过 Stranski-Krastanow 技术 [12] 生长的基于 InGaAs-[10] 和 InGaN-[11] 的 QD。在 GaAsBi 的情况下,这种生长机制仍未实现。已在参考文献中系统地研究了退火外延 GaAsBi 层中 Bi 相关簇的成核及其结构特征。 [13]。已经表明,不同晶体结构和成分的纳米团簇——菱面体 As 和 Bi 以及闪锌矿 GaAsBi 纳米团簇——在退火时在双化物层中成核;它们的大小在 5 到 20 纳米之间变化。在低温 (200°C) 下生长的具有相对较大 Bi 含量 (4.7%) 的 GaAsBi 中观察到纯铋的菱形团簇 [13]。在我们之前的研究 [9] 中,据报道在高温退火的 GaAsBi 中形成了纳米尺寸的 Bi 簇,Bi 含量高于 6%。此外,已经假设由于尺寸量化效应,铋纳米团簇变成半导体而不是半金属(就像块状 Bi 晶体的情况一样),并且在 Bi 团簇中发生的辐射复合可以是负责在退火的 GaAsBi 样品中观察到的长波长发射 [9]。
目前的工作报告了在退火的 GaAsBi/AlAs 量子阱中形成 Bi 纳米晶体。在退火过程中,AlAs 层用作电荷载流子限制和防止 Bi 从 GaAsBi 层向外扩散的阻挡层。 AlAs 层的存在以更可控的方式确保了 Bi 纳米颗粒的成核——它们的尺寸分布更窄,密度高于退火的体层 [9]。获得的样品通过高分辨率透射电子显微镜 (HRTEM)、PL 和拉曼光谱测量进行表征。这些实验的结果表明在退火的异质结构中存在纯铋纳米晶体。进行的理论估计证实,Bi纳米晶体可以通过尺寸量化效应转化为直接间隙半导体。
方法
GaAsBi/AlAs MQW 结构使用配备金属 Ga、Al 和 Bi 源以及两区裂解源的 SVT-A MBE 反应器在半绝缘 GaAs (100) 衬底上生长以生产 As2。使用了以下 MBE 生长方案。首先,使用标准 MBE 生长模式在 600°C 的高温下生长 GaAs 缓冲层(约 100 nm)和第一个 AlAs 势垒。然后,中断生长并降低衬底温度以生长 GaAsBi QW 和 AlAs 势垒。迁移增强外延 (MEE) 模式用于按以下生长顺序进行 AlAs 沉积:一个单层 (ML) Al,III 族原子迁移中断 5 秒,然后供应 1 ML As [14, 15 ]。最后,MQW 结构被 5 纳米厚的 GaAs 覆盖层覆盖。 GaAsBi层中Bi的含量由ω-2Θ XRD扫描的(200)-反射确定,对于生长样品约为7%。
选择了两个不同的 MQW 样品进行测量。 MQW A 样品包含三个 10 纳米厚和一个 20 纳米厚的 GaAsBi QW(在 330°C 下 MBE 生长),由 20 纳米厚的 AlAs 势垒(MEE 在相同温度下生长)分隔。 MQW B 样品包含 20 个 QW,具有 10 纳米宽的 GaAsBi 层,由 4 纳米厚的 AlAs 势垒隔开,生长条件与 A 样品的生长条件相似。两种样品的高温处理均在快速热退火 (RTA) 烘箱中在 750°C 的温度下在氮气环境中进行 180 秒。为防止表层砷流失,在退火时,样品用牺牲GaAs晶片覆盖。
原子力显微镜表面分析表明,生长的和退火的 MQW 结构均无液滴表面。 GaAs 帽层的表面粗糙度低于 1 nm。样品退火后在 MQW 中形成的纳米颗粒的结构高分辨率测量是通过 FEI Tecnai G2 F20 X-TWIN TEM 与 STEM 模块进行的,配备了用于元素的 X 射线能量色散光谱 (EDS) 检测器映射和用于 Z 对比度成像的高角度环形暗场 (HAADF) 检测器。配备 Omniprobe 机械手的 FEI Helios Nanolab 650 双光束显微镜用于制备用于 TEM 测量的样品。
图 1 显示了 A 样品的 STEM 图像。该图像清楚地显示了许多纳米粒子,这些纳米粒子在退火后形成在 GaAsBi 量子阱 (QW) 层中。纳米粒子的尺寸和 QW 层的宽度之间的明显相关性可以在图像中追踪。相关性证明,AlAs 层(最暗区域)有效地充当了阻止 Bi 原子从 GaAsBi 层向外扩散的屏障。与HAADF成像同时获得的样品选定区域的EDS元素映射表明(图2)形成的纳米晶体主要由铋原子组成。
<图片>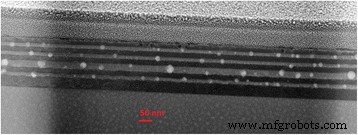
在 750°C 温度下退火 180 秒后,具有三个 10 纳米厚和一个 20 纳米厚的 GaAsBi QW 的 A 样品的 STEM 图像由 MBE 和 20 纳米厚的 MEE 生长的 AlAs 势垒生长而成
<图片>
GaAsBi/AlAs MQW 结构中 Bi 纳米晶体的 HAADF-STEM Z 对比图像(上图 )。 EDS 图像(下方 ) 表示在 STEM 图像的标记区域上测量的 Ga、Al、Bi 和 As 强度的元素映射
结果
拉曼光谱
所研究的 GaAsBi MQW 样品的拉曼光谱通过配备热电冷却 (-70°C) CCD 相机和显微镜的 Via Raman (Renishaw) 光谱仪在背向散射几何中记录。来自二极管泵浦固态激光器的 532 nm 辐射线用于光激发。 50×/0.75 NA 物镜和 1800 线/mm 光栅用于记录拉曼光谱。累积时间为 400 秒。为避免样品损坏,样品处的激光功率限制为 0.06 mW。拉曼频率使用硅标准(线在 520.7 cm -1 )。振动模式的参数通过使用 GRAMS/A1 8.0 (Thermo Scientific) 软件将实验光谱与高斯-洛伦兹形状分量拟合来确定。
生长和退火的 GaAsBi/AlAs MQW A 样品的拉曼光谱如图 3 所示。在生长样品中观察到的强烈双峰(图 3,绿色曲线)在 269 和 290 cm −1 分别对应于类 GaAs 横向光学 (TO) 和纵向光学 (LO) 声子模式 [16,17,18]。在背向散射几何中,对于理想的 GaAs 晶体,TO 带是对称禁止的 [17, 18],但是 Bi 诱导的晶体结构无序破坏了 GaAs 晶格的对称性并激活了 TO 模式。在 227 和 181 cm −1 附近可见另外两种宽的 Bi 诱导振动模式 可以归因于类似 GaBi 的振动模式 [18]。在 402 cm −1 处的锐利 LO 模式的拉曼光谱中可以识别出 AlAs 势垒的存在 [19].
<图片>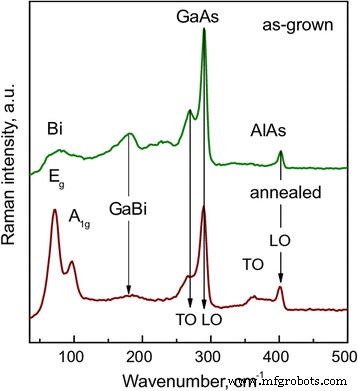
生长时的拉曼光谱(绿色曲线 ) 和退火(红色曲线 ) GaAsBi MQW A-样品
样品在 750°C 下相对较短(180 秒)的热退火会导致拉曼光谱发生本质变化:(i) 在 72 和 96 cm -1 处出现强烈的低频带 , (ii) 269、227 和 181 cm −1 附近波段的强度 减小,以及 (iii) 361 cm −1 附近的宽阔特征 出现在退火样品光谱中。 72 和 96 cm −1 处的两个低频段 对应于 E g 和 A 结晶铋的 1g 模式 [20,21,22,23,24]。这些带的出现以及在 269 和 181 cm -1 处 Bi 诱导的类 GaBi 带的强度降低 显示热退火导致铋从 GaAsBi 晶格位点退出并聚集成 Bi 纳米晶体。此外,铋纳米晶体的形成也会影响 AlAs 层的晶体结构,这从 361 cm -1 附近的宽缺陷诱导 TO 特征的上升中可以明显看出 [25].
光致发光测量
使用 500 毫米焦距单色器 (Andor SR-500i) 和液氮冷却 InGaAs 光电探测器进行温度相关光致发光 (PL) 测量。发射波长为 532 nm 的二极管泵浦固态激光器用作激发功率为 38 mW 的激发源。将样品安装在带有温度控制器的闭环氦低温恒温器的冷指上,允许在 3-300 K 的温度范围内进行测量。
图 4a 显示了在不同温度下测量的退火 A 样品的 PL 光谱,其中包含三个 10 nm 厚和一个 20 nm 厚的 GaAsBi QW。可以区分 GaAs 带隙以下的两组主要光谱特征。位于约 1.35 eV 的强高能峰可归因于 GaAsBi QW 中的辐射跃迁。峰的位置接近于在 GaAs0.979Bi0.021/GaAs 量子阱 [26] 中观察到的位置,并且与 XRD 数据相关,表明退火后 A 样品的 GaAsBi QW 层中的 Bi 含量为 2.1%。在样品热退火后,低能量侧的光谱特征出现在 PL 光谱中,0.6-1.05 eV,因此可归因于 Bi 纳米晶体中的光学跃迁。低能 PL 带具有内部结构,可在低温下显示出来。即,在 T =3 K,可以区分位于 0.67、0.88 和 0.98 eV 的 PL 分量。从图 4a 可以看出,在液氦温度下,来自 GaAsBi QW 的 PL 信号比低能 PL 带强两个数量级。然而,随着温度的升高,高能 PL 峰迅速下降,低能 PL 峰在 T 开始占主导地位。> 100 K。
<图片>
退火a的温度相关PL光谱 A-样品由三个 10 纳米宽和一个 20 纳米宽的 GaAsBi/AlAs QW 和 b 组成 B-样品由 20 个 10 纳米宽的 GaAsBi/AlAs QW 组成
B 样品的 PL 光谱显示在图 4b 中,该样品包含 20 个 10 nm 厚的 GaAsBi 量子阱,由 4 nm 厚的 AlAs 势垒隔开。在热退火之前,与 A 样品的情况一样,B 样品仅表现出更高能量、QW 相关的 PL 带。在热退火后观察到约 0.85 eV 处的强低能 PL 峰,因此,我们假设可归因于 Bi 纳米晶体的发射。 B 样本中低能量峰的强度强于 A 样本中的强度,并且随着 QW 数量的增加而放大。在低温下,可以追踪在 A 样品中得到良好分离的峰的三个组分。然而,在 B 样品中,低能量 PL 峰在研究的整个温度范围内由其 0.85 eV 分量主导。根据 XRD 数据,较高能量、QW 相关的 PL 峰的位置相对于其在 A 样品中的位置略微移动到较低能量,这表明在处理后 B 样品的量子阱层中含有 2.8% Bi其热退火。在 B 样本中,QW 相关的 PL 峰揭示了其内部结构。该峰由约 1.27 eV 处的束缚激子相关成分(在低温下占主导地位)和离域激子相关成分(位于约 1.35 eV 处且在较高温度下占主导地位)构成。 QW 相关峰的内部结构导致 PL 峰位置的特征 S 型温度依赖性(图 5 中的全点),这在先前在块状 GaAsBi [27] 和 GaAsBi/GaAs 量子阱中均观察到[26]。位于低光子能量处的 PL 峰显示出更弱的温度依赖性(图 5 中的空点和曲线),这可以通过 Varshni 函数 E 拟合 (T ) =E (0) − αT 2 /(β + T ) α 和 β 参数等于 10 −4 分别为 eV/deg 和 100 K。需要注意的是,负责能隙随温度变化的α参数值远小于大多数半导体的标准值3°10 -4 –5°10 -4 eV/度这使得Bi纳米晶基体成为发射电信波长和低温度敏感性的光源的重要潜在系统。
<图片>
由二十个 10 nm 宽 GaAsBi/AlAs QW 组成的退火 B 样品的高能和低能 PL 带光谱位置的温度依赖性
讨论
本研究中进行的 HRTEM、EDS 和拉曼光谱测量表明,在对低温 MBE 生长的 GaAsBi/AlAs MQW 样品进行热退火后,Bi 纳米晶体(量子点)在 GaAsBi 层中沉淀。人们可以假设这些纳米晶体是长波长光致发光带的原因,该带在退火样品中显示出来。尽管块体铋是半金属的,但 Bi 载流子的小有效质量导致 Bi 基纳米结构中量子限制效应的早期开始。事实上,对于薄的 Bi 层 [28] 报道了尺寸量化效应的第一个实验观察结果之一。薄铋薄膜中的半金属到半导体的转变,d <30 nm,在参考文献中通过实验观察到。 [29]。在直径小于 65 nm 的 Bi 纳米线中也发现了这种转变 [30, 31]。在这两种情况下,半导体状态都是通过对温度相关电特性的测量来确定的。铋纳米粒子中的量子尺寸效应首次通过电子能量损失光谱进行研究 [32],并且发现半金属到半导体的转变发生在直径低于 40 纳米的铋纳米粒子中。最近报道了胶体 3.3 nm Bi 纳米粒子向直接半导体状态的转变 [33]。
在纯 Bi 中,电子和空穴的主要谷位于 L 和 T 布里渊区的点并对应于椭球等能表面(表 1)。球形量子点中椭圆谷电子(空穴)的基态可近似估计为
$$ W=\frac{\pi^2{\hslash}^2}{2\overline{m}{r}_0^2}\ . $$ (1)这里r 0 是 QD 半径,\( \overline{m} \) 是平均逆有效质量,
$$ \frac{1}{\overline{m}}=\frac{1}{3}\left(\frac{1}{m_1}+\frac{1}{m_2}+\frac{1}{1}{ m_3}\right), $$ (2)米 1、米 2、m 3为椭圆谷的主要有效质量。
现象学公式 (1) 给出了无限深球形 QD 中任意有效质量比的地面能级 ε1 的近似估计。事实上,它是精确的,ε1 =W , 在球面等能面 (m 1 =m 2 =m 3), 以12%的精度预测ε1能量,ε1 ≈ 0.88 W , 和 25%, ε1 =0.75 W , 在强长椭球谷 (m 1 =m 2、米 3 → ∞) 和强扁球体 (m 1 =m 2、米 1 → ∞)。因此,在主有效质量任意值下,公式(1)近似QD地能精度优于25%。
公式 (1) 允许对铋量子点的有效能隙进行简单直接的评估,E g,eff =E g + W e + W h,其中 E g 是块状晶体中的能隙,W e 和 W h 是电子和空穴大小的量子化能量 (1)。计算出的有效T 和 L 能隙以图形方式显示在图 6 中。(T 处的电子和空穴质量 和 L 假设点数相等。)
<图片>
随着 Bi QD 能谱尺寸的减小 (r 0 和 d 是QD半径和直径)
在块状半金属铋中,L 的导带最小值 谷值比 T 低 38 meV 价带最大值。当 Bi 颗粒尺寸减小时,L 处的有效能带隙 点的增加速度比 T 处的要快 由于 L 的有效质量较小 -谷,什么最终导致半金属到半导体的转变(i - 图 6 中的交叉点)。首先,铋纳米晶体成为在 L 处具有最低导带最小值的间接半导体 点和 T 处的最高价带最大值 观点。随着 QD 尺寸的进一步减小,价带和导带边缘都将出现在 T 使 Bi QD 成为直接带隙半导体(d - 图 6 中的交叉点。
应该注意的是,图 6 仅呈现了能谱的粗略方案,因为该方案忽略了非抛物线效应并假设了 QD 的无限能垒。 L 必须偏离抛物线色散定律 -valley(参见例如,[34])。实际上,L 处的有效质量 -valley center 大约比它们在费米能量下的值小五倍(用于计算图 6 中显示的能谱)。另一方面,非抛物线效应在 T 处较弱 点,其中能带隙较大,因此,呈现的有效 T 可以将能隙(图 6)视为其相关估计。
上面,我们假设~0.85 eV 的低能量 PL 峰是由于在直径约为 10 nm 的 Bi 纳米晶体中发生的光学跃迁。 d 的计算 =10 nm QD 预测 E g,eff =0.76 eV 的有效能隙,这与实验相吻合,因此支持低能PL峰起源的假设。
结论
总之,通过混合 MBE/MEE 工艺在 GaAs 衬底上生长了多个 GaAsBi/AlAs 层状量子阱结构。在 750°C 下对结构进行生长后热退火后,大量分散相对较低的纳米粒子在 GaAsBi 量子阱内成核。 HRTEM、EDS 和拉曼光谱测量表明纳米晶体主要由铋组成。进行的光致发光测量揭示了退火样品中出现的额外低能量 ≈0.85 eV PL 峰。低能量 PL 峰可能是由于 Bi 纳米晶体中的光学跃迁,通过量子尺寸效应转变为直接带隙半导体状态。对 Bi 量子点能谱进行的估计支持该假设。需要进一步详细的实验和理论工作才能得到明确的答案。
缩写
- EDS:
-
能量色散光谱
- HAADF:
-
高角度环形暗场
- HRTEM:
-
高分辨透射电子显微镜
- MBE:
-
分子束外延
- MEE:
-
迁移增强外延
- PL:
-
光致发光
- QD:
-
量子点
- QW:
-
量子阱
- RTA:
-
快速热退火
- STEM:
-
扫描透射电子显微镜
- TO 和 LO:
-
分别为横向光学和纵向光学声子模式
纳米材料
- N,N-二甲基甲酰胺调节 MXene 量子点的荧光,用于灵敏测定 Fe3+
- 合成富含吡啶的 N、S 共掺杂碳量子点作为有效的酶模拟物
- InP/ZnS 核/壳量子点的绿色合成在无重金属发光二极管中的应用
- 从豆腐废水中合成荧光碳量子点的简单方法
- 水溶性硫化锑量子点的合成及其光电特性
- 石墨烯/Ag3PO4 量子点复合材料的简便一步声化学合成和光催化性能
- 消除 InAs/GaAs 量子点中的双峰尺寸,用于制备 1.3-μm 量子点激光器
- 掺杂铕的核-壳 ZnSe/ZnSe 量子点中粒子间能量转移的壳厚度依赖性
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- 水溶性蓝色发光锰合金碲化碲化镉量子点的合成和性质
- 在硅衬底上设计用于中红外直接带隙发射的应变工程 GeSn/GeSiSn 量子点
- 通过生长掺杂方法实现双发射和颜色可调的 Mn 掺杂 InP/ZnS 量子点


