使用二氧化碳的低温等离子体增强原子层沉积 SiO2
摘要
在这项工作中,我们报告了使用与湿气/氧敏感材料兼容的氧化剂通过低温等离子体增强原子层沉积成功生长高质量 SiO2 薄膜。使用 CO2 和双(叔丁基氨基)硅烷作为工艺前体,在 90 °C 下生长 SiO2 薄膜。研究了 SiO2 薄膜的生长、化学成分、密度、光学特性和残余应力。 SiO2 薄膜的每周期饱和生长为 ~ 1.15 Å/周期,其密度为 ~ 2.1 g/cm 3 ,在波长为 632 nm 时的折射率为 ~ 1.46,以及 ~ 30 MPa 的低拉伸残余应力。此外,薄膜显示出低杂质水平,体积浓度为~ 2.4 和~ 0.17 at。 % 分别用于氢和氮,而发现碳含量低于飞行时间弹性反冲检测分析的测量极限。这些结果表明,CO2 是一种很有前景的氧化前驱体,可用于与等离子体增强原子层沉积工艺相关的湿气/氧敏感材料。
背景
SiO2 是一种广泛用于微电子 [1, 2]、微机电系统 [3, 4]、光伏 [5, 6] 和光学 [7, 8] 等应用的材料。虽然 SiO2 薄膜可以通过多种方法生长,例如热氧化、等离子体增强化学气相沉积 (PECVD) 或物理气相沉积 (PVD),但原子层沉积 (ALD) 提供了结合精确薄膜厚度控制的特殊优势,高均匀性和保形性[9,10,11]。
许多 ALD 工艺采用各种 Si 前体(氯硅烷或氨基硅烷)和氧化剂(H2O、H2O2 或 O3),用于 SiO2 的生长。这些过程通常需要相对较高的温度(> 150 °C)[12,13,14,15,16]。对于与有机、生物和聚合物材料等热敏材料兼容的工艺,催化 ALD [17,18,19] 和等离子体增强原子层沉积 (PEALD) [9, 20,21,22] 已被用作工艺温度低于 100 °C 的有效解决方案。然而,在湿气/氧敏感材料的情况下,常用的基于 H2O 和 O2 的氧化剂会导致材料降解。与 H2O 和 O2 相比,在低温下,CO2 不具有化学反应性。在这种情况下,使用 CO2 作为氧化剂可以避免不必要的氧化,从而最大限度地减少湿气/氧气敏感材料的降解。此外,King [23] 报告说,当使用 SiH4 作为 Si 前体时,CO2 是一种可行的氧化剂,可用于 PEALD SiO2 薄膜的生长。然而,这些PEALD工艺的生长温度在250-400 °C范围内,与高温敏感材料不兼容。
在这项工作中,我们报告了在 90 °C 下用于 SiO2 薄膜的基于 CO2 的 PEALD 工艺的开发。研究了薄膜生长对工艺参数(前驱脉冲/吹扫时间和等离子体功率)的依赖性。我们还报告了薄膜的化学成分、结构和光学性能以及残余应力分析。
方法
影片准备
使用 CO2(99.5%,Air Products)等离子体作为氧源和双(叔丁基氨基)硅烷(BTBAS)(97%,Strem Chemicals)作为 Si,在 90 °C 下在 Si(100)和蓝宝石衬底上生长 PEALD SiO2 薄膜前体[22]。这些过程是在 Beneq TFS 200 反应器中进行的,该反应器带有远程等离子体系统,使用电容耦合的 13.56 MHz 射频 (rf) 操作源。 N2 (99.999%, AGA) 用作载气和吹扫气体,通过反应器流量为 600 sccm,而 N2 (200 sccm) 和 CO2 (75 sccm) 的混合气体流过等离子系统。本研究中选择的等离子体功率基于等离子体系统的稳定性。 BTBAS 的源温度设置为 21 °C,并在前体脉冲期间应用 N2 增压器。工艺参数详见表1。PEALD工艺过程中,反应器压力约为1 hPa。
电影特征
PEALD SiO2 薄膜的厚度用 SENTECH SE400adv 椭偏仪测定,使用 HeNe 激光器,波长为 632.8 nm,入射角为 70°。使用获得的膜厚度除以 ALD 循环次数计算每循环的生长 (GPC)。 GPC的偏差是基于膜厚的不均匀性。
通过辉光放电光学发射光谱 (GDOES)、飞行时间弹性反冲检测分析 (TOF-ERDA) 和衰减全反射傅里叶变换红外光谱 (ATR-FTIR) 测量化学成分。 GDOES 测量是在 Horiba GD-Profiler 2 上进行的。使用了 4 毫米直径的阳极和 35 W 的脉冲模式射频功率。元素强度报告为在整个膜厚度上积分的值,如参考文献 1 中所述。 [22]。对于 TOF-ERDA 测量,从 5MV 串联加速器获得的 40 MeV 能量 Br 离子被引导到测量样品上。检测角度为40°。 ATR-FTIR 测量是使用 Thermo Electron Corporation Nicolet 380 ATR-FTIR 光谱仪以金刚石晶体作为内反射元件进行的。该程序包括从 Si 衬底收集背景和从样品收集数据。一个 2 厘米 −1 分辨率超过 800–4000 cm −1 使用波数范围。
X 射线反射率 (XRR) 分析是使用 Philips X’Pert Pro 衍射仪使用 Cu-Kα1 辐射进行的。薄膜密度是通过使用内部开发的拟合软件从测量数据中获得的 [24]。硅衬底和 PEALD SiO2 膜之间的界面氧化物层被模拟为 XRR 拟合层模型的一部分。使用 PerkinElmer Lambda 900 光谱仪,在蓝宝石衬底上生长后,在 360–800 nm 波长范围内记录 PEALD SiO2 薄膜的透射光谱。折射率 (n ) 和消光系数 (k ) 由透射光谱的柯西拟合确定。为确保良好的拟合精度,本次测量在蓝宝石衬底上生长了 150 nm 厚的 SiO2 薄膜。
50 nm 厚的 PEALD SiO2 薄膜的残余应力是用晶片曲率法 [25] 和 Stoney 方程 [26] 确定的。使用 TOHO FLX-2320-S 工具测量薄膜生长前后的晶片曲率。使用 120 毫米扫描长度对晶片进行双轴扫描。测量结果以最大测量不确定度表示[25]。
结果与讨论
电影成长
在氧化步骤中研究了 SiO2 薄膜 GPC 对 BTBAS 脉冲和吹扫时间的依赖性,固定等离子体功率为 180 W,CO2 等离子体暴露时间为 3 s,CO2 等离子体吹扫时间为 2 s。图 1a 和 b 分别显示了 GPC 值作为 BTBAS 脉冲和吹扫时间的函数。对于脉冲时间依赖性,BTBAS 吹扫时间设置为 3 s,而对于吹扫时间依赖性,BTBAS 脉冲时间设置为 0.3 s。如图 1a 所示,最低 GPC 是通过 0.05 s 的 BTBAS 脉冲获得的,而发现 0.1 s 的脉冲时间足以达到自限性生长,GPC 为 ~ 1.15 Å/周期。此外,当使用 0.3 s 的固定 BTBAS 脉冲和从 3 到 0.5 s 减少的吹扫时间(图 1b)时,没有观察到 GPC 的变化。这表明 BTBAS 的短吹扫时间足以防止 CVD 成分。但请注意,随着清洗时间的增加,薄膜厚度的均匀性得到改善。
<图片>
在硅衬底上生长的 PEALD SiO2 薄膜的 GPC 作为 BTBAS a 的函数 脉冲时间和b 清洗时间。施加的等离子体功率为180 W
分别使用固定的 BTBAS 脉冲和 0.3 和 3 s 的吹扫时间研究氧化步骤中 SiO2 的生长。图 2a 和 b 分别显示了在硅晶片上生长的 PEALD SiO2 薄膜的 GPC 作为 CO2 等离子体暴露和吹扫时间的函数。在研究等离子体暴露时间效应期间,应用了 50、180 和 300 W 的等离子体功率。作为一般观察,在所有等离子体功率条件下都观察到最高 GPC 值 1.15 Å/循环,这可以被认为是 90 °C 时的饱和 GPC [27]。对于等离子体暴露时间为 1 s 的工艺,与使用的功率无关,GPC 值低于 1.15 Å/周期暗示薄膜生长不完全。这表明 1 s 的等离子体暴露时间不足以产生足够数量的 O 自由基。这些自由基是完全表面反应所必需的,是由 CO2 等离子体解离反应产生的 [28]。对于 50 W 的等离子体功率,发现 GPC 随着 CO2 等离子体暴露时间的增加而增加,直到 6 s,之后 GPC 达到饱和值 1.15 Å/循环。该值在长达 15 s 的曝光时间内保持不变。然而,对于以更高功率(180 和 300 W)生长的薄膜,当等离子体暴露时间在 1 到 6 s 之间时,观察到 GPC 的反向 V 趋势。根据我们之前报道的 PEALD 薄膜的生长阶段 [27] 和在这项工作中获得的最高 GPC 1.15 Å/周期,在 180 和 300 W 下实现了生长饱和,等离子体暴露时间为 3 s。对于 6 s 的等离子体暴露时间,GPC 降低可能是薄膜致密化的结果,类似于我们之前报道的 Al2O3 薄膜的 PEALD [27]。请注意,这两条曲线(描绘 GPC 对 180 和 300 W 的 CO2 等离子体暴露时间的依赖性)完全重叠。观察到的 GPC 曲线重叠表明 180 和 300 W 的 SiO2 薄膜的生长涉及相同的机制,可能与高功率等离子体产生的相当数量的离子和自由基通量有关 [29]。与高功率的情况相比,使用 50 W 等离子体功率的 SiO2 薄膜的生长行为是不同的,因为没有发生薄膜致密化。这很可能是由于 50 W 的低功率导致的离子和自由基通量相对较低 [29]。
<图片>
在 Si 衬底上生长的 PEALD SiO2 薄膜的 GPC 作为 CO2 等离子体的函数 a 不同等离子功率为 50、180 和 300 W 和 b 的曝光时间 等离子功率为 180 W 时的吹扫时间
CO2 等离子体吹扫时间对 GPC 的影响如图 2b 所示。与 BTBAS 吹扫时间相关的情况一样,当 CO2 吹扫时间在 0.5 到 3 s 之间变化时,GPC 值保持不变。因此,可以得出结论,两种前体的应用吹扫时间对我们的 SiO2 薄膜的 GPC 的影响可以忽略不计。这与早先报道的使用 SAM.24、BTBAS 的一类氨基硅烷和 O2 等离子体的 PEALD 工艺不同 [9],其中发现清洗时间短于 2 s 的清洗步骤对薄膜生长有显着影响。在这里,我们应用的前体吹扫时间和 GPC 之间的独立性可以归因于有效去除残留的前体和副产物,这可以部分受益于使用交叉流的反应室设计。这种配置使得前驱脉冲之间的气体交换时间相对较短。尽管如此,不能排除前体的粘性。基于图 2a 所示的结果,通过使用 0.3 s/3 s 的 BTBAS 脉冲/吹扫时间和 3 s/2 s 的 CO2 等离子体暴露/吹扫时间,饱和生长期间的最高沉积速度为 50 nm/h .这意味着通过应用高等离子体功率并使用 0.1 s/0.5 s 的 BTBAS 脉冲/吹扫时间和 3 s/0.5 s 的 CO2 等离子体暴露/吹扫时间,可实现高达 100 nm/h 的沉积速度。
影片属性
通过 XRR 研究了 SiO2 薄膜的密度,结果如图 3 所示。测量的样品使用不同的等离子体暴露时间在 Si 衬底上生长,等离子体功率为 180 W,BTBAS 脉冲时间为 0.3 s, BTBAS 净化时间为 3 s,CO2 等离子体净化时间为 2 s。所研究的样品分别标记为“SiO1”、“SiO3”和“SiO6”,等离子体暴露时间分别为 1、3 和 6 s。尽管这些值在测量误差范围内,但最低和最高平均值分别显示在“SiO1”和“SiO6”中,表明薄膜密度随着等离子体暴露时间的增加而略有增加。这支持了我们在等离子体功率为 180 W 和曝光时间为 6 s 的过程中薄膜致密化的假设。在饱和生长的情况下,虽然我们的薄膜密度为 2.11 g/cm 3 与使用商业 ALD 反应器的 O2 基 PEALD SiO2 薄膜的早期研究报告的值非常一致,生长温度范围在 50 和 300 °C 之间 [9, 21, 30],它低于该值 (2.3 g/厘米 3 ) 由 King 报道,他在改进的 PECVD 反应器中在 400 °C 下演示了 PEALD SiO2 工艺 [23]。
<图片>
等离子暴露时间为1、3、6 s时生长的SiO2薄膜的密度
PEALD SiO2 的化学成分由 GDOES 测量。由于测量没有针对成分深度分析进行校准,即没有考虑元素相关的发射率,因此只能比较不同样品之间相同元素的强度,而无法比较不同元素之间。因此,在这种情况下,GDOES 测量提供了关于化学成分的相当定性的信息。检测到的元素Si、O、H、N和C如图4所示。如图所示,虽然“SiO1”中H的强度略低于其他样品,但考虑到误差边缘,没有观察到等离子体暴露时间对 Si、O 和 H 含量的显着影响。这一发现类似于我们之前关于使用 BTBAS 和 O2 等离子体生长的 PEALD SiO2 的工作中报道的等离子体功率效应 [22]。在 N 含量的情况下,“SiO1”和“SiO3”的强度相当恒定,而“SiO6”的强度较低。这表明在膜致密化过程中去除 N 杂质更有效。请注意,与样品生长条件无关,所有测量样品的 C 含量强度均相同。
<图片>
通过 GDOES 测量的等离子暴露时间为 1、3 和 6 s 时生长的 SiO2 薄膜的定性化学成分。测量精度为± 15%,本工作无法进行强度的跨元素比较(无校准因子)
使用 TOF-ERDA 和 ATR-FTIR 测量对薄膜化学成分进行了进一步评估。考虑到饱和生长通常是 ALD 工艺的目标,在下文中,我们将研究重点放在等离子体功率为 180 W、BTBAS 脉冲时间为 0.3 s、BTBAS 吹扫时间为 3 s、CO2等离子体暴露时间为 3 s,CO2 等离子体吹扫时间为 2 s。 TOF-ERDA 深度剖面和元素组成如图 5a 所示。请注意,薄膜深度剖面中显示的 O 的下降斜率是由 Si 衬底的影响引起的,这与我们的 SiO2/Si 样品结构的 TOF-ERDA 的深度分辨率相关。在元素组成分析过程中,已经考虑了底物效应。研究的样品表现出低杂质水平,总浓度为~ 2.4 和~ 0.17 at。 % 分别用于氢和氮,而发现整个薄膜中的总 C 浓度低于 TOF-ERDA 的测量极限。根据深度剖面的信息,碳数主要是从薄膜表面收集的。因此,我们推测 GDOES 测量检测到的 C 含量并显示在图 4 中,可能是由于储存期间或测试环境中的样品污染造成的。值得注意的是,还发现表面的 H 浓度高于本体。此外,发现这些薄膜具有轻微的富氧成分,Si/O 比为~ 0.48。这一结果与 Dingemans 等人报道的结果一致。对于使用 SAM.24 和 O2 等离子体在 100 到 300 °C 之间的温度范围内生长的 PEALD SiO2 [9]。这种富含氧的成分很可能是由于残留在薄膜中的-OH物质的贡献所致。
<图片>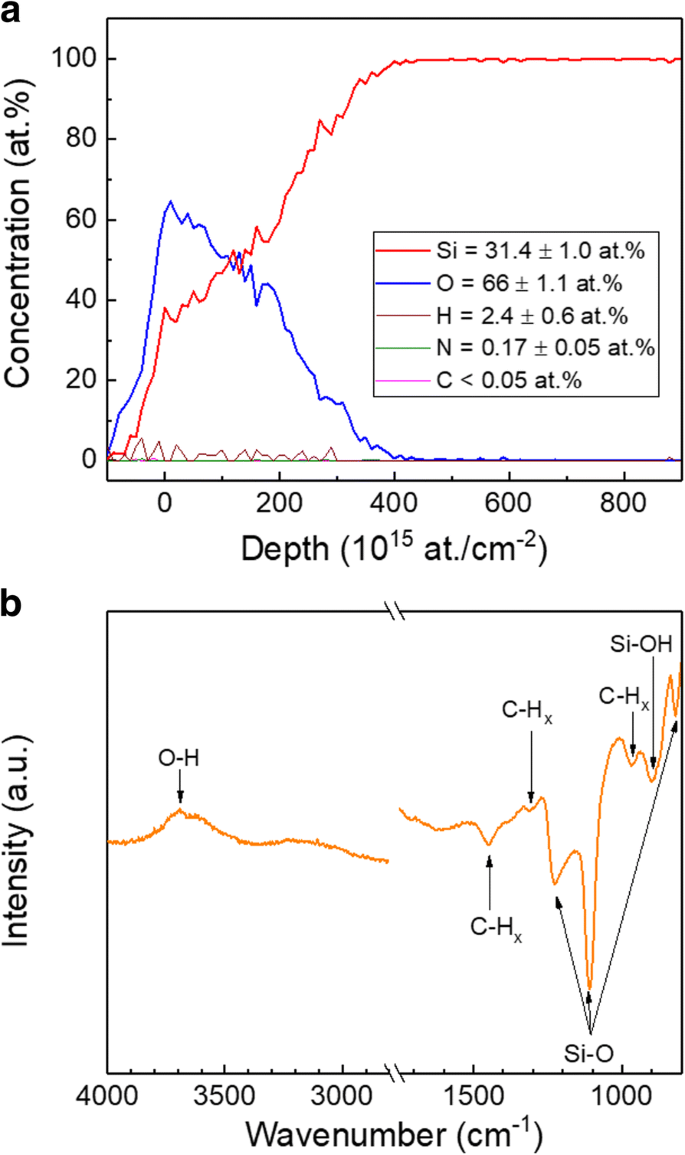
一 TOF-ERDA 深度剖面和 b SiO2 薄膜的 ATR-FTIR 透射光谱。目标膜厚为50 nm
图 5b 显示了在同一样品上测得的 ATR-FTIR 光谱。宽带特征,位于 3200–3800 cm −1 区域,可以分配到 Si-OH 和水的 O-H 段,但前者不太可能 [14, 31]。另一个带,也是典型的 Si-OH 拉伸 [31],在 ~ 900 cm -1 处可见 .与上述 TOF-ERDA 结果一致的 -OH 基团的存在意味着类似燃烧的反应,包括 -NH 的燃烧 t 卜 配体和 –OH 基团的形成,在氧化步骤中占主导地位。之前曾报道过类似的机制发生在三甲基铝和 O2 等离子体 [32] 中的 Al2O3 以及 SAM.24 和 O2 等离子体 [9] 中的 SiO2 生长过程中。除了 -OH 基团外,在 1108 和 1226 cm -1 附近检测到 Si-O-Si 键拉伸 [14, 33] 而在大约 820 cm -1 处看到键弯曲 [34, 35]。请注意,与文献值 [14, 34, 35] 相比,这项工作中的 Si-O-Si 拉伸频率相对较高。这可能是由于 Si-O 键长的变化会受到薄膜残余应力的影响。 Jutarosaga 等。据报道,压应力越高,Si-O-Si 拉伸频率越低 [36]。 ~ 970、1301 和 1450 cm −1 处的带 分别分配给 CH3 摇摆、CH3 对称变形和 CH2 剪刀 [14]。 C-H表面基团的发现与TOF-ERDA的结果一致,很可能是表面污染所致。
从图 5 中的数据和之前文献 [37] 中报道的结果来看,我们在第一个 ALD 半周期中的工艺表面反应可以考虑如下:
$$ \mathrm{Si}-{\mathrm{OH}}^{\ast }+{\mathrm{H}}_2\mathrm{Si}{\left[{NH}^t Bu\right]}_2\到 \mathrm{Si}-\mathrm{O}-{\mathrm{SiH}}_2{{\left[{NH}^t Bu\right]}_{2-x}}^{\ast }+{ xH}_2{N}^t Bu $$ (1)其中表面物种用星号 (*) 表示。在第一个半反应中,只有一个 (x =1) 或两者 (x =2) -NH t 卜 配体可以与表面 -OH 基团反应形成 t -丁胺分子。
O 自由基是 CO2 等离子体解离反应过程中产生的主要活性物质 [28],因此在氧化反应中占主导地位。因此,在后半周期,建议的类燃烧反应[9]为:
$$ {\mathrm{SiH}}_2{{\left[{NH}^t Bu\right]}_{2-x}}^{\ast }+\mathrm{O}\to \mathrm{Si} -{\mathrm{OH}}^{\ast }+{\mathrm{H}}_2\mathrm{O}+{\mathrm{CO}}_2+\mathrm{N}-\mathrm{包含}\ \mathrm {物种} $$ (2)由于实际反应产物的不确定性,建议的表面反应故意不平衡。为了能够完全确定这种反应,需要在薄膜生长过程中进行原位分析,例如副产物气体分析。
通过光谱法研究了在蓝宝石衬底上生长的 SiO2 薄膜的光学特性。图 6a 显示了作为波长函数的测量透射率以及曲线的柯西拟合。从透射光谱模拟的折射率色散如图 6b 所示。由拟合可知,在波长 632 nm 处,折射率为 1.456,零 k 获得了价值。该折射率值与先前报道的低温 PEALD SiO2 [9, 21] 的值非常一致,并且与高温工艺 [23] 的报道值相比相对较低。事实上,已知生长温度会影响生长薄膜中的 -OH 浓度,从而影响它们的折射率 [38]。另外,得到的零k 值与薄膜中的低碳含量一致。 k 之间的相似相关性 值和 C 浓度先前由 Putkonen 等人报道。 ALD法生长的SiO2薄膜[21]。
<图片>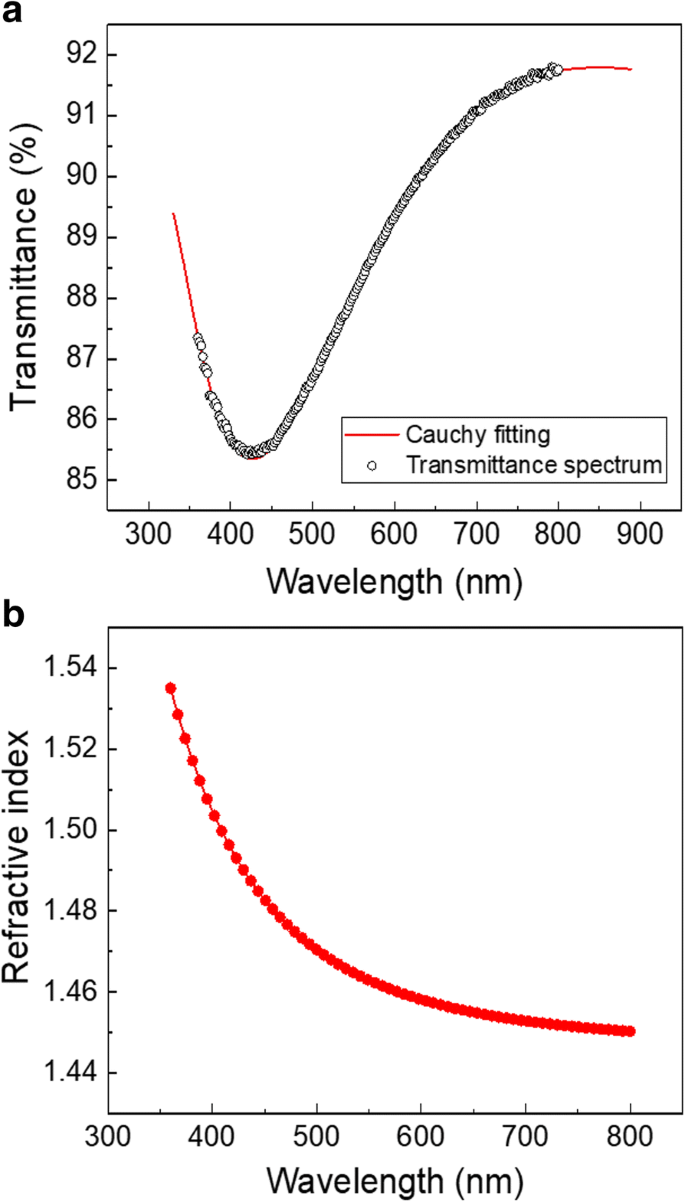
一 透射光谱和柯西拟合和b 在等离子功率为 180 W、BTBAS 脉冲时间为 0.3 s、BTBAS 吹扫时间为 3 s、CO2 等离子体暴露时间为 3 s 和 CO2 等离子体吹扫的情况下,在蓝宝石衬底上生长的 SiO2 薄膜的折射率色散时间为 2 s。目标膜厚为150 nm
ALD 薄膜的残余应力包括热应力和内应力的贡献。热应力是由薄膜和基材之间的热膨胀差异引起的。内应力定义为薄膜生长过程中产生的内应力,取决于前驱体、生长温度和 ALD 方法 [30, 39]。图 7 显示了作为生长温度函数的 SiO2 薄膜的残余应力。最高应力值 150 MPa(压缩)[23],是从在 400 °C 下生长的样品中获得的;然而,在这项工作中,在 90 °C 下获得了 30 ± 10 MPa 的低拉伸应力。普特科宁等人。和 Shestaeva 等人。显示出 SiO2 薄膜应力对生长温度的明显依赖性 [21, 30]:较高的温度导致较高的压缩应力。温度越高,热应力的贡献越大。他们还报告了低温 PEALD SiO2 薄膜的残余应力值接近“零”[21, 30]。考虑到此处和文献中报告的残余应力值,接近“零”的应力很可能是内应力而不是热应力的结果。 PEALD SiO2 薄膜的内应力可能是由等离子体效应引起的。然而,不能排除其他因素,如气体流量、工艺压力或使用的前驱体[40]。
<图片>
SiO2 薄膜的残余应力随生长温度的变化。我们的样品在等离子体功率为 180 W、BTBAS 脉冲时间为 0.3 s、BTBAS 净化时间为 3 s、CO2 等离子体暴露时间为 3 s 和 CO2 等离子体净化时间为 2 s 的条件下生长。参考文献包括 Putkonen 等人。 [21],Shestaeva 等人。 [30] 和国王 [23]。我们样品的目标薄膜厚度为50 nm
结论
这项工作证明了 CO2 作为氧化剂在湿气/氧敏感材料上生长低温 PEALD SiO2 的潜力。使用 CO2 和 BTBAS 作为前驱体,通过 PEALD 在 90 °C 下生长具有低杂质水平和低拉伸残余应力的 SiO2 薄膜。薄膜显示出~ 1.15 Å/循环的饱和GPC以及~ 2.1 g/cm 3 的密度 .该研究还表明,在约 4 s 的极短 ALD 循环时间内达到薄膜饱和生长的可能性,这对于高产量和工业应用来说是非常理想的。
缩写
- ALD:
-
原子层沉积
- ATR-FTIR:
-
衰减全反射傅里叶变换红外光谱
- BTBAS:
-
双(叔丁基氨基)硅烷
- GDOES:
-
辉光放电发射光谱
- GPC:
-
每周期增长
- PEALD:
-
等离子体增强原子层沉积
- PECVD:
-
等离子体增强化学气相沉积
- PVD:
-
物理气相沉积
- rf:
-
射频
- TOF-ERDA:
-
飞行时间弹性后坐力检测分析
- XRR:
-
X射线反射率
纳米材料
- 在原子尺度上成像的海洋碳
- 用于 Micro-LED 和 VCSEL 的高级原子层沉积技术
- 揭示叠杯碳纳米纤维的原子和电子结构
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 通过原子层沉积和水热生长制备的抗菌聚酰胺 6-ZnO 分层纳米纤维
- 通过等离子体增强原子层沉积制备的 Co3O4 涂层 TiO2 粉末的光催化性能
- 在 p-GaN 上两步沉积 Al 掺杂的 ZnO 以形成欧姆接触
- 通过超循环原子层沉积调节 ZnO 薄膜的费米能级
- 使用纳米尺寸的苯二胺薄膜提高电流传感器的选择性
- 固态二氧化碳传感器
- 使用显微镜测量层厚


