HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
摘要
HfO2/TiO2/HfO2 三层结构电阻式随机存取存储器 (RRAM) 器件已通过原子层沉积 (ALD) 在具有 Pt 顶部电极的 Pt 和 TiN 涂层硅衬底上制造。已经研究了 Pt 和 TiN 底部电极对三层结构单元电阻开关特性的影响。 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 都表现出典型的双极电阻开关行为。两个存储单元在低电阻和高电阻状态(LRS 和 HRS)下的主要导电机制分别是欧姆行为和空间电荷限制电流。发现Pt和TiN的底电极对三层结构存储单元的电铸极性偏好、高低电阻比和工作电压的分散性有很大影响。与使用对称 Pt 顶部/底部电极相比,使用非对称 Pt 顶部/TiN 底部电极的 RRAM 单元显示出更小的负形成电压 -3.7 V,设置/复位电压的分布相对较窄,高低电阻比较低,为 10 2 .电极相关的电铸极性可以通过考虑电极与氧的化学活性、阳极的相关反应以及 HfO2/TiO2/HfO2 三层结构中氧空位浓度在 Pt 和 TiN 涂层硅上的不均匀分布来解释.此外,对于Pt/HfO2/TiO2/HfO2/TiN器件,TiN电极作为储氧器在降低形成电压和提高阻变参数均匀性方面起着重要作用。
背景
电阻式随机存取存储器 (RRAM) 因其在下一代非易失性存储器中替代闪存的潜力而备受关注 [1,2,3]。在过渡金属氧化物、固体电解质和有机聚合物中广泛发现了电阻开关 (RS) 现象 [4,5,6,7]。基于过渡金属氧化物的 RRAM 器件因其简单的组成和与传统互补金属氧化物半导体 (CMOS) 制造的兼容工艺而得到广泛探索 [8,9,10]。氧空位迁移的细丝模型用于阐明转换行为 [1, 11]。提出了一种统一的微观原理来量化基于过渡金属氧化物的 RRAM 的单极和双极开关特性,这些特性与氧化物开关层中局部氧空位的分布有关 [12, 13]。
然而,使用过渡金属氧化物的存储单元存在阻变参数的不均匀性,例如低阻态和高阻态(LRS 和 HRS)的不稳定电阻值、分散的设置和复位电压,阻碍了商业应用。最近,三层结构的基于氧化物的 RRAM 器件已被证明可以改善电阻开关参数的分散。具有 Al2O3/HfO2/Al2O3 结构的电池表现出极好的设置和复位电压均匀性,以及在 LRS 和 HRS 之间切换的出色耐久性[14]。在 Al2O3/IL/HfO2/IL/Al2O3 之间的两个界面层中更容易发生导电丝的连接或断裂。同时,TaOx/TiO2/TaOx的三层结构单元在一个选择器一电阻阵列中表现出良好的性能,这归因于TiO2薄膜的能带在顶部和底部TaO
此外,给定氧化物存储介质的 RS 行为会受到电极材料的显着影响 [1, 16, 17]。然而,基于界面氧化物形成的自由能和金属功函数的现有模型不足以完全解释结果。同时,目前对三层结构RRAM的电极依赖RS现象的研究也比较缺乏。
原子层沉积(ALD)是一种基于序贯自限互补表面化学吸附反应的新型薄膜沉积技术,采用前驱体蒸汽,具有简单精确的厚度控制、大面积均匀性和优异的三维保形性,特别适用于沉积纳米层压结构[18, 19].
在这项工作中,HfO2/TiO2/HfO2 三层结构的 RRAM 器件已通过 ALD 在带有 Pt 顶部电极的 Si/SiO2/Ti/Pt 和 Si/TiN 衬底上制备。已经仔细研究了 Pt 和 TiN 底部电极对 HfO2/TiO2/HfO2 器件的 RS 行为的影响。已提出相关解释。
方法
在这个实验中,我们使用了两种不同的底部电极,包括商业 Si/SiO2/Ti/Pt 和自制的 Si/SiO2/TiN。本实验室采用等离子增强原子层沉积(PEALD)沉积导电TiN。
ALD 在商用 Picosun SUNALE TM 中进行 R-200 先进反应堆(Picosun,芬兰)。 P 电阻率为 1~10 Ω cm 的 Si (100) 型晶片用作起始衬底。在不去除原生氧化物的情况下对 Si 晶片进行常规 RCA 清洁后,使用室温 TiCl4 和 NH3 等离子气体作为 Ti 和 N 前体,在 400°C 下通过 PEALD 在 Si 上沉积 30 nm 厚的 TiN 作为底部电极,分别。在室温下选择液态 NH3 作为 NH3 等离子体源。等离子体功率和 NH3 气体流速分别为 2500 W 和 150 sccm。
随后,使用 Hf[N(C2H5)CH3]4 (TEMAH)、TiCl4 通过热 ALD 在 250°C 下依次沉积 5 nm HfO2/10 nm TiO2/5 nm HfO2 堆叠结构在 Pt 和 TiN 涂层的 Si 衬底上和 H2O 分别作为 Hf、Ti 和 O 前体,其中一个氧化物循环由 0.1s 组成 金属源注入,4s N2 吹扫,0.1s H2O 注入,和 4s N2 吹扫。在 150°C 蒸发 TEMAH。纯 N2 (99.999%) 用作载气和吹扫气。然后,使用 Q150T 系统通过直径为 150 μm 的荫罩直流溅射 100 nm 厚的 Pt 顶部电极。
通过光谱椭偏仪(GES-5,Sopra)测定Si上纯HfO2或TiO2的每个循环的生长(GPC)。通过原子力显微镜(AFM,Cypher,Asylum Research)分析薄膜和底部电极的形貌和表面粗糙度。从 1 μm × 1 μm 区域记录均方根 (RMS) 粗糙度值。堆叠结构的组成和化学状态通过 X 射线光电子能谱(XPS,Thermo Fisher K-Alpha)和单色 Al Kα 源(hν =1486.6 eV)用于激发光电子。通过设置 C 1s 校准电荷效应 光发射为 284.6 eV。 HfO2/TiO2/HfO2 在 Pt 和 TiN 涂层硅上的 XPS 深度分布是通过 Ar 离子蚀刻获得的。 HfO2/TiO2/HfO2 三层结构 RRAM 器件的电气特性由 Keithely 4200 半导体表征系统在探针台 (CasCade Summit 12000 B-M) 上测量。施加 10 mA 的电流顺应性以保护制造的设备单元在设置过程中免受大电流的损坏。偏置电压施加在Pt顶部电极上,Pt或TiN底部电极接地。
结果与讨论
图 1 显示了 ALD 的 HfO2/TiO2/HfO2 三层结构 RRAM 器件的示意图。底部电极的表面形貌和粗糙度以及 HfO2/TiO2/HfO2 在 Pt 和 TiN 涂层上的三层结构思已考。 Pt 底部电极具有 0.39 nm 的 RMS 值比 0.87 nm 的 PEALD 衍生的 TiN 更小。因此,HfO2/TiO2/HfO2 样品在 Pt 涂层的 Si 上也表现出相对光滑的表面,RMS 为 0.68 nm,比在 TiN 涂层的 Si 上的 RMS 为 1.3 nm。
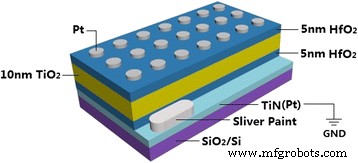
ALD制备HfO2/TiO2/HfO2三层结构RRAM器件示意图
包含初始电铸过程的 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 器件的 DC I-V 曲线分别绘制在图 2a、b 中,表明典型的双极电阻开关特性。对于几乎所有的样品,在切换测试之前需要更大的形成电压来形成导电细丝。当在 Pt 顶部电极上施加正偏压时,Pt/HfO2/TiO2/HfO2/Pt 器件单元在图 2a 中显示 +7 V 的形成电压。随着电压扫描的继续,从 LRS 到 HRS 的单位单元测量到 -0.8 V 的复位电压和从 HRS 到 LRS 的 2.0 V 设置电压。高低电阻对应的比例约为10 5 .电铸和休息过程也可以通过分别施加 -11 V 的负电压和 +4 V 的正电压来完成,这远大于正成型和负复位电压。此外,器件单元仅在负形成过程后从 LRS 切换到 HRS 几个周期,然后由于不可逆击穿(此处未显示)而无法重置为 HRS。在图 2b 中,与对称的 Pt 顶电极和底电极相比,具有非对称 TiN 底电极和 Pt 顶电极的三层结构 RRAM 器件显示出相反的较低形成电压约为 -3.7 V,设定电压为 -1.5 V ,+1.5V 的复位电压,相对较小的高低阻比为 10 2 .当施加正电铸电压时,在 Pt/HfO2/TiO2/HfO2/TiN 电池中无法观察到 RS 现象,并且器件在 +14 V 时永久击穿,而没有在负电压下从 LRS 到 HRS 的有效复位(不此处显示)。
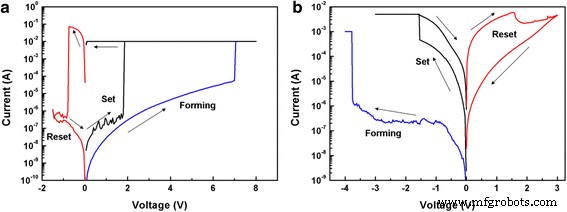
RRAM 器件的典型双极电阻开关特性。 一 Pt/HfO2/TiO2/HfO2/Pt。 b Pt/HfO2/TiO2/HfO2/TiN
具有对称 Pt 顶部/底部电极和不对称 TiN 底部电极/Pt 顶部电极的三层结构 RRAM 器件表现出这种不同的电铸极性偏好。化学惰性 Pt 或相对活跃的 TiN 底部电极似乎起着关键作用。考虑到 Pt 和 TiN 涂层硅上 HfO2/TiO2/HfO2 三层结构的 XPS 深度分布,稍后将讨论电极依赖电铸极性的相关原因。
对于高密度存储器应用,RS 参数的一致性非常重要。图 3a、b 分别绘制了 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 的单个器件单元在 200 次测试中测得的设置和复位电压分布的统计结果。图 3c、d 分别记录了 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 的 10 个随机选择的器件单元的 I-V 曲线。具有对称 Pt 顶部和底部电极的三层结构 RRAM 器件单元显示出 1.2 至 2.8 V 的设定电压和 -0.5 至 -1 V 的复位电压(图 3a)和色散 I-V 曲线(图 3a)的广泛分布。 3c)。而具有不对称 TiN 底部和 Pt 顶部电极的器件单元显示出更好的 RS 行为,例如相对集中的设置电压从 -0.8 到 -1.8 V 和从 1.3 到 1.8 V 的复位电压,以及稳定的 I-V 曲线再现性(图 3b、d)。同时,与Pt-coated Si相比,TiN-coated Si上的不同器件单元在RS参数上也表现出改善的单色散,有利于RRAM的实际应用。

单个器件单元200次测试测得的置位和复位电压分布的统计结果。 一 Pt/HfO2/TiO2/HfO2/Pt。 b Pt/HfO2/TiO2/HfO2/TiN。 10 个随机选择的器件单元的 I-V 曲线。 c Pt/HfO2/TiO2/HfO2/Pt。 d Pt/HfO2/TiO2/HfO2/TiN
已经检查了 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 器件单元的耐久性和保持性能,分别如图 4a-d 所示。在 Pt/HfO2/TiO2/HfO2/Pt 中,设置的扫描电压为 0 到 3 V,复位为 0 到 -1.5 V。在 Pt/HfO2/TiO2/HfO2/TiN 中,施加的扫描电压为 0 至 -2 V 用于设置,0 至 2 V 用于复位。在室温下使用 0.2 V 读取 ON 和 OFF 电阻值。保持测试在室温下测量,读取电压为 0.2 V。经过 200 次编程/擦除循环后,Pt/HfO2/TiO2/HfO2/Pt 器件单元显示出相对稳定的 OFF/ON 状态电阻比高于 10 5 (图 4a);然而,Pt/HfO2/TiO2/HfO2/TiN 存储单元的耐久性特性似乎不如 Pt/HfO2/TiO2/HfO2/Pt(图 4b)。具有 Pt-TiN 电极的器件的 ON 和 OFF 状态不是很稳定,OFF/ON 状态的电阻比较小,约为 10 2 在开关周期测试中,特别是HRS波动比LRS显着。基于参考文献中的物理模型。 [12],提高氧空位和界面O 2− 的形成能可提高耐久性 数量。我们推测一种合理的解释。在我们之前的工作 [14] 中,ALD 衍生的具有不对称 TiN 底部和 Pt 顶部电极的 Al2O3/HfO2/Al2O3 三层结构的优异双极电阻开关性能已经被证明,包括更好的开关耐久性高达 10 3 具有稳定的 ON/OFF 电阻比的循环。在此,我们采用 HfO2/TiO2/HfO2 配置代替 Al2O3/HfO2/Al2O3。 HfO2 和 TiO2 中的金属离子具有相同的 +4 化学价,导致界面带电缺陷较少,例如三层 HfO2/TiO2/HfO2 的两个界面层 (IL) 之间的氧空位。而Al2O3和HfO2中的金属离子具有不同的Al 3+ 化学价 和 Hf 4+ ,在 Al2O3/HfO2/Al2O3 的两个 ILs 之间产生更多界面带电缺陷的氧空位。可以推导出接口 O 2− 在 Al2O3/HfO2/Al2O3 之间添加两个 IL 的量应高于 HfO2/TiO2/HfO2 之间。此外,Al2O3/HfO2/Al2O3 存储层中氧空位的形成能也高于 HfO2/TiO2/HfO2(氧空位的形成能 7.08 eV (Al2O3)、6.53 eV (HfO2) 和 4.35 eV) (TiO2) [20, 21])。考虑到这些因素后,Pt/HfO2/TiO2/HfO2/TiN 的存储单元与 Pt/Al2O3/HfO2/Al2O3/TiN 相比表现出耐久性退化。

设备单元的耐久性和保持特性。 一 , c Pt/HfO2/TiO2/HfO2/Pt。 b , d Pt/HfO2/TiO2/HfO2/TiN。
对于 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN,在累积等待 10 4 后,ON 和 OFF 状态的电阻水平没有明显变化 图 4c-d 中室温下的 s,表明基于外推法的两种存储单元在 10 年内具有更好的保留性能。
Pt/HfO2/TiO2/HfO2/TiN 器件的 OFF/ON 状态电阻比比 Pt/HfO2/TiO2/HfO2/Pt 低得多,这可以归因于底部电极在功函数和电导率方面的差异。 Pt 和 TiN 底电极的功函数分别为 5.65 和 4.5 eV;因此,在 Pt/HfO2/TiO2/HfO2/TiN 器件中,TiN 和下面的 HfO2 之间的界面势垒相对较低。在复位过程中,电子穿过势垒所需的能量也较小。因此,Pt/HfO2/TiO2/HfO2/TiN 在 OFF 状态下表现出比 Pt/HfO2/TiO2/HfO2/Pt 更低的电阻值。在设定的过程中,由于导电通道的形成,RRAM 器件从 HRS 变为 LRS。 Pt底电极比TiN底电极具有更高的电导率;因此,Pt/HfO2/TiO2/HfO2/TiN 的导通状态电阻值高于 Pt/HfO2/TiO2/HfO2/Pt。因此,Pt/HfO2/TiO2/HfO2/TiN 器件的关断/导通状态电阻比较小,为 10 2 .然而,电阻比为 10 2 已经满足RRAM应用需求。
为了阐明电阻开关过程中的导电机制,典型的 I-V 曲线以双对数标度重新绘制。图 5a、b 显示了 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 器件电压扫描区域的 I-V 曲线的线性拟合。两个存储单元表现出相似的导电机制。当设备切换到 LRS 时,log (I)-log (V) 的曲线呈线性,斜率接近 1(图 5a 中的 0.94,图 5b 中的 0.98),表明在LRS 受欧姆定律支配。氧空位迁移的细丝模型可用于解释开关行为。对于 HRS,在低电压区域(绝对值 <0.11 V),I-V 受欧姆定律支配,电流和电压呈线性关系(图 5a 中的斜率 1.05,图 5b 中的斜率 1.09)。在较高电压区域(图 5a 中的 6.8 V> 绝对值>0.11 V,图 5b 中的 1.85 V> 绝对值>0.11 V),log (I)-log (V) 线的斜率约为 2 和电流取决于施加电压的近似平方 (I/V 2 )。在临界电压(图 5a 中的绝对值 6.8 V,图 5b 中的 1.85 V)下,突然出现陡峭的电流上升,斜率非常大。该结果由HRS中的三个区域组成,基本遵循典型的陷阱控制空间电荷限制传导(SCLC)注入[11]。
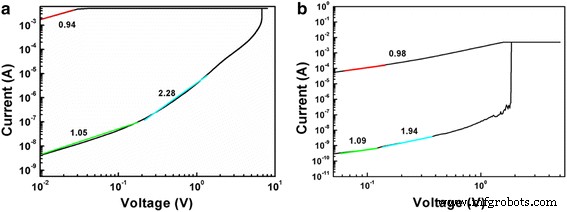
以a的双对数标度绘制的典型I-V曲线 Pt/HfO2/TiO2/HfO2/Pt 和 b Pt/HfO2/TiO2/HfO2/TiN
为了进一步了解 HfO2/TiO2/HfO2 在 Pt 涂层和 TiN 涂层硅上的潜在电阻转换机制,我们对具有对称和非对称底部/顶部电极的三层结构进行了 XPS 窄扫描和深度分析。 XPS光谱经过智能型背景减法拟合高斯-洛伦兹(G-L)函数。
图 6a-d 说明了 Hf 4f 的窄扫描 XPS 光谱 , Ti 2p , 和 O 1s 在 TiN 涂层的 Si 上的 HfO2 和 TiO2 层中出现峰值。 Hf 4f HfO2 和 TiO2 层的 Ti 2p 和 Ti 2p 光谱可以解卷积为两组峰。更强的 Hf 4f 5/2 和 Hf 4f 18.4 和 16.7 eV 处的 7/2 峰与 1.7 eV 的自旋轨道分裂被指定为 Hf-O 键合(Hf 4+ )来自 HfO2(图 6a)。在 17.6 和 14.8 eV 的较低结合能处较弱的自旋轨道双峰可能是由于 Hf n 的低化学价态 + -O (n <4),表明 HfO2 层中存在氧空位。计算出的 Hf n 的百分比浓度 + (n <4) 在 Hf 离子中约为 3.7%。在图 6b 中,更强的双峰对应于 Ti 2p 3/2 和 2p 1/2 特征在 458.8 和 464.5 eV,属于 Ti-O 键合 (Ti 4+ ) 来自二氧化钛。较弱的双峰位于 456.1 和 462.0 eV,分配给 Ti 3+ -O 键合。 Ti 3+ 的计算百分比浓度 约 21% 的钛离子。这说明TiO2层中存在氧空位。
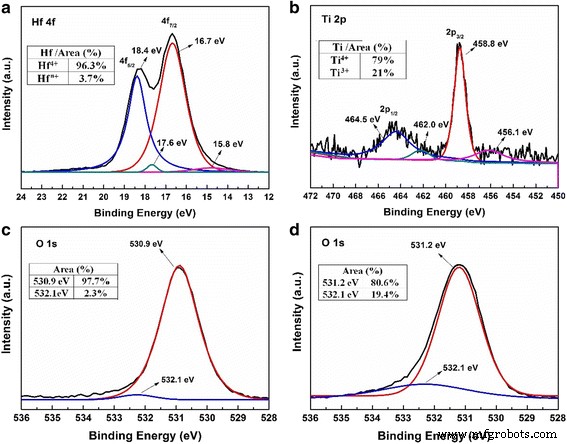
来自 TiN 涂层 Si 上 HfO2/TiO2/HfO2 三层结构的窄扫描 XPS 光谱。 一 Hf 4f,b 钛 2p HfO2/TiO2/HfO2 的峰值。 O 1s c 的峰值 HfO2 和 d TiO2层
O 1s HfO2 和 TiO2 层的光谱也可以解卷积为两个峰,如图 6c、d 所示。 O 1s 的结合能相对较低 ~530.9 和 531.2 eV 的峰值分别归于 TiO2 和 HfO2 层中的 Ti-O 和 Hf-O 键合,属于没有氧空位的晶格氧。而 O 1s 中略高的能量为 532.1 eV 图 6c、d 的光谱归因于基于文献报道的 HfO2 和 TiO2 层中氧空位附近的氧原子 [22,23,24,25]。氧化层中的相对氧空位浓度可以通过计算每个峰的面积比例来粗略评估[22, 23]。与 Hf n 的结果一致,HfO2 和 TiO2 层中氧空位的计算百分比浓度分别约为 2.3% 和 19.4% + 和 Ti 3+ .
图 7a、b 分别显示了通过 Ar 离子蚀刻在 Pt 和 TiN 涂层硅上的 HfO2/TiO2/HfO2 样品的 XPS 深度分布。尽管已经观察到 HfO2/TiO2 和 HfO2/TiN 之间的显着界面扩散,但可以很容易地识别出 HfO2/TiO2/HfO2 在 Pt 和 TiN 涂层硅上的三层结构。通常氧空位迁移的细丝模型在基于过渡金属氧化物的 RRAM 器件中支配 RS 行为 [11]。然而,简单地增加氧空位含量并不完全有效。如何有效控制氧空位丝的分布是最终提高RS均匀性的关键问题[20]。大量工作表明,氧空位的不均匀分布通常有利于 RS 行为,包括降低形成电压、提高开关稳定性和耐久能力 [1, 14, 20, 26,27,28,29]。通常通过使用具有相对高氧亲和力的化学活性电极(例如,Ta、Ti、Al 或 TiN)或通过故意引入富氧空位来获得存储氧化物层中氧空位的初始不均匀分布。界面工程的界面层[1, 17, 30]。
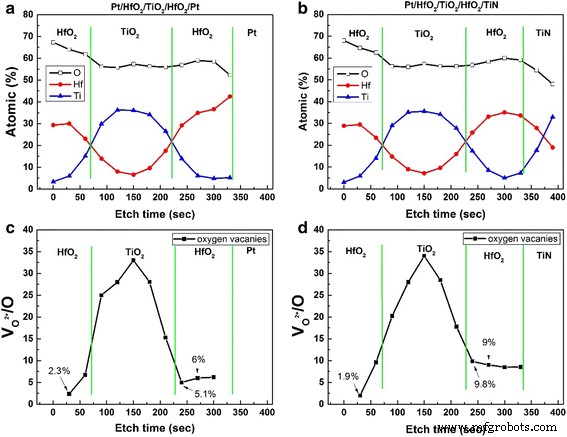
通过 Ar 离子蚀刻,HfO2/TiO2/HfO2 在 Pt 和 TiN 涂层硅上的 XPS 深度分布。 一 HfO2/TiO2/HfO2 在 Pt 涂层的 Si 上。 b HfO2/TiO2/HfO2 在 TiN 涂层的 Si 上。氧空位浓度深度分布(V 哦 2+ /O) 由 XPS 光谱在 Pt 和 TiN 涂层的 Si 上确定的 HfO2/TiO2/HfO2。 c HfO2/TiO2/HfO2 在 Pt 涂层的 Si 上。 d HfO2/TiO2/HfO2 on TiN-coated Si
图 7c、d 分别显示了基于上述深度 XPS 分布的 Pt 和 TiN 涂层硅上 HfO2/TiO2/HfO2 氧空位浓度的分布曲线。使用上述方法评价氧空位浓度。可以发现最高的氧空位浓度(~34%)出现在 TiO2 中间层。另一个值得注意的特征是,靠近 Pt 或 TiN 底部电极的底层 HfO2 层的氧空位浓度高于上部 HfO2 层(~2%)。此外,TiN包覆Si上底层HfO2层的氧空位浓度(~9%)明显高于Pt包覆Si上的氧空位浓度(~6%)。
图 8 显示了 Pt/HfO2/TiO2/HfO2/Pt 在正负偏压下的电铸和复位示意图。对于化学惰性的 Pt 顶部和底部电极,依赖于偏压极性的电铸现象与作为电还原产物从阳极氧化层释放的 O2 气体有关。众所周知,在电铸过程中,高电场会产生氧空位并迁移到阴极,在氧化层中形成局部导电细丝,即O 哦 →V 哦 2+ + O 2− , V 哦 2+ + 2e - →V 哦 [12](图 8b、e)。同时,O 2− 离子向阳极漂移,释放电荷并释放出 O2 气体,即 O 2− →1/2O 2 + 2e - (图 8b、e),这可能会导致电池的物理变形,甚至形成裂纹或孔洞 [31]。当对 Pt 顶部电极施加正形成电压时,我们假设在上部 HfO2 膜上方释放的 O2 气体很容易在顶部电极边缘或通过 Pt 顶部电极中的小纳米孔逸出(图 8b),这会导致弱物理变形。同时,考虑到 Pt 底部电极附近的底层 HfO2(~6%)中的氧空位浓度比上部 HfO2 层(~2.3%)(图 7c)相对更高,导电丝很容易形成,导致更小的正形成电压+7 V。反向电压为-0.8 V,反向反应导致灯丝破裂,器件很容易切换回HRS状态(图8d)。

具有对称 Pt 顶部和底部电极的 HfO2/TiO2/HfO2 三层结构的电铸和复位示意图。 一 –d 正电压电铸,负电压复位。 e –g 负电压电铸正电压复位
相反,在顶部电极上的负形成电压下,在下面的 HfO2 层下方和 Pt 上方形成底部电极(图 8e)。 O2 的释放变得更加困难,这将阻碍导电细丝的形成。此外,由于上部 HfO2 层的氧空位浓度(~2.3%)低于下面的 HfO2(~6%)(图 7c),因此需要 -11 V 的较高负形成电压来形成细丝.当更多的 O2 在下面的 HfO2 下积累到一定压力时,它可能会从薄膜的机械最薄弱的部分喷出,导致氧化膜中的孔洞或由气泡破裂引起的氧化膜与底部电极之间的分离。尽管器件可以在施加 +4 V 偏压时重置为 HRS(图 8g),但在几个开关周期后存储单元会退化。在我们的样品中,一部分顶部电极在成型过程后被吹掉。在 Pt/TiO2−x 中也观察到了类似的电铸极性偏好情况 /Pt 双极 RRAM 单元具有各种结的物理变形证据 [31, 32]。
Pt/HfO2/TiO2/HfO2/TiN 器件表现出与 Pt/HfO2/TiO2/HfO2/Pt 完全不同的电铸极性。在负偏压和正偏压下都可以观察到电铸引起的LRS;然而,只有在 Pt/HfO2/TiO2/HfO2/TiN 器件中的正偏置电压下才能实现从 LRS 到 HRS 的有效复位。在一些具有各种存储氧化物层(如 HfO2 [33, 34]、TiO2 [35]、ZrO x)的文献中,已经观察到类似的电铸偏好与不对称的 Pt 和 TiN 电极 /HfO y 双层 [22] 和 Al2O3/HfO2/Al2O3 三层 [14]。但相关解释存在分歧或缺乏。
考虑到 TiN 电极与氧的化学活性 [1, 30, 36] 和基于 XPS 深度分布的 HfO2/TiO2/HfO2 三层结构中氧空位浓度的非分布(图 7),电铸的可能机制提出了 Pt/HfO2/TiO2/HfO2/TiN 电池的极性偏好。图 9 显示了 Pt/HfO2/TiO2/HfO2/TiN 在负偏压和正偏压下的电铸和复位示意图。 TiN 底部电极在电铸极性中起着关键作用。郭等人。据报道,相对活跃的 TiN 电极很容易从氧化膜中吸收氧离子形成 TiOx N1−x (TiON) 界面层 [36]。在我们的样品中,XPS 深度剖面证实了下面的 HfO2 层严重的氧扩散到 TiN 底部电极中(图 7b)。对于 Pt/HfO2/TiO2/HfO2/TiN 器件,具有高氧亲和力的 TiN 电极 [34, 36] 在靠近 TiN 底部电极的底层 HfO2 层中产生大量氧空位。底层HfO2层~9%的氧空位浓度远高于Pt/HfO2/TiO2/HfO2/Pt器件中~6%的氧空位浓度。
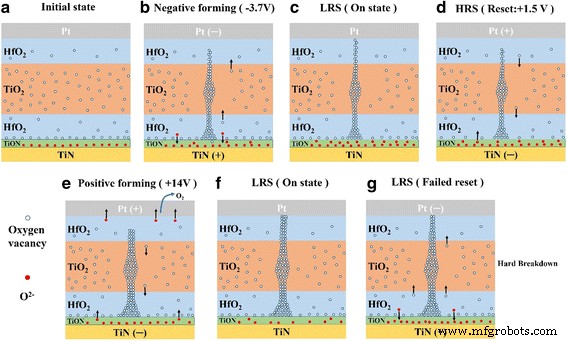
具有不对称 Pt 顶电极和 TiN 底电极的 HfO2/TiO2/HfO2 三层结构的电铸和复位示意图。 一 –d 负电压电铸,正电压复位。 e –g 正电压电铸负电压复位
对于化学惰性的 Pt 顶部电极和相对活跃的 TiN 底部电极,当施加负形成电压时,O 2- 离子向 TiN 阳极漂移并被吸收形成 TiOx N1−x 层(图 9b),即 TiN + x O 2− →TiOx N 1−x + x 2e ,避免 O2 释放和可能对细胞造成的损害。 TiN 电极可能充当氧离子在外加电压下漂移的储存器 [1, 36]。同时,由于底层 HfO2 层(~9%)和中间 TiO2 层(~10-34%)比上部 HfO2 层(~1.9%)更高的氧空位,富氧空位从底层迁移HfO2 层通过 TiO2 层向上 HfO2 层,直接产生具有 -3.7 V 较小形成电压的导电氧空位丝(图 9b)。在+1.5 V进行反向复位过程时,作为储氧器的TiN层底部电极提供氧离子与氧空位反应,即O 2- + V 哦 2+ →O 哦 (晶格氧),这有利于从 LRS 到 HRS 的复位操作,同时导电丝断裂(图 9d)。最重要的是,TiN底电极的储氧效应有助于降低形成电压以及更好的设置/复位电压变化[1, 29, 36]。
另一方面,当在顶部电极 Pt 上施加正形成电压时,氧空位从上面的 HfO2 迁移到下面的 TiN 上的 HfO2,在其附近积累,并发展成细丝。由于上部 HfO2 中的氧浓度(~1.9%)低于下面的 HfO2 层(~9%)和中间的 TiO2 层(~10-34%),这导致下面 HfO2 中氧空位浓度的进一步增加和中间 TiO2 层。同时,由于PEALD衍生的TiN薄膜中存在少量氧(约10%),TiN中的一些氧离子漂移到下面的HfO2层中,与附近的氧空位形成绝缘晶格氧,阻止导电丝的生长(图 9e)。最后,当偏置电压达到 +14 V 时,会形成粗化的氧化物导电细丝。然而,当在器件上施加负电压时,三层结构的导电细丝太大而无法破裂(图 9g)。因此,器件不能通过施加负电压切换到HRS,表明Pt/HfO2/TiO2/HfO2/TiN器件发生了不可逆的硬击穿。
最后,由于插入的 TiO2 层比 HfO2 层存储更多的氧空位,三层结构中氧空位的分布并不均匀,尤其是在 HfO2/IL/TiO2/IL/HfO2 之间的两个界面层中,可能会影响导电丝的生长位置、方向和重叠。导电细丝的连接或断裂分别对应于从 HRS 到 LRS 的设置过程或从 LRS 到 HRS 的重置过程,这更容易发生在两个界面层。此外,HfO2和TiO2层中导电细丝的形状和位置在置位和复位过程中变化较小。
结论
总之,基于 Pt/HfO2/TiO2/HfO2/Pt 和 Pt/HfO2/TiO2/HfO2/TiN 三层结构的 RRAM 器件已通过 ALD 制备。两个存储单元都显示出典型的双极电阻开关特性,以及分别在 LRS 和 HRS 中的欧姆和 SCLC 主导传导机制。研究发现,Pt和TiN的底电极对三层结构存储单元的电铸极性偏好、高低电阻比和工作电压的分散有很大影响。与对称的 Pt 顶/底电极相比,具有非对称 Pt 顶/TiN 底电极的 RRAM 单元显示出更小的负形成电压 -3.7 V,设置/复位操作电压的分布相对较窄,以及较低的高低电阻比10 2 .电极相关的电铸极性可以通过考虑电极与氧的化学活性、阳极的相关反应以及 HfO2/TiO2/HfO2 三层结构中氧空位浓度在 Pt 和 TiN 涂层硅上的不均匀分布来解释.此外,作为储氧器的 TiN 电极在形成 Pt/HfO2/TiO2/HfO2/TiN 器件的电压降低和更好的 RS 参数分散方面起着重要作用。考虑到电极和三层结构对电阻开关性能的调制效应,该工作为未来RRAM应用提供了新的器件设计途径。
纳米材料
- 用于 Micro-LED 和 VCSEL 的高级原子层沉积技术
- 具有自整流开关特性的 TaO/HfO x 和 TaO/AlO x RRAM 的保持模型
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 通过原子层沉积和水热生长制备的抗菌聚酰胺 6-ZnO 分层纳米纤维
- 通过纯 CMOS 逻辑工艺具有自抑制电阻开关负载的 RRAM 集成 4T SRAM
- TiO2 中金纳米粒子分布对染料敏化太阳能电池光学和电学特性的影响
- 通过等离子体增强原子层沉积制备的 Co3O4 涂层 TiO2 粉末的光催化性能
- 通过超循环原子层沉积调节 ZnO 薄膜的费米能级
- 电阻式随机存取存储器建模和仿真的集体研究
- 在 c 面 GaN 上沉积的 AlN 原子层中界面和电特性的厚度依赖性
- 使用二氧化碳的低温等离子体增强原子层沉积 SiO2
- 具有通过原子层沉积制造的 Al2O3 钝化膜的硅纳米线异质结太阳能电池


