使用 Tetrakis(乙基甲基氨基)和 Tetrakis(二甲基氨基)前驱体在原子层沉积 Hf0.5Zr0.5O2 薄膜中铁电性能的比较研究
摘要
比较了使用四(乙基甲基氨基)(TEMA)和四(二甲基氨基)(TDMA)前体沉积的 Hf0.5Zr0.5O2 薄膜的化学、物理和电学特性。金属有机前驱体的配体强烈影响残余 C 浓度、晶粒尺寸和由此产生的铁电性能。用 TDMA 前驱体沉积 Hf0.5Zr0.5O2 薄膜会导致 C 浓度降低和晶粒尺寸稍大。这些发现有利于生长更多的铁电相主导薄膜,从而减轻其唤醒效应。从TDMA-Hf0.5Zr0.5O2薄膜在2.8 MV/cm循环场的唤醒试验中,不良唤醒效应被很好地抑制到10 5 循环,具有相当高的双剩余极化值 ~40 μC/cm 2 .该影片还显示了高达 10 9 的可靠切换 2.5 MV/cm 循环场的循环,不涉及唤醒效应,但具有典型的疲劳行为。
介绍
原子层沉积 Hf1-x Zrx O2 (HZO, x ~ 0.5) 薄膜一直是用于存储器和逻辑应用的半导体器件领域中超薄铁电 (FE) 层的主要竞争者。这是因为萤石结构的 FE HZO 薄膜甚至可以缩小到 10 nm 以下,并通过利用成熟的原子层沉积 (ALD) 技术均匀沉积在三维纳米结构上。此外,它与传统的钙钛矿结构铁电体难以实现的传统 TiN 电极兼容 [1, 2]。尽管在过去几年中使用基于 ALD 的薄膜在 HZO 膜加工和器件制造方面取得了显着改进,但仍有一些未解决的缺点。特别是萤石结构铁电体的可靠性是不确定的。目前,唤醒效应和有限数量的耐力被认为是最严重的问题[3]。通常,极化电场 (P-E) 曲线在原始状态下被收缩,这表明矫顽场 (Ec) 在空间上是不均匀的,并且几个 FE 域被固定 [4]。在场强高于 Ec 的电场循环后,可以获得更对称和方形的 P-E 曲线,这种现象称为唤醒效应。在某些情况下,这样的唤醒过程持续 10 4 –10 5 周期,这是典型的耐力周期约。闪存,使设备和系统操作变得复杂 [5]。如果打算将其用作工作记忆(耐力> 10 15 是必须的)。对于金属-铁电-金属电容器结构,报告的最大耐久性小于 10 11 [6],对于铁电场效应晶体管中的金属-铁电-半导体栅叠层,其耐久性限制为10 5 次 [3, 7]。
文献中提出了唤醒效应的各种起源。建议的机制是通过缺陷固定畴边界,例如杂质、氧空位以及在原始状态下与电极或半导体通道相邻的界面处存在非铁电相(立方相或四方相) [5, 8 ,9,10]。在重复极化切换期间,预计钉扎位点浓度会降低。此外,电场循环将界面四方或立方相转变为 FE 正交相 [5]。本研究主要集中在通过在ALD过程中采用替代的Hf和Zr前驱体来改善HZO薄膜的电学性能或消除唤醒效应,这可能导致较低的杂质浓度,尤其是碳杂质。
对于使用金属有机前驱体的 ALD 工艺,几乎不可避免地会在生长膜中引入残留杂质,例如 C、N 和 H,这些杂质很可能来自有机配体。金等人。 [11, 12] 表明,通过改变 HfO2 和 HZO 薄膜的沉积温度,可以控制多晶型和由此产生的电性能。从俄歇电子能谱 (AES) 来看,ALD HZO 薄膜中的 C 浓度随着沉积温度的降低而增加,这可能是由于配体交换反应不完善 [11, 12]。此外,横向晶粒直径随着 C 浓度的增加而减小。在这种萤石结构薄膜中形成不稳定或亚稳定相(四方、斜方和立方)而不是稳定的单斜相与晶粒尺寸效应密切相关[13,14,15,16]。因此,控制杂质浓度对于获得所需的相(FE正交)以及提高薄膜的电气可靠性至关重要。
对于 FE HZO 薄膜的 ALD,最常用的金属有机 Hf 和 Zr 前体是四 [乙基甲基氨基] 铪 (TEMAH) 和四 [乙基甲基氨基]锆 (TEMAZ) [11, 12, 17]。这些前体是为金属有机化学气相沉积而开发的,目的是通过甲基和乙基之间的电荷转移进行配体分解 [18,19,20]。然而,这种类型的热诱导配体分解和随后有机配体(碎片)的去除不利地干扰了容易的 ALD 反应,导致杂质(C、H 和 N)掺入薄膜 [11, 17, 18, 19,20]。
相比之下,四[二甲氨基]铪(TDMAH)和四[二甲氨基]锆(TDMAZ)前体也被用于沉积FE HZO薄膜[21,22,23,24],它们的基团只有甲基。配体。因此,尽管不能保证完全抑制热分解,但这种不利影响可能并不严重。
本研究对使用两种不同金属前驱体通过 ALD 工艺生长的 HZO 薄膜进行了比较分析; TEMAH/TEMAZ 和 TDMAH/TDMAZ。后一过程导致薄膜中较低的 C 浓度,这显着提高了 HZO 薄膜的电性能。在优化的开关循环条件下,几乎没有唤醒效应,而可开关极化保持在~ 40 μC/cm 2 .
方法/实验
Hf0.5Zr0.5O2 薄膜的制备
这项工作检查了金属有机前驱体类型对原子层沉积 Hf0.5Zr0.5O2 薄膜结构和电性能的影响。使用具有 TDMAH(或 TEMAH)、TDMAZ(或 TEMAZ)和臭氧(190 g/m 3 )的 4 英寸直径热 ALD 反应器沉积 HZO 薄膜 浓度)分别作为 Hf 前体、Zr 前体和氧源。使用 TEMAH/TEMAZ 前体的优化 ALD 工艺与作者之前的研究 [5, 9, 11,12,13,14,15,16] 相同。具有 TDMAH/TDMAZ 前驱体的 HZO 薄膜是通过热 ALD 在 260 °C 的衬底温度下制备的。选择 50:50 的 Hf:Zr 比率进行电气测试,因为据报道,该成分在之前的研究中显示出最大的剩余极化 (Pr) 值 [17, 25, 26]。具有 TDMAH/TDMAZ 前体的 HZO 薄膜以 1:1 的 Hf 和 Zr 前体的 ALD 循环比沉积在 TiN/Ti/SiO2/Si 衬底上。一个ALD循环由源进料(2 s)-源净化(20 s)-臭氧进料(3 s)-臭氧净化(10 s)过程组成。 HZO 薄膜的生长速率为每个循环 0.13 nm,10 nm 厚的 HZO 薄膜由 TDMAH/TDMAZ 前驱体制备用于实验。最佳条件可能因 ALD 室的体积而异。表 1 显示了 TEMA 和 TDMA 源的物理特性的比较。 TiN (50 nm) 和 Ti (5 nm) 薄膜是使用商业溅射工具 (Endura, Applied Materials) 以 5 kW 的溅射功率在热氧化的 p 型 Si 衬底上沉积的。沉积的HZO薄膜在沉积状态下仅部分结晶或非晶态,因此随后使用快速热处理(RTP)在N2气氛中在450 °C下进行结晶退火。
<图>Hf0.5Zr0.5O2 薄膜的化学/物理特性的表征
使用 X 射线衍射仪(XRD,X'pert pro,Panalytical)在入射角为 0.5° 的掠入射几何结构内分析沉积薄膜的晶体结构。使用扫描电子显微镜(SEM,S-4800,Hitachi)分析样品的微观结构,并使用Gwyddion软件[29]通过分水岭法分析晶粒尺寸分布。使用 X 射线荧光(XRF、Quant'X、Thermo SCIENTIFIC)分析沉积的 HZO 膜的化学成分,并使用时间分析法分析化学成分的深度变化,包括杂质,如 C,飞行俄歇电子能谱(AES、PHI-700、ULVAC-PHI)
Hf0.5Zr0.5O2 薄膜的电学特性表征
为了分析 HZO 薄膜的电性能,在 92.6%-Ar/7.4%-N2 气氛下通过溅射工艺反应沉积顶部 TiN 电极,功率为 100 W。使用具有直径为 300 μm 的圆孔的荫罩对 TiN 顶部电极进行图案化。使用铁电测试仪(TF 分析仪 2000,Aixacct 系统)在 1 kHz 的测量频率下分析 P-E 特性。使用由脉冲发生器(81110A,Agilent)和铁电测试仪(TF 分析仪 2000,Aixacct 系统)产生的矩形双极脉冲进行耐久性测试,矩形双极脉冲的高度和宽度分别为 2.8 ~ 3.8 MV/cm 和 10 μs。使用阻抗分析仪(4194A,Hewlett-Packard)在频率为 10 kHz 和高度为 50 mV 的正弦交流脉冲和直流偏置下测量电容-电压(C-V)特性。 HZO 薄膜的介电常数由测量的电容以及通过光学显微镜测量的电极面积和使用光谱椭偏仪 (ESM-300, J. A. Woollam) 测量的厚度计算。使用半导体参数分析仪(4155B,Hewlett-Packard)在直流偏置下,延迟时间为1 s,分析电流密度-电场(J-E)特性。
结果与讨论
图 1a 显示了使用 TDMAH/TDMAZ(TDMA-HZO,黑色曲线)和 TEMAH/TEMAZ(TEMA-HZO,红色)沉积的 10 nm 厚 Hf0.5Zr0.5O2 薄膜的掠入射 X 射线衍射 (GIXRD)曲线),入射角为 0.5°。从文献中获取的关于单斜晶、四方晶和正交晶相的参考图案附在底部。从 TDMA 和 TEMA HZO 薄膜的 GIXRD 图中,单斜晶相的衍射峰强度可以忽略不计,峰形和强度没有显着差异。因此,从 GIXRD 实验证实 TDMA 和 TEMA HZO 的晶体结构没有显着差异。

(a) 使用 TDMAH/TDMAZ(黑色曲线)和 TEMAH/TEMAZ(红色曲线)沉积的 HZO 薄膜的 GIXRD 图案,从文献中获取的单斜晶、四方晶和正交晶相的参考图案附在底部面板中。 (b) TDMA HZO 薄膜和 (c) 的平面 SEM 图像 TEMA(红色;复制自参考文献 [15])、TDMA(黑色)HZO 的粒度分布。 (d) 使用飞行时间俄歇电子能谱分析的 TDMA HZO 薄膜的深度分布,以及 (e) HZO薄膜部分扩大的低浓度区。显示了 TDMA(黑色点划线)、TEMA(红色虚线;转载自参考文献 [12])、HZO 的平均 C 浓度
微观结构,包括横向晶粒尺寸,是另一个可以强烈影响 HZO 薄膜 FE 性能的关键因素 [13,14,15,16,30]。因此,使用扫描电子显微镜 (SEM) 分析了 TDMA 和 TEMA HZO 薄膜的微观结构。图 1b 显示了 TDMA HZO 薄膜的平面 SEM 图像。先前的各种研究报告称,使用热 ALD 沉积的 HZO 薄膜显示出柱状晶粒结构,这表明垂直晶粒尺寸与薄膜厚度一样大 [1, 5, 11, 31]。使用上述软件 [29] 分析的横向晶粒尺寸分布符合高斯函数。 TEMA HZO 的晶粒尺寸分布(红色曲线)取自先前的研究 [15],并与 TDMA HZO 的晶粒尺寸分布(黑色曲线)绘制在图 1c 中。如图 1c所示,TDMA HZO的平均横向晶粒直径(8.5 nm)大于TEMA HZO的平均横向晶粒直径(7.1 nm)。这可能是提高 TDMA HZO FE 性能的主要原因。根据先前的报道,亚稳相的形成,例如正交相和四方相,是由动力学起源驱动的,并且四方相和正交相在小晶粒尺寸区域中是优选的[13, 16]。大得多的晶粒优选为单斜晶相,较小的晶粒优选为四方晶相,而稍大的晶粒优选为正交晶相。衍射图案中两相(四方相和正交相)的峰位置几乎重叠,无法明确识别两种膜中的主要相。然而,SEM和伴随的晶粒尺寸分析表明与TEMA HZO薄膜相比,TDMA HZO薄膜可以具有更高比例的正交相。
不同的晶粒尺寸可能是由于两种薄膜中 C 杂质浓度水平不同造成的。杂质的浓度会强烈影响 HZO 薄膜的微观结构和由此产生的铁电性能 [11, 12, 32]。因此,使用飞行时间 AES 分析了 TDMA 和 TEMA HZO 薄膜的化学成分,以及 TDMA HZO 中各种原子(如 Hf、Zr、O、C、Ti 和 N)的深度浓度在图 1d 中,将薄膜绘制为溅射时间的函数。图 1e 显示了放大的图 1d(红色虚线框)中HZO 薄膜部分的低浓度区域。 TDMA HZO 薄膜(黑色方块)中的平均 C 浓度为~ 2.4%,比 TEMA HZO 薄膜(红色三角形)[12] 中的 C 浓度小~ 38%(~ 3.9%),其中 AES 数据报告在作者之前的研究 [12]。所有其他浓度,包括 N,均未显示出任何显着差异。
Cho 等人。表明在 ALD 过程中形成的残留 C 杂质阻碍了晶粒生长,并导致最终沉积的薄膜的晶粒尺寸较小 [32]。 Kim 等人对铁电 Hf0.5Zr0.5O2 薄膜和纯 HfO2 薄膜观察到了类似的趋势。当沉积温度从 280 降低到 200 °C [11, 12]。荣格等人。使用计算模拟表明,四方相和单斜相之间的自由能差异随着 HfO2 中 C 浓度的增加而减小,表明包含 C 杂质增强了亚稳四方相的稳定性 [33]。 Kuenneth 等人。还检查了 C 浓度对 HfO2 自由能值的影响。然而,他们报告说,C 浓度的增加并未导致正交相和单斜相之间的自由能差异减小 [34]。在 Kuenneth 等人的工作中,虽然 C 杂质通常被称为 HfO2 中的间隙缺陷 [33, 35],但也考虑了置换 C 缺陷。因此,理论计算并没有清楚地表明 C 杂质可以降低四方相和正交相之间的自由能差。然而,实验已经证实,C杂质的增加会增加ALD HZO薄膜中的四方相分数[11, 12, 33]。
TDMA HZO 薄膜中较低的 C 杂质浓度可归因于 TDMA 和 TEMA 配体的不同热分解性质。在 ALD 工艺过程中,TEMA 配体中最外层的碳原子易于热解离并留在薄膜表面 [11, 12],而 TDMA 配体可能不是这种情况。
作为下一步,讨论了 C 浓度和由此产生的微观结构对铁电性能的影响。图 2a 和b 分别显示了具有TDMA HZO 和TEMA HZO 薄膜的MFM 电容器在原始状态和疲劳状态切换10 2 时的P-E 曲线 , 10 3 , 10 4 , 和 10 5 使用 3.8 MV/cm 高和 10 μs 宽的双极矩形脉冲。从图 2a和b(原始状态)中的P-E曲线来看,与TDMA HZO电容器(黑色曲线,图 2a)。图 2b 清楚地显示了 TEMA HZO 电容器的原始 P-E 曲线中的驼峰,而 TDMA HZO 电容器的原始 P-E 曲线并非如此。 P-E 曲线中的驼峰源于开关电流峰值的分裂,这通常是由内部电场和/或矫顽场的空间不均匀性引起的。图 2c 显示了TDMA 和TEMA HZO 电容器的2Pr 值随疲劳脉冲的变化。 10 5 后的2Pr值 与原始 2Pr 值相比,TDMA 和 TEMA HZO 电容器的电脉冲次数分别为 ~ 80 和 ~ 69%。这表明与 TDMA HZO 薄膜相比,TEMA HZO 薄膜具有更高的唤醒行为。

(a的极化-电场(P-E)曲线 ) TDMA HZO 和 (b ) TEMA HZO(从参考文献 [5] 中复制)在原始状态和疲劳状态下测量的电容器 10 2 , 10 3 , 10 4 , 和 10 5 3.8 MV/cm 高和 10 μs 宽的双极矩形脉冲。 (c) 作为疲劳脉冲函数的 TDMA(黑色)和 TEMA(红色)HZO 电容器的 2Pr 值的变化。 (d的介电常数-电场曲线 ) TDMA HZO 和 (e ) TEMA HZO(从参考文献 [5] 中复制)具有在原始状态和疲劳状态下测量的顶部和底部 TiN 电极的电容器。 (f) TDMA(黑色)和TEMA(红色)HZO电容器的介电常数值随着疲劳脉冲次数的增加而变化
图 2d和e显示了TDMA HZO和TEMA HZO电容器在原始状态和疲劳状态切换10 2 时的介电常数-电场(εr - E)曲线 , 10 3 , 10 4 , 和 10 5 使用 3.8 MV/cm 高和 10 μs 宽的双极矩形脉冲。在所有测试条件下,TDMA HZO 电容器的 εr 值都明显低于 TEMA HZO 电容器。图 2f 显示了随着TDMA 和TEMA HZO 电容器疲劳切换循环次数的增加,εr 值的变化。 εr 值是通过平均在图 2d 和 e 中的最高和最低电场测量的 εr 值来计算的。从图 1a 中的GIXRD 图可以看出,两种薄膜中的单斜相分数都可以忽略不计。因此,εr 值的差异可能由四方相和正交相的相对分数或缺陷浓度决定,这预计会随着局部晶格畸变而降低平均介电常数。四方相(35-40)的εr值高于正交相(25-30)的εr值。因此,TEMA HZO 电容器的高 εr 值表明与 TDMA HZO 电容器相比,它具有更高的四方相分数。随着疲劳脉冲次数的增加,TEMA HZO 和TDMA HZO 电容器的εr 值均减小,如图 2f 所示。 10 5 期间εr值的下降幅度 TDMA HZO 电容器(26.8 至 25.3)的极化切换倍数比 TEMA-HZO 电容器(32.2 至 29.6)小~ 42%。这与图 2c所示的唤醒行为一致。
从 C 浓度的差异可以理解四方相分数的差异和 TDMA 和 TEMA HZO 薄膜的不同 εr 值。根据 Kim 等人的说法。 [12],与正交相相比,C 浓度的增加降低了四方相的自由能(与正交相相比,四方相仍然更有利)。因此,随着 C 浓度的增加,预计四方相分数会增加。由于 TDMA HZO 膜的 C 浓度低于 TEMA HZO 膜的 C 浓度,因此预计 TDMA HZO 膜中的四方相分数低于 TEMA HZO 膜的四方相分数。图 1c 中显示的晶粒尺寸差异也支持相对结晶相分数的相同趋势。根据 Materlik 等人的说法。 [30],四方相的自由表面能(2.5 J/m 2 ) 低于 (2.9 J/m 2 ) 的正交相,尽管估计这些自由表面能可以解释在具有不同厚度和 Zr 浓度的 HZO 薄膜中的实验观察结果。巴特拉等人。 [36] 计算了不同取向的各种晶相的自由表面能,结果表明四方相的自由表面能低于斜方晶相和单斜晶相的自由表面能。人们普遍认为,大角度晶界能量大约是自由表面能的 1/3 [37]。因此,与正交相和单斜相相比,四方相的晶界能最低,使其成为最小晶粒尺寸下最稳定的相。这些与 TEMA HZO 的较小晶粒尺寸倾向于包括与 TDMA HZO 膜相比更高部分的非铁电四方相的想法一致,TDMA HZO 膜具有较大的平均晶粒尺寸。因此,实验观察到的 C 浓度和晶粒尺寸一致支持 TDMA 和 TEMA HZO 薄膜的不同晶体结构和由此产生的电性能。
为了阐明唤醒效应背后的机制,在 TDMA HZO 和 TEMA HZO 电容器上进行了脉冲开关测量,该测量可以估计源自电极附近非铁电层的界面电容 (Ci) [5]。图 3a 和b 分别显示了TDMA HZO 和TEMA HZO 电容器的Ci、接触电阻(Rc) 和Ec 值随着疲劳脉冲数量的增加而发生的变化。详细的测量方法和结果包含在在线支持信息中。 TEMA HZO 电容器的数据取自 Kim 等人之前的工作 [5],其中 Ci 值随着电场循环次数的增加而增加 [5]。在原始状态下,Ci (37.6 μF/cm 2 ) TDMA 电容器的值高于 (21.1 μF/cm 2 ) TEMA HZO 电容器的 ~ 75%,表明 TDMA HZO 中非铁电界面层的厚度远小于 TEMA HZO 薄膜中的厚度。另一方面,TDMA 和 TEMA HZO 电容器在原始状态下的 Ec 值差异仅为 13%,表明 TDMA 和 TEMA HZO 电容器原始 P-E 特性差异的主要原因是厚度不同非铁电界面层。由于 Rc 值受电气测试设置的接触电阻影响很大,因此与其他两个因素相比,它的重要性可能较低。因此,基于 Kim 等人提出的先前唤醒模型,可以一致地理解 TDMA 和 TEMA HZO 电容器在原始状态下的不同 P-E 特性。 [5]。根据之前的研究,TiN 电极附近的氧空位浓度高于原始状态下的薄膜体区域。根据霍夫曼等人的说法。 [38],与正交相相比,氧空位浓度的增加增强了四方相的稳定性。在耐久性测试中的重复极化切换过程中,界面四方相似乎通过将氧空位扩散到薄膜的主体区域而转化为 FE 正交相。外加场还诱导界面非 FE 相向 FE 相的相变。由于TDMA-HZO电容器的界面层厚度小于原始状态的TEMA-HZO电容器的界面层厚度,因此可以减轻场循环期间的唤醒效应。
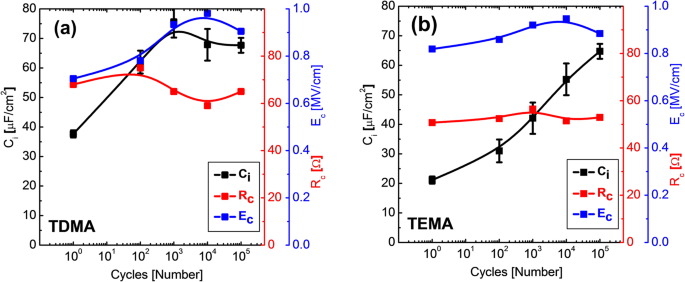
(a的变化 ) TDMA HZO 和 (b ) TEMA HZO(复制自参考文献 [5])在界面电容 (Ci)、接触电阻 (Rc) 和矫顽场 (Ec) 值中随疲劳脉冲数量的增加
此外,疲劳脉冲的幅度是另一个关键因素,可以强烈影响萤石结构铁电体的唤醒现象 [6, 8]。因此,使用具有 2.8、3.1、3.5 和 3.8 MV/cm 的各种振幅的疲劳脉冲来检查 TDMA HZO 电容器的唤醒效果。图 4a、b 和c 显示了在唤醒测试期间测量的P-E 曲线,疲劳脉冲高度分别为2.8、3.1 和3.5 MV/cm。图 4d总结了唤醒测试期间2Pr的变化。与图 2a 所示的唤醒测试结果类似,在给定场幅值的一定数量的唤醒循环后,在 3.8 MV/cm 的测量电场下进行 P-E 测量。 P-E 滞后的变化随着疲劳脉冲幅度的减小而减小,如图 4a-c 所示。图 4d 显示了在2.8、3.1、3.5 和3.8 MV/cm 振幅疲劳脉冲下的耐久性测试期间2Pr 值的变化汇总。如图 4d所示,10 5 后2Pr的幅度增加 场循环次数分别为0.41、5.18、9.93和9.94 μC/cm 2 对于不同的疲劳场振幅,分别对应~ 1、~ 13、~ 26和~ 24%的变化。该结果表明,当施加 2.8 MV/cm 振幅的疲劳脉冲时,唤醒效应可以忽略不计,其中 2Pr 值相当高(~ 40 μC/cm 2 ) 仍然可以实现。
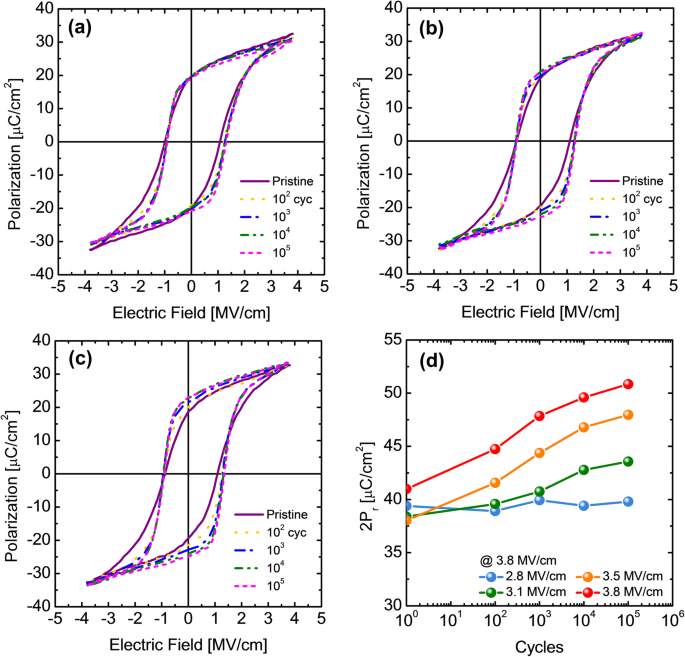
在疲劳脉冲高度为 (a ) 2.8, (b ) 3.1, 和 (c ) 3.5 MV/cm。 (d) 2.8、3.1、3.5、3.8 MV/cm-高疲劳脉冲耐久试验中2Pr值的变化
唤醒效应与氧空位的漂移以及由此产生的从四方相到正交相的相变密切相关,主要在界面层 [9, 10]。氧空位的漂移受到疲劳脉冲幅度的强烈影响,适当降低疲劳试验场幅度(在这种情况下为2.8 MV/cm)可以在很大程度上减轻这种不利影响。虽然可达到的最大 2Pr 值从 ~ 51 μC/cm 2 (在 3.8 MV/cm) 到 ~ 40 μC/cm 2 (at 2.8 MV/cm), ~ 40 μC/cm 2 对于铁电存储器件来说,它仍然具有相当高的价值。对于 TEMA HZO 薄膜,可以应用类似的策略来缓解唤醒问题,但其最初的 2Pr 值较低(~ 30 μC/cm 2 ) 可能是这种方法的潜在问题。
10 9 耐久试验进一步阐明了C浓度的影响 循环,如图 5a 和b 所示,分别显示了TEMA 和TDMA HZO 薄膜在场振幅为2.5 和3.0 MV/cm 下Pr 的变化。在这两种情况下,Pr 值都是由 P-E 回路估算的,其中最大电场强度与循环场相同,因此估算的 Pr 值通常小于图 4 中的那些值,其中 P-E测试以 3.8 MV/cm 进行。当图 4 中 P-E 测试的最大场 (3.8 MV/cm) 用于耐久测试时,薄膜会过早破裂,禁止耐久测试达到最大循环次数。这两种薄膜在 Pr 与循环行为的演变中显示出一致的趋势:TEMA HZO 薄膜不断增加 Pr 值,而 TDMA HZO 薄膜的趋势要低得多。 TEMA HZO薄膜在~ 10 7 分解前表现出不稳定的Pr变化 和 ~ 10 9 分别使用 3.0 和 2.5 MV/cm 场循环。相比之下,TDMA HZO 薄膜显示出高达 ~ 10 7 的击穿迹象 和 ~ 10 9 在 3.0 MV/cm 和 2.5 MV/cm 场循环下循环,并观察到突然击穿。 ~ 10 7 后Pr值略有下降 在 2.5 MV/cm 的循环场强下,这对应于真正的疲劳行为。对于传统的钙钛矿铁电体,随着开关周期的 Pr 性能的类似衰减已被广泛报道,这通常归因于由于缺陷密度增加而导致的畴壁钉扎 [40, 41]。在之前对 HZO 基铁电薄膜的研究中,由于涉及显着的唤醒和早期击穿,几乎没有观察到这种真正的疲劳行为,这在图 5a 中也是如此。图 5b中的数据表明,在适当解决唤醒和早期击穿问题的情况下,HZO薄膜也可能受到钙钛矿铁电薄膜中已知的疲劳效应的影响。
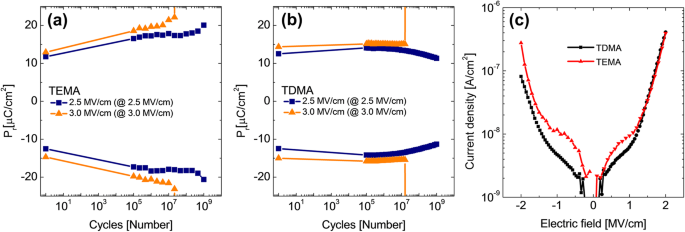
(a ) TEMA HZO(从参考文献 39 中复制)和 (b ) TDMA HZO,电场循环和脉冲场幅度分别为 2.5 和 3.0 MV/cm。用于耐久性测试的矩形双脉冲频率固定为 100 kHz。 (c) TDMA HZO(黑色)和TEMA HZO(红色;转载自参考文献[39])的电流密度-电场曲线
图 5c 显示了两种薄膜的漏电流密度性能比较。由于较低的 C 浓度,TDMA HZO 膜在场强 <~ 1.5 MV / cm 时具有比 TDMA HZO 膜更低的漏电流,其中陷阱辅助隧道可能占主导地位。由于 TDMA HZO 中漏电流的改善,薄膜没有表现出击穿高达 10 9 2.5 MV/cm的相对较低的场强。
然而,在较高场强区域,差异变小,这可能表明高场漏电流更多地受界面肖特基势垒特性支配,并且这种势垒特性对 C 浓度不太敏感。在后续工作中将进行进一步研究,以更准确地识别漏电流机制。类似的高场区漏电流与击穿前开关周期数在 3.0 MV/cm 处无显着差异相吻合,如图 5a 和 b。
结论
总之,这项工作检查了金属有机前驱体类型对原子层沉积 Hf0.5Zr0.5O2 薄膜结构和电性能的影响。采用的 Hf 和 Zr 前体具有 TEMA 或 TDMA 配体,其中前者比后者更容易热分解。使用具有 TDMA 配体的前体的 ALD 工艺导致 HZO 膜中的 C 杂质浓度较低(~2.4 原子% 与~3.9 原子%),这导致晶粒尺寸稍大(~8.5 纳米与~7.1 纳米) .由于稍大的晶粒更喜欢铁电正交相而不是非铁电四方相,TDMA HZO 薄膜优于 TEMA HZO 薄膜,特别是在唤醒性能方面。当唤醒场周期为2.8 MV/cm时,TDMA HZO薄膜几乎没有唤醒效应,而2Pr值高达~40 μC/cm 2 可以实现。这是相对于 TEMA HZO 膜的严重唤醒特性的重要优点。与 TEMA HZO 膜相比,TDMA HZO 膜还包含与 TiN 电极的界面非铁电相的下部。由于较低的 C 浓度,TDMA HZO 薄膜在低场区 (<~1.5 MV/cm) 显示出较低的漏电流,但高场漏电流行为相似。因此,当循环场高达 3.0 MV/cm (~10 7 周期),但可以延长超过 10 9 对于 TDMA HZO 薄膜,当循环场较低 (2.5 MV/cm) 时循环。 TDMA HZO 薄膜揭示了典型的疲劳行为,即随着开关周期的增加而降低 Pr 值,在 ~ 10 7 之后可以观察到 循环速度为 2.5 MV/cm,这可能是由于累积缺陷导致畴壁钉扎,与传统的钙钛矿铁电薄膜一样。
数据和材料的可用性
支持本文结论的数据集包含在文章及其附加文件1中。
缩写
- TEMA:
-
四(乙基甲基氨基)
- TDMA:
-
四(二甲氨基)
- TEMAH:
-
四[乙基甲基氨基]铪
- TEMAZ:
-
四[乙基甲基氨基]锆
- TDMAH:
-
四[二甲氨基]铪
- TEMAZ:
-
四[二甲氨基]锆
- TDMA HZO:
-
使用TDMAH/TDMAZ沉积的Hf0.5Zr0.5O2薄膜
- TEMA HZO:
-
TEMAH/TEMAZ沉积Hf0.5Zr0.5O2薄膜
- ALD:
-
原子层沉积
- AES:
-
俄歇电子能谱
- RTP:
-
快速热处理
- XRD:
-
X射线衍射仪
- GIXRD:
-
掠入射X射线衍射
- SEM:
-
扫描电镜
- HZO:
-
Hf1-xZrxO2, x~0.5
- FE:
-
铁电体
- Pr:
-
剩余极化
- Ec:
-
强制领域
- P–E:
-
极化-电场
- C–V:
-
电容-电压
- J–E:
-
电流密度-电场
- 词:
-
界面电容
- Rc:
-
接触电阻
纳米材料
- 揭示叠杯碳纳米纤维的原子和电子结构
- 通过原子层沉积和水热生长制备的抗菌聚酰胺 6-ZnO 分层纳米纤维
- 硼烯稳定性和STM图像的第一性原理研究
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 在 Ge (100)、(110) 和 (111) 衬底上制造 SrGe2 薄膜
- 通过原子力显微镜研究聚苯乙烯薄膜的附着力和玻璃化转变
- 碳纳米纤维和活性炭作为水性电解质中对称超级电容器的研究:一项比较研究
- ITO/PtRh:PtRh 薄膜热电偶的制备和热电特性
- 关于双层/三层宽带 SiO2 抗反射膜横截面形貌的 TEM 和 STEM 研究
- 天然和合成纳米材料的电化学、生物医学和热特性的比较研究
- 一种通过 PECVD 沉积低缺陷密度 nc-Si:H 薄膜的便捷有效方法
- 在 c 面 GaN 上沉积的 AlN 原子层中界面和电特性的厚度依赖性


