通过光致发光研究的 InGaN/GaN 量子阱中两种定域态之间的载流子再分布
摘要
InGaN/GaN 多量子阱 (MQW) 在相同条件下通过金属有机化学气相沉积 (MOCVD) 制备,除了在每个 InGaN 阱层上额外生长的帽层厚度。薄盖层样品的光致发光 (PL) 强度比厚盖层样品强得多。有趣的是,厚盖层样品在高激发功率下有两个光致发光峰,PL峰能量-温度曲线显示随着激发功率的增加,从反V形到规则S形的异常转变。同时,在较高激发功率下,厚盖层样品的热稳定性比在较低激发功率下更差。这种不典型的现象归因于两种局域态之间的载流子重新分布,这是由厚盖层样品中铟成分的不均匀分布引起的。此外,深局域态发光的热稳定性较好,浅局域态发光的热稳定性较差。事实上,这种更严重的不均匀铟分布可能是由于较长的低温GaN帽层生长时间导致InGaN/GaN MQWs区域后续外延生长退化所致。
介绍
InGaN/GaN 多量子阱 (MQW) 结构因其在发光二极管 (LED) 和激光二极管 (LD) 中的广泛应用而受到极大关注 [1,2,3,4,5,6]。尽管 InGaN/GaN MQW 的自发极化和压电极化导致了高穿透位错密度和波函数重叠的减少,但它们的发光效率仍然非常高 [7,8,9,10]。主要原因之一是由于铟含量的波动,激子在电位最小值的局域化导致在 InGaN/GaN 量子阱中形成类似量子点的状态 [11]。然而,定位状态在发光机制中的作用仍然不明确。一些研究报告了 InGaN 成分波动对辐射和俄歇复合的影响 [12,13,14]。琼斯使用的原子紧束缚的理论模拟发现,定位增加了辐射和俄歇复合率,但俄歇复合率比辐射复合率增加了一个数量级 [15]。实验上,载流子定位导致俄歇复合过程中 k 选择规则的松弛,从而在高光激发下强烈增强极性 InGaN/GaN QW 中的俄歇复合过程 [16]。众所周知,发光峰值能量的温度相关 S 形行为是载流子定位的指纹。提出了许多模型,例如局部状态集成(LSE)模型来解释载流子的定位和热重分布行为,表明发光峰值能量随温度的变化可以受到不同激发水平下独特的载流子重分布过程的影响[17, 18、19、20、21]。通常,制造的器件(如激光二极管)总是以更高的注入载流子密度运行 [22]。在这种情况下,局域态的光致发光光谱可能在与局域态均匀性相关的不同激发水平下表现出独特的行为。因此,需要进一步研究以了解合金波动对InGaN器件的影响。
在这项工作中,通过金属有机化学气相沉积系统 (MOCVD) 在每个 InGaN 阱层上额外生长了两个具有不同厚度的 GaN 盖层的典型样品。 MQW 的特性通过高分辨率 X 射线衍射 (HRXRD)、温度相关光致发光 (TDPL) 和功率相关光致发光 (PDPL) 测量进行了详细表征。发现厚盖层样品在高光激发功率下在高能侧出现异常峰。这意味着两种不同的局部状态共存。同时,当激发功率增加得更高时,PL 强度在低温下衰减得更快。因此,我们可以假设深局域态的光致发光具有更好的热稳定性,而浅局域态的光致发光具有较差的热稳定性。
方法
材料
研究了通过 AIXTRON 3 × 2 在密耦合喷头反应器中在 c 面蓝宝石衬底上生长的具有不同盖层厚度的 InGaN/GaN MQW 样品。三甲基镓 (TMGa)、三甲基铟 (TMIn) 和氨 (NH3) 分别作为 Ga、In 和 N 源前驱体用于外延生长,其中 H2 和 N2 分别是 GaN 和 InGaN 生长的载气. MQW 由两个周期的 InGaN/GaN QW 组成。在每个孔层的生长过程中,TMIn 流速保持恒定。然后在与阱层相同的温度(即 710°C)下生长 GaN 盖层。之后,温度上升到 830°C,并保持几秒钟,然后在 830°C 下生长阻挡层。样品 A 和 B 的生长条件相同,除了 GaN 帽层生长时间,即样品 A 为 30 s,样品 B 为 200 s。 两个 InGaN/GaN MQW 的结构和生长参数示意图 A和 B 如图 1 所示。
<图片>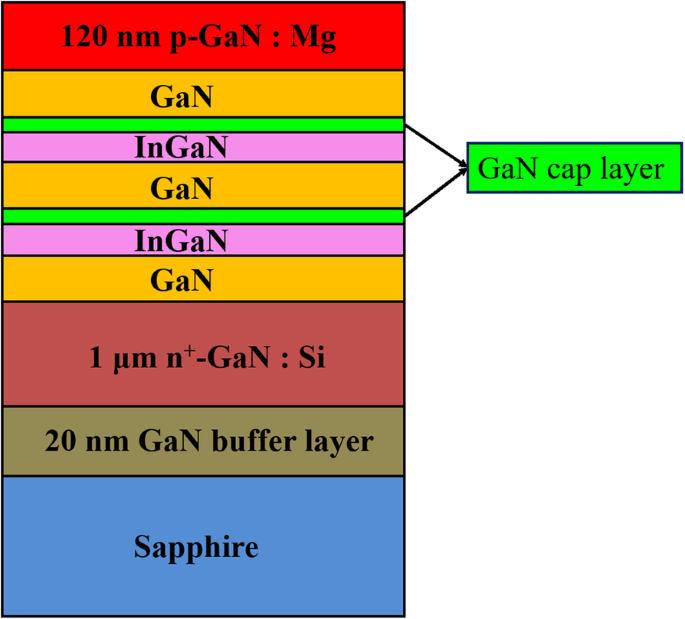
两个MQW的外延层结构截面示意图
特征化
为了确定两个 InGaN/GaN MQW 的平均铟含量、周期厚度和材料质量,使用 Rigaku Ultima IV 和 Cu-Ka 辐射(λ =1.54 Å)进行高分辨率 X 射线衍射 (HRXRD) 测量40 kV 和 30 mA。对于温度相关光致发光 (TDPL) 和激发功率相关 PL (PDPL) 测量,使用 405 nm 激光作为激发光源,光斑尺寸为 0.5 mm 2 ,激发功率从 0.01 到 50 mW 不等。样品安装在封闭循环 He 低温恒温器中,温度控制在 10 到 300 K。
结果和讨论
为了研究两个样品 A 和 B 的结构特性,进行了 ω-2θ 对称(0002)扫描,如图 2a 所示。衬底峰来自 GaN (002) 平面,卫星峰来自 MQW。在所有两个样本中都可以清楚地观察到高达四阶的卫星峰,表明层具有良好的周期性。此外,通过对实测曲线进行拟合,可以得到平均铟成分和周期厚度,如表1所示。可以看出,随着盖层厚度的增加,GaN势垒厚度以及InGaN的厚度和铟成分井层略有增加。实际上,由于盖层的生长速度低至 0.006 nm/s,生长温度低至 710 K,因此势垒厚度的变化相对较小。然而,需要注意的是,额外的 GaN 盖层的生长可能不仅会影响势垒层的厚度,还会影响 InGaN 阱层中 In 原子的扩散、蒸发和重新分布,这将在后面详细讨论。 <图片>
两个样品的 Omega-2theta 扫描和倒易空间映射由 HRXRD 执行。 一 样品 A 和 B 在 GaN (0002) 平面上的 HRXRD Omega-2theta 曲线。b 样品A的GaN(10-15)衍射的倒易空间映射(RSM)
同时,为了检查 GaN QB 和 InGaN QW 层的应变状态,在 GaN (10-15) 面附近执行倒易空间映射 (RSM)。样品 A 的结果如图 2b 所示(B 的 RSM 图类似,但此处未显示)。我们可以观察到,对于样品 A,MQW 和 GaN 峰的卫星峰在同一条垂直线上很好地对齐,表明两个样品的 MQW 完全应变,没有任何松弛[23]。
图 3 显示了两个样本在 10 K 下的 PDPL 测量结果。有趣的是,两个样本表现出完全不同的行为。对于样品 A,有一个位于较低能量侧的小峰(峰 A 1) 主峰A 2. 确认峰A 1 是声子复制品,距离主峰 A 92 meV 2. B 的声子复制品 2 也出现在样品 B 中,称为峰 B 1. 另一方面,在图 3b 中,可以观察到只有一个主发光峰 B 2 激发功率低于 5 mW。然而,当激发功率高于 10 mW 时,另一个峰值 B 3异常出现在B的高能侧 2、峰值B 3 逐渐成为主要发射峰而不是 B 2 当激发功率进一步增加时。在这里,我们可以假设大多数光激发载流子首先被困在第一种电子态(例如,由局部富 In 簇产生的局域态),然后辐射复合,产生发光峰 A 2 和 B 2. [24]。
<图片>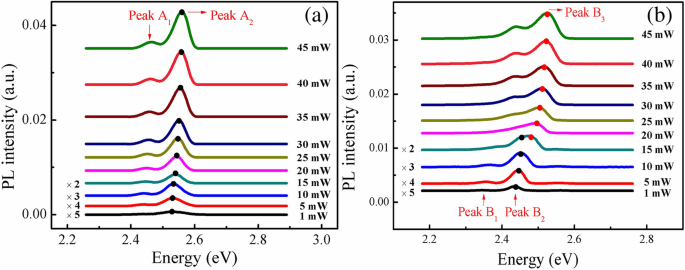
样品 A (a ) 和 B (b ) 在几种不同的激发功率下,在 10 K 的温度下测量
检查异常峰B的行为 进一步参考样品 B 的 3,我们在图 4 所示的不同激发功率下进行了 TDPL 测量,其中图 4a 和 b 分别是在 5 mW 和 40 mW 激发功率下获得的 PL 光谱。请注意,图 4b 中发射光谱的双峰现象在低于 200 K 的温度下清晰可见,并在接近 300 K 时变得模糊。总结发射光谱行为,可以看到从低能量发射峰到高能量发射峰出现在较窄的激发功率范围内,具有“开关”特性。在狭窄的过渡区之外,单个低能量(B 2) 或高能量 (B 3) 发射峰分别在低激发功率和高激发功率下占主导地位。
<图片>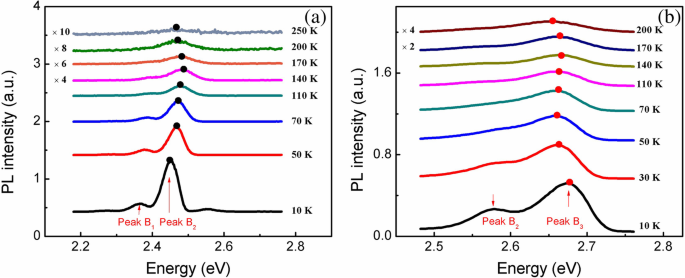
样品 B 在 10-300 K 温度范围内的 PL 光谱,在 5 mW (a ) 和 40 mW (b )
此外,仔细检查两个样品的主要发射峰值能量随温度的变化,我们可以发现一些独特的东西。如图 5a 所示,当样品 A 的激发功率从 5 mW 增加到 40 mW 时,PL 峰值能量随温度升高的变化(以下称为 ET 曲线)呈现“倒 V 形”曲线,这与常规的不同“S”形。除了峰值能量的整体蓝移之外,随着激发功率的增加,反转的 V 形几乎没有变化。反转的“V”形温度依赖性被解释为发光中心载流子填充效应和带隙收缩效应的共同作用,伴随着温度的升高[25, 26]。另一方面,如图 5b 所示,样品 B 在低于 5 mW 的激发功率下的 E-T 曲线显示出倒 V 形。这种情况与样品 A 类似。但是,当激发功率逐渐增加到 40 mW 时,在较低温度范围内出现第一次红移,E-T 曲线呈规则的 S 形。显然,这种现象与当激发功率足够大时,局域效应完全消失,峰值能量的温度行为将密切遵循Varshni定律[27]的预期相矛盾。
<图片>
样品 A (a ) 和 B (b ) 在不同的激励功率下。实线是使用 LSE 模型的理论拟合曲线。圆点为实验数据
因此,为了定量解释观察到的局域态发光的异常激发光功率依赖性,采用 LSE 发光模型来拟合 E-T 曲线,这是由 Q. Li 等人提出的。该型号适用于所有温度范围,不仅可以拟合“S”形E-T曲线,还可以拟合“V”形或倒“V”形。此外,还证明了LSE模型在高温下可以简化为Eliseev等人的带尾模型[24, 25]。在该模型中,作为温度函数的峰值能量可以描述为[18,19,20,21]:
$$ E(T)=\left({E}_0-\frac{\alpha {T}^2}{\theta +T}\right)-{xk}_BT $$ (1)其中 θ 是特定材料的德拜温度,a 是 Varshni 参数,k B 是玻尔兹曼常数,x 可以通过以下超越方程进行数值求解[18,19,20,21]:
$$ {xe}^x=\left[{\left(\frac{\sigma}{k_BT}\right)}^2-x\right]\left(\frac{\tau_r}{\tau_{tr} }\right){e}^{\left({E}_0-{E}_a/{k}_BT\right)} $$ (2)其中 σ 是局部状态分布的标准差。换句话说,它意味着高斯型态密度分布的宽度。 τ r 和 τ tr 代表局部载流子的辐射复合和逃逸寿命,因此 τ r /τ tr 意味着非辐射重组的载流子部分。 E 0 是局部中心的中心能量,E a 给出了一个“标记”能级,低于该能级的所有局域态都被 0 K 处的载流子占据,这就像费米-狄拉克分布中的准费米能级一样。很明显 E 0 和 E a 共同与发光定域中心的起源有关[17]。
得到的两个样本的拟合参数如表2所示。对于样本A,中心能量E 0 和 E a 分别从 5 到 40 mW 变为 19 meV 和 18 meV。注意到 E 0-E a 和 σ 几乎没有变化。这是因为随着激发功率的增加,会激发越来越多的载流子。首先,InGaN阱的强压电场会被光生载流子屏蔽,导致中心能量E增加 0. 其次,越来越多的载流子会根据填充效应占据更高的电子态,导致局域载流子的准费米能级E 一个。因此,E 0-E a代表偏振屏蔽效应和载流子填充效应的共同作用,因此观察到样品A的峰位整体蓝移。与样本 A 不同,对于样本 B,从 5 到 40 mW,E 有更大的增加 0 和 E a,分别为 73 meV 和 57 meV。 E 0-E 增加 16 meV,τ r /τ tr 变化了几个数量级,σ 减少一点。这种变化太大了,我们不得不假设在5 mW和40 mW的不同激发功率下发光中心的起源是不同的。
因此,建议对于样品B,由于铟组分的不均匀分布,存在两种局域态,分布在阱层中的两个不同能量深度,即具有较高的铟组分(深局域态)和较低的铟成分(浅定位状态)。此外,为了解释样品 B 的上述现象,图 6 中绘制了指示两种局域态之间载流子重新分布可能机制的示意图。在 10 K 时,在较低的激发功率(例如 5 mW)下,如图所示在图 6a 中,大多数光激发载流子首先被困在第一种类型的电子态(深局域态)中,因此较低的能量峰值占主导地位,而在 40 mW 时,如图 6b 所示,越来越多的光生载流子会占据较高的能级,然后能量态密度较高的浅局域态也被填充,因此随着激发功率的增加,较高的能量峰逐渐占主导地位。因此,E 0 和 E 增加了很多,τ r /τ tr 增加几个数量级,这意味着载流子脱离局域状态的能力。随着温度升高到 30 K,在 5 mW,如图 6c 所示,具有一定热能的光生载流子主要用于填充更深的局域态,导致 E-T 曲线的第一次蓝移;然而,在图 6d 中,当谈到 40 mW 时,基于浅局域态比深局域态具有更大容量的假设,大多数光生载流子停留在浅局域态,并且将能够转移到具有很强结合载流子能力的深局域态。因此,E-T 曲线红移。换言之,由于样品 B 的 InGaN 阱层中铟分布不均匀,ET 曲线的外观异常变化与多种局域态有关。 这种成分波动主要是由于样品 B 上的随机合金波动造成的。原子尺度[28]。
<图片>
示意图显示了不同激发功率下 PL 峰值能量与 T 曲线异常变化的可能机制。较低 T (10 K) 下的载流子分布显示在 (a ) 和 (b ) 对于 P =5 mW 和 40 mW,分别。较高 T (30 K) 下的载流子分布显示在 (c ) 和 (d ) 对于 P =5 和 40 mW,分别
此外,样品B在高激发功率下出现的高能量发射峰也导致PL积分强度的异常变化。在图 7 中,分别绘制了在 5 mW 和 20 mW 激发功率下测量的样品 A 和 B 的积分强度与温度曲线。首先,请注意样品 B 的热猝灭明显快于样品 A。通常,InGaN MQW 的发光热猝灭主要由非辐射复合过程主导,可用 Arrhenius 方程描述。因此,快速热猝灭意味着样品 B 的热稳定性较差。 此外,当激发功率足够高时,非辐射复合中心在较低温度下的影响不会那么明显,因为非辐射复合中心很容易饱和由多余的载体 [27]。这可以很好地解释随着样品 A 激发功率的增加,PL 积分强度与 1/T 曲线的较慢变化。然而,样品 B 非常有趣的是,5 mW 激发功率下的归一化积分强度甚至更高当温度低于 125 K 时低于 20 mW,而在高于 125 K 时则相反。如前所述,假设只有一个源自深局域态的较低能量发射峰占主导地位在 5 mW,而另一个源自浅局域态的更高功率在 20 mW 时占主导地位。因此,可以得出结论,深局域发光中心比浅发光中心具有更好的发光效率。这与先前与局部状态相关的研究结果非常吻合[28]。因此,也可以在一定程度上证明样品B在20 mW激发下有两种局域态。
<图片>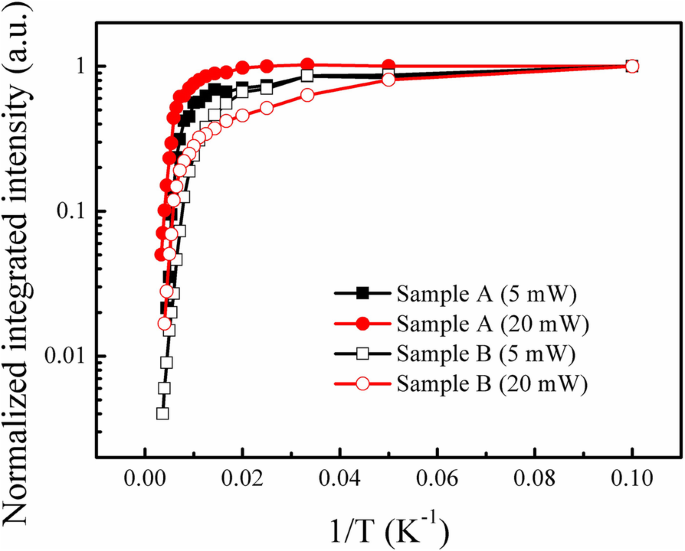
在 5 mW 和 20 mW 激发功率下测量的两种样品在 10-300 K 温度范围内的 PL 光谱中提取的积分强度
基于所有这些分析,我们证明峰值 B 3源于样品B中铟组分分布不均匀导致电位较低的局域态,与较高发射能量峰B的实验结果吻合较好 3 以及在较高激发功率下低温下样品 B 的 IQE 降低。实际上,在 QW 的生长过程中,考虑到拉动效应,铟原子很容易在 InGaN QW 层的顶部积累并形成一个额外的层,称为铟浮层 [29]。在低温下生长较厚的 GaN 盖层不利于这些铟浮动原子的蒸发。因此,在 QW 生长之后,In 原子可能会结合到 GaN 盖层和势垒层中 [30]。自然地,这种行为会导致阱层厚度的增加,从而提高 QCSE。有源 QW 中更高的应变和更强的压电场会引起更多的局部弛豫,从而产生更深的局部电位和更高的势垒。同时,更多的位错和缺陷被引入到GaN势垒层的后续生长中。一般位错附近有较大的拉应力,铟原子容易在位错附近聚集,分布不均匀。 [31, 32] 因此,在InGaN阱层的生长过程中,随着位错密度的增加,富铟区和贫铟区越来越多。这意味着随着覆盖层厚度的增加,铟波动的规模将变得更大。在我们的实验中,它表明两种不同的局域态被引入到具有较厚帽层的样品 B 中,并且在更高的激发功率下激活了更高发射能量的 PL 峰。另一方面,停留在深局域态的光生载流子可以屏蔽缺陷,从而具有更好的热稳定性,而停留在浅局域态的光生载流子一旦克服了缺陷相关的非辐射复合,就会被缺陷相关的非辐射复合捕获。相对较低的屏障高度。
结论
总之,通过金属有机化学气相沉积系统 (MOCVD) 制备了在 InGaN 阱层上额外生长的具有不同厚度的 GaN 帽层的 InGaN/GaN 多量子阱 (MQW) 样品。通过 HRXRD、TDPL 和 PDPL 测量研究并分析了它们的结构和光学特性。 PDPL 结果表明,仅对于生长有厚盖层的样品 B,在更高的激发功率下会激发一个额外的高发射能量峰。同时,样品 B 在不同激发功率下测量的 TDPL 结果表明,当激发功率增加时,主导 PL 峰的 E-T 曲线从反 V 形变为规则的 S 形。此外,还发现样品 B 在高激发功率下的热稳定性较差。这些异常现象意味着样品 B 存在两种由相对不均匀的铟分布引起的局部状态。这些结论使我们进一步了解绿色InGaN/GaN量子阱的光致发光机理和高激发能级下的不均匀性效应,有助于我们制造InGaN/GaN激光二极管。
缩写
- HRXRD:
-
高分辨率X射线衍射
- LD:
-
激光二极管
- LED:
-
发光二极管
- 伦敦证券交易所:
-
本地化状态集成
- MOCVD:
-
金属有机化学气相沉积系统
- MQW:
-
多量子阱
- NH3 :
-
氨
- PDPL:
-
功率相关的光致发光
- RSM:
-
倒易空间映射
- TDPL:
-
温度依赖性光致发光
- TMGa:
-
三甲基镓
- TMIn:
-
三甲基铟
纳米材料
- H2/NH3 混合气体中基于 GaN 的多量子阱的原子重排以改善结构和光学性能
- 电子倍增器发射层的设计
- 具有半极性 InxGa1−xN/GaN 多量子阱的紫外 GaN 基光子准晶纳米锥结构的多色发射
- 检测自组织 InAs/InGaAs 量子点超晶格中的空间局域激子:提高光伏效率的一种方法
- 退火 GaAsBi/AlAs 量子阱中的铋量子点
- 通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 生长序列中量子势垒的最佳硅掺杂层形成八周期 In0.2Ga0.8N/GaN 蓝色量子阱的软限制势LED
- 背面有黑硅层的晶体硅太阳能电池的研究
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- 了解机械剥离石墨上 GaN 外延层的生长机制
- 采用后沉积蚀刻的浸渍法制备周期性聚苯乙烯纳米球阵列及其在提高 InGaN/GaN 光提取效率中的应用LED


