温度相关的 HfO2/Si 界面结构演变及其机制
摘要
在这项工作中,氧化铪 (HfO2) 薄膜通过远程等离子体原子层沉积在 p 型 Si 上在 250 °C 下沉积在 p 型 Si 衬底上,然后在氮气中快速热退火。研究了后退火温度对 HfO2 薄膜和 HfO2/Si 界面结晶的影响。通过场发射透射电子显微镜、X 射线光电子能谱、X 射线衍射和原子力显微镜研究 HfO2 薄膜和 HfO2/Si 界面的结晶。实验结果表明,在退火过程中,氧从 HfO2 扩散到 Si 界面。对于低于 400 °C 的退火温度,HfO2 薄膜和界面层为非晶态,后者由 HfO2 和二氧化硅 (SiO2) 组成。在450-550 °C的退火温度下,HfO2薄膜变成多相多晶,界面处发现结晶SiO2。最后,在超过550 °C的退火温度下,HfO2薄膜以单相多晶为主,界面层完全转变为结晶SiO2。
介绍
氧化铪 (HfO2) 薄膜是一种适用于各种应用的有趣材料。由于具有高密度、高折射等优异特性,可用于多层光学镀膜[1]、保护镀膜[2]、栅极电介质[3]、钝化层[4,5,6]等。指数、宽带隙和相对较高的热稳定性。许多方法已被用于制备 HfO2 薄膜,如电子束蒸发 [7]、化学溶液沉积 [8]、反应溅射 [9]、金属有机化学气相沉积 [10]、分子束外延 [11] 和原子层沉积 (ALD)。 ALD是获得具有高精度厚度控制和高精度均匀性的薄膜的有前途的方法。发现后退火对 ALD HfO2 薄膜有显着影响 [12,13,14,15]。根据研究,HfO2 薄膜可以在高于 500 °C 的退火温度下结晶 [16,17,18]。 HfO2 的晶体结构强烈影响光学和电学特性。例如,HfO2 从非晶相到单斜晶相的结构变化可能导致折射率从 1.7 变为 2.09,光学间隙从 5.75 变为 6.13 eV,介电常数从 24.5 变为 14.49 [19, 20]。对于沉积在硅衬底上的 ALD HfO2,通常在 HfO2/Si 界面处观察到氧化层 [21, 22]。据报道,该界面层的存在会降低介电常数 [22]。此外,科帕尼等人。 [23] 介绍了硝酸氧化 n 掺杂 Si 衬底后 5 纳米 HfO2 薄膜的结构特性。他们发现高退火温度会增加晶核的生长速度。然而,对它们的结晶特性,特别是 HfO2/基材界面的研究很少。因此,退火温度对ALD制备的HfO2薄膜结晶性能的影响值得进一步研究。
在这项工作中,HfO2 薄膜是通过远程等离子体原子层沉积 (RP-ALD) 在 p 型硅衬底上制造的。后退火通过不同温度下的快速热退火 (RTA) 系统进行。通过原子力显微镜 (AFM)、掠入射 X 射线衍射 (GIXRD)、X 射线光电子能谱 (XPS) 和高分辨率透射电子显微镜 (HR) 表征了 RTA 制备的 HfO2 薄膜的结构变化和结晶性能。 -TEM)。还研究了温度依赖的HfO2/Si界面结构演化及其机制。
方法
使用了电阻率为 30 Ωcm 的双面抛光 (100) 取向 p 型 2 英寸 250 微米直拉硅晶片。在沉积之前,Si 晶片通过标准的美国无线电公司方法清洁,然后浸入稀释的氢氟酸溶液 (5%) 2 分钟以去除可能的杂散氧化物,而无需最后用水冲洗。清洁后,所有晶片都用纯氮气 (N2) 干燥并安装到基板支架上。大约 15 nm HfO2(168 个 ALD 循环)薄膜通过 RP-ALD(Picosun R-200,芬兰)使用四(乙基甲基氨基)铪(TEMAH)和氧气(O2)在交替脉冲和 N2 吹扫下沉积在 Si 晶片上脉冲之间的反应室。 TEMAH 和 O2 等离子体按以下顺序脉冲进入反应器:TEMAH 脉冲 1.6 s; N2 吹扫 10 s; O2 等离子脉冲 10 s,N2 吹扫 12 s。沉积 HfO2 薄膜后,在 N2 环境中进行快速热退火 10 分钟。退火温度从 400 到 600 °C 不等,以研究对 HfO2 薄膜和 HfO2/Si 界面结晶的影响。表 1 列出了 RPALD 和后退火的典型条件。
AFM 测量以轻敲模式进行,以研究 HfO2 薄膜的表面形态。这项工作中显示的 AFM 图像是 2 μm × 2 μm 扫描,分辨率为 256 点 × 256 线。 HfO2 薄膜的结构通过使用 Cu 长细焦点 X 射线管的掠入射 X 射线衍射(GIXRD,Rigaku TTRAXIII,日本)测量来表征。在50 kV的工作电压和300 mA的电流下产生波长为0.154 nm的X射线。选择 0.5° 的入射角以获得超过 2θ 的衍射图 20-60°的范围。 X射线光电子能谱(XPS,Thermo Fisher K-alpha)也使用单色Al Kα X射线辐射(hν =1486.6 eV)进行。对于 XPS 分析,使用 100 微米直径的光斑,并以 45° 的起飞角收集光电子。 HfO2 薄膜的横截面是在 Hitachi NX2OOO 系统中通过聚焦离子束提升技术制备的。 HfO2薄膜的横截面图像通过场发射高分辨率透射电子显微镜(HR-TEM,JEM-2100F,USA)进行检查。
结果与讨论
图 1 显示了在不同温度下退火的 HfO2 薄膜的 AFM 图像。显示均方根 (RMS) 和平均表面粗糙度 (Ra) 值以指示表面粗糙度。沉积态薄膜的 RMS 值为 0.44 nm。当退火温度上升到 500 °C 时,它会略微增加到 0.47 nm。进一步将退火温度提高到 600 °C 会导致表面粗糙度显着增加,RMS 增加到 0.69 nm。在 Ra 值中观察到相同的趋势。退火膜表面粗糙度的增加可能预示着结构的变化。
<图片>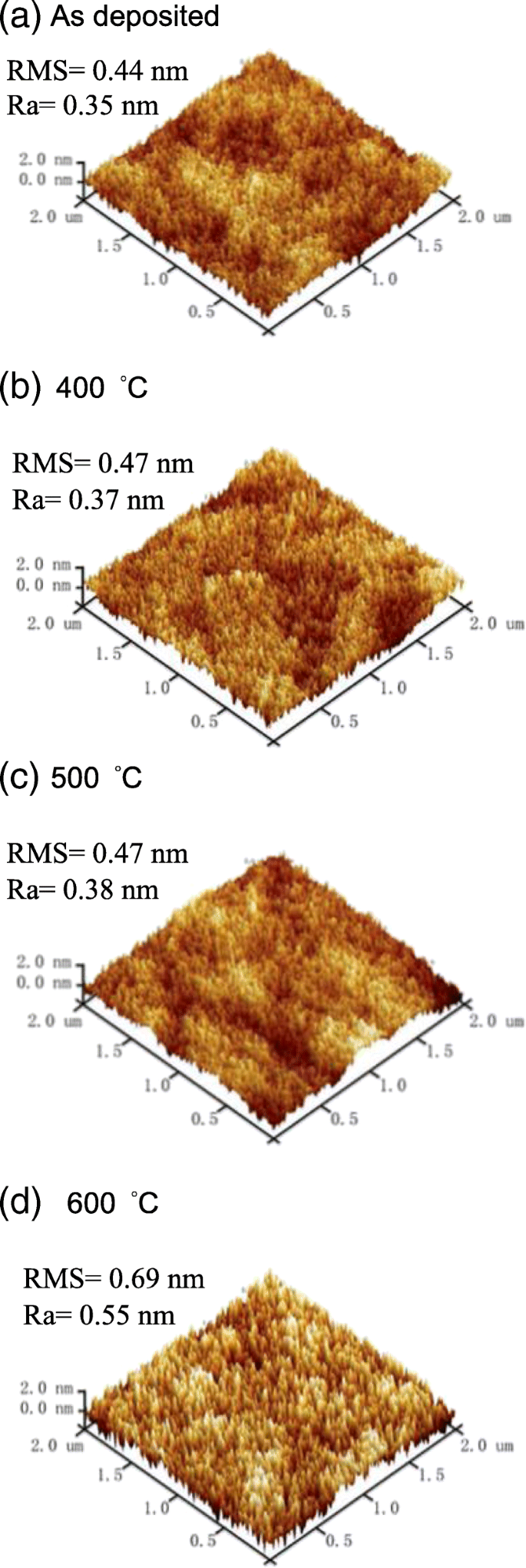
a 的 AFM 图像 原样,b 400 °C 退火,c 500 °C 退火,d 600 °C退火的HfO2薄膜
图 2 显示了各种 HfO2 薄膜的温度相关 GIXRD 光谱。沉积的 HfO2 薄膜是非晶态的,在 400 和 450°C 下退火后仍保持非晶态。在高于 500 °C 的退火温度下,出现衍射峰,表明形成了结晶 HfO2。在 1/d =0.319 和 0.354 Å −1 处的峰值 分别对应于- 111 和 111 平面到单斜相(ICDD PDF#34-0104,空间群 P21/c)。 1/d =0.340 Å −1 处的峰 对应于正交相的 (111) 平面(ICDD PDF#21-0904,空间群 Pbcm)。 1/d =0.380~0.395附近的其他峰是单斜晶相的200、020、002面和正交晶相的020面。结果还表明,随着退火温度的升高,单斜晶相减少,斜方晶相增加。在较高的退火温度下,正交晶系 HfO2 在晶体结构中占主导地位。然而,与 ICDD PDF#21-0904 中的衍射峰相比,在较低的 1/d(较小的 d 间距)处观察到正交 HfO2 的衍射峰。此外,1/d =0.340 Å −1 的位移 向更高的值表示d间距随着退火温度的增加而减小。
<图片>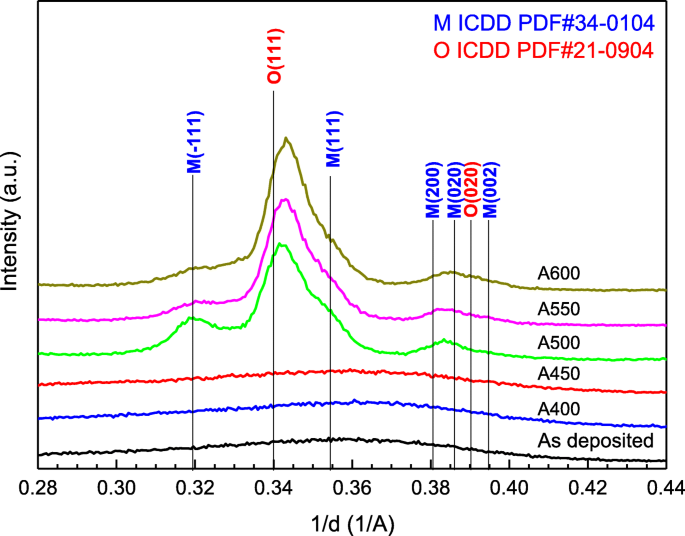
不同温度退火HfO2薄膜的GIXRD谱
HfO2 薄膜中 Hf 和 O 的浓度使用深度剖面 XPS 测量。图 3 显示了沉积态和退火后的 HfO2 薄膜的 O/Hf 组成比。随着退火温度的升高,O/Hf 比从 1.60 降低到 1.29。由于在退火过程中使用了 N2,HfO2 随着温度的升高而变得缺氧。如前所述,缺氧的 HfO2 薄膜也导致较小的 d 间距。
<图片>
不同温度退火HfO2薄膜的氧与铪原子比
图 4a、b、c、d、e 和 f 显示了沉积态 400 °C-、450 °C-、500 °C-、550 °C-和 550 °C-的高分辨率横截面 HR-TEM 图像分别在 Si 衬底上经过 600 °C 退火的 HfO2 薄膜。可以看出,在这些图像中清楚地展示了 HfO2 层和 Si 衬底。此外,在 HfO2 和 Si 衬底之间的厚度为 1-2 nm 的薄层可以是 SiO2 膜。如图 4a 所示,沉积的 HfO2 薄膜中没有明显的晶格排列,表明该薄膜是非晶态的。在 400 °C 下退火后,尽管 HfO2 薄膜的大部分区域仍然是非晶态,但我们可以观察到,在该薄膜中形成了一部分 d 间距值为 2.82 和 3.12 Å 的晶格排列。这两个 d 间距值分别指向单斜 HfO2 (111) 和单斜 HfO2 (- 111) 平面,并且 400 °C 退火膜显示纳米晶体结构。随着退火温度从 400 升高到 600 °C,HfO2 薄膜的晶体质量逐渐提高。当 HfO2 薄膜在 500-550 °C 下退火时,可以确定由单斜 HfO2 (- 111)、单斜 HfO2 (200) 和正交 HfO2 (111) 组成的主要晶格排列。然而,进一步提高退火温度至600 °C,薄膜中仍然存在正交HfO2(111)晶格结构,其他两种晶格排列逐渐消失。另一方面,500 °C-、550 °C-和600 °C-退火的HfO2薄膜的正交HfO2(111)平面的d间距值分别确定为2.93、2.90和2.88 。这与 XRD 结果非常吻合,即随着退火温度从 500 增加到 600 °C,正交 HfO2 (111) 衍射峰向大角度方向移动。结果表明,随着退火温度的升高,HfO2薄膜的氧含量逐渐降低。另一个有趣的现象可以在 SiO2 层的晶体结构和厚度的变化中找到。在沉积状态下,SiO2 层是无定形的。即使样品在 400 °C 下退火,热能也不足以将 SiO2 层的结构从非晶态转变为晶态。然而,通过将退火温度从 450 提高到 600 °C,会形成结晶 SiO2 层(具有立方 SiO2(220)结构),其厚度从 1.0 增加到 1.6 nm。可以观察到,样品在 600 °C 下退火后,非晶 SiO2 层完全转变为立方 SiO2 结构。随着退火温度从 550 增加到 600 °C,立方 SiO2 (220) 的 d 间距值从 2.48 增加到 2.56 Å。这意味着 SiO2 层的氧含量随着退火温度的升高而增加。可以合理地推测,SiO2 层中氧含量的增加归因于源自 HfO2 膜的氧原子的扩散。此外,退火温度为550和600 °C时,整体厚度减小,这可能与结晶和除氢引起的膜密度增加有关。
<图片>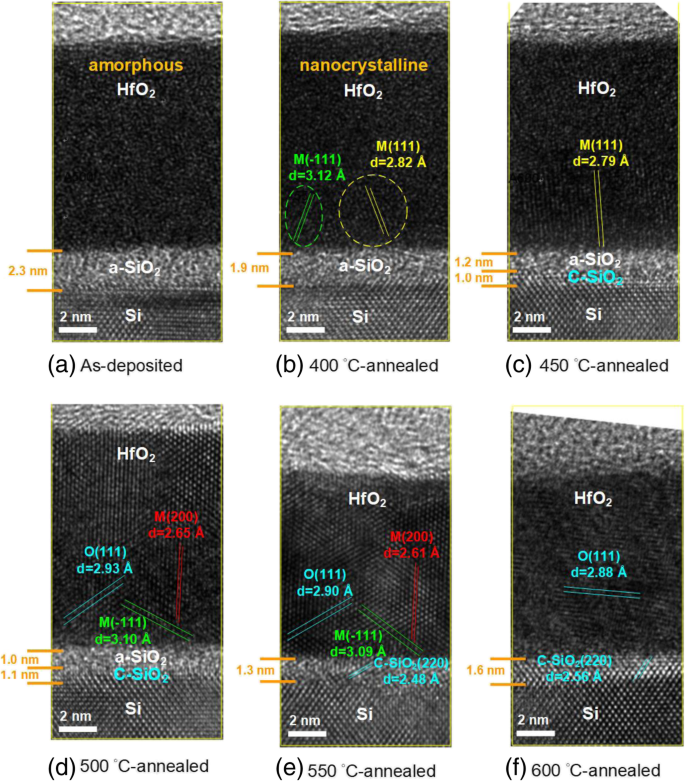
a 的横截面 TEM 图像 原样,b 400 °C 退火,c 450 °C 退火,d 500 °C 退火,e 550 °C 退火,f 600 °C 退火 HfO2/Si
基于上述结果,图 5 说明了不同退火温度下 HfO2 薄膜的机理。考虑到退火温度小于 400 °C(图 5a),薄膜是无定形的,其中 Hf 和 O 原子随机排列。 HfO2 和 c-Si 晶片之间的界面层是由 a-SiO2 和 a-HfO2 组成的混合氧化物。在 450-550 °C 的退火温度下(图 5b),HfO2 膜接收热能,导致结构从非晶转变为具有单斜相和正交相的多晶。根据 HR-TEM 和 GIXRD 结果指示晶体取向和 d 间距。形成结晶SiO2层。一些工作报道了在 a-SiO2 和 (100) c-Si 界面处的有序氧化硅层,但其机理和原子级结构仍存在争议。硅热氧化可以看作是氧原子顺序插入到 Si-Si 键中的操作,这会在氧化区域引起大量压缩应变的积累,并可能导致在 SiO2/c-Si 界面处结构转变为有序氧化物[24]。据报道,在 Si 的高氧过饱和度 [25] 或低界面缺陷密度 [26] 的条件下,可以形成结晶含氧相。从这项工作中的 XPS 和 TEM 图像来看,HfO2 层是缺氧的。大量的氧从 HfO2 向硅衬底扩散,这可能导致 c-Si 界面氧的过饱和和结晶 SiO2 的形成。在此温度范围内,结晶SiO2层厚度会增加,但a-HfO2 + a-SiO2混合层厚度会随着退火温度的升高而减小。在高于 550 °C 的退火温度下(图 5c),HfO2 结构以多晶正交(111)单相为主。界面层完全由结晶 SiO2 控制。正交 HfO2 层的 d 间距减小,而 c-SiO2 的 d 间距增大。虽然 HfO2 的退火对于实现高 Si 晶片钝化和介电常数是必要的,但在高温下,HfO2 和界面 SiO2 的结晶可能会降低薄膜性能。发现 500 °C 的退火温度可获得 17.2 的最佳介电常数。进一步提高退火温度会导致介电常数降低,这可能是由于结晶相的变化。富田等人。据报道,当结构从多晶转变为单斜晶系时,HfO2 的介电常数会降低 [27]。 HfO2/Si的最佳钝化也可以在500 °C的退火温度下获得,因为较高的温度可能导致完整的c-SiO2界面层和界面脱氢。
<图片>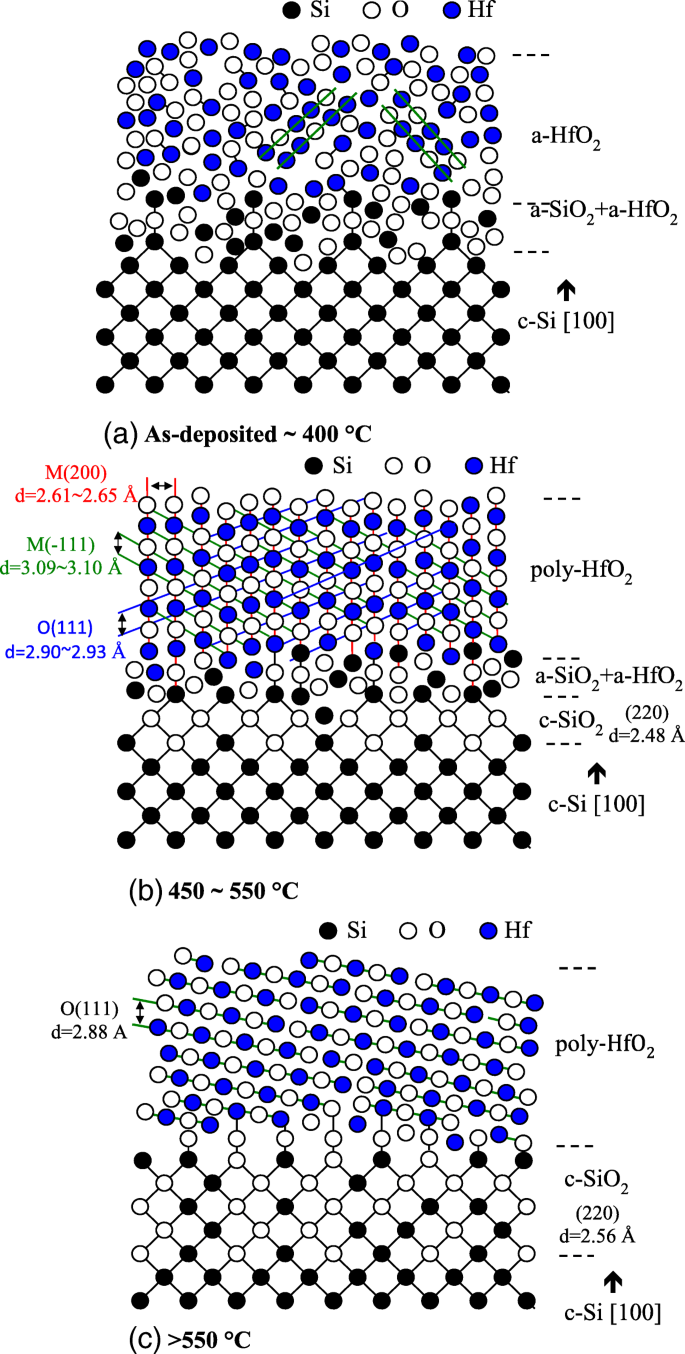
在a温度范围内HfO2薄膜和界面层的结晶机理图 沉积到 400 °C,b 450 至 550 °C 和 c 超过 550 °C。 d-间距值和晶体取向也被指出
结论
使用 RP-ALD 制备 HfO2 薄膜,并研究了退火温度对 HfO2 晶体结构的影响。对于沉积态的 HfO2 和在 400 °C 以下退火的 HfO2,HfO2 和界面层是非晶态的。随着退火温度的升高,正交晶界的 d 间距减小,而 c-SiO2 界面层的 d 间距增大,表明氧从 HfO2 扩散到 Si 界面。高于550 °C的退火温度显示HfO2层为多晶正交单相,界面层完全转变为c-SiO2。尽管 HfO2 在许多应用中需要退火,例如实现 Si 晶片的高钝化和高介电常数,但结晶可能对薄膜性能有害。 500 °C的退火温度可以获得最佳的Si晶片钝化质量和介电常数。
缩写
- 原子力显微镜:
-
原子力显微镜
- a-HfO2 :
-
无定形氧化铪
- ALD:
-
原子层沉积
- a-SiO2 :
-
无定形二氧化硅
- c-SiO2 :
-
结晶二氧化硅
- GIXRD:
-
掠入射X射线衍射
- HfO2 :
-
氧化铪
- HR-TEM:
-
高分辨透射电子显微镜
- N2 :
-
氮气
- O2:
-
氧气
- RMS:
-
均方根
- RP-ALD:
-
远程等离子体原子层沉积
- RTA:
-
快速热退火
- TEMAH:
-
四(乙基甲基氨基)铪
- XPS:
-
X射线光电子能谱
纳米材料
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 钯(II)离子印迹聚合物纳米球的制备及其从水溶液中去除钯(II)
- 氮化处理的基于 HfO2 的 RRAM 中的传导机制和改进的耐久性
- 在 Ge (100)、(110) 和 (111) 衬底上制造 SrGe2 薄膜
- 探测 Ag n V (n =1-12) 簇的结构、电子和磁特性
- CA/TPU 螺旋纳米纤维的制备及其机理分析
- 组合条纹图案的 FeCoBSi 薄膜的厚度相关磁和微波共振表征
- Si、Ge 和 Si/Ge 超晶格对低能辐射的辐射响应的理论模拟
- Pr2CuO4 纳米片的可控合成和选择性吸附特性:机理讨论
- PEG-PCCL 纳米颗粒的毒性评估及其负载紫杉醇抗肿瘤作用的初步研究
- 蚀刻变化对 Ge/Si 沟道形成和器件性能的影响


