通过集成选择性外延生长和选择性湿蚀刻方法制造高质量和应变松弛的 GeSn 微盘
摘要
GeSn 是一种用于制造片上光子和纳米电子器件的有前途的材料。因此已经开发出专用于 GeSn 的加工技术,包括外延、退火、离子注入和蚀刻。在这项工作中,通过一种新方法实现了悬浮、应变松弛和高质量的 GeSn 微盘,而无需对 GeSn 合金进行任何蚀刻。 GeSn合金通过分子束外延在低温下在预图案化的Ge(001)衬底上生长。进行透射电子显微镜和扫描电子显微镜以确定GeSn样品的微观结构。通过控制选择性湿法刻蚀时间制备了不同直径的锗基座微盘,显微拉曼结果表明,剩余锗基座不同尺寸的微盘具有不同程度的应变弛豫。在合适的条件下,微盘的压缩应变几乎完全松弛。这项工作中提出的半导体加工技术可以作为一种替代方法来制造创新的基于 GeSn 和其他材料的微/纳米结构,用于一系列 Si 兼容光子学、3D-MOSFET 和微机电设备应用。
介绍
锗锡 (GeSn) 是一种互补金属氧化物半导体 (CMOS) 兼容的 IV 族材料,近年来因其在电子和光电子领域的应用而备受关注。将更多的 Sn 合金化到 Ge 中可以提高载流子迁移率,并将带隙从间接过渡到直接过渡 [1, 2]。理论工作 [3,4,5] 和基于光致发光的实验研究 [6,7,8] 表明,松弛的 GeSn 合金从间接到直接的转变发生在 Sn 含量不低于 6.5% 时。然而,Sn 在 Ge 中的低 (1%) 平衡溶解度 [9, 10] 以及 Ge 和 α-Sn 之间的大晶格失配 (~ 15%) 为实现无缺陷的 GeSn 合金带来了巨大挑战,即使是取代 Sn 的几个原子百分比。使用非平衡生长技术,例如低温分子束外延 (MBE) [11,12,13,14,15]、化学气相沉积 (CVD) [16,17,18,19,20] 和固相外延 [21, 22] 急需。
在应变松弛的 Ge 虚拟衬底或 Ge 衬底上生长的 GeSn 合金的情况下,预计在伪晶或完全应变的条件下可以获得最高质量的 GeSn,这可以避免形成错配和螺纹位错。然而,这种 GeSn 合金是压缩应变的(每 1% Sn~ 0.15%),并且这种外延诱导的应变抵消了将 Sn 与 Ge 合金化以实现带隙转换的效果。因此,Ge (001) [23] 上的假晶 GeSn 外延层需要更高的 17% Sn 含量来实现直接带隙,从而导致外延和低材料质量的极高挑战。因此,在不牺牲 GeSn 外延层晶体质量的情况下控制应变成为一个非常重要的问题。选择性去除 GeSn 外延层下方的应力诱导 Ge 虚拟衬底或 Ge 衬底以形成部分悬浮的微结构是克服 GeSn 膜中压缩应变的有前途的技术。例如,制造了在中心带有支柱的悬浮 GeSn 微盘 [24,25,26,27,28]。该结构不仅可以通过自由表面的弹性变形来松弛 GeSn 层中的压缩应变,而且由于 GeSn 与周围介质(空气)之间的强烈折射率对比,例如耳语,还可以将光学模型限制在微盘边缘附近-画廊模式 [16, 25]。到目前为止,仅报道了一种通过二维 GeSn 膜的生长后光学光刻和自上而下蚀刻制备 GeSn 微盘的方法 [16, 24, 29, 30]。然而,该工艺在生长后蚀刻过程中可能会受到热失配的影响,这将导致 GeSn 微盘的材料质量下降。最近,P.Ponath 等人。报道了高度结晶 c 的选择性区域生长 轴定向 BTO [31],这启发了我们制造 GeSn 微结构。通过在最后一步直接在预先图案化的 SiO2/Ge 衬底上沉积 GeSn 微盘,然后在去除牺牲 SiO2 层后选择性地蚀刻掉 Ge 衬底,无需传统和复杂的生长后蚀刻工艺即可制造悬浮的 GeSn 微盘。如果可行,这种方法可以避免上述问题,从而获得更高质量和应变松弛的 GeSn 微观结构。此外,它也是一种非常有前景的方法,可以实现高精度和良好纵横比的任意图案,特别是对于需要精确控制层厚度的复杂器件结构的三维集成。
在本文中,GeSn 微盘结构通过一种新方法成功制造。这是第一次通过将选择性外延生长与选择性湿蚀刻的简单步骤相结合来制备 GeSn 微盘。 GeSn 外延层的厚度、Sn 浓度和晶体质量通过高分辨率透射电子显微镜 (HRTEM) 和二次离子质谱 (SIMS) 进行表征。使用扫描电子显微镜 (SEM) 和微拉曼光谱 (μ-Raman) 来深入了解所制造的 GeSn 微盘的微观结构。室温 (RT) μ-Raman 结果表明,剩余 Ge 基座的不同尺寸的微盘具有不同程度的应变弛豫。在合适的条件下,微盘的压缩应变几乎完全松弛。这种无需刻蚀GeSn本身即可制备微盘的方法有利于获得弛豫的高质量GeSn等材料纳米结构。
方法
材料
Ge晶片购自AXT公司。丙酮、异丙醇、氢氟酸、乙醇、双氧水、氨水和氢氧化钾由国药化学试剂(中国)提供。去离子水 (18.2 MΩ·cm) 来自超滤系统 (Milli-Q, Millipore, Marlborough, MA).
图案化锗基板的制备
Ge (001) 晶片(n 型,0.025–0.031 Ωcm)首先浸入丙酮和异丙醇中 3 分钟,然后使用稀释的氢氟酸溶液(HF:H2O =1:20)在室温下化学清洗 20 秒.然后在流动的去离子水 (DI–H2O) 中冲洗。清洁程序很重要,尤其是 HF 处理,以剥离原生氧化层并确保 Ge 表面清洁并与下一个 SiO2 层紧密接触。在这种情况下,剥离剖面是通过沉积 Si/SiO2 复合层实现的。然后通过吹干 N2 将晶片干燥并快速装入等离子体增强化学气相沉积 (PECVD) 的超高真空 (UHV) 室中,并在 300°C 下退火 20 分钟以完全除气。然后,在相同温度下通过 PECVD 沉积 300 nm SiO2 层,然后在室温下通过磁控溅射沉积 50 nm 未掺杂多晶硅,如图 1a 所示。使用标准光刻技术(图 1b)和两步蚀刻工艺(图 1c、d)对 Si/SiO2 复合层中的圆形开口进行图案化。
<图片>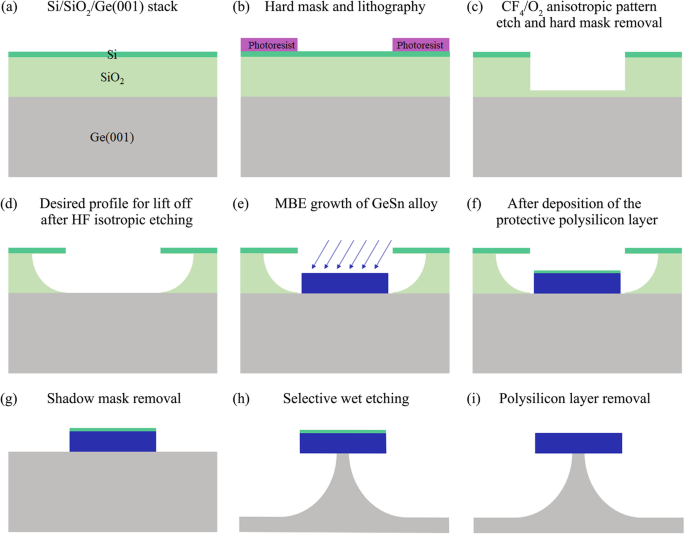
制备悬浮GeSn微盘的横截面示意图
具体来说,在对 Si/SiO2/Ge 晶片进行图案化之前,先用丙酮、乙醇和 DI-H2O 清洗晶片,然后用 N2 吹干并在 90°C 的烘箱中进行预烘烤。此后,使用旋涂机以4000 r / min的速度旋涂AZ5214光刻胶30 s,然后放置在热板上在90°C下软烘烤2分钟。然后利用制版机(海德堡,uPG501)在 Si/SiO2/Ge 叠层上创建圆形图案阵列。圆形图案固定在彼此相距 5 μm 处,而直径范围从 3 到 5 μm。然后通过两步蚀刻将图案转移到底部 SiO2 层。使用CF4和O2的混合气体通过反应离子蚀刻的各向异性干蚀刻首先用于蚀刻Si/SiO2层,并在剩余约20nm的SiO2时停止。然后在室温下使用稀释的 HF 溶解光刻胶和湿蚀刻,以去除左侧的 SiO2 层,以暴露圆形开口中的锗,并在定义的多晶硅边缘下横向蚀刻以创建悬垂,这是所需的提升轮廓关闭。
GeSn 生长和微盘制造
对于GeSn薄膜沉积,基础压力为2×10 -10 的固体源MBE系统(Riber SSC) 托被使用 [32]。电子束蒸发器和使用高纯度固体源的热解 BN 喷流池配备用于 MBE 系统中的 Ge 和 Sn 蒸发。石英晶体监视器用于校准沉积速率。在将图案化基板装入 UHV 系统之前,用 O2 等离子体清洁基板以去除由干蚀刻引起的任何有机残留物。随后用丙酮、异丙醇和稀释的 HF 冲洗,将基板转移到 MBE 室中进行 GeSn 生长。在 450 °C 下热解吸 15 分钟后,基板原位冷却至 150 °C 以生长 GeSn 合金层,Ge 生长速率为 0.5 Å s -1 和受控的锡通量作为掺杂源。该生长温度足够低以有效抑制 Sn 表面偏析。为了防止氧化,最终在相同温度下沉积了10 nm的Ge盖层。
生长后,标称 Sn 浓度为 4% 和 10% 的 GeSn 合金将用于微盘制造。然后在室温下使用磁控溅射在样品顶部沉积另外 30 nm 厚的多晶硅层,以保护 GeSn 层免受后续蚀刻。然后,使用稀释的 HF (1:1) 去除牺牲 SiO2 层,这也导致去除覆盖的多晶硅层和沉积在其上的 GeSn 膜。从图 2 中可以看出,去除 SiO2 层后,出现了孤立的圆形 GeSn 台面。然而,圆形台面的外围不是那么光滑,这对光学限制效应不利。意想不到的情况是由底部SiO2层的边缘上的GeSn沉积引起的,这是由于底部SiO2的横向蚀刻不足和偏离法线角(30°)沉积引起的。随后,一个简单的选择性湿蚀刻步骤在 RT 处底切圆形台面,导致悬浮的 GeSn 微盘结构。选择性蚀刻剂 (APM) 由体积比为 2:0.5:80 [30] 的 H2O2 (31 wt%)、NH4OH (28 wt%) 和 DI-H2O 组成。最后,通过 KOH 去除顶部保护多晶硅层。工艺步骤示意图如图 1e-i 所示。
<图片>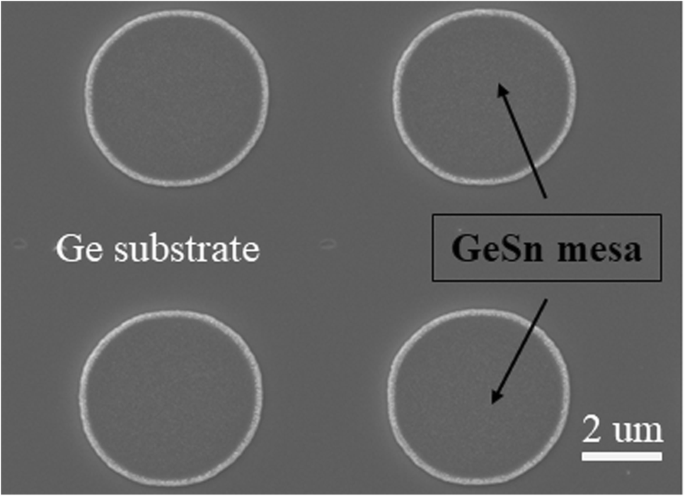
去除荫罩后孤立的 5 μm 直径 GeSn 圆形台面的俯视 SEM 图像
在我们制造 GeSn 微盘的方法中,由于具有不同 Sn 浓度的 GeSn 材料的蚀刻速率不同,因此最终的选择性湿法蚀刻很重要。 Ge 对 Ge1-xSnx 的蚀刻选择性也将随 Sn 浓度而变化。 GeSn 中 Sn 的浓度越高,SnOy 的表面覆盖率就越高 [33]。它会降低 GeSn 的湿蚀刻速率并导致 Ge 比 GeSn 更高的蚀刻选择性。之前的研究报道了基于 H2O2 的湿法蚀刻 (H2O2:NH4OH:H2O =2:0.5:80),与这项工作相同,实现了 Ge 对 Ge0.928Sn0.072 的蚀刻选择性为 9:1 [30] .
结果与讨论
图 3a 显示了没有顶部多晶硅层的 5 μm 直径 GeSn 圆形台面的横截面 TEM 显微照片。图 3b、c 是区域 A 和 B 的高分辨率 TEM (HRTEM) 显微照片,分别对应于 GeSn/Ge 界面和 GeSn 层的中间区域。 GeSn 层的膜厚比阴影掩模的厚度低约 250 nm(图 3a)。从图 3b 中可以看出,缺陷主要位于 30 nm 厚度的 GeSn/Ge 界面,导致以下单晶 GeSn 生长。 B 区的 HRTEM 图像显示 GeSn 层的清晰晶格条纹,表明该合金是高度结晶的,B 区的快速傅立叶变换 (FFT) 图案与 GeSn 的衍射图案非常匹配,如图 3c 所示。此外,为了确认 GeSn 合金的 Sn 浓度,完成了 SIMS 测量,如图 3a 的插图所示。 Sn 浓度为 9.8 ± 0.5%,与约 10% 的标称值一致。除此之外,在生长的GeSn薄膜的深度分布中,Sn原子的分布非常均匀。
<图片>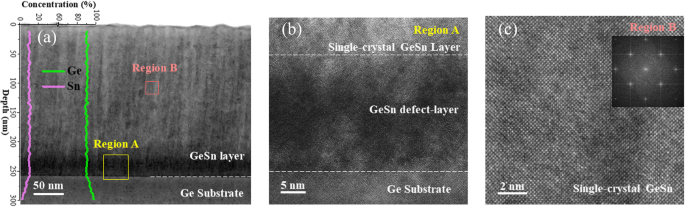
一 没有顶部多晶硅层的 5 μm 直径 GeSn 圆形台面的横截面 TEM 图像。插图:GeSn 层的 SIMS 深度剖面。 b GeSn/Ge 界面(区域 A)的高分辨率 TEM 图像。 c GeSn 层中间区域(区域 B)的高分辨率 TEM 图像。插图:区域 B 的 FFT 模式
通过SEM研究样品的表面结构。图 4a 显示了 5 μm 直径 Ge0.96Sn0.04 圆形台面在室温下通过 APM 溶液选择性湿蚀刻 510 秒后的俯视 SEM 图像。必须提到的是,蚀刻剂是在实验之前准备好的,以避免化学品老化的影响。 SEM 图像表明不仅 Ge 衬底而且部分 GeSn 台面都被蚀刻掉了。 Ge0.96Sn0.04 合金未能形成盘状结构是由于 Sn 浓度低导致 Ge 相对于 GeSn 的蚀刻选择性低。与 Ge0.96Sn0.04 样品相比,具有 9.8% 更高 Sn 浓度的 5 μm 直径 GeSn 圆形台面样品也在室温下通过 APM 蚀刻。如图4b、c所示。 c,Ge0.902Sn0.098合金在510秒湿蚀刻后成功形成微盘结构。此前,韩等人。 [30] 报道称,他们使用选择性为 7:1 的 H2O2 湿法蚀刻制造了部分悬浮的 Ge0.928Sn0.072 微盘(尺寸为 5 μm),底切约为 1.2 μm。然而,在选择性湿蚀刻之后,由于随着蚀刻剂液体的去除,悬浮结构和基板之间产生强大的毛细管吸引力,它们的圆盘边缘变得弯曲和断裂,这将释放的微圆盘结构拉到与基板接触。 24]。但是这种现象在我们的实验中不会发生,即使延长选择性蚀刻以几乎完全去除下方的 Ge 基座。这可以通过更高的蚀刻选择性和约 250 nm 的更厚 GeSn 层来解释。有趣的是,在选择性湿蚀刻过程中,基座显示出不同方向的意外刻面,这可能是由方向相关的横向蚀刻速率引起的。
<图片>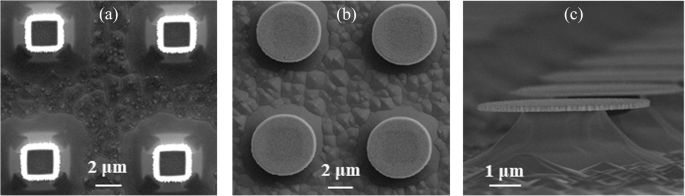
选择性湿蚀刻后的 SEM 图像。 一 蚀刻 510 秒后直径为 5 μm 的 Ge0.96Sn0.04 圆形台面。 b , c 5 μm 直径 Ge0.902Sn0.098 圆形台面蚀刻 510 s 后
此外,通过控制选择性蚀刻时间,制备了具有不同直径 Ge 基座的微盘。图 5a 显示了剩余 Ge 基座的直径作为 APM 中蚀刻时间的函数。误差线代表同一样品中五个不同微盘数据的标准偏差。类似的线趋势表明,对于 3 μm 和 5 μm 不同直径的 Ge0.902Sn0.098 磁盘,Ge 的蚀刻速率大致相等,并且与参考文献的蚀刻速率值一致。 [30]。此外,用于放置GeSn微盘的Ge基座的最小直径约为300 nm。如果Ge基座变小,悬浮的GeSn微盘会被强大的毛细管吸引力拉下。
<图片>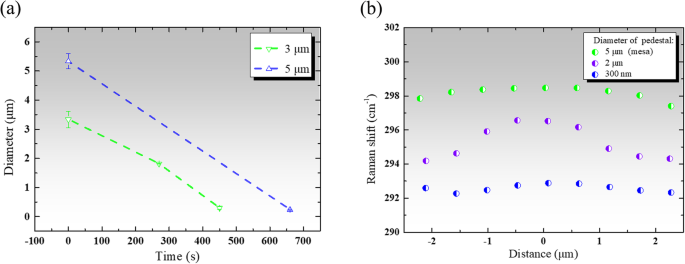
一 对于 3 μm(绿色虚线)和 5 μm(蓝色虚线)直径的 Ge0.902Sn0.098 圆盘,Ge 基座的直径作为选择性湿蚀刻时间的函数。 b 拉曼位移线扫描测量沿直径 5 μm Ge0.902Sn0.098 台面(绿点)和具有 2 μm 直径 Ge 基座(紫点)和 300 nm 直径 Ge 基座(蓝点)的微盘进行
为了研究 GeSn 微盘的弹性应变分布,在 RT 下在 5 μm 直径的盘上进行 μ-Raman,使用 633 nm 激光进行激发,光斑尺寸约为 600 nm。激光功率仅为最大功率 (15 mw) 的 1%,以最大限度地减少热效应 [34],激发激光在 GeSn 薄膜中的穿透深度约为 50 nm [26]。拉曼位移是通过用洛伦兹函数拟合光谱来测量的。
图 5b 显示了 Ge0.902Sn0.098 微结构的一维拉曼线扫描。清楚地注意到(1)对于没有底切的 5 μm 直径台面,与 Ge-Ge LO 声子模式相关的拉曼峰从台面的中心到边缘不明显地向较低波数移动,并且大的拉曼位移表明GeSn 台面存在较大的压缩应变; (2) 对于直径为 2 μm 的 Ge 基座,直径为 5 μm 的微盘,与 Ge-Ge LO 声子模式相关的拉曼峰从盘的中心到边缘明显向低波数移动,显示出由于锚定引起的应变梯度到比较大的葛台座。而5μm直径2μm基座的GeSn微盘在其外围仍保持一定的压应变; (3) 沿直径为 300 nm 的 Ge 基座的 5 μm Ge0.902Sn0.098 微盘的直径测量的 Ge-Ge 峰位置保持一致,拉曼位移明显减小。因此,具有窄Ge基座(直径约300 nm)的圆盘有望完全松弛。
在图 6 中,我们展示了具有 300 nm 直径 Ge 基座的 5 μm 直径 Ge0.902Sn0.098 微盘的典型拉曼散射光谱。对于圆盘,拉曼光谱在 292.4 cm -1 的频率处显示出不对称峰 对应于 Ge-Ge LO 模式。还绘制了为 5 μm 直径台面和参考块状 Ge (001) 衬底记录的拉曼光谱以进行比较。注意底切后,清除拉曼位移 (− 6.3 cm −1 ) 可以观察到 9.8% Sn 微盘的 Ge-Ge 峰,因为半导体合金中的拉曼频移主要受应变和成分的影响。之前的拉曼研究 [33, 35,36,37] 表明 Ge-Ge LO 声子模式在 GeSn 中的拉曼位移可以表示为 Sn 浓度的函数 x Sn 和面内双轴应变 ε ∥ 遵循等式。 (1):
<图片>
具有 300 nm 直径 Ge 基座、5 μm Ge0.902Sn0.098 直径台面和块状 Ge 衬底作为参考的 5 μm Ge0.902Sn0.098 微盘的拉曼光谱的比较。插图:拉曼光谱的放大图。 Ge-Sn 峰也可以在 260 cm -1 附近观察到 , 并且随着Ge基座直径的减小而向下移动
$$ \Delta \omega ={\omega}_{\mathrm{Ge}\mathrm{Sn}}-{\omega}_{\mathrm{Ge}}=\mathrm{A}\cdotp {x}_{ \mathrm{Sn}}+\mathrm{B}\cdotp {\varepsilon}_{\parallel } $$ (1)其中 ω GeSn和ω Ge分别为GeSn和体Ge中Ge-Ge LO声子模的峰值位置,A和B为系数。
台面和圆盘的 Ge-Ge LO 拉曼峰显示 - 1.4 cm -1 的位移 和− 7.7 cm −1 与体 Ge 峰 (300.1 cm −1 )。通过从以前的实验结果[37]中取系数,面内双轴染色的值ε 对于生长的 GeSn 台面,∥ 计算为 - 1.18%。对于制造的微盘,面内双轴染色 ε ∥ 大约等于 0,证实微盘几乎完全应变松弛。根据最近Ge1-x的理论计算 Snx 电子能带结构 [38],生长的 Ge0.902Sn0.098 层是带隙能量约为 0.56 eV 的间接带隙材料,而完全弛豫的 Ge0.902Sn0.098 微盘是带隙能量为 0.50 eV 的直接带隙材料.
结论
总之,通过将选择性外延生长与选择性湿蚀刻工艺相结合,成功地制造了 GeSn 微盘。进行 HRTEM 和 SEM 以确认 GeSn 合金是高度结晶的,并且 GeSn 微盘结构很容易通过简单的选择性湿法蚀刻形成。 μ-Raman 测量表明,由于较小的 Ge 基座的机械约束同时降低,GeSn 微盘的应变弛豫会随着 Ge 基座直径的减小而增大。最后,通过这种更具成本效益的方法实现了高质量和完全应变弛豫的 GeSn 微盘。该制造工艺也是一种非常有前景的方法,可以在横向量子尺寸效应变得重要之前实现更小的 GeSn 台面尺寸,并获得其他 GeSn 纳米结构,如 GeSn 量子点、GeSn 纳米网和 GeSn 纳米线,用于未来的 Si 兼容光子和电子设备应用。
数据和材料的可用性
相应作者可根据合理要求提供支持这项工作结果的数据。
缩写
- APM:
-
过氧化氨混合物(湿蚀刻剂)
- FFT:
-
快速傅里叶变换
- HRTEM:
-
高分辨透射电子显微镜
- MBE:
-
分子束外延
- PECVD:
-
等离子体增强化学气相沉积
- RT:
-
室温
- SEM:
-
扫描电镜
- SIMS:
-
二次离子质谱
- μ-拉曼:
-
显微拉曼光谱
纳米材料


