通过引入痕量镓,热力学控制从 InP 到 GaP 纳米线的急剧转变
摘要
以低成本生长用于光电和电子应用的高质量 III-V 纳米线是一项长期的研究追求。尽管如此,使用化学气相沉积法控制合成 III-V 族纳米线仍是一项挑战,缺乏理论指导。在这里,我们展示了使用真空化学气相沉积方法在大面积高密度下生长 InP 和 GaP 纳米线。结果表明,需要高生长温度来避免氧化物形成并提高 InP 纳米线的晶体纯度。将少量 Ga 引入反应器会导致形成 GaP 纳米线而不是三元 InGaP 纳米线。相图计算 (CALPHAD) 方法中的热力学计算用于解释这种新的生长现象。凝固过程的成分和驱动力计算表明,催化剂中只有 1at.% 的 Ga 就足以将纳米线的形成从 InP 调整到 GaP,因为 GaP 成核显示出更大的驱动力。热力学研究与III-V族纳米线生长研究相结合,为指导纳米线生长提供了很好的范例。
介绍
纳米线在应变弛豫、异质结形成以及晶相工程方面显示出优势,因此在过去十年中发展迅速 [1,2,3,4]。 III-V 族半导体纳米线由于其优异的光学和电子特性,已广泛应用于两个应用领域(如光伏 [5]、光电探测器 [6、7]、光电二极管 [8] 和电子器件 [9])和基础科学研究[10]。对于自下而上的纳米线制造,金属有机化学气相沉积 (MOCVD) [11, 12] 和分子束外延 (MBE) [13] 技术被广泛应用于合成高质量纳米线。例如,纯纤锌矿 [14] 和闪锌矿孪晶超晶格 InP 纳米线 [15, 16] 已被证明并应用于太赫兹检测 [17] 和激光应用 [18]。然而,这些高质量纳米线的生产成本很高。相反,使用廉价的化学气相沉积(CVD)方法可以大大降低 III-V 族纳米线的生产成本并扩大其应用领域,如光电化学领域 [19]。此外,由于其可行性,CVD 在增长探索方面具有优势 [20]。 III-P 及其三元 InGaP 纳米线,由于其合适的带隙、低毒性和低表面复合速度 [14],因此在生物传感器 [21]、激光 [22] 和光催化 [23] 应用中显示出潜力。慧等人。 [24] 证明了具有高迁移率的 InP 纳米线的 CVD 生长 (~ 350 cm 2 V −1 s −1 ) 与通过 MOCVD 和 MBE 技术生长的纳米线相当。使用通过 CVD 方法制造的 InP 纳米线,Zheng 等人。 [25] 制造了铁电聚合物侧门控单 InP NW 光电探测器,显示了一种超灵敏光电探测,其中暗电流被这种铁电材料产生的局部电场大大抑制。 GaP 是一种带隙为 2.26 eV 和高折射率的半导体,因此是绿黄色区域 [26] 以及光子学应用 [27] 中发光二极管的良好候选者。此外,GaP 合适的带隙使其在光催化领域也很有用 [23, 28]。但是,关于 GaP 及其三元 InGaP 纳米线的 CVD 生长的报道非常有限。 GaP 纳米线主要通过物理气相沉积方法生产 [18, 20, 29, 30]。三元 InGaP 纳米线已通过 MOCVD [31, 32]、MBE [33] 以及溶液相合成方法 [23] 得到证明。金属种子 GaP 和 InGaP 纳米线的详细生长以及生长基础需要进一步探索。热力学是影响纳米线生长的重要因素。 CALPHAD 是一种强大且行之有效的方法,用于计算散装材料的相平衡和热力学性质 [34]。这种半经验热力学计算方法可以计算成核过程中的热力学性质,从而指导纳米线的生长。 CALPHAD 方法已被应用于计算 In-Sb 系统的纳米相图 [35],并了解 GaAs 和 InAs 纳米线的 Au 种子生长 [36] 以及 InGaAs 纳米线的成分分析 [37]。尽管如此,要完全应用 CALPHAD 方法来指导 III-V 族纳米线的生长,还有很多工作要做。例如,没有进行 CALPHAD 分析来解释 Au 种子 InGaP 纳米线的生长行为。
在这项工作中,使用 InP 粉末和金属 Ga 作为前体,在真空条件下的 CVD 反应器中生长高密度的 InP 和 GaP 纳米线。该方法被证明在宽温度范围内生产纳米线是有效的。在优化 InP 纳米线生长后,我们通过将纯 Ga 引入反应器来进一步研究 GaP 纳米线的生长。与形成三元 InGaP 纳米线不同,几乎纯的 GaP 纳米线的形成与 Ga 的输入重量或生长温度无关。进一步的成分测定和热力学计算表明,纳米线的成分受热力学而非动力学控制。 Au 液滴中少量的 Ga 可以将纳米线的生长从 InP 调节到 GaP,很好地解释了观察到的纳米线生长行为。该工作为III-V族纳米线的生长提供了一种低成本、有效的方法,所应用的相图分析方法对于理解III-V族纳米线的生长具有重要意义。
方法
InP 和 GaP 纳米线的制备
InP 和 GaP 纳米线在真空条件下在自制 CVD 系统中生长,如图 1a 所示。高度纯化的 Ga(99.999%,Innochem)和 InP 粉末(99.99%,Aladdin)被用作固体资源并分离到两个隔离的石英管中。石英管的内径为 8 毫米,长度为 180 毫米。使用电子束蒸发将大约 2 nm 厚的 Au 膜沉积在 Si(111) 衬底上。这些石英管与 Au 沉积的 Si(111) 衬底一起装入另一个大石英管(如图 1a 所示)并用真空密封机 (Partulab MRVS-1002) 密封。整管压力为 ~ 3.0 × 10 –3 Pa。然后,在两温区炉中进行样品生长。对于所有样品,第一区的温度和 InP 粉末重量分别保持在 720 °C 和 20 mg。对于 InP 纳米线生长,没有引入 Ga 粉末,第二生长温度区在 400 到 550°C 之间变化。在 InP 纳米线生长优化后,添加 Ga 功率(0-5 毫克)以在 520 至 630°C 的温度范围内生长 InGaP 纳米线。在依赖温度的生长过程中,Ga 的重量固定在 3 毫克。将温区升至目标温度,保温 60 分钟,然后冷却。
<图片>
InP 纳米线的生长研究。 一 InP 和 GaP 纳米线生长的实验装置示意图。在 b 处生长的 InP 纳米线的 SEM 图像 400°C,c 450°C,d 480°C,e 520°C 和 f 550°C。 g 在不同温度下制备的纳米线的直径分布。 h 拉曼和 i 不同温度下生长的纳米线的PL比较
纳米线表征
生长后,通过在 300 kV (Titan G2 60-300) 下操作的扫描电子显微镜 (SEM) 和透射电子显微镜 (TEM) 研究纳米线的形态和结构。通过X射线衍射(MiniFle × 600)研究了生长的纳米线的晶体结构。对于详细的成分测量,应用了配备在 SEM 和 TEM 中的能量色散谱 (EDS)。 Thermo-Calc 软件用于进行热力学计算。 InP 和 GaP 纳米线的光学特性在商业雷尼绍系统 (inVia) 中通过微拉曼和光致发光 (PL) 检查。简而言之,纳米线通过物镜(100 ×)通过绿色激光(532 nm)泵浦。
结果和讨论
InP 纳米线
生长后,在所有研究的 400-520°C 生长温度范围内,在光学显微镜下都可以观察到高密度的 InP 纳米线。图 1b-g 中的详细形态表征显示了 Si(111) 衬底上的非垂直和随机分布的 InP 纳米线,这类似于通过 CVD 生长的其他纳米线 [20]。一般来说,所有纳米线的长度都超过 10 μm,几乎没有锥形形态,这比 MBE [38] 或 MOCVD [39] 的 III-V 纳米线生长速率长得多。插图中放大的 SEM 图像显示了单个纳米线的形态。在生长前沿观察到金液滴,表明 InP 纳米线的生长受众所周知的气-液-固 (VLS) 生长机制控制 [11] 除了倾斜和弯曲的纳米线,面内 InP 纳米线也是在基板上观察到(参见图 1 中的插图)。尽管形态变化,似乎生长温度影响纳米线直径。在低生长温度 (400 °C) 下,纳米线相对较细,平均直径为 121 nm。随着生长温度的升高,纳米线直径单调增加但分布更无序。例如,在 550 °C 时,观察到直径为 210 到 290 nm 的纳米线,并且纳米线在硅衬底上的分布不均匀。
拉曼散射和 PL 技术用于快速测试生长的 InP 纳米线的晶体质量和光学特性,如图 1h 所示。 ~ 302 cm −1 处的两个峰 和 341 cm −1 观察到所有样品,这对应于 InP 的纵向光学 (LO) 和横向光学 (TO) 声子模式 [40]。这表明所有制造的纳米线确实是 InP。然而,图 1i 中相应的 PL 数据非常混乱。对于在 400 到 480°C 之间生长的纳米线,PL 光谱在 ~ 775 nm 到 811 nm 范围内显示出强而宽的发射峰。发射的光子能量远大于纤锌矿 (WZ) (872 nm) 或闪锌矿 (ZB) (922 nm) InP 纳米线的带隙,表明发射不是来自纯 InP。 886 nm 附近的凹面是由我们的光学系统中的系统错误引起的。当温度高于 520 °C 时,观察到 900 nm 附近的强发射峰,这归因于多晶 InP 纳米线的发射 [40]。这些研究表明InP纳米线的最佳生长温度为 ~ 520°C,从而使InP纳米线分布均匀,具有较高的光学质量。
为了澄清观察到的 PL 光谱差异,在相同的测试条件下对在 480 和 520°C 下生长的样品进行 X 射线光电子能谱 (XPS) 测试,如图 2 所示。对于这两个样品,XPS 光谱显示特征峰来自 In-3d 和 P-2p .此外,O-1s 和 C-1s -相关的峰值也被记录下来。 In-3d的慢扫描结果 在 480 °C 生长的样品峰(见图 2c)可以解卷积为 443.5、442.3 和 444.4 eV 的三个峰,分别归因于 InP、In2O3 和 InPO4 [41, 42]。根据相对强度,上述化合物的重量比分别为31.0%、48.7%和20.3%。强 P-2p 132 eV 的峰值(见图 2b)进一步证实了 InPO4 的存在。相比之下,对于在 520 °C 下生长的样品,In-3d 的峰值强度 , P-2p , 和 O-1s ,代表 InPO4,In2O3,在很大程度上抑制了 InP 的相对强度。这些比较表明,较高的生长温度能够抑制氧化物的形成并提高 InP 的纯度。在较低的生长温度下,InP 纳米线中的氧化物形成不可忽视,PL 发射以氧化铟为主,因此显示出由 In2O3 缺陷态引起的宽发射峰 [43, 44]。相反,在较高生长温度下 InP 纳米线纯度的增加导致了 InP 半导体的特征峰。此外,这些实验表明,除了生长条件本身外,实验过程还应小心避免在密封管中引入氧气。例如,真空度应该更高以避免氧气含量。此外,在密封过程中,InP粉末应冷却以避免可能的氧化。
<图片>
在 480°C 和 520°C 温度下生长的 InP 纳米线表面的 XPS 比较。 一 调查光谱,b 的高分辨率 XPS 光谱 P-2p , c 在-3d , d O-1s
在 InP 纳米线生长研究之后,将 Ga 功率(3 毫克)引入反应器以生长三元 InGaP 纳米线。 Ga 的添加导致在 520 到 630°C 的温度范围内形成高密度的纳米线。基材甚至变成黄色。平均纳米线直径从 90 nm 增加到 253 nm,然后在 580 °C 后再次减小(见图 3a)。在不同条件下生长的纳米线的晶体和成分首先通过 XRD 检查,如图 3b 中的比较。使用的 Si(111) 衬底在 28.43° 处仅显示一个主峰。对于在 550°C 下生长的 InP 纳米线,观察到 33.08°、43.61°、51.71°、58.93° 和 63.52° 处的额外峰,这些峰归因于 (200)、(220)、(311)、(222)、( 400) ZB InP [45] 的平面。对于 InGaP 纳米线,在所有研究条件(温度相关或 Ga 重量相关)下生长的纳米线的 XRD 谱非常相似,峰值位置几乎相同,峰值分别为 32.64°、46.93°、55.80° 和 58.93° .这些峰代表 ZB GaP [46] 的 (200)、(220)、(311) 和 (222) 平面。尽管 InP 和 Ga 粉末的输入重量比代表 In0.44Ga0.56P 的标称成分,XRD 数据表明 GaP 纳米线的成功生长,而不是预期的三元 InGaP 纳米线。这是非常有趣的,因为只有少量的 Ga 粉末能够将纳米线的生长完全从 InP 转化为 GaP。为了准确研究这种现象,我们将这些纳米线转移到 Si 衬底上进行能量色散 X 射线光谱 (EDX) 分析。在 550°C 下用 3.0 毫克 Ga 粉生长的纳米线的典型 SEM 图像和相应的 EDX 光谱如图 3c、d 所示。 EDX 光谱仅显示来自 Ga 和 P 的主要峰,只有一个非常弱的 In 峰。此外,沿该纳米线的 EDX 分析显示出相同的成分分布。该结论适用于所有测量的纳米线。这些EDX光谱与XRD结果非常吻合,即生长的纳米线主要是GaP。
<图片>
InGaP 纳米线的合成。 一 InGaP 纳米线在不同生长温度(550-630°C)下的直径分布以及嵌入的特征 SEM 图像。 b InP(红色曲线)和 InGaP(蓝色曲线)纳米线在不同生长条件下的 XRD 谱。 Si(111)衬底的 XRD 谱显示在插图中作为参考。 SEM (c ) 和相应的 EDS 光谱 (d ) 在 550°C 下生长的 InGaP 纳米线。镓粉重量为 3.0 毫克
为了进一步揭示生长的基本原理,对 InP 和 GaP 纳米线进行了 TEM 分析,如图 4 所示。通常主要的 InP 和 GaP 纳米线沿 [111] 方向生长,具有 ZB 结构 [47, 48],与以上XRD分析。特别是,InP 纳米线呈现孪晶超晶格状结构(见图 4a),这类似于通过 MOCVD 在高温下生长的 InP TSL 纳米线 [16]。周期性双平面距离在 35 和 21 nm 之间略有波动,并且似乎沿着生长方向减小,尤其是在 Au 液滴附近。相比之下,在 GaP 纳米线中发现了高密度的平面缺陷。靠近 Au 液滴的高分辨率 TEM (HRTEM) 图像(见图 4e,f)显示液滴主要由具有 ZB 相的 AuIn2 组成 [49]。此外,AuIn2 和 GaP 纳米线呈现相同的晶体取向。因此,这表明在凝固过程中,AuIn2 相在 GaP 纳米线上外延生长。 InP 纳米线上的 Au 液滴显示出相同的亮度对比,表明是单相。相比之下,根据图 4g 中的亮度对比以及附加文件 1 中图 S1 中的 EDX 映射,似乎在 AuIn2 凝固后形成了少量的富金层。图 4g 中的 EDX 分析比较。 4 小时证实形成了 GaP 纳米线,并且几乎没有观察到 In 峰。然而,铟是催化剂中的主要元素。 In 和 Au 之间的相对比率对于 InP 和 GaP 纳米线是相同的。基于图 4e 中的 HRTEM 分析,催化剂相主要是 AuIn2。 Ga的引入不会降低In含量,而只会导致催化剂中Ga的浓度很小。然而,Ga的含量足够高以抑制In从液滴成核到纳米线中,从而仅形成GaP纳米线。 InP 和 GaP 纳米线中较大的催化剂形状差异是由局部表面张力差异引起的 [50]。这些 EDX 观察提出了一个问题,即为什么催化剂中更高的 In 含量不会导致富 In InGaP 纳米线的形成。
<图片>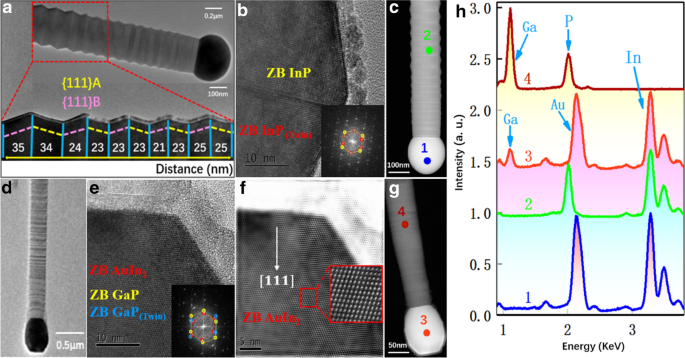
InP 和 GaP 纳米线的结构和成分分析。 一 , b InP 纳米线的 HRTEM 图像,显示了 ZB 孪晶超晶格结构。 d , e GaP 纳米线的 TEM 图像。 f Au 液滴的快速傅立叶变换图像,展示了 AuIn2 相的形成。同一 InP (c) 的高角度环形暗场 (HAADF) 图像 ) 和间隙 (g ) 纳米线。 h (c 中点 1–4 的 EDX 光谱 , g )。 EDX 强度被归一化并移动以提高可见度
为了找出这种成分差异,我们通过结合两个 Au-Ga-In 和 Ga-In-P 热力学数据库在 Au-Ga-In-P 四元系统中进行了热力学计算 [51, 52]。根据伪二元相图(见图 5a),三元 InGaP 化合物中存在混溶间隙,这使得 InGaP 纳米线的成分可调性具有挑战性。使用热计算软件,我们计算了来自过饱和 Au 液滴的 InGaP 的固化,以模拟 Au 种子纳米线的生长。根据实验,催化剂中的温度和铟成分范围分别为 793-873 K 和 50-80 at.%。在液滴中添加 Ga 期间 InGaP 的计算成分如图 5b 所示。在热力学上,当 Ga 含量超过 1 at.% 时,纳米线成核从 InP 变为 GaP。只有当 Ga 含量低于 1 at.% 时才能形成 InGaP 纳米线,而这种条件在我们的实验中几乎无法实现。此外,这种趋势几乎与催化剂中的生长温度和铟含量无关。这些计算很好地解释了不同生长条件下 GaP 纳米线的形成。此外,这表明我们系统中的 InGaP 纳米线生长接近平衡条件。进一步的驱动力 (∆μ ) 图 5c 中的分析解释了如此剧烈的构图变换。形成 InP 的驱动力仅随 Au 液滴中铟含量和生长温度的变化而略有变化。相反,在催化剂中加入少量的 Ga 会导致驱动力的急剧变化。尽管液滴中的镓含量比铟小 10 倍以上,但大幅增加的驱动力会导致形成 GaP 而不是 InP。这是因为在热力学上,GaP 比 InP 稳定得多。根据热力学计算,生长 InGaP 纳米线具有挑战性。因此,我们建议将生长条件推到动力学控制区域以形成三元纳米线 [5]。另一种方法是在选择性区域外延方法中生长 InGaP 纳米线 [32]。否则,金催化剂应该被另一种可能的金属代替,或者纳米线应该在没有催化剂的情况下生长[32]。我们进一步计算了图 5d 中自种 InGaP 纳米线的情况。与 Au 液滴相比,InP 纳米线形成的驱动力增强。然而,形成GaP的驱动力仍然远大于InP,表明通过这种方法自催化生长InGaP纳米线对于实现成分控制仍然具有挑战性。
<图片>
成核过程的热力学分析。 一 伪二元 InP-GaP 相图。计算 (b ) 在 Inx 中的内容 Ga0.5-x P0.5 和吉布斯能量变化 (c ) 作为 Au 液滴中 Ga 含量的函数。 d In-seed条件下InGaP纳米线形成的成分和吉布斯能量分析
上述实验观察和 CALPHAD 计算表明,热力学是决定 III-V 族纳米线生长的重要因素。因此,建立一个有效的热力学数据库,尤其是那些包括纳米尺寸效应的数据库,并利用CALPHAD方法的原理,可以提供指导III-V族纳米线生长的关键热力学信息,包括但不限于成分和晶体结构。
结论
总之,我们使用真空 CVD 方法成功地大面积高密度生长了 InP 和 GaP 纳米线。 PL 和 XPS 分析证实了在较低的生长温度下形成了 In 2 O 3 并导致在 ~ 775 至 811 nm 范围内的宽发射峰。提高温度有助于避免氧化物形成并提高 InP 纳米线的纯度。因此,在高温下生长的 InP 纳米线形成 ZB 孪晶超晶格结构,在室温下具有很强的发射峰。此外,我们通过向反应器中添加少量 Ga 观察到从 InP 到 GaP 纳米线的急剧转变,如不同的表征技术所证实的那样。所有测试的生长温度和 Ga/InP 粉末的比例都会导致 GaP 纳米线的形成。详细的 EDX 研究揭示了 Au 催化剂中的高铟含量,但纳米线中没有。结合四元热力学数据库(Au-In-Ga-P)来计算凝固过程。根据计算,由于 GaP 的成核驱动力急剧增加,Au 催化剂中仅 1 at.% Ga 就足以将纳米线生长从 InP 转移到 GaP。计算还表明这种现象在大的生长条件范围内以及自成核 InGaP 纳米线生长中都是有效的,很好地解释了观察到的生长基础。因此,我们认为使用CALPHAD方法进行热力学计算有助于指导III-V族纳米线的生长。
数据和材料的可用性
作者声明支持本研究结果的数据可在文章中找到。
缩写
- CALPHAD:
-
相图的计算
- MOCVD:
-
金属有机化学气相沉积
- MBE:
-
分子束外延
- CVD:
-
化学气相沉积
- SEM:
-
扫描电子显微镜
- TEM:
-
透射电子显微镜
- EDS:
-
能量色散谱
- PL:
-
光致发光
- VLS:
-
气-液-固
- LO:
-
纵向光学
- 致:
-
横向光学
- ZB:
-
闪锌矿
- WZ:
-
纤锌矿
- XPS:
-
X射线光电子能谱
- EDX:
-
能量色散X射线光谱
- HRTEM:
-
高分辨透射电子显微镜
纳米材料
- 由 ANDROID 智能手机控制的 RASPBERRY PI WIFI 机器人
- 材料科学家教纳米线如何“跳舞”
- 利用磷化镓实现未来信息技术
- 通过金属有机化学气相沉积在 InAs 茎上自催化生长垂直 GaSb 纳米线
- 纳米技术:从体内成像系统到受控给药
- 通过低温快速热退火工艺控制高均匀度硒化铟 (In2Se3) 纳米线的生长
- 用于最大太阳能收集的高效且有效的 InP 纳米线设计
- 利用柠檬汁通过水热反应制备的荧光碳量子点的材料和光学特性
- 通过生长掺杂方法实现双发射和颜色可调的 Mn 掺杂 InP/ZnS 量子点
- InGaAs/InP 核壳纳米线的自种 MOCVD 生长和显着增强的光致发光
- 微小的稀土氟化物纳米粒子通过电极性相互作用激活肿瘤细胞生长
- N 掺入对利用 UDMH 的 GaP(N) 纳米线的 VLS 生长的影响


