具有自整流开关特性的 TaO/HfO x 和 TaO/AlO x RRAM 的保持模型
摘要
自整流 TaO/HfO x 的保留行为模型 - 和 TaO/Al2O x 提出了基于电阻式随机存取存储器(RRAM)。 Trapping-type RRAM 可以有高阻态(HRS)和低阻态(LRS); LRS 的退化通常比 HRS 更严重,因为 SET 过程中的 LRS 受到内部电阻层的限制。但是,如果 TaO/Al2O x 元素按层堆叠,可以提高 LRS 保留率。通过外推法估计的 LRS 保留时间在室温下超过 5 年。 TaO/HfO x - 和 TaO/Al2O x 基于 RRAM 的结构具有相同的 TaO 覆盖层,两种结构的激活能级均为 0.38 eV。此外,额外的 Al2O x TaO/Al2Ox 的开关层 结构创造了更高的 O 扩散势垒,可以显着提高保留率,并且 TaO/Al2O x 结构在偏置条件下也表现出相当稳定的LRS。
背景
由于 NAND 闪存技术面临缩放限制,因此具有低薄膜堆栈、高制造良率和无交叉耦合问题的垂直电阻随机存取存储器 (VRRAM) 设计是高密度存储器应用的有希望的候选者 [1,2,3 ]。具有三维 (3D) 垂直结构的 1TnR 架构有助于为高度紧凑的密集阵列实现超低位成本 [4,5,6]。一些研究人员建议通过将电阻切换机制从丝状类型更改为缺陷捕获、空位调制或界面类型导电路径模型,从而在低电流水平下运行 RRAM [7,8,9]。然而,保留失败和氧空位迁移的核心问题仍未解决 [3, 10]。在一些丝状保留研究中,提出了许多不同的模型来解释保留损失 [11,12,13]。切换机制的变化也表明了可能提高保留率的不同方向[11]。我们之前的研究表明,TaO/HfO x 设备可以显示大约 40 的有利非线性值、超过 1000 次循环的耐久性值和 85°C 的数据保留 [6, 7]。尽管如此,要在如此低的工作电流水平下获得稳定的保留仍然具有挑战性。在这封信中,提出了一种保留模型,以使用 Arrhenius 方法实现两种不同缺陷捕获型器件中的保留损失。提取的活化能不能令人信服地解释 Al2Ox 的保留改进 层。尽管原文含糊不清,但最可能的解释是密集的结合有助于保留。
方法
在 TaO/HfO x 的制造中 和 TaO/Al2O x 对于本研究的设备,底部电极 (BE) 由通过物理气相沉积 (PVD) 在 8 英寸上沉积的 TiN 金属组成。热氧化物/硅衬底。每个 BE 都使用传统的光刻和蚀刻工艺进行图案化和蚀刻。在用氯基气体蚀刻每个 TiN BE 后,使用远程等离子系统去除剩余的光刻胶 (PR) 和蚀刻残留物,该系统在 180°C 下施加 O2 和 H2O。在 PR 去除过程中,在每个 TiN BE 的表面上形成了一层薄薄的 TiON 氧化层。然后,HfO x 的阻变层 和氧化铝 x 分别使用 HfCl4-H2O 和 TMA-H2O 前体通过原子层沉积 (ALD) 制备。两个电阻元件 HfO x 和氧化铝 x 在 300 和 250°C 下沉积。在电阻开关层的顶部,然后通过低温等离子体氧化 (LTPO) [14] 通过 PVD 沉积 TaO 层。这种制造以超低速率 (0.2 Å/s) 沉积 Ta 金属。使用 Ar 和 O2 气体的混合物进行稳定的等离子体氧化。该 TaO 层用作内部自顺应电阻,与之前的电阻开关膜相比,该电阻相对泄漏 [7]。顶部电极也是 PVD-TiN。 TaO/HfO x 的截面图和厚度信息 和 TaO/Al2O x 存储设备分别如图 1a、b 所示。 TaO/HfOx的膜厚 通过透射电子显微镜检查(未显示)。在电池被图案化后,在 250°C 下沉积低温氧化物以进行钝化。最后,采用传统的后端工艺完成接触和金属焊盘结构的制作。
<图片>
a 具有厚度信息的单元示意图 TaO/HfO x 设备和b TaO/Al2O x 设备。两幅图都描述了 PVD 采用 LTPO 工艺沉积 TaO 层的器件,底部 TiON 界面层是在光刻胶去除过程中通过等离子体氧化形成的
结果与讨论
电气测量是用 HP4156C 半导体参数分析仪进行的。设置和复位电流密度(J ) 对电压 (J –V ) TaO/HfO x 曲线 和 TaO/Al2O x 设备分别如图 2a、b 所示。两个初始阻力状态 (R 初始)的 TaO/HfO x 和 TaO/Al2O x 设备是 HRS。原始存储设备被编程为具有正偏压的 LRS 并被扫回。然后,通过施加负电压将每个电池从 LRS 切换到 HRS。 J-V 图包含三种细胞尺寸,即 0.1、0.56 和 25 μm 2 .在J-V 图中,具有不同面积的设备的所有曲线彼此相似,这表明 TaO/HfO x 和 TaO/Al2O x 器件具有 (i) 初始状态相同的电流密度,(ii) 相似的设置和复位电压,以及 (iii) LRS 和 HRS 中的相同电流密度。此外,恒流密度特性可以通过电阻与面积 (R –A ) 图 2c, d。 R 中的强区域依赖性 通过控制电流密度可以观察到初始和LRS。无论单元面积和顺从电流的大小如何,两种器件都保持相同的开/关电阻比。这种恒定电流密度开关特性意味着存储单元被电场均匀编程或擦除。这些器件被认为具有俘获型开关特性,这与空位的调制密切相关 [8]。在捕获型 RRAM 的情况下,在设置过程中没有观察到急剧的电流跳跃,但对于丝状 RRAM,通常观察到急剧的电流跳跃。在目前的研究中,不同的开关层与 HfO x 观察到不同的开关电压 或氧化铝 x . TaO/AlO x 的设定电压范围 器件为 4 到 4.5 V,大于 TaO/HfO x 设备(3 到 4 V)。 TaO/AlO x 的复位电压范围 器件为 -1.5 至 -2.5 V,大于 TaO/HfO x 设备(-0.5 至 -1.5 V)。一个氧化铝 x 系统比 HfO x 消耗更多的能量来完成设置和重置开关 系统消耗。在开关设置期间,开关层 HfO x 和氧化铝 x 分别在大约 3 V 和 3.5 V 的电压下实现软击穿。在这两种类型的器件中,在开关层中形成灯丝之前,电流受到 TaO 层内阻的限制。在捕获型 RRAM 的自顺应过程中,开关层内部会产生过多的氧空位 [7]。这些氧空位在负偏压复位过程中重新结合。与丝状 RRAM 不同,复位操作后 HRS 始终低于初始电阻状态 (IRS) [15,16,17]。总而言之,缺陷捕获是一种通过氧离子-空位复合来调节空位以控制开关层电阻变化的过程。与 HfO x 相比 开关层,缺陷捕获导致 AlO x 中更高的电压和功率 开关设置和复位过程中的层。
<图片>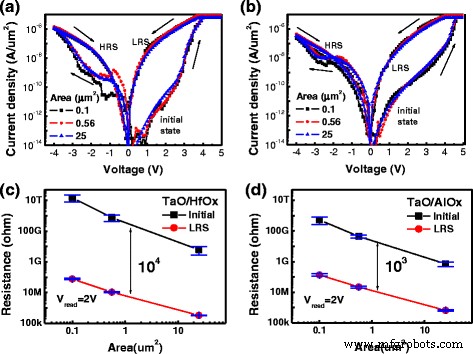
电流密度与 a 的电压图 TaO/HfO x 具有不同单元大小的设备。 b TaO/Al2O x 具有不同单元大小的设备。 c 的电阻与面积图 a TaO/HfO x 设备和 d a TaO/Al2O x 设备。两个图都包含 IRS 和 LRS,读数电压 =2 V。每个数据点提供了 10 个设备的平均值和相应的标准偏差
在研究了开关行为之后,研究了捕获型存储单元的 HRS 和 LRS 保留行为。 TaO/HfO x 在 85 °C 和 1 V 下电阻变化与时间的关系图 和 TaO/Al2O x 设备如图 3a、b 所示。在这两个图中,LRS 变化比 HRS 变化更明显。 TaO/Al2Ox的电阻稳定性 高于 TaO/HfO x .这些数字表明,对于两种类型的设备,HRS 都倾向于向 IRS 漂移; IRS 在图 3a、b 中用虚线标记。图 3c 描绘了 TaO/Al2O x 的电阻恢复到器件原始状态的趋势 在图 3d 中,TaO/HfO x .为了实现这一点,这两种类型的设备最初都在室温下编程为 LRS,如 I-V 所示 扫掠(黑线)。然后,TaO/Al2O x 和 TaO/HfO x 设备分别在 150°C 的烤箱中烘烤 48 小时和在 120°C 下烘烤 120 小时。对于这两种情况,I–V 烘焙后的扫描与初始扫描相似。通过这个过程,在高温环境中经过一段时间后,俘获型器件的 LRS 恢复到原始状态。与以氧原子显着运动为特征的灯丝型器件不同,捕获型器件具有由短距离隔开的氧离子对和空位。电阻漂移至初始状态的趋势与其原始结晶度有关,主要受ALD工艺温度控制。因此,两种类型的设备中的 LRS 都可以通过负偏压或热能重置为 HRS(或 IRS)。此属性与细丝 RRAM 不同。
<图片>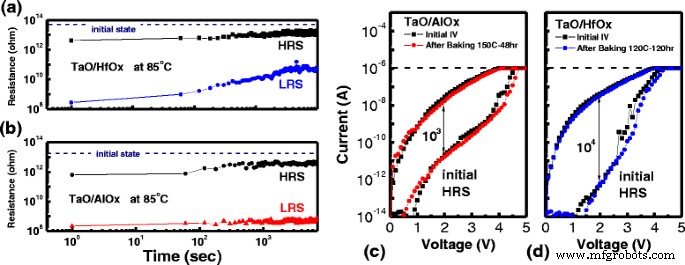
a 的电阻随时间变化图 TaO/HfO x 和 b TaO/Al2O x 设备。两个图都包含在 85°C 下读数电压 =1 V 时的 HRS 和 LRS 变化。在 I 之后 –V 每个原始设备的扫描已经设置,设备被烘烤,然后再次编程到 LRS:c TaO/Al2O x (150°C 持续 48 小时); d TaO/HfO x (120°C 持续 120 小时)
在非易失性存储器的标准保留测试中,数据保留在室温和高温下进行测试;设备必须能够在室温和高温下保留数据,才能在实际应用中发挥作用。活化能 (E a) 在保留图中通过 Arrhenius 方法提取是评估数据保留的常用方法 [18, 19]。从图 3a 中可以看出,LRS 变化比 HRS 变化更明显。因此,电阻比(R 在 30 到 150°C 的温度范围内,分析了 LRS 与烘烤时间的比率)。从 TaO/Al2O x 中提取保留时间的一个示例 设备如图 4a 所示。电阻退化率可以通过log(R ratio)-log(time) scale。考虑到最大开/关电阻比约为 10 3 对于 TaO/Al2O x 设备,如图 3c 所示,保留时间为 10 3 可以计算 LRS 变化的倍数。图 4b 显示了在 30 到 150°C 的测量温度范围内估计的 LRS 数据保留。每个数据点代表来自两种设备类型的超过 18 个设备的信息。在 TaO/Al2O x 设备,数据保留高达10 6 s 在 150 °C 和 2 × 10 8 s(大约 5 年)在室温下;那些时间几乎是 10 1.5 长于 TaO/HfO x 设备。最有趣的一点是 TaO/HfO x 和 TaO/Al2O x 设备显示相同的 E a =0.38 eV,根据提取的斜率计算得出。相同的 E a 意味着两种类型的设备在 LRS 降解过程中都会经历相似的化学反应。这个E a 参与所有热激活动力学过程,包括 TaO 界面附近氧离子的释放和 AlO x 中的氧扩散过程 和 HfO x 层。然而,HfO x 的氧自扩散系数 和氧化铝 x 在高温(> 1000°C)下层是不同的;精确的测量值可以在文献 [20, 21] 中找到。低温 (<200 °C) 下的氧扩散系数还取决于 HfO x 的厚度 电介质 [22]。如果开关层中的扩散过程支配化学反应,则 E 由于 HfO x 中的扩散系数不同,a 值应该不同 和氧化铝 x 层。这项工作中的两种类型的设备都表现出相同的 E a =0.38 eV;这与两种类型的器件在开关层顶部具有相同的 TaO 覆盖层有关。 LRS 退化是空位和离子复合的过程,这意味着 TaO 层控制了这种化学反应,并且大多数空位都聚集在 TaO 和开关层之间的界面附近。那些空位更喜欢留在 TaO/交换层界面上;正如钟等人报道的那样,这种现象可以得到热力学稳定性的支持。 [23]。在他们对 TiN/Ta/HfO x 的模拟中 /TiN 堆叠,氧离子首选留在 Ta/HfO x 界面,因为 Ta 和 HfO x 之间存在低能量差 [23]。在他们的模拟中,正如在本实验中一样,TaO 电阻层捕获了大部分氧离子并主导了这种空位复合过程。 LRS 退化如图 4c 所示。氧离子在烘烤过程中恢复到先前的热平衡状态,从而导致保留损失。可以注意到 Ta/HfO x 之间的差异 由钟等人提出的装置。和 TaO/HfO x 本研究中的器件,但在这两项研究中,TaO 层是通过金属 Ta 沉积和 LTPO 工艺的几个循环形成的 [14]。由于 LTPO 工艺,富含金属的 TaO/HfO x 界面可以被认为是一个氧离子库。在氧离子和空位的复合过程中,原子堆积密度起着至关重要的作用。在 Al2Ox 中获得了优异的 LRS 保留性能 转换层可以用 Al2Ox 的高原子密度来解释 层。众所周知,Al-O 的键长比 Hf-O 的键长短 [24, 25]。 AlOx 中的短键 由于高库仑相互作用,降低了氧离子迁移率,从而导致高氧空位扩散势垒。该势垒导致 TaO/Al2O x 中的保留时间更长 装置比在 TaO/HfO x 一个。
<图片>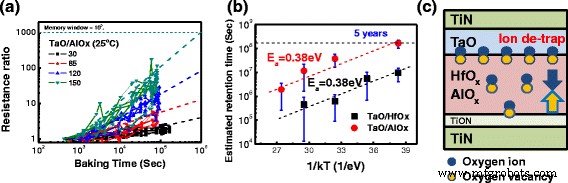
一 不同温度下 TaO/Al2Ox 中电阻变化率与烘烤时间的关系 设备。平均初始电阻为 179 Mohm,读数电压为 2 V,LRS 电阻退化率通过线性拟合法计算得到 log(R ratio)–log(T) 量表。 b 估计保留时间 (1000 ×) 与 1/kT 的关系图。每个点包含 18 个器件的数据,读取电压为 2 V。在 TaO/Al2O x 中提取的活化能均为 0.38 eV 和 TaO/HfO x 设备。 c HfO<i>x中不同氧扩散势垒的保留示意图 或氧化铝 x 带有 TaO 覆盖层
此外,丝状器件的保持损耗模型与缺陷捕获型器件的不同。细丝型 RRAM 的保留行为与细丝断裂有关,空位扩散方向是横向的 [11, 19, 24]。在缺陷捕获 RRAM 中,缺陷扩散方向是纵向的,与外部电场平行。因此,保持行为会受到偏置方向和大小的影响。图 5a、b 显示了两个器件通过电阻比的偏压保持率。电阻比定义为应力装置的电阻与 LRS 的电阻。正偏压有助于维持 LRS,但负偏压会加速退化过程。这些偏压特性可以通过氧离子对和空位的局部场与外部电场之间的相互作用来解释。如果外场方向与设定方向相同(正),则延长保留时间;如果外场在复位方向(负),则会导致退化。在 ±100 mV 的低电场中,两种类型的器件的偏置衰减与无偏置衰减相同。这个 ±100 mV 偏置可能被 TiON-HfO x 的带偏移覆盖 , TiON-Al2O x , 和 TiN-TaO 结。 A TaO/Al2O x 器件在 500 mV 的高正偏压下未表现出明显的退化。
<图片>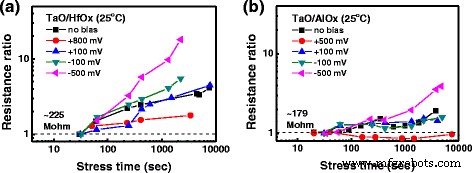
a 的偏置电阻比与应力时间 TaO/HfO x 和 b TaO/Al2O x 室温下的设备
结论
总之,我们通过开关特性比较了两种类型的自整流 RRAM 器件并分析了它们的保持行为。 TaO/Al2O x 器件显示出比 TaO/HfO x 更高的开关电压和更稳健的 LRS 热稳定性 设备做到了。 Al2Ox 的强大保留的好处 开关层是由于高氧扩散势垒而不是活化能。保留损失的活化能与 TaO 电阻层中的离子去陷阱过程有关。 AlOx的高原子密度 薄膜可能会改善 LRS 保留。已经提出了保留损失示意图模型,并且偏压保留结果支持该模型。该模型有利于开发用于未来高密度存储器应用的低电流、长保持、自整流 RRAM 器件。
纳米材料
- 钛的特性及应用
- 带开关的电路
- 坚持不懈地领导
- switch…case in C (Switch Statement in C) with Examples
- 具有高级农业化学活性的智能纳米材料和纳米复合材料
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 化学蚀刻制备的硅纳米线的光学和电学特性
- 涂有 CuS 纳米粒子的有色导电 CuSCN 复合材料的简便合成
- 提高阳极 TaO x 纳米管阵列的生物相容性
- 氮化处理的基于 HfO2 的 RRAM 中的传导机制和改进的耐久性
- ITO/PtRh:PtRh 薄膜热电偶的制备和热电特性


