高性能阳极硫化预处理门控 P+–π–M–N+ InAs/GaSb 超晶格长波红外探测器
摘要
InAs/GaSb 超晶格红外探测器的开发付出了巨大的努力。然而,它的性能,尤其是长波长红外探测器(LWIR),仍然受到电性能和光量子效率(QE)的限制。强制活动区域为 p 型通过适当的掺杂可以极大地提高 QE,并且可以采用门控技术大大提高电气性能。然而,饱和偏压太高。降低饱和偏置电压对于栅极电压控制器件的未来应用具有广阔的前景。在本文中,我们报告门控 P + –π –M–N + InAs/GaSb 超晶格长波长红外探测器表现出不同的 π 区掺杂水平,在经过简单有效的阳极硫化预处理后,具有 200 nm SiO2 层的 - 10 V 下的最小饱和偏压降低。饱和栅极偏置电压远低于 - 40 V,据报道具有相同厚度的 200 nm SiO2 钝化层和类似结构。光学和电学特性表明器件的电学和光学性能会因掺杂浓度过高而减弱。在 77 K 时,器件的 50% 截止波长约为 8 µm,100% 截止波长为 10 µm,最大量子效率为 62.4%,最大响应率为 2.26 A/W 在 5 µm,最大设备的 RA 为 1259.4 Ω cm 2 .此外,无栅电极的 Be 780 °C 掺杂检测器的比检测率峰值为 5.6 × 10 10 厘米赫兹 1/2 /W 在 5 µm 处,反向偏置电压为 70 mv,是掺 Be 820 °C 检测器的三倍多。此外,峰特异性检测率可以进一步提高到1.3 × 10 11 厘米赫兹 1/2 /W 在 5 µm 处,具有 10-mv 备用偏置电压,在栅电极处具有 - 10 V 的偏置。
介绍
自 Sai-Halasz 等人 以来,II 型应变层超晶格 (T2SL) 越来越成为当前研究的焦点。 [1] 提出了它的概念。通过仔细设计 T2SL [2] 的能带结构和应变,可以生成高性能红外探测器。 InAs/GaSb 超晶格是 T2SL 的一个被充分研究的成员,是一种优秀的材料系统,在红外探测器中具有广阔的前景 [3]。 InAs/GaSb 超晶格红外探测器的开发付出了巨大的努力。然而,它的性能,尤其是长波长红外探测器(LWIR),仍然受到电性能和光量子效率(QE)的限制[4]。长波红外探测器相应的环境温度(地基)约为 300 K,对应于 9.6 µm 的峰值波长(长波红外大气透射窗口的中心),具有广泛的应用 [5]。广泛应用于气体探测、夜视、红外预警、红外遥感、红外制导等各个领域,不仅用于军事用途,也适用于人们的生活。研制高性能长波红外探测器具有极其重要的意义和挑战性。
探测器的结构设计和工艺准备对长波红外探测器的性能有显着影响。增加有源区的厚度似乎是改善 QE 最直接、最有效的方法。然而,随着厚度的增加,更多的陷阱中心被引入,导致探测器的电特性降低。在 LWIR 和超长波长红外探测器 (VLWIR) 中,InAs 层往往比 GaSb 层厚。因此,材料是 n -型(少数载流子是空穴)。强制活动区域为 p 型通过适当的掺杂可以大大增加 QE,而不会改变器件的区域尺寸 [6]。然而,并不是掺杂浓度越高,器件性能的提升就越多。特别是掺杂浓度过高会削弱器件的电学[7]和光学性能。
除了改变π中的掺杂浓度 区域,门控技术最近已应用于中波长红外探测器 (MWIR) 和 LWIR 探测器 [8],以提高器件性能。然而,它需要非常高的栅极偏置电压。栅极偏置可以用方程表示。 (1).
$$\sigma =\varepsilon \varepsilon_{0} V/d,$$ (1)其中\(\varepsilon\)表示介电层的相对介电常数,\(\varepsilon_{0}\)表示真空的介电常数,V 指的是饱和栅极偏置电压,d 是介电层的厚度,σ 代表界面上的电荷密度。根据公式费了很大力气减弱了栅极偏置;使用高 k 电介质(如 Y2O3 [9])钝化或减少层的厚度 [10] 的方法是有效的。然而,关于降低电荷密度的研究很少。在本文中,首先进行阳极氧化以显着降低饱和偏差。 NaS2·5H2O 和乙二醇的混合物用作硫化溶液。在阳极固化过程中,器件表面的硫原子和悬空键的结合使器件表面的导电通道关闭[11],减少了器件的表面复合,削弱了器件表面的电荷密度。设备。然后,在器件表面得到一层致密均匀的元素硫。接下来,元素硫层的表面覆盖有 200 nm SiO2 层。栅电极放置在 SiO2 层上。随着界面电荷密度的降低,饱和栅极偏置电压降低。
在本研究中,阳极硫化预处理的 LWIR P + –π –M–N + 探测器在低饱和栅极偏置电压下制造,基于具有不同掺杂 π 的 InAs/GaSb T2SL 地区。结果表明,并不是掺杂浓度越高,器件性能的提高就越多。具体而言,器件的电学和光学性能会因掺杂浓度过高而减弱。此外,阳极硫化预处理可以显着降低- 10 V的栅极偏压,远低于相同厚度的200-nm SiO2钝化层和类似结构的约40 V。
方法
材料和结构
材料由 2 英寸 n 上的固体源 GEN 20 MBE 系统生产 型 GaSb (001) 衬底。在这项工作中,高性能长波红外探测器基于 P + –π –M–N + 结构体。器件的示意图、高分辨率 X 射线衍射 (HRXRD) 图案和原子力显微镜 (AFM) 如图 1 和图 2 所示。 1 和 2。图 1 表明该结构由 1300 nm 厚的 P + 组成 GaSb 缓冲液,然后是 500 nm 厚的 8-ML InAs/12-ML GaSb(Be:约 1 × 10 18 厘米 −3 )P + 区域,2000-nm 轻度 P 掺杂 12-ML InAs (Be:780 °C 800 °C 820 °C)/7-ML GaSb π 区域,500 纳米未掺杂的 18-ML InAs/3-ML GaSb/5-ML AlSb/3-ML GaSb M 区域,500-nm 厚 18-ML InAs/3-ML GaSb/5-ML AlSb /3-ML GaSb(Si:约1 × 10 18 厘米 −3 ) N + 区域和 30 纳米 N + InAs 帽层。并且它还显示了与结构的模拟带对齐。考虑到 P + 的性能 –π –M–N + π 的掺杂会显着影响 LWIR 探测器 区域,我们制备了三个不同 Be 掺杂温度的样品,从 780 到 820 °C。
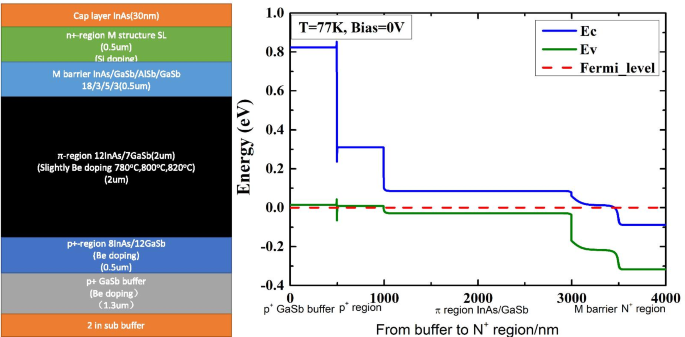
不同π区掺杂水平材料的外延结构和能带排列

不同π区掺杂水平样品的HRXRD摇摆曲线
p 的超晶格周期为 59.3 Å、58.4 Å 和 89.5 Å -联系,p -活性区和 M 结构层,晶格失配分别为 60 弧秒、0 弧秒和 0 弧秒,相应地,如图 2 所示。每个区域中 SL 的半高全宽为 32弧秒、25弧秒和12弧秒,表明材料在界面处质量高。
图 3 显示了在 10 × 10 µm 区域上出现的原子阶跃,粗糙度的均方根 (RMS) 为 1.87 Å。
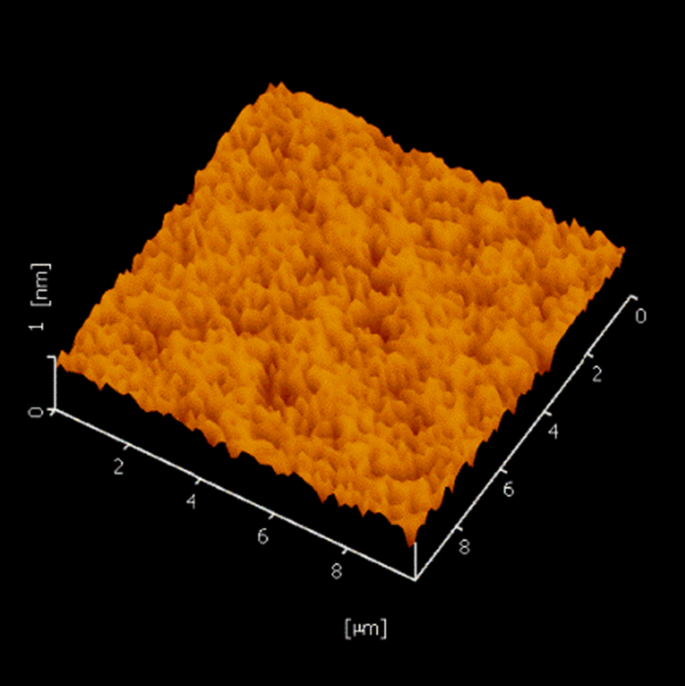
10 × 10 µm的原子力显微镜 2 样品面积
设备结构和制造
该过程类似于参考文献 [12] 中的过程。首先,晶片用 SiO2 覆盖作为听音掩模。然后,采用相应的标准光刻步骤。然后,我们通过电感耦合等离子体 (ICP) 系统进行硬掩模打开。接下来,使用具有 CH4/Cl2/Ar 混合物的电感耦合等离子体 (ICP) 系统获得台面。具体来说,晶圆从顶层蚀刻到P + 联系[12]。然后,去除剩余的 SiO2 层。然后,我们将晶片的一侧浸入硫化钠和乙二醇的混合溶液中,然后对晶片施加恒定电流并设置阈值电压。薄膜表面会形成硫原子层,电阻会发生变化。晶圆上的电压会逐渐升高,直到达到阈值电压,然后硫化完成。然后,元素硫层覆盖有 200 nm SiO2 层。此外,再次进行光刻以通过作为顶部和底部金属电极的金属接触区的SiO2和元素硫层打开窗口。此外,还进行了另一种设计为两种电极形状的光刻;一种电极形状用于门控二极管 (GD),另一种用于非门控二极管 (UGD)。 Ti (50 nm)/Pt (50 nm)/Au(300 nm) 通过为金属电极沉积的电子束沉积。最后,通过金属剥离获得顶部、底部和栅电极。
图 4 说明了 GD 的结构。众所周知,材料蚀刻的倾斜角可以通过改变ICP功率、RF功率、气体流量和腔室压力来调整。在这项研究中,侧壁的实际倾斜角在 80 度到 85 度之间,以便更容易在侧壁上沉积栅极接触。栅电极置于SiO2层的侧壁上。
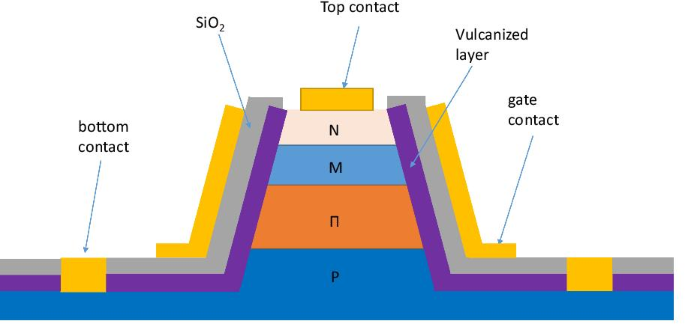
GD的设备结构图
图 5 表明,半二极管在三个管芯中沉积为 GD(780 °C、800 °C 和 820 °C Be 掺杂)。然后,可以获得栅控二极管(GD)和非栅控二极管(UGD)。最终,样品 A (780 °C GD)、样品 B (780 °C UGD)、样品 C (800 °C GD)、样品 D (800 °C UGD)、样品 E (820 °C GD) 和样品 F (820 °C UGD) 可以获得。

光学显微镜下的装置图片
结果与讨论
在红外探测器中,特定探测率 (D *) 通常用于表征检测器性能,其计算公式为(2).
$$D^{*} =\frac{Ri}{{\sqrt {2qJ + 4\frac{kT}{{RA}}} }}$$ (2)其中 q 表示电子电荷量; K 指玻尔兹曼常数; T 是开尔文温度; Ri是指红外探测器的响应度; J 是器件在一定偏压下的暗电流密度;和 RA 是指电阻值和芯片面积的乘积。 J 和 RA 表征器件的电气性能。而 Ri 可以通过以下公式转换为 QE:
$$QE =\frac{hC}{{q\lambda }}Ri$$ (3)其中\(h\) 是普朗克常数,\({ }C\) 是光速,q 表示电荷量,\({}\lambda\) 是特定波长,QE 和 Ri 表征器件的光学性能。图 6 展示了不同 π 样品的光学特性 77 K 时的区域掺杂水平。所有样品在 77 K 时具有相似的 50% 截止波长和 10 µm 的 100% 截止波长。虽然可以通过改变掺杂类型来提高器件的 QE 和响应度p -π 的类型 区域,并不是温度越高,QE 和响应度就越高。然而,QE和响应度随着掺杂浓度的增加而显着降低。对于 II 型应变层超晶格 (T2SL),生长期间的掺杂温度对掺杂浓度至关重要。温度越高,掺杂浓度越高。 780°C的QE达到最大值62.4%,是820°C的QE的1.5倍。这是因为随着掺杂浓度的增加,引入了过多的杂质,导致过剩载流子寿命/扩散长度减少,QE和响应率降低[6]。此外,它们导致图 6a 中的光谱红移。图 6a 和 b 表明,780 °C 是光学表征材料的最佳掺杂温度,在 5 µm 处的峰值响应率为 2.26 A/W,峰值 QE 为 62.4%。
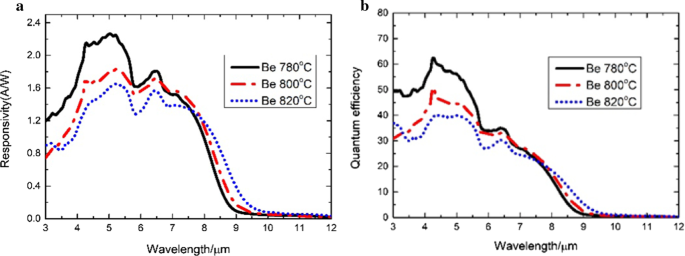
不同π区掺杂水平样品在77 K时的光学特性
图 7 显示了具有不同 π 的 UGD 样品的电气特性 区域掺杂水平为 77 K。器件的电气性能会受到不同 π 的高度影响 区域掺杂浓度 [7]。随着π区掺杂量的增加,一定偏压下的电阻值与裸片面积(RA)的乘积变小,暗电流密度相应变大。与参考文献 [6] 类似,RA 在接近 0 V 时达到最大值,随着反向偏置的增加出现软击穿,表明该器件具有隧道暗电流模式。我们达到 RA 的最大值 1259.4 Ω cm 2 在− 200 mv 下掺入 780°C 的 Be,几乎是掺入 820°C 的 Be 的 40 倍。图7b说明在- 0.1至0 V范围内的负偏压下暗电流密度相似,并且与其他相比,780°C掺杂Be的暗电流密度略小。暗电流为4.9 × 10 −3 A/cm 2 对于掺有 Be 的器件,在 - 70 mv 条件下 780 °C。
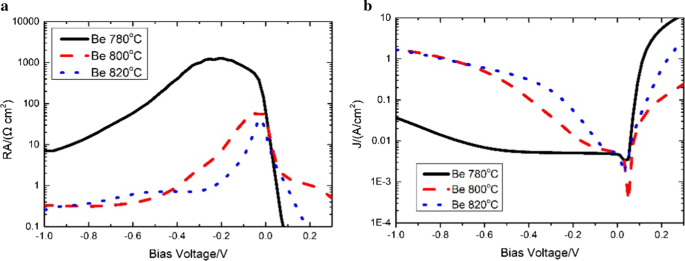
不同π的UGD样品的电学特性 区域掺杂水平在 77 K
对应的D * 可以通过取具体的 Ri, J 来计算 , 和 RA 值在 77 K 的不同偏压下。 图 8 展示了具有不同 π 的 UGD 样品的检测率 地区。在− 30 mv 处,峰值检测率为 5.6 × 10 10 厘米赫兹 1/2 /W 在 5 µm 时掺有 Be 780 °C,而它是 3.8 × 10 10 厘米赫兹 1/2 /W 与 Be 掺杂 820 °C。 Be 掺杂 780 °C 的峰值检测率是 820 °C 掺杂 Be 的 1.5 倍。因此,适当的掺杂浓度极为重要。然而,过高的掺杂浓度会削弱器件性能。

UGD样品在77 K的比检测率与π的相关性 区域掺杂水平和波长
图 9 显示了掺有 Be 的 GD 样品在 760 °C 和 77 K 下的电气特性。与普通栅极电压控制器件不同,本研究首先进行阳极硫化预处理,以显着降低饱和栅极偏置电压。此外,使用NaS2·5H2O和乙二醇的混合物作为硫化溶液。采用阳极硫化钝化法,在器件表面形成一层致密均匀的单质硫。在电化学反应过程中,硫原子与器件表面的悬挂键结合,有助于关闭由表面悬挂键产生的电子通道并隔离器件表面电子-空穴复合机制[11]。然后在元素硫层的表面覆盖一层200nm的SiO2保护层,将栅电极放置在SiO2层的侧壁上。正如先前研究报告的那样,饱和偏置与器件介电层厚度之间的相关性几乎是线性的。图 9 表明,通过简单有效的硫化预处理,器件的饱和偏压可以降低到约 - 10 V;在其他研究中,这个降低的值大约为 40 V,并且在具有相同厚度 SiO2 层的类似结构的器件中大四倍 [10]。此外,RA 达到其最大值 25 Ω cm 2 在接近 0 V。当我们在大约 - 10 V 处施加负偏压时,下降趋势显着放缓。当我们在栅电极上施加 - 10 V 的偏压时,RA 为 10 Ω cm 2 - 0.3 V,是未施加偏置电压时的 40 倍。此外,它比在- 0.6 V的无偏置电压下低近两个数量级。图9b表明暗电流达到其最小值2 × 10 –4 A/cm 2 接近 0 V,并在 - 0.3 V 处降低一个数量级。 正如我们所知,当偏置电压为正时,IV 曲线不会随 0 V 的栅极偏置而变化。此外,当偏置电压从0增加到- 10 V时,器件的RA显着增加;同时,器件的暗电流也相应减小。当偏置电压从- 10到- 20 V变化时,器件的RA略有下降,器件的暗电流相应增加。在顶部和底部电极之间的高储备偏压(例如,- 1 V)下,暗电流随着栅极偏压而减小,然后在超过 - 12 V 时略微增加。这主要是针对栅极偏压特性。进一步的介绍如图 10 所示。对于低反向偏置(例如,- 0.1 V),暗电流似乎随着栅极偏置的增加而增加,这与 - 1 V 时的暗电流完全不同。对于不同的反向偏置,我们怀疑主要的泄漏机制不同。对于低储备偏压,高栅极偏压显示出负面影响,因为它会影响电子和热电子的表面散射。而对于高反向偏压,其表面漏电流减小,漏电流减小。所以它是不同的。

780 °C Be掺杂不同栅极偏置电压和上下电极偏置电压的GD样品的电学特性
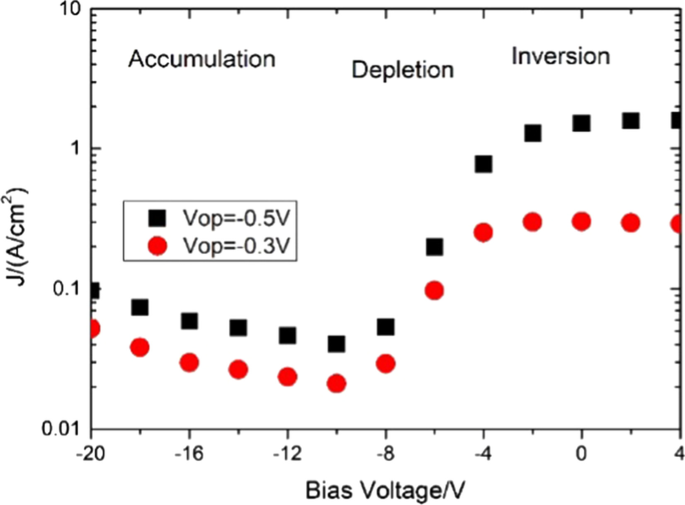
不同二极管工作偏压下780℃Be掺杂GD样品的反向暗电流密度与栅极偏压的相关性
如图 10 所示,在高储备偏压(例如,- 1 V)下,顶部和底部电极之间的暗电流随着栅极偏压而降低,然后略微增加超过 - 12 V;我们可以看到器件存在于三个阶段,偏置电压在 77 K [10] 发生变化。根据参考文献[13],P + 和 N + P + 的区域 –π–M–N + 结构器件重掺杂,M区是一个更大的带区,与π相比,有效质量更大 和 P + 地区;因此,栅极偏置对 π 的影响更大 地区与其他地区相比[13]。使用与Chen [10] 类似的方法,分析了在栅极上施加高负偏压(- 20 到 - 10 V)过程中的三个阶段;结果表明,台面侧壁处于平坦状态或处于堆积状态[8],由于硫化界面,暗电流密度随栅极偏置略有增加。怀疑硫化界面轻微密度不均,某处密度不足轻微破裂。当施加负偏压(- 10至- 2 V)时,台面侧壁进入耗尽状态,暗电流平滑增加。此外,当- 2 V的偏置电压施加到正栅极偏置时,场致耗尽宽度达到最大值并形成反型层;因此,暗电流密度保持恒定。根据参考文献[14],解释了为什么- 0.5 V 处的表面生成-复合(G-R)电流大于- 0.3 V 处的电流。
图 11 表明,当栅极偏置为 − 10 V 时,D * 对于 780 °C Be 掺杂的 GD 样品达到其峰值检测率 1.3 × 10 11 厘米赫兹 1/2 /W at 5 µm,是无偏压下 780 °C Be 掺杂的两倍多,是无偏压下 820 °C Be 掺杂的 3 倍以上,表明施加适当的负偏压可以显着提高设备性能。
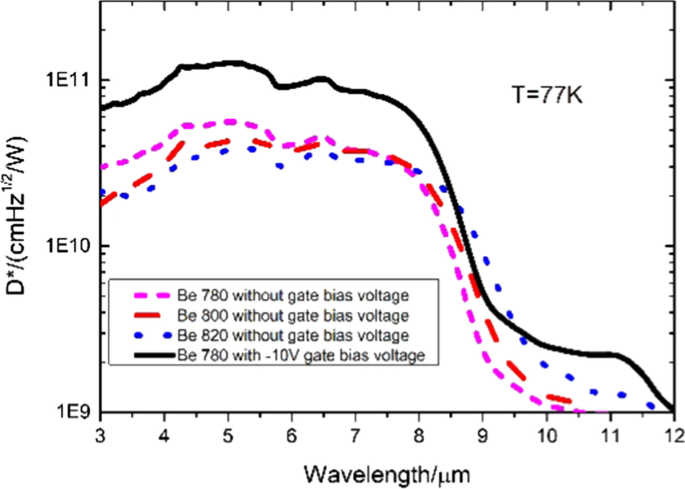
780 °C Be掺杂的GD样品与不同π区掺杂水平的UGD样品的检测率与77 K波长的相关性
结论
2017 年西北大学报告了基于 InAs/InAs1−x 的长波长红外 (LWIR) nBn 光电探测器 Sbx II 型超晶格。该器件在 77 K 下的截止波长为 10 µm,峰值响应率为 2.65 A/W,对应于 43% 的量子效率和 RA 664 Ω cm 2 暗电流密度为8 × 10 5 A/cm 2 , 在 77 K 时,在 80 mV 偏置电压下;光电探测器的比探测率为 4.72 × 10 11 厘米赫兹 1/2 /W [5]。该器件峰值响应率为1.3 × 10 11 厘米赫兹 1/2 /W 在 5 µm 和 0 V 下,- 10 V 栅极偏置电压与 nBn 器件相当。但弱点是影响器件性能的器件RA均匀性。
总之,强制活动区域为 p -通过在π中掺杂 区域可以有效提高 LWIR InAs/GaSb 超晶格 P + 的性能 –π –M–N + 检测器[6]。然而,并不是掺杂浓度越高,器件性能的提升就越多。特别是,器件的电学和光学性能会因掺杂浓度过高而降低。 77 K 下的光学特性表明,我们在 4.26 µm 处获得了 62.4% 的 QE 最大值,在 5 µm 处获得了 2.26 A/W 的最大值,其中掺有 780 °C 的 Be。电气特性表明 RA 的最大值为 1259.4 Ω cm 2 获得掺有 780 °C 的 Be。比检测率达到最大值5.6 × 10 10 厘米赫兹 1/2 /W 在 5 µm 处掺杂有 Be,温度为 780 °C。此外,通过简单有效的阳极硫化预处理可以显着降低器件的饱和偏差。硫化预处理显示出降低栅极偏置电压的潜力。电学表征表明,饱和偏压仅为- 10 V,而在其他研究中,在相同厚度的SiO2层中,未经硫化预处理的类似结构的饱和偏压为40 V。此外,通过在栅电极上施加适当的负偏压,可以显着提高器件性能。最大1.3 × 10 11 厘米赫兹 1/2 /W 在 5 µm 和 0 V 时达到 - 10 V 栅极偏置电压,在 77 K 下掺杂了 780 °C 的 Be。受实验设备和实验条件的限制,我们选择 SiO2 作为介电层,但在后续,考虑使用 Hi-K 培养基进行进一步的实验。理论上可以进一步降低栅极偏置电压。
数据和材料的可用性
作者声明,这些材料和数据可以及时提供给读者,无需获得材料转让协议的不当资格。本研究中生成或分析的所有数据均包含在本文中。
缩写
- LWIR:
-
长波红外探测器
- 量化宽松:
-
量子效率
- T2SL:
-
II型应变层超晶格
- VLWIR:
-
甚长波长红外探测器
- MWIR:
-
中波长红外探测器
- HRXRD:
-
高分辨率X射线衍射
- 原子力显微镜:
-
原子力显微镜
- ICP:
-
电感耦合等离子体
- GD:
-
门控二极管
- UGD:
-
非门控二极管
- D*:
-
特异性检测
- RA:
-
电阻值与芯片面积的乘积
- Ri:
-
红外探测器响应度
- G–R:
-
生成-重组
纳米材料
- 专家访谈:Oxford Performance Materials 的 Scott DeFelice 关于 3D 打印高性能聚合物的演变
- 作为高性能可见光驱动光催化剂的异质结构 WS2/Bi2MoO6 的简便合成
- 通过金属有机化学气相沉积在 InAs 茎上自催化生长垂直 GaSb 纳米线
- 提高阳极 TaO x 纳米管阵列的生物相容性
- N 掺杂 ZnO/g-C3N4 纳米复合材料的可见光驱动光催化性能
- 中空结构LiNb3O8光催化剂的制备和光催化性能
- 具有增强光催化性能的新型 Bi4Ti3O12/Ag3PO4 异质结光催化剂
- 增强新型阳极 PdAu/VGCNF 催化剂在甘油燃料电池中的电氧化性能
- 基于 SnO2-TiO2 Nanomace 阵列的高性能自供电紫外检测器
- 用于高性能超级电容器的二维 VO2 介孔微阵列
- 通过分子束外延在 GaAs 衬底上生长的中波和长波 InAs/GaSb 超晶格的电学特性
- 自动评估 X 射线探测器性能


