通过分子束外延在 GaAs 衬底上生长的中波和长波 InAs/GaSb 超晶格的电学特性
摘要
在目前的工作中,我们报告了通过分子束外延 (MBE) 系统在 GaAs (001) 上生长的中波 (MWIR) 和长波红外 (LWIR) InAs/GaSb II 型超晶格 (T2SL) 的面内电传输特性基质。基于界面错配阵列 (IMF) 技术的 GaSb 缓冲层的生长减少了 T2SL 和 GaAs 衬底之间的巨大晶格失配。为了补偿 InAs/GaSb T2SL 中的应变,我们利用特殊的快门序列来获得类 InSb 和类 GaAs 界面。发现 MWIR InAs/GaSb T2SL 表现出 p - 和 n 分别在低温和高温下导电。有趣的是,观察到传导变化温度取决于生长温度。另一方面,LWIR T2SL 传导仅由电子主导。值得注意的是,LWIR T2SL在低温下的主要散射机制是界面粗糙度散射机制。
背景
由于 InAs/GaSb T2SL 已被 Sai-Halasz 等人概念化。 [1] 1977年,对这种半导体材料的研究引起了极大的关注。基于此 T2SL 的光电探测器理论上比碲化镉汞 (HgCdTe) 和用于下一代红外 (IR) 应用的最先进红外材料系统具有更高的潜力 [2, 3]。有趣的是,InAs/GaSb T2SL 表现出不寻常的 II 型断隙带阵容,其中 InAs 导带最小值比 GaSb 价带顶低 140 meV [1]。因此,重空穴子带和导带底部之间的基本过渡取决于 InAs 或 GaSb 层的厚度 [4]。然而,这种对齐的主要优点是由于抑制了价带中的一些非辐射路径,从而降低了俄歇复合率 [5]。此外,由于大的有效质量(≈ 0.04 m),带间隧穿显着降低 0) 的电子和空穴 [6]。后两个特性允许降低暗电流,从而导致光电探测器的高工作温度(HOT)。
InAs/GaSb T2SL 传统上生长在晶格匹配的 GaSb 衬底上。然而,后者价格昂贵且可用于小于 3 英寸的小尺寸,这阻碍了大格式焦平面阵列 (FPA) 的实现。此外,GaSb 衬底不是“epi-ready”,它们的生长表面包含许多宏观缺陷[7]。此外,GaSb 衬底的吸收系数相对较高 (≈ 100 cm -1 ) 对于 5 μm 以上的红外辐射 [8]。由于其众多优势,GaAs 已被提议作为 InAs/GaSb T2SL 生长的可行候选者 [9,10,11,12]。事实上,它们是“epi-ready”,具有成本效益,并且可以提供高达 6 英寸的大尺寸。此外,GaAs 的吸收系数比 GaSb 低两个数量级。不幸的是,GaAs 和 InAs/GaSb T2SL 之间存在巨大的晶格失配 (~ 7.5%),导致高错配位错密度 (10 9 cm −2 ) [13]。因此,必须构思新的生长技术以减轻应变并降低位错密度。其中包括低温成核技术[14]和IMF技术[15, 16]。
为了提高基于 InAs/GaSb T2SL 的光电探测器的性能,需要更好地了解基本参数。这些参数之一是与少数载流子寿命和扩散长度相关的背景载流子浓度。值得注意的是 InAs 和 GaSb 块状材料具有相反的载流子浓度极性。事实上,使用分子束外延 (MBE) 生长的 InAs 和 GaSb 材料是残留的 n - 和 p -type,分别为 [17, 18]。因此,InAs/GaSb T2SL 的导电性取决于每个成分的厚度。
在本文中,我们研究了 10 ML InAs/10 ML GaSb 和 24 ML InAs/7 ML GaSb T2SL 的面内传输特性,这些 T2SL 分别专用于 MWIR 和 LWIR 区域的检测,生长在半绝缘 GaAs (001) 上基材。这项研究是通过使用范德堡方法执行与温度相关的霍尔效应测量来实现的。此外,还介绍了生长温度对InAs/GaSb T2SL导电性的影响。
方法
InAs/GaSb T2SL 样品在 RIBER Compact 21-DZ 固体源 MBE 系统中的半绝缘 GaAs (001) 衬底上生长。后者配备了用于 III 族元素(铟 (In) 和镓 (Ga))的标准渗出池和用于 V 族材料(砷 (As) 和锑 (Sb))的带阀裂隙池。 As 和 Sb 的裂解温度均保持在 900°C,以分别生产 As2 和 Sb2。机械手热电偶 (TC) 和 BandiT (BT) 用于监测生长温度。后者已根据 GaAs 氧化物解吸温度进行校准。在 610°C(通过 BT 测量)对 GaAs 衬底进行脱氧后,在 585°C (BT) 下沉积 250 nm 厚的 GaAs 层以获得光滑的起始表面。随后,使用 IMF 技术在 440°C 的 BT 温度下生长了 1 微米厚的 GaSb 缓冲层 [16, 19]。该技术包括在 GaAs/GaSb 界面形成 90°错配位错的周期性阵列,从而导致低位错密度 (≈ 10 6 cm −2 ) [20]。在 GaSb 缓冲层生长后,由于发射率变化、表面粗糙化和额外的辐射吸收机制,BT 不能再使用 [21]。因此,InAs/GaSb T2SL 的生长温度仅由 TC 控制。 MWIR 10 ML InAs/10 ML GaSb T2SL 在不同的衬底温度 330、390 和 400°C (TC) 下生长,以研究生长温度对传输特性的影响。另一方面,LWIR 24 ML InAs/7 ML GaSb T2SL 仅在 390°C 下沉积。为了补偿 InAs 和 GaSb 之间的应变,据报道可以产生更好的结构质量 [22, 23] 的特殊百叶窗序列如下使用:InAs 的生长之后是 8 秒的 Sb 浸泡以形成 InSb类键,而 GaSb 生长之后是 2 秒的 As 浸泡以生长类 GaAs 界面。 InAs 和 GaSb 的 V/III 通量比分别为 8.3 和 4.6。此外,InAs 和 GaSb 的增长率均为 0.5 ML/s。通过反射高能电子衍射(RHEED)系统原位监测生长。
已通过帕纳科 X'Pert 的高分辨率 X 射线衍射 (HRXRD) 评估生长的样品,以研究其结构特性。 Cu Kα1 辐射 (λ ≈ 1.5406 Å) 源自线焦点和四反射 Ge (004) 单色器已被使用。在 ECOPIA 系统中使用范德堡方法通过霍尔效应测量评估传输特性,温度范围为 80–300 K。测量是在 6 × 6 mm 2 的方形样品上进行的;通过每个角的铟点进行接触。向样品垂直施加 0.4 T 磁场。
结果与讨论
图 1 说明了测量和模拟的 HRXRD 2θ-ω MWIR 和 LWIR InAs/GaSb T2SL 对称 (004) 反射的扫描曲线。模拟由帕纳科 X’Pert 提供的“外延”软件执行。可以看出,有一些分辨率良好的卫星,其中 MWIR T2SL 最多 4 颗,LWIR 最多 7 颗。这表明生长层的高结构质量,特别是对于 LWIR T2SL。另一方面,在 ω-2θ 中测量的零阶峰的半峰全宽 (FWHM) MWIR 和 LWIR T2SL 的方向分别为 107 和 99 弧秒。超晶格周期 (L ) 由两颗相邻卫星之间的角度距离 (Δθ ) 如下:
<图片>
HRXRD 004 2θ-ω a 的扫描 中波红外b 和 LWIR InAs/GaSb T2SL。实验(黑线)和模拟(红线)HRXRD 2θ-ω 扫描 a 的 (004) 反射 中波红外 T2SL;有很好分辨的卫星,阶数高达4,这是超晶格质量好的特征。零阶峰值的 FWHM 为 107 弧秒,b 和 LWIR InAs/GaSb T2SL;有高达7阶的卫星峰,证实了高结晶质量。零阶峰值的 FWHM 为 99 角秒。每个超晶格的周期由相邻卫星之间的距离计算
$$ L=\lambda /\left(2\times \Delta \theta \times \mathit{\cos}{\theta}_{SL}\ \right) $$ (1)其中 λ 是前面提到的入射 X 射线光束的波长,θ SL 是超晶格零阶峰的布拉格角。从图 1 中,MWIR 和 LWIR T2SL 的周期分别为 6.74 ± 0.01 和 10.24 ± 0.02 nm。通过将测量曲线与模拟曲线拟合,发现一个周期的 MWIR T2SL 的成分如下:GaSb 3.4 nm (11.2 ML)、GaAs 0.1 nm (0.2 ML)、InAs 3.0 nm (10.1 ML) 和InSb 0.2 纳米(0.5 毫升)。此外,LWIR T2SL 成分的厚度如下:GaSb 2.3 nm (7.5 ML)、GaAs 0.1 nm (0.2 ML)、InAs 7.4 nm (24.7 ML) 和 InSb 0.4 nm (1 ML)。由零阶峰与GaSb缓冲层之间的夹角确定的晶格失配为8.9 × 10 -3 和 4.5 × 10 −3 分别用于 MWIR 和 LWIR T2SL。图 2 显示了生长的 T2SL 的不对称 (115) 倒易空间图 (RSM)。在两个样品中,超晶格的卫星和 GaSb 峰垂直对齐(它们具有相同的散射矢量 Qx 分量),这导致两个 T2SL 几乎完全应变的结论。
<图片>
a 的不对称 115 RSM 中波红外和b LWIR InAs/GaSb T2SL。 a的非对称反射(115)的倒易空间图 中波红外和b LWIR InAs/GaSb T2SL。两个超晶格中的峰值垂直对齐(它们具有相同的散射矢量 Qx 值)。因此,MWIR和LWIR的两个超晶格实际上是完全应变的
生长的 MWIR InAs/GaSb T2SL 的面内电参数如图 3 所示。可以看出,无意掺杂的 InAs/GaSb T2SL 表现出可重复的导电类型变化。尽管受到 GaSb 缓冲层的影响 (p -type) 在霍尔效应测量中,应注意导电类型的变化仅归因于 T2SL 层。几个小组也报告了这种变化 [6, 24,25,26]。 T2SL 表现出 p -型传导低于发生变化的温度 (T ch ) 和一个 n -T上方的-型传导 ch .如前所述,InAs 和 GaSb 层表现出 n -type 和 p 型传导,分别。因此,两种成分具有相似厚度的 InAs/GaSb T2SL 的残余背景是由 T2SL 的二元成分的多数载流子补偿引起的 [27]。对于 T 的值 ch , Mohseni 等。 [6] 报道了 140 K 的值,Christol 等人。 [24] 的值为 190 K,而 Khoshakhlagh 等人。 [25] 指出值为 200 K。片状载流子浓度和迁移率的行为受众所周知的固有声子散射(声学、压电、极性和非极性光学)机制控制。异常地,霍尔迁移率随着 T 以上温度的升高而增加 ch (图 3b);这是可能 由于 GaSb-on-InAs 界面处的 InSb 界面引起的电离陷阱 [6]。 T ch 对于在 330、390 和 400°C 下生长的 T2SL,值分别为 145、195 和 225 K(图 3);这是由于可能 到较高的生长温度下的高空穴浓度,这使 T ch 以降低温度。高空穴浓度是由于高生长温度下的缺陷和电离空位造成的。在 390°C 下生长的 InAs/GaSb T2SL 的特征在于载流子浓度为 1.8 × 10 16 和 2.5 × 10 16 厘米 −3 分别为 80 和 300 K。这个结果比 Mohseni 等人报道的要好。 [6](霍尔浓度范围从1.5到4 × 10 17 厘米 −3 ) 并且实际上与 Christol 等人报道的相同。 [24](霍尔浓度为1.6 × 10 16 和 6 × 10 16 厘米 −3 分别为 100 和 300 K)。另一方面,霍尔迁移率为 1300 (p -type) 和 3200 cm 2 /V s (n -type),分别为 80 和 300 K。达到的流动性比 Christol 等人报告的要高得多。 [24],霍尔移动度为 100 和 1800 cm 2 /V s 分别为 100 和 300 K。
<图片>
一 霍尔浓度和b 在不同温度下生长的 MWIR InAs/GaSb T2SL 的霍尔迁移率。在不同温度下生长的 MWIR InAs/GaSb T2SLs 的电参数。 一 霍尔浓度:三个 T2SL 表现出电导率的变化。它们是 p - 在低温和 n 下键入 - 高温下的类型。 b 霍尔迁移率:迁移趋势有两个区域。对于低温,由于不同的散射机制,迁移率会降低。对于高温,迁移率随着温度的升高而增加,这可以通过类 InSb 界面中的电离陷阱来解释。当生长温度升高时,发生电导率变化的温度升高,这是由于在较高温度下缺陷水平较高
三个不同样品的电阻率如图 4 所示。可以注意到电阻率和温度有两个明确定义的斜率。对于每个样品,可以从阿伦尼乌斯定律中提取两个热活化能。对于 n -型区域,活化能E 一个 对于在 330、390 和 400°C 下生长的 T2SL,分别为 58、72 和 68 meV。而对于 p -类型区域,E ap 对于分别在 330、390 和 400°C 下沉积的 InAs/GaSb T2SL,分别等于 7、12 和 14 meV。对于低温(低于 T ch ),T2SL 显示 p -type 由于 p - 与 E 相关的类型载体 ap 它们主导着载流子的产生和重组机制。对于高于 T 的温度 ch ,T2SL 表现出 n 由于与高激活能 E 相关的深能级载流子的激活引起的 - 型传导 一个 .这些深能级的来源是体 InAs 中的浅能级,这是 InAs 和 InAs/GaSb T2SL 之间的能带排列的结果,并作为 InAs/GaSb T2SL 中的深能级 [28]。
<图片>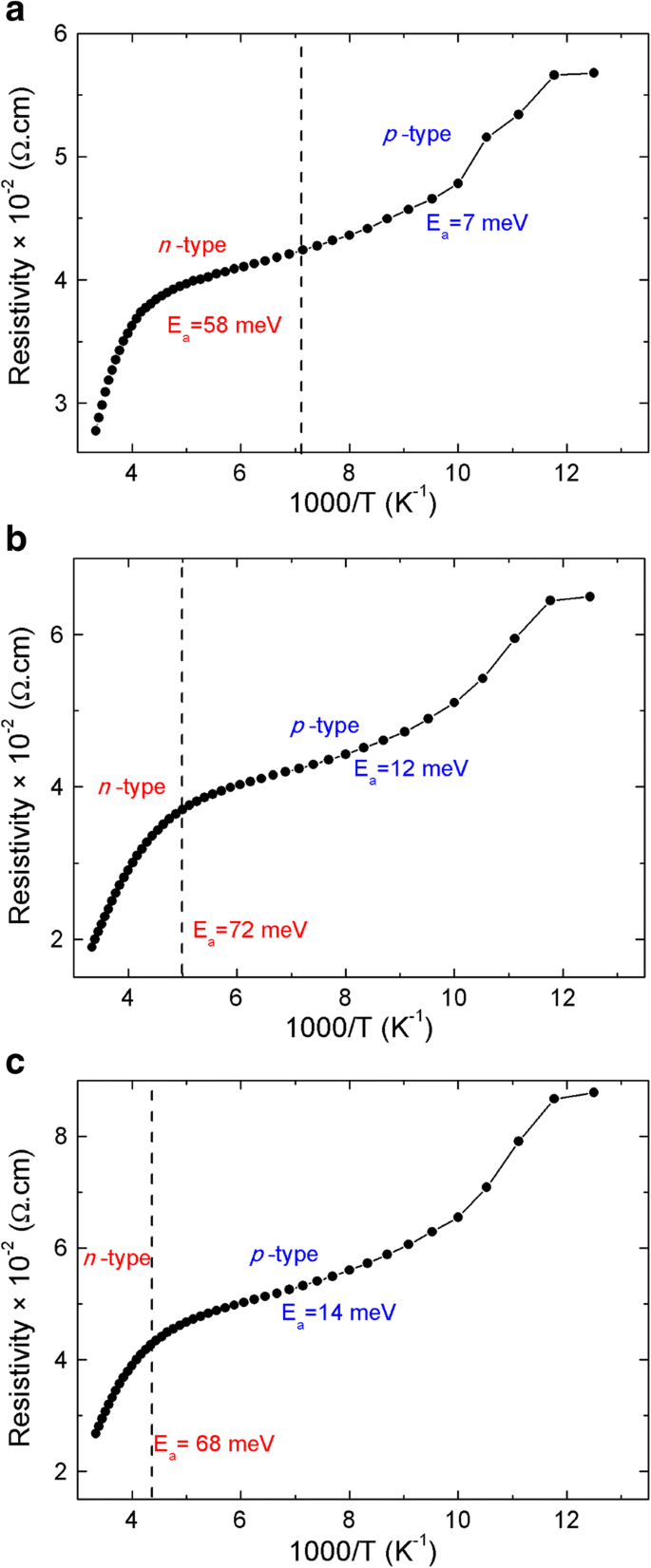
在 a 生长的 MWIR InAs/GaSb T2SL 的霍尔电阻率 330°C,b 390°C 和 c 400°C。不同生长温度下沉积的 MWIR InAs/GaSb T2SL 的霍尔电阻率,a 330°C,b 390°C 和 c 400°C。对于每个图形,有两个明确定义的斜率。根据阿伦尼乌斯定律,可以提取出两个热能,这证实了两个杂质能级的存在。一个代表n -类型的载体,第二个对应p 型载体。与 n 相关的深层杂质水平 型载流子是 InAs 和 InAs/GaSb T2SL 能带排列的结果
LWIR InAs/GaSb T2SL 的霍尔浓度、迁移率和电阻率如图 5 所示。与 MWIR T2SL 相反,在该样品的情况下,电导率类型没有变化。该 T2SL 表现出 n 型传导。 p 的影响 - 型 GaSb 缓冲层(低迁移率载流子)对此 n 的霍尔效应测量 型 T2SL(高迁移率载流子)可以忽略不计,因为霍尔迁移率与载流子迁移率的平方成正比。 Khoshakhlagh 等。 [25] 报告了 13 ML InAs/7 ML GaSb T2SL 的相同结果。此外,Szmulowicz 等人。 [29]指出LWIR T2SL,其中InAs层比GaSb厚,趋于n -类型。这个n - 型传导是由于 InAs 层的大厚度(残余 n 掺杂。)与 GaSb 相比。这些n 型载流子与 33 meV 的活化能相关(图 5b)。霍尔浓度和迁移率的行为对于 n 是典型的 型半导体,但低于 95 K 的温度范围除外,其中载流子的浓度和迁移率几乎与温度无关。这表明在该温度区域存在与温度无关的散射机制。后者被证明是界面粗糙度散射 (IRS) 机制 [30,31,32,33,34]。这种机制在低温下占主导地位,此时声子散射被冻结 [35]。 IRS机制是由于界面的存在,以及层厚的变化,导致电子能级的变化;因此,它们充当载流子散射的来源 [35]。此外,由 IRS 机制主导的霍尔迁移率与 InAs 厚度的六次方成正比 (\( \mu \propto {d}_{\mathrm{InAs}}^{6.2} \)) [35]。
<图片>
一 霍尔浓度、霍尔迁移率和 b 无意掺杂的 LWIR InAs/GaSb T2SL 的霍尔电阻率。 LWIR InAs/GaSb T2SL 的传输特性。 一 霍尔浓度和迁移率:这个超晶格只表现出 n 型传导适用于整个温度范围。霍尔浓度随着电离效应引起的温度升高而增加。另一方面,对于高于 95 K 的温度,霍尔迁移率行为受不同散射机制(声子和电离杂质)的控制。对于低于 95 K 的温度,迁移率是恒定的(以及霍尔浓度),这证实存在另一种与温度无关的散射机制。后者是界面粗糙度机制。 b 霍尔电阻率:根据阿伦尼乌斯定律,只有一种热能与一种杂质水平相关
结论
总之,InAs/GaSb T2SLs 已经使用基于 IMF 技术的 GaSb 缓冲层在 GaAs 衬底上生长。此外,这些 T2SL 已被证明用于 MWIR 和 LWIR 检测区域。已经发现 MWIR T2SL 表现出传导类型的变化,形式 p - 到 n - 温度升高时类型。此外,随着 T2SL 的生长温度升高,发生变化的温度也会升高。这种传导类型的变化归因于具有两种不同活化能的两种杂质能级的存在。另一方面,LWIR InAs/GaSb T2SL 传导被证明是 n - 整个温度范围的类型。除了传统的散射机制外,IRS 机制被证明是低温下的主要散射机制。这些结果有助于更好地了解 InAs/GaSb T2SL 的物理性质,从而提高基于该材料的红外光电探测器性能。
缩写
- BT:
-
盗贼
- FPA:
-
焦平面阵列
- FWHM:
-
半高全宽
- 热点:
-
工作温度高
- HRXRD:
-
高分辨率X射线衍射
- IMF:
-
界面错配阵列
- IR:
-
红外线
- 国税局:
-
界面粗糙度散射
- LWIR:
-
长波红外
- MBE:
-
分子束外延
- MWIR:
-
中波红外
- RHEED:
-
反射高能电子衍射
- RSM:
-
互易空间图
- T2SL:
-
II型超晶格
- TC:
-
热电偶
纳米材料
- 钴掺杂 FeMn2O4 尖晶石纳米粒子的制备和磁性
- 走向 TiO2 纳米流体——第 1 部分:制备和性质
- 铈的金刚石切割的分子动力学建模和仿真
- 化学蚀刻制备的硅纳米线的光学和电学特性
- 分子束外延生长的 MoSe2 中带隙的温度依赖性
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- 变质 InAs/InGaAs/GaAs 量子点异质结构光电压的双极效应:光敏器件的表征和设计解决方案
- 使用分子束外延法制备锗铋薄膜及其光学特性
- 探测 Ag n V (n =1-12) 簇的结构、电子和磁特性
- 纳米粒子毒性对其物理和化学性质的依赖性
- <100>拉伸载荷下钽单晶弹性特性的温度和压力依赖性:分子动力学研究
- 氧化锌纳米粒子的特性及其对微生物的活性


