变质 InAs/InGaAs/GaAs 量子点异质结构光电压的双极效应:光敏器件的表征和设计解决方案
摘要
与假晶(常规)InAs/GaAs 量子点 (QD) 结构相比,研究了 GaAs 衬底和附近层对垂直变质 InAs/InGaAs 光电压的双极效应。变质和假晶结构都是通过分子束外延生长的,在生长的 n 处使用底部接触 + - 缓冲器或 GaAs 衬底。与 QD、润湿层和缓冲液相关的特征已在两种缓冲液接触结构的光电光谱中确定,而基底接触样品的光谱显示出归因于 EL2 缺陷中心的额外起始。与基板接触的样品表现出双极光电压;这被认为是由于与 QD 相关的组件与其覆层与基板相关的缺陷和最深生长层之间的竞争而发生的。在缓冲液接触结构的光谱中没有发现直接的底物效应。然而,n 的显着负面影响 + 在 InAs/InGaAs 结构中观察到光电压和光电导信号上的 -GaAs 缓冲层。分析获得的结果和进行的计算,我们已经能够为变质 QD 结构的设计提供见解,这对于开发新型高效光子器件很有用。
背景
在过去的 20 年里,由于光敏性、制造的简便性和低成本、光谱可调性以及寿命短的高效发射,含有半导体纳米结构的复合材料在光子应用中得到了广泛的应用 [1,2,3,4,5 ]。 In(Ga)As 量子点 (QD) 异质结构是一类重要的红外敏感纳米结构,已广泛应用于各种光子器件,如激光器 [2, 6]、单光子源 [7, 8]、光电探测器 [9,10,11,12,13] 和太阳能电池 [14,15,16]。许多研究致力于改善这种光敏器件的光电特性。例如,可以通过中间带隙[17, 18]或多激子产生[19, 20]的激发来扩展光敏范围,从而使基于QD的太阳能电池的功率转换效率理论上可以超过单个的限制。 -带隙太阳能电池[21]。应变平衡 [22] 和错配管理技术 [23] 以及热退火 [24] 等方法用于减少这些结构中的应变、操作工作范围 [25] 以及增加由于抑制作为复合中心的应变相关缺陷[26]。
一种有效的减少应变的方法是基于 InGaAs 变质缓冲层 (MB) 的生长,而不是传统的 GaAs 变质缓冲层。因此,InAs/InGaAs QD 结构在过去十年中引起了极大的兴趣 [27,28,29]。通过在 InGaAs MB 上生长 QD,人们可以观察到与 GaAs 基质中的传统 QD 相比,其形成过程和 QD 光学特性的本质差异 [25, 30,31,32,33]。例如,InGaAs 限制层减少了 QD 和缓冲区之间的晶格失配,从而减少了 QD 中的应变。结果,InAs 的带隙减小,并且观察到发射波长显着增加 [34]。 MB 作为限制材料的应用允许将其值转移到 1.3 和 1.55 μm 的电信窗口 [28, 29, 35, 36]。
同样,将变质 InAs QD 结构的光电特性应用于诸如变质红外光电探测器 [11,12,13] 和太阳能电池 [37,38,39] 之类的光敏器件的设计上也有一些有希望的尝试。进行了一些研究以开发结构设计 [25, 31,32,33] 和其他研究以提高光电性能 [39, 40]。正在进行研究以减少异质结构中的应变 [34, 41],因为这会显着改善太阳能电池的光电流密度和光谱响应 [39, 40] 以及此类结构的光发射效率 [ 29, 32, 42]。
光敏器件的开发需要对光电特性进行深入研究。光电压 (PV) 或光电导 (PC) 研究是确定光响应作为光能、能级之间的跃迁、载流子传输和器件工作范围的函数的理想工具 [10, 43, 44]。然而,尽管去年已经对具有变质 InAs QD 的结构的光电特性进行了一些研究 [37,38,39,43],但光响应机制的全部方面仍然不清楚,以及 MB 的影响关于纳米结构的特性。特别是 GaAs 衬底和相关界面对 InAs/InGaAs/GaAs QD 结构光电光谱的影响尚未详细探讨。尽管为避免基板影响做出了重大努力,但光响应受基板和附近层通过分子束外延 (MBE) 生长的影响。因此,虽然应用的接触几何形状是为了保持底层和基板的电活性,但我们在之前的研究中已经检测到它们对 PV 和光电流的显着负面影响 [43]。最近,我们比较了变质 InAs/In0.15Ga0.85As QD 结构与标准 InAs/GaAs QD 结构的光电特性,发现变质 InAs/In0.15Ga0.85As 异质结构的光电流不受能级的影响与 QD 附近的缺陷有关 [45]。此外,已经得出结论,可以开发出具有类似纳米结构作为活性材料的 1.3 μm 的高效光子器件。
在这项工作中,我们继续研究具有嵌入变质 In0.15Ga0.85As 或传统 GaAs 缓冲器的 InAs QD 的异质结构的光电特性,重点是 GaAs 衬底和附近 MBE 层的影响。为了清楚地了解衬底和缓冲层的作用,我们考虑了在 (i) In0.15Ga0.85As 缓冲层或 (ii) 底部 GaAs 衬底上具有底部接触的结构(见图 1)。因此,根据底部接触选择,电流流过 (i) 仅 QD 和缓冲层,以及 (ii) 包括基板及其与 MBE 层界面的完整结构。对结果和计算的分析使我们能够深入了解变质 QD 结构上光传感器的最佳设计。
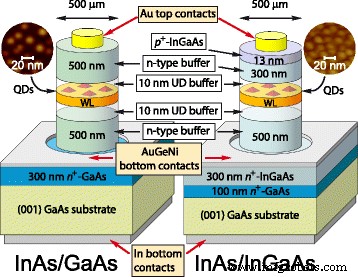
(彩色在线)变质 InAs/In0.15Ga0.85As/si 的示意图 -GaAs(右)和 InAs/GaAs/si -GaAs(左)研究的 QD 样品;显示未加帽结构的AFM图像
方法
采用 MBE 在 (001) 半绝缘 (si ) GaAs 衬底。基材为 n -type,值为 3 × 10 7 厘米 −3 残余载流子浓度,厚度为 500 μm,电阻率为 2 × 10 7 Ω × 厘米。变质 InAs/InGaAs QD 结构由 (i) 100-nm n 组成 + -GaAs 缓冲层在 600 °C 下生长,(ii) 300 nm 厚 n + -In0.15Ga0.85As MB with n =5 × 10 18 厘米 −3 在 490 °C 下生长,(iii) 500 nm 厚 n -In0.15Ga0.85As MB with n =3 × 10 16 厘米 −3 在 490°C 下生长,(iv) 3.0 个单层 (ML) 自组装 InAs QD 嵌入在 20-nm 未掺杂 In0.15Ga0.85As 层中,在 460°C 下生长,(v) 300-nm n -In0.15Ga0.85As 上覆盖层 n =3 × 10 16 厘米 −3 在 490°C 生长,和 (vi) 13-nm p + 具有 p 的掺杂 In0.15Ga0.85As 帽 =2 × 10 18 厘米 −3 在 490°C 下生长(图 1)。除了 QD 的生长速度为 0.15 ML/s 外,生长速度为 1.0 ML/s。未掺杂的层是将 QD 与 n 分开所必需的 掺杂区域,从而减少非辐射复合中心的影响,从而最大限度地提高 QD 发光效率 [30, 46]。标准 InAs/GaAs QD 结构包括 (i) 300-nm n + -具有 n 的 GaAs 缓冲层 =5 × 10 18 厘米 −3 在 600 °C 下生长,(ii) 500 nm 厚 n -GaAs MB 与 n =3 × 10 16 厘米 −3 在 600°C 下生长,(iii) 3.0 MLs 的 InAs QD 嵌入在 20-nm 未掺杂的 GaAs 层中,在 460°C 下生长,以及 (iv) 500-nm n -GaAs 上覆盖层 n =3 × 10 16 厘米 −3 在 600°C 下生长。除了 QD 的生长速度为 0.15 ML/s 外,生长速度为 1.0 ML/s。
未加帽结构的原子力显微镜 (AFM) 图像如图 1 所示。通过对类似结构的 AFM 数据的分析,最常见的 QD 尺寸值估计为 20 纳米(直径)和 4.9 纳米(高度),用于变质标准量子点 [30、31、45] 的量子点和 21 纳米(直径)和 5.0 纳米(高度)。
对于光电测量,在结构上蚀刻了 500 微米厚的圆形台面直到底部缓冲 n + 层数;然后在台面顶部蒸发直径为 400 微米、厚度为 70 纳米的金整流顶部触点。在底部获得欧姆接触 n + -InGaAs 和 n + -GaAs 缓冲层,Au0.83Ge0.12Ni0.05 合金分别在 400°C 和氮气气氛中沉积 1 分钟。在相同样品的其他部分的衬底底部制作厚铟欧姆接触,以便对流过 GaAs 缓冲器和 si 的电流进行测量 -GaAs 衬底。 I 已验证触点的欧姆性 -V 测量,接触一块基材;发现电流-电压特性呈线性(数据未显示)。
遵循参考文献中提出的方法。 [47] 和其他作品 [48, 49] 中使用的薄 p + -Au 触点和 n 之间的 InGaAs 层 -InGaAs 层用于提高肖特基势垒高度,因为通过在 n 上简单沉积金属获得的结构 -InGaAs 表现出相对较低的肖特基势垒高度。因此,薄 p 的沉积 + -InGaAs 层扩大了肖特基势垒高度,使其与 Au-GaAs 接触的势垒高度相似,从而保持了变质结构和 InAs/GaAs 结构的势垒轮廓的相似性。
为了结构和接触设计以及理解由 In0.15Ga0.85As 或 GaAs MB、In(Ga)As QD、未掺杂帽层和 Au/AuGeNi 接触组成的两种结构的能量分布,进行了计算使用 Tibercad 软件 [50]。带分布在漂移扩散近似中建模,考虑到应变条件、与 InGaAs/GaAs 界面区域的缺陷相关的陷阱密度、接触附近的耗尽层和适当的肖特基势垒高度。为了计算变质 QD 带轮廓,考虑了 AFM 数据的大小并包括应变效应,遵循参考文献中已经验证的方法。 [42, 51]。 QD 量子能级的计算超出了本文的范围,QD 建模之前已经在参考文献中进行过。 [45]。然而,在这项工作中,我们计算了包括衬底在内的整个异质结构的能带分布。
在室温 (RT) (300 K) 和相同光源强度 (1.5 mW/cm 2 )。使用电流放大器和直流技术 [10, 43,44,45] 以 1 V 偏置测量光电流。电流是通过 100 kΩ 串联负载电阻上的电压信号降来测量的(参见图 5 中的插图)。在 532 nm 激发的光致发光 (PL) 在 300 K 下测量。有关结构和方法的一些信息在参考文献中进行了更详细的描述。 [45].
结果与讨论
A.光电表征
InAs/In0.15Ga0.85As 和 InAs/GaAs 样品的 PV 光谱如图 2 所示。仅接触 MBE 层,厚 n -InGaAs 或 n -GaAs 缓冲液,光谱的特征已在别处描述 [45]。 InAs/In0.15Ga0.85As 在 0.88 eV 处的光谱阈值与 QD 系综中的基态吸收有关,这对应于早先测量的 RT 处 PL 光谱中 QD 带的开始 [45](图 3)。 2a)。变质 QD 发射光谱在 0.94 eV 处显示出宽带,这在 1.3 μm (0.95 eV) 的电信范围内,而 QD PL 表现出良好的效率,正如之前的论文 [30, 45, 46, 52]。 PV 光谱的宽带峰值为 1.24 eV,边缘为 1.11 eV,这是由于 In0.15Ga0.85As MB 和润湿层 (WL) 中的载流子生成,包括穿过浅能级的途径。应该补充的是,为 MBE 生长层计算的 In0.15Ga0.85As 带隙为 1.225 eV [53],在 1.2 eV [45] 处观察到 WL PL。此外,观察到高于 1.36 eV 的显着急剧下降可能是由参考文献中提到的位于相互接触区域外部的重掺杂 GaAs 缓冲层的间接影响引起的。 [43]。缓冲层被许多浅能级和由 MBE 生长缺陷和掺杂中心引起的带非均匀性填充,这些缺陷和掺杂中心使 GaAs 的带间吸收发生红移 [33, 46, 54, 55]。对于传统的缓冲接触 InAs/GaAs 纳米结构,图 2b 中 PV 光谱在 1.05 eV 处的起始源自 QD 基态,正如 PL 光谱所证实的那样,而 1.3 eV 处的急剧步长可能与WL [56] 中的转换。 1.39 eV 之后的特征显然与掺杂 GaAs 上缓冲层的吸收有关。下面将详细讨论这种作用的机制。

(Color online) a 的室温 PV 光谱 变质 InAs/In0.15Ga0.85As 和 b InAs/GaAs QD 结构;测量 PV 仅接触 MBE 层 [45](黑色曲线)并通过半绝缘 si -GaAs 衬底(蓝色)。通过 si 测量的 PV 光谱 -GaAs 衬底被电压符号反转为分别低于 1.68 和 1.44 eV 的 a 和 b .曲线的低能量部分在插图中给出;在[45]之前测量的两种结构的QD PL波段用于QD基态能量定位(红色)
如上所述,在 InAs/In0.15Ga0.85As 结构中,PV 信号在 1.36 eV 以上的急剧下降与 n 有关 + -GaAs 底层覆盖衬底。为了清除底部 AuGeNi 触点下方的层对光响应的影响,我们研究了在衬底背面使用铟触点的结构的光电特性。与之前允许单极 PV 的 Au 和 AuGeNi 接触几何形状不同,已经观察到与样品顶部和基板背面接触的结构的双极信号(图 2)。需要注意的是,PV 符号沿光子能量轴发生变化,在图 2 中,对于 InAs/In0.15Ga0.85As 和 InAs,两个样品的光谱都被低于 1.68 和 1.44 eV 的电压符号反转/GaAs QD 结构。在这里,当与 MBE 层接触时,当正电位施加到顶部 Au 触点而负电位施加到底部触点时,PV 被认为是正的。
上面提到的所有光学跃迁都对基板-顶部接触几何结构中的结构的 PV 信号有贡献。然而,当通过基板测量 PV 时,变质结构和传统结构的信号起始发生在大约 0.72 eV。 0.72 eV 的开始归因于位于 si 的 EL2 缺陷中心的转变 -GaAs 衬底和相关界面在 GaAs 导带下方接近 0.75 eV [57],考虑到通过浅层缺陷过渡的可能性 [46, 54, 55]。与它们的位置以及 EL2 PC 起始红移相关的方面已在别处详细讨论 [10, 45]。由于在与 InGaAs 或 GaAs 缓冲液接触的样品的光谱中没有观察到 QD 相关带下的信号(图 2),我们得出结论,衬底和相关界面对 MBE 生长的异质结构的性质没有实质性影响.
要了解样本中 PV 信号的外观,应查看图 3,其中我们显示了沿生长方向计算的带状分布。 Au和AuGeNi触点之间的PV起源的详细解释在之前的论文中给出[45]。综上所述,光激发电子(空穴)主要向衬底(表面)漂移,在 Au 触点处为正电位,在 AuGeNi 触点处为负电位。

(在线颜色)计算变质 InAs/In0.15Ga0.85As(上)和假晶 InAs/GaAs(下)结构中的能带分布,以解释 PV 机制。 AuGeNi 接触下方更深层的带弯曲以灰色表示。在 PV 光谱中观察到的光学跃迁由垂直箭头表示;粗箭头表示内场下光激发电荷载流子的漂移方向(PV 产生); E F 是费米能量。计算采用Tibercad软件[50]
从具有电活性si的结构解释双极光伏 -GaAs 衬底,可以考虑图 3 中计算出的能带结构。像以前一样,在顶层以及 QD 和 WL 中产生的载流子可能在顶部给出“+”,在衬底给出“-”。半绝缘衬底中的费米能级远低于 n 中的费米能级 掺杂的 MBE 层。因此,在 n 附近的能带弯曲 + -GaAs/衬底界面与 MBE 生长结构的其余部分相反(见图 3)。因此,n 中的激发 + -GaAs 层和衬底(高于 1.36 eV)提供与 QD、WL 和缓冲器相反的 PV 信号。这同样适用于来自 GaAs 衬底的 EL2 缺陷(高于 0.72 eV)的激发,尤其是 n 中的类 EL2 缺陷 + -GaAs/GaAs 应变区 [46, 57]。底物和n的贡献 + -GaAs 对总 PV 信号的影响本质上强于上层 MBE 层的信号,通常在较低激发能量下观察到 PV 的负信号,而 InGaAs 层和纳米结构的影响在各自的光谱曲线上表现为谷值. 2. 通过比较与 MBE 缓冲液接触的结构的 PV 曲线上的 QD、WL 和缓冲液光谱带与基底顶部接触样品的光谱中的谷值,可以清楚地看出这一点。然而,对于更高的能量,激发在更接近样品表面的地方被吸收,不会到达更深的 MBE 层和基板,这是负信号的主要来源。因此,PV 信号在较大能量下变为正。因此,电活性 si 的存在 -substrate 导致与上 MBE 生长层相关的光谱分量和与基板相关的缺陷和 n 之间的竞争 + -GaAs吸收。
此外,在最近对 p 的详细研究中,通过表面 PV 光谱观察到了 1.35 eV 以上的类似特征。 基于si的掺杂InAs/GaAs QD和InAs/InGaAs点阱结构 -GaAs 衬底 [58]。与我们的情况不同,PV 幅度的急剧下降可以通过低于和高于 1.35 eV 产生的不同电荷载流子来解释。然而,考虑到所引用和呈现的结构的巨大差异以及应用方法的细节,我们遵循我们对自己结果的解释。
基于 AuGeNi 接触下方的能带弯曲的概念,可以解释图 2a 中观察到的缓冲接触变质 InAs/InGaAs 结构中 PV 信号在 1.36 eV 以上的急剧下降。这种光谱特征是由于底物和最深 MBE n 的影响 + -GaAs 层。事实上,那里产生的电子在本征场下移动到 AuGeNi 触点,在那里引起额外的电场,因此由于 InGaAs/GaAs 异质结处的能带弯曲而产生的势垒显然太低而不能成为电荷载流子的基本障碍。这使上层的能带弯曲对齐,这直接有助于 PV,因此,减少了 n 上方光激发的载流子的供应 + -GaAs 层,因此,总 PV 信号。
在图 2b 中观察到与 MBE 缓冲液接触的伪晶样品的光谱中接近 1.39 eV 的一个小特征,尽管考虑到类似的带弯曲,应该预计像变质结构中的信号急剧下降高于 1.36 eV n 附近 + -GaAs/衬底界面。这样的特征不仅仅是底物和n的属性 + - 掺杂的 GaAs;基于 p 在 In(Ga)As/GaAs QD 结构中检测到这种跃迁 掺杂 [58] 和未掺杂的 GaAs [10, 55]。这些转变显然也发生在我们的假晶结构的上部 GaAs 层中,主要补偿了近基板层对 PV 信号的负面影响。结果,在图 2b 中 InAs/GaAs 样品的黑色曲线上只能观察到近衬底层的影响可以忽略不计,而不是源自更深 GaAs 层的变质曲线的下降,尽管有类似的双极观察到底物直接参与光伏形成的影响。
与 MBE 缓冲液接触的 InAs/GaAs 样品的光谱中 1.39 eV 后出现小特征的原因可能与上面讨论的变质 InAs/InGaAs 样品不同。在我们看来,这是由于上部 MBE 生长的 500 nm 厚 GaAs 缓冲器的吸收边缘造成的信号轻微下降,遮蔽了 QD 和 WL,而 QD 和 WL 在这些光子能量下是更有效的 PV 贡献者。实际上,在 QD 和 WL 中产生的电子和空穴被带到不同的侧面并避免复合,这与体积生成不同,后者更有可能复合。这是有效检测来自甚至单层 QD 和 WL 的光载流子的主要原因。更高能量的光子在近地表 n 中被带间吸收 -GaAs 缓冲层和电子远离空穴逃逸到样品体积,导致 PV 急剧上升至 1.4 eV 以上。对基于 InAs/GaAs 结构的太阳能电池的研究证实了缓冲接触 InAs/GaAs 结构中 1.36 eV 特征的正确性,而不是假设的变质结构,在 n + -GaAs 衬底 [18, 24, 59],即从接触到接触整个样品弯曲的单调带。它们的 PV 光谱显示出相同的特征,没有与 MBE 层与基板的界面相关的障碍。此外,在具有横向接触几何形状且无本征场的 InGaAs/GaAs 结构的 PC 光谱中,在相同光谱范围内观察到窄倾角 [10, 55]。
在 1 V 偏压下获得的结构的 PC 光谱如图 4 所示。与 MBE 层接触的结构与图 2 中的 PV 非常相似。来自 QD、WL、InGaAs 或 GaAs 缓冲器以及 n 的组件 + -GaAs 层在相同的能量下被观察到。关于 si 底部接触的结构 -GaAs 衬底,PC 光谱的阈值接近 0.72 eV,与 EL2 缺陷中心吸收相关。
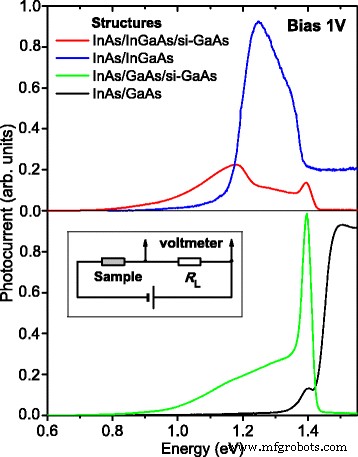
(在线颜色)变质 InAs/In0.15Ga0.85As/si 的室温光电流谱 -GaAs 和传统的 InAs/GaAs/si -GaAs QD 结构。插图:连接样品进行PC测量的电气方案
图 4 中与 MBE 层接触的结构的 PC 光谱特征主要对应于上述图 2 中 PV 光谱中的特征。关于 si 底部接触的结构 -GaAs 衬底与 EL2 中心组件,MBE 层中的吸收信号和 EL2 相关级别的信号之间存在竞争,如上所述。然而,曲线的形状可以得出结论,在 n 之上的层内没有激发电荷载流子 + -GaAs参与PC;这与变质 QD 结构光谱特别相关。显然,由于 si 引起的高势垒(见图 3),电子没有到达底部 -基质。基板电阻太高,施加偏压的主要下降发生在基板上,因此不会发生势垒降低。
因此,可以注意到 PV 和光电流受到与基板相关的 n 的负面影响 + -GaAs 层:超过 1.36 eV 的吸收会导致信号急剧下降。 AuGeNi 触点下方势垒的主要原因是 si -GaAs 衬底的费米能级位置相当低,导致能带弯曲与结构顶部相反。这是在这种接触几何形状下在 PV 中观察到的基板的唯一影响,即使在底部接触和基板之间相当厚 (400 nm) 的中间层也表现出来。
B.基板异质结构中间层设计解决方案
从实用的角度来看,可以得出这样的设计 InAs/InGaAs 结构与 si -GaAs 衬底在垂直光敏器件工程中没有用处,尤其是与相对较薄的 n 一起使用时 + - 掺杂的缓冲液,即使接触配置消除了通过基板的电流。 n中形成的空间电荷区 + -GaAs/衬底界面区域迫使此处激发的电荷载流子与在变质结构中激发的电荷载流子相反地移动,如图 2 和图 2 所示。 3和5a,从而产生相反的PV信号并降低样品的总量子效率。
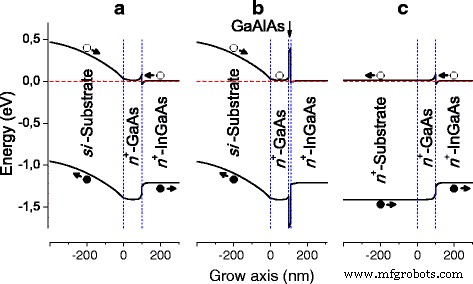
(在线颜色)计算在 si 上生长的变质结构的 In0.15Ga0.85As/GaAs 界面附近的能带分布 -带有 n 的底物 + -GaAs层厚度a 100 纳米(当前样品),b 100 纳米和 10 纳米薄的 Ga0.3Al0.7As 阻挡层,以及 c 结构像现在,但生长在 n + -衬底掺杂类似于 100 纳米厚的 n + -GaAs 层以上。计算采用Tibercad软件[50]
因此,对于基于光吸收的器件,应考虑不同的结构设计。我们认为,有必要提出这样的改进,因为许多研究小组认为 si -GaAs 衬底作为新型 p 的基础 -n -类型QD红外光电探测器[11,12,13]和太阳能电池[15]。
n 的简单加厚 + -GaAs 缓冲在变质结构下似乎不是一个很好的主意。尽管这种缓冲器可以吸收 1.37 eV 以上的更多激发量子并遮蔽下方的界面和衬底,但其厚度必须非常高,因为上方 800 nm 的更窄带隙 InGaAs 材料不足以完全抑制负双极效应。而且,即使是很厚的n + -GaAs 缓冲液不能排除类 EL2 中心的负面影响,这些中心主要位于衬底中并靠近它们与 MBE 层的界面。然而,由于电荷载流子的平均自由程有限,n + -GaAs层可以减弱上方AuGeNi触点上的感应负场。
通过为来自衬底的电子生长薄势垒层可以提供更好的改进,如图 5b 所示。为了计算,选择了 10 纳米薄的未掺杂 Ga0.3Al0.7As 阻挡层。这种势垒可以将衬底中激发的电子强烈限制在 n + -GaAs 层。类似的由宽带隙材料生长的高欧姆层,如 InAlAs、GaAlAs 和 AlAs,已被用于激光器结构中,以避免光电子器件有源区的电荷载流子泄漏 [60]。然而,对于基于 GaAs-In0.15Ga0.85As 的器件,由于外延层之间的宽带隙和小晶格失配,Ga0.3Al0.7As 最匹配。降低 AuGeNi 接触面上的载流子感应场,可以抑制衬底区域对光响应的负面影响,特别是与 n 的增加相结合 + -InGaAs 层厚。
然而,垂直结构的更优化设计似乎是使用单调的掺杂梯度,包括 n + 参考文献 [14, 39, 40] 中提出的掺杂 GaAs 衬底。这种设计是最有效的,同时也是最简单的。如果衬底掺杂类似于封盖n + -层或更重,这会导致图 5c 中描绘的带弯曲。此外,这种基板的一个重要优势可以在太阳能电池设计中体现出来。低电阻基板允许利用样品底部“-”接触的配置 [24, 38,39,40, 59],不会遮挡阳光下的 MBE 结构。
结论
我们已经表明,在电活性 si -GaAs 衬底。两种纳米结构都表现出双极 PV 由源自 GaAs 衬底和底部 MBE n 附近的相反倾斜带轮廓的组件的竞争引起 + -GaAs 层在一侧,MBE 生长结构的其余部分在另一侧。另一种允许避免电流通过底层的接触配置展示了单极 PV。最后一种配置与基板上的厚缓冲层一起强烈抑制了源自与 si 界面的光活性深能级的影响 -GaAs 衬底对纳米结构光电特性的影响。然而,当激发被衬底和近衬底 n 吸收时,观察到衬底对来自 InAs/InGaAs 结构的光电压和光电流信号的显着负面间接影响 + -GaAs MBE 层。分析获得的结果和进行的计算,我们已经能够为变质 QD 结构的设计提供见解,这对于开发新型高效光子器件很有用。
缩写
- 原子力显微镜:
-
原子力显微镜
- MB:
-
变质缓冲液
- MBE:
-
分子束外延
- ML:
-
单层
- PC:
-
光电导
- PL:
-
光致发光
- PV:
-
光电压
- QD:
-
量子点
- R :
-
负载电阻
- si :
-
半绝缘
- WL:
-
润湿层
纳米材料
- 5G 设备的设计和开发:5G 性能范围
- S、N 共掺杂石墨烯量子点/TiO2 复合材料用于高效光催化制氢
- 三态电致变色器件的浸涂工艺工程和性能优化
- 基于微柱中 InAs 双层量子点的 1.3 μm 明亮单光子源
- 检测自组织 InAs/InGaAs 量子点超晶格中的空间局域激子:提高光伏效率的一种方法
- 用于最大太阳能收集的高效且有效的 InP 纳米线设计
- 石墨烯/WO3 和石墨烯/CeO x 结构作为超级电容器应用电极的评估
- 消除 InAs/GaAs 量子点中的双峰尺寸,用于制备 1.3-μm 量子点激光器
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- 在硅衬底上设计用于中红外直接带隙发射的应变工程 GeSn/GeSiSn 量子点
- 射频和微波设计指南
- RF PCB 设计中的挫折和解决方案


