消除 InAs/GaAs 量子点中的双峰尺寸,用于制备 1.3-μm 量子点激光器
摘要
随着有源层结构的进步,半导体量子点激光器的器件特性得到了改善。自组装形成在 GaAs 上生长的 InAs 量子点得到了大力推广,以实现具有优异器件性能的量子点激光器。在生长高密度 InAs/GaAs 量子点的过程中,由于较大的失配等因素,会出现双峰尺寸。通过高温退火的方法消除InAs/GaAs量子点体系中的双峰尺寸,优化原位退火温度。以退火温度为关键优化参数,得到最佳退火温度680℃。在此过程中,优化了量子点生长温度、InAs 沉积和砷 (As) 压力,以提高量子点质量和发射波长。 1.3μm 高性能 F-P 量子点激光器,阈值电流密度为 110 A/cm 2 被证明了。
介绍
十年前,研发出1.3微米量子点(QD)激光器;然而,从那时到现在,量子点的增长没有明显的发展或进步。 1.3μm量子点激光器再次成为研究的热点。已成为高速光通信局域网(LAN)光源的有力竞争者之一。量子点的高密度是导致低功耗、高温稳定性和高速的重要因素。众所周知,由于三维量子限制,1.3-μm InAs/GaAs 量子点激光器有望在阈值电流、温度稳定性和调制特性方面表现出优异的性能 [1]。在过去的 10 年里,世界各地的许多实验室都实现了他们的目标,即大大提高 QD 激光器的性能 [2,3,4,5]。然而,InAs/GaAs 量子点系统中的双峰尺寸仍然存在[6, 7]。消除双峰尺寸可以提高量子点质量。
通过分子束外延 (MBE) 生长的 InAs/GaAs 异质结构已受到广泛关注,以制造低维纳米结构,例如由于 InAs 层和 GaAs 衬底之间的大晶格 (~ 7%) 失配而导致的自组装 QD [8] . InAs 在 GaAs (001) 衬底上的生长导致在 InAs 上以 Stranski-Krastanov (SK) 生长模式形成三维 (3D) 岛形。 SK 生长技术有望成为一种方便的高密度相干 QD 制造方法,并且仍然是一个开放的挑战 [9, 10]。然而,SK QD 存在一些问题,例如 QD 能级的大不均匀展宽和双峰尺寸问题 [11,12,13,14,15]。对于 MBE 生长高密度量子点,常规方法是提高 InAs 的沉积速率并降低生长温度。这种做法的目的是降低迁移速度,使岛屿快速形成。然而,低温生长可能会降低外延材料的晶格质量。另一方面,快速增长可以增加量子点密度,但也会产生更多位错。因此,当我们使用常规方法获得高密度 InAs QD 时,InAs QD 的光致发光强度变弱。
在这封信中,单层高温退火可以有效地消除帽盖材料的缺陷并改变位错的生长方向。 InAs SK 量子点的尺寸和形状通过在 GaAs (001) 衬底上生长的单层退火显示出高度的均匀性。 InAs 的沉积增加,同时提高了每个 QD 的饱和度。均匀 InAs QD 的 PL 光谱显示出小于 26 meV 的窄线宽。制作了具有激光阈值电流 I 的 1.3-μm InAs/GaAs QD 激光器 th 为 220 mA,阈值电流密度为 110 A/cm 2 .
素材优化
在本研究中,量子点结构在 Veeco Gen 930 MBE 系统中的 GaAs (001) (N+) 衬底上生长。对退火温度进行了研究,这四个样品 (N170813、N170824A-N17084C) 的退火温度分别为 630、680、730 和 780°C。这四个样品的量子点生长参数完全相同(表1)。
对四个样品进行了光致发光 (PL) 测量。随着退火温度的升高,在 680°C 的退火温度下达到最强的 PL 强度(如图 1 所示)。这是因为随着退火温度升高,砷 (As) 和 Ga 被解吸。这个过程会产生更多的缺陷,InAs量子点的晶格在高温下发生了变化。
<图片>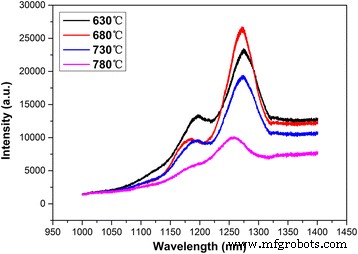
不同退火温度下外延片的光致发光(PL)光谱对比
在4×10 − 7 的低砷压下优化了量子点激光活性区 Torr [16] 和 0.025 ML/s 的低增长率。退火后,我们发现波长小于1300纳米;因此,我们微调了生长条件。 2.5 单层 (ML) 厚的 InAs 在 520°C 下生长,并在相同温度下由 5 纳米厚的 In0.15Ga0.85As 应变降低层覆盖。该层之后是 15-nm GaAs 层,该层在 520°C 的较低温度 (LT) 下沉积。然后,我们在 630°C 的更高温度 (HT) 下生长最终的 20-nm GaAs 层(如图 2a 所示)。
<图片>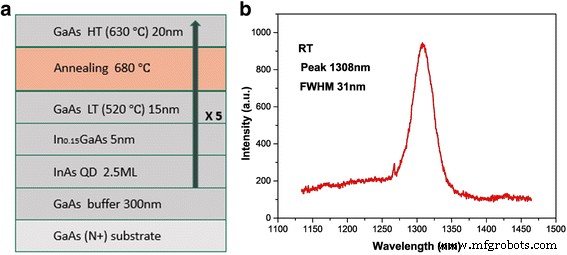
活性区域结构和 PL 光谱。 一 未掺杂 QD 激光有源区的结构。 b 室温 (RT) 下 QD 激光活性区域的 PL 光谱。发射峰为 1305 nm,FWHM 约为 31 nm
测量了测试样品的 QD 表面的 PL 光谱和原子力显微镜 (AFM) 图像。 1308 nm 的发射峰是由基态跃迁引起的,峰的半峰全宽 (FWHM) 约为 31 nm(如图 2b 所示)。我们在测试样品的五层埋层上生长一层裸量子点,以进行AFM测量。生长条件与之前描述的掩埋量子点完全相同。量子点表面的AFM图像显示,退火样品的量子点密度约为3.2 × 10 10 cm − 2 (如图 3a 所示)。量子点的平均高度为 8 纳米。相反,未退火的量子点样品的大小和分布并不均匀。可见双峰尺寸,QD密度约为2.9 × 10 10 cm − 2 .量子点的高度为 5-7 nm(如图 3b 所示)。
<图片>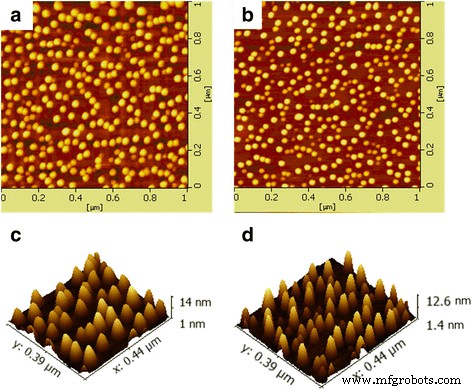
InAs/GaAs QD 的 AFM 图像。 一 单层高温退火。 b 没有退火。 c 高温退火的 3D 小面积尺寸分布图像。 d 未退火的3D小面积尺寸分布图
在1.3μm量子点激光器的外延生长过程中,通过激光活性区的单层退火可以很好地消除InAs量子点的双峰尺寸。与未经退火生长的样品相比(如图 3c 所示),在 680 ° 退火温度下生长的样品 C(如图 3d 所示)具有更高的量子点密度和均匀的量子点尺寸。这可以归因于以下原因。起初,GaAs 盖层在 InAs 量子点生长后立即生长,因此只能在低温下生长,这降低了 GaAs 的晶格质量并引入了缺陷。高温退火可以消除缺陷,可以生长高质量的 GaAs 帽层,用于继续生长 InAs 量子点。此外,InAs/GaAs异质外延过程中会产生位错,原位单层退火可以消除位错或改变位错生长方向,进而提高InAs量子点的质量。
设备设计与准备
激光器的结构由嵌入五层自组装 InAs QD 核心层的 GaAs 层组成。 200 nm n 波导层和 p 波导层生长在 QD 结构的顶部和底部。 QD 有源区和波导层被两个 1.8-μm p 型(Be:4E18)和 n 型(Si:2E18)Al0.45Ga0.55As 层夹在中间。沉积 200 nm p+ GaAs (Be:3E19) 层用于电接触(如图 4a 所示)。
<图片>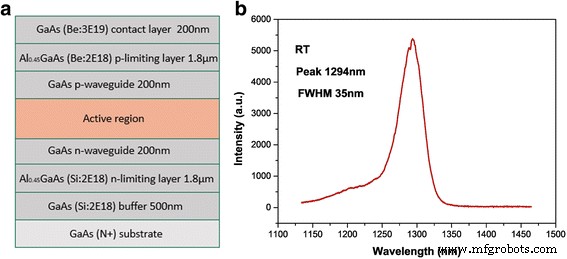
装置结构。 一 1.3-μm 量子点 F-P 广域激光器的外延结构。 b QDs 激光器外延结构在室温下的 PL 光谱。中心波长为 1294 nm
在激光外延结构完成后,通过化学蚀刻对晶片的一小部分进行蚀刻,用 H3PO4-H2O2-H2O (1:1:4) 减薄上覆层 [17, 18]。可以看出,该样品的 PL 光谱的中心波长为 1294 nm(如图 4b 所示)。与上述测试样品相比,中心波长的蓝移(如图 2a 所示)是由于上包层生长步骤中的高温生长(650°C),生长时间超过 2 小时.也可能来自于In0.15GaAs盖层岩石漂移的铟(In)成分。
InAs/GaAs QD 激光晶片涂有光刻胶以定义表面图案。第一版光刻形成 100 μm 的脊图案。脊形波导是通过电感耦合等离子体 (ICP) 蚀刻制造的,蚀刻深度为 2 μm,然后是等离子体增强化学气相沉积 (PECVD),以形成 SiO2 绝缘层。在下一步中,我们在脊上制作了一个 90 μm 宽的接触窗口,用于电流注入。然后使用磁控溅射沉积 Ti/Pt/Au 51 nm/94.7 nm/1122 nm 作为 p 型电极(如图 5 所示)。将晶片减薄至 120 μm,并在晶片背面沉积 50 nm 厚的 AuGeNi(80:10:10 wt% 合金)和 300 nm 厚的 Au 层,对 n 型电极使用热蒸发[19, 20]。整个样品在 460°C 下退火 10 秒以形成欧姆接触。在整个制作过程中,样品依次用丙酮和异丙醇清洗,并用去离子水冲洗。
<图片>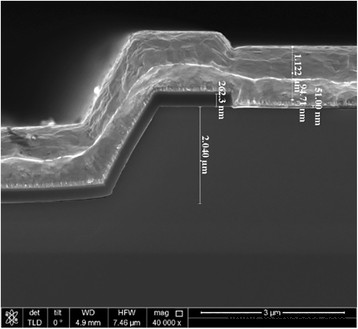
激光器横截面的 SEM 图像。采用标准激光制造工艺的 F-P 广域激光器。 GaAs/AlGaAs 蚀刻深度约为 2-μm。 PECVD 形成的 SiO2 为 260 nm
激光完成后,测量器件的电学和光学特性。电源-电流-电压 (P -I-V ) 在 RT 的连续波 (CW) 中测试了广域激光器的特性。激光器的阈值电流密度为110 A/cm 2 (如图 6a 所示),激光光谱的中心波长为 1.3 μm(如图 6b 所示)。从激光光谱可以看出,由于激光器工作的热效应,室温下激光器的中心波长发生红移。在本研究中,激光器可以在室温下连续发射激光并达到良好的阈值电流密度和良好的输出功率,而没有刻面涂层和有源区的去掺杂,这表明激光器的高晶体质量。单层退火法对双峰尺寸量子点体系有一定的影响。将在此基础上进一步研究更深层次的研究,以进一步提高量子点密度,以实现更低的阈值电流、更低的功耗、更高的输出功率和更高的特性温度。
<图片>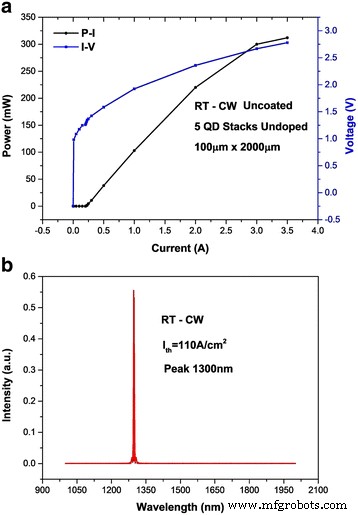
设备测量。 一 QD 激光器的 P-I-V 曲线。 b 激光波长为1.3μm
结论
研究了一系列高密度量子点生长参数的优化。使用单层退火方法成功地抑制了量子点双峰尺寸系统的形成。我们详细研究了退火温度和退火层位置。获得了 680 °C 的优化退火温度和 20 nm 与量子点层的距离。 110 A/cm 2 的阈值电流密度 1.3-μm InAs/GaAs QD F-P 激光器在室温和连续波操作下实现,激光波长为 1.3 μm。
缩写
- 原子力显微镜:
-
原子力显微镜
- 退火温度:
-
退火温度
- CW:
-
连续波
- F-P:
-
法布里-珀罗
- FWHM:
-
半高全宽
- 增长T:
-
生长温度
- HT:
-
高温
- LT:
-
低温
- MBE:
-
分子束外延
- PL:
-
光致发光
- QD:
-
量子点
- RT:
-
室温
- SEM:
-
扫描电子显微镜
- WPE:
-
墙插效率
纳米材料
- N,N-二甲基甲酰胺调节 MXene 量子点的荧光,用于灵敏测定 Fe3+
- S、N 共掺杂石墨烯量子点/TiO2 复合材料用于高效光催化制氢
- 基于微柱中 InAs 双层量子点的 1.3 μm 明亮单光子源
- 检测自组织 InAs/InGaAs 量子点超晶格中的空间局域激子:提高光伏效率的一种方法
- 退火 GaAsBi/AlAs 量子阱中的铋量子点
- 变质 InAs/InGaAs/GaAs 量子点异质结构光电压的双极效应:光敏器件的表征和设计解决方案
- InP/ZnS 核/壳量子点的绿色合成在无重金属发光二极管中的应用
- 从豆腐废水中合成荧光碳量子点的简单方法
- 纳米级 CL-20/氧化石墨烯的一步球磨制备显着降低粒径和灵敏度
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- 在硅衬底上设计用于中红外直接带隙发射的应变工程 GeSn/GeSiSn 量子点
- InAs/GaAs 量子点双模分布式反馈激光器面向大调谐范围连续波太赫兹应用


