具有 ZrO2 种子层的基于 Hf0.5Zr0.5O2 的 FeFET 的存储器窗口和耐久性改进以快速电压脉冲测量为特征
摘要
具有金属/铁电/绝缘体/半导体 (MFIS) 栅极堆叠的 HfO2 基铁电场效应晶体管 (FeFET) 目前被认为是高密度和快速写入速度的非易失性存储器的可能候选者。尽管具有 MFIS 栅极堆叠的 HfO2 基 FeFET 的保持性能可以满足实际应用的要求,但其存储窗口 (MW) 和耐久性方面的可靠性还需要进一步提高。这项工作通过使用快速电压脉冲测量,研究了使用 ZrO2 种子层对具有 MFIS 栅极堆叠的基于 Hf0.5Zr0.5O2 (HZO) 的 FeFET 的 MW、保持力和耐久性的优势。结果表明,与没有 ZrO2 种子层的 HZO 基 FeFET 相比,具有 ZrO2 种子层的 HZO 基 FeFET 显示出更大的初始和 10 年外推 MW,以及改进的耐久性性能。结果表明,采用直接结晶高k/Si栅堆叠可以进一步提高HfO2基FeFET的MW和可靠性。
背景
HfO2 基铁电薄膜因其互补金属氧化物半导体 (CMOS) 兼容性和可扩展性而被认为是用于铁电场效应晶体管 (FeFET) 的有前途的栅极堆叠材料。在可用于 FeFET 的几种栅堆叠结构中,金属/铁电/绝缘体/半导体 (MFIS) 代表了一种更实用的配置,因为它遵循当前的 MOS 器件架构并与现代高 k 金属栅匹配良好(HKMG) 流程。因此,已经付出了巨大努力来设计和制造具有 MFIS 栅极堆叠结构的 FeFET,以用于嵌入式非易失性存储器、负电容场效应晶体管、人工神经元、突触和逻辑存储器件 [1,2,3,4 ,5,6,7,8]。
到目前为止,已经使用 HKMG 工艺成功制造了具有 MFIS 栅极堆叠结构的高密度和快速写入速度的 FeFET [9, 10]。除了高集成密度和快速写入速度之外,大存储窗口 (MW) 以及在保持和耐用性方面的高可靠性对于将 FeFET 用于非易失性存储器应用也至关重要 [11,12,13,14]。由于 HfO2 基铁电薄膜的大能带偏移、高矫顽力和中等介电常数,具有 MFIS 栅极堆叠结构的 HfO2 基 FeFET 表现出可靠的保持特性(10 年外推)[15,16 ,17]。然而,尽管 HfO2 基薄膜在 1 × 10 9 在开关周期 [14, 18] 中,具有 MFIS 栅极堆叠结构的基于 HfO2 的 FeFET 具有相当有限的耐久性,范围为 1 × 10 4 到 1 × 10 7 切换周期 [17, 19,20,21,22,23]。从理论上讲,采用高 k 绝缘体层有望降低 MFIS 栅极堆叠中的电场,这将减轻能带弯曲,从而提高 HfO2 基 FeFET 的耐久性和 MW [12, 14]。实验上,阿里等人。证实增加超薄绝缘体层的 k 值(即使用 SiON 代替 SiO2)可以有效提高 HfO2 基 FeFET 的耐久性和 MW [13]。在我们之前的研究 [24] 中,我们报道了在 MFIS 栅极堆叠中插入结晶 ZrO2 高 k 层可以提高晶体质量并抑制 Hf0.5Zr0.5O2 (HZO) 薄膜中单斜相的形成,这导致通过直流电压扫描法表征的 2.8 V 的大 MW。
在这项工作中,我们通过使用快速正负电压脉冲测量报告了具有和不具有结晶 ZrO2 晶种层的 HZO 基 FeFET 的 MW、保留和耐久性的表征。此外,讨论了采用结晶ZrO2种子层对MW和耐久性性能的优势。
方法
带有和不带有 ZrO2 种子层的 n 沟道 FeFET 是使用后栅极工艺制造的,如 [24] 中所述。 ZrO2 种子层和 HZO 层均在 300 o 的生长温度下生长 C 通过原子层沉积 (ALD)。制造的 FeFET 的示意图如图 1a 所示,其沟道宽度 (W ) 和长度 (L ) 分别为 80 和 7 μm。同时,还制作了 TaN/HZO/TaN 和 TaN/HZO/ZrO2/TaN 电容器以评估 HZO 薄膜的铁电性能。极化电压 (P–V ) 电容器的磁滞回线是使用 Radiant Technologies RT66A 铁电测试系统测量的,而 FeFET 的器件特性是通过带有脉冲发生器单元 (B1525A) 的 Agilent B1500A 半导体器件分析仪测量的 [20]。用于 MW 和耐久性测量的两个主要测试序列如图 1b 和 c 所示。对于 MW 和保留测量,首先将编程/擦除 (P/E) 脉冲施加到 FeFET 的栅极,然后使用 I 在不同的时间间隔执行读取操作 D–V G 扫描 (V D =0.1 V) 感知V 泰。一般来说,V TH被确定为对应于10 -7 的漏电流的栅极电压 A∙W/L [25],而 MW 定义为 V 的差值 编程和擦除状态之间的 TH 值。对于耐久性测量,在一定数量的交替 P/E 脉冲后测量 MW。

一 制造的 FeFET 的示意图。额外的结晶 ZrO2 晶种层由黑色网格线标记。 b , c 用于 MW 和耐久性测量的测试序列
结果与讨论
图 2a 显示了 P–V TaN/HZO/TaN 和 TaN/HZO/ZrO2/TaN 电容器的磁滞回线。值得注意的是,TaN/HZO/ZrO2/TaN 电容器比 TaN/HZO/TaN 电容器具有更好的铁电性能,这与报道的结果一致 [26],表明结晶 ZrO2 种子层确实可以提高结晶质量和抑制 HZO 薄膜中单斜相的形成 [24]。图 2b 显示了 I D–V P/E 脉冲后具有和不具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 G 曲线。红色符号线代表 I D–V 施加 7 V/100 ns 的编程脉冲后的 G 曲线,而蓝色符号线代表 I D–V 施加- 7 V/100 ns的擦除脉冲后的G曲线。可以看到 I D–V 两种 FeFET 的 G 曲线都显示逆时针开关特性,表明当前 FeFET 的 MW 源自 HZO 层的极化切换,而不是电荷捕获和注入。尽管如此,具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 MW 提高了 1.4 V,大约是没有额外晶态 ZrO2 晶种层的 HZO 基 FeFET 的 MW (0.8 V) 的 1.8 倍。此外,获得的 1.4 V MW 与迄今为止报道的最佳结果相当 [9, 11, 14, 17, 21,22,23, 27]。
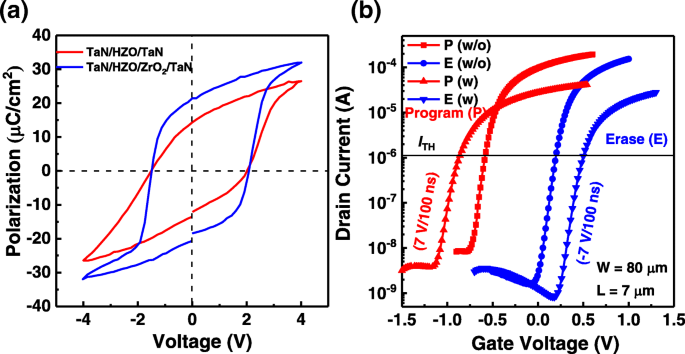
一 P-V 在 4 V 和 5 kHz 频率下测量的 TaN/HZO/TaN 和 TaN/HZO/ZrO2/TaN MFM 结构的磁滞回线。 b 我 D–V 在编程脉冲(+ 7 V/100 ns)和擦除脉冲(- 7 V/100 ns)之后,具有(w)和不具有(w/o)ZrO2种子层的HZO基FeFET的G曲线
还评估了基于 HZO 的 FeFET 在有和没有额外结晶 ZrO 2 种子层的情况下的可靠性。图 3 显示了 V 在室温下施加 7 V/100 ns 的编程脉冲和 – 7 V/100 ns 的擦除脉冲后的 TH 保留特性。很明显,V TH 值与对数时间尺度近似线性。具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 在 10 年后的外推 MW 为 0.9 V,大于没有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 MW (0.6 V)。由于 ZrO2 (1.5 nm)/SiO2 (2.6 nm) 栅极绝缘层的厚电容等效厚度 (CET) 会导致栅极堆叠中的去极化场增强 [13, 15],因此可以预期保留性能的进一步改善如果降低SiO2层的厚度。

含和不含ZrO2种子层的HZO基FeFETs的保留特性
图 4 展示了 I 的演变 D–V ± 7 V/100 ns交替P/E循环后的G曲线。对于没有额外结晶 ZrO2 晶种层的 FeFET,I 中的显着偏移和斜率退化 D–V 从 P/E 循环的早期阶段观察到 G 曲线,I D–V 与编程状态相比,擦除状态下的 G 曲线表现出更多的斜率退化。对于具有额外结晶 ZrO2 晶种层的 FeFET,尽管 I D–V 擦除状态下的 G 曲线在 P/E 循环的早期阶段表现出明显的正偏移,这归因于“唤醒”效应 [13, 28,29,30,31,32], 没有明显偏移我 D–V 程序状态下的G曲线观察到1 × 10 3 循环。此外,对于具有额外结晶 ZrO2 晶种层的 FeFET,I D–V G 曲线在擦除和编程状态下仅表现出轻微的斜率下降,最高可达 1 × 10 3 循环。
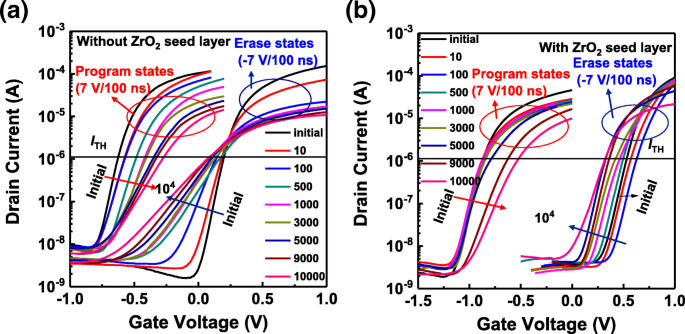
I的进化 D–V HZO 基 FeFET 的 G 曲线 a 没有和 b 具有 P/E 循环的 ZrO2 种子层
根据之前的报道 [12, 28, 33],I 的平行位移 D–V G 曲线归因于栅堆叠中俘获电荷的逐渐积累,而 I 中的斜率下降 D–V G 曲线是界面陷阱生成的结果。由于俘获的电荷可以通过电学手段解除俘获,但界面陷阱的产生是不可逆的,因此最大限度地减少界面陷阱的产生对于提高耐久性非常重要[28]。 P/E 循环产生的界面陷阱 (ΔN it) 可以使用等式来描述。 (1) [34, 35]:
$$ \Delta \mathrm{SS}=\frac{\Delta {N}_{it} kT\ln 10}{C_{FI}{\varnothing}_F} $$ (1)其中 ΔSS 是亚阈值摆幅的变化,k 是玻尔兹曼常数,T 是绝对温度,C FI 是栅叠层的总电容,∅ F 是费米势。 ΔN 图 5 显示了具有和不具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 P/E 循环的函数。显然,对于没有额外晶态 ZrO2 晶种层的 FeFET,ΔN 从 P/E 循环的早期阶段开始明显增加,ΔN 它在擦除状态下比在程序状态下大得多。然而,ΔN 对于具有额外结晶 ZrO2 晶种层的 FeFET,它几乎没有变化到 1 × 10 3 循环,并且它总是小于没有额外结晶 ZrO2 晶种层的 FeFET。由于插入额外的ZrO2种子层降低了栅叠层中的电场,因此能带弯曲更弱,减少了界面陷阱的产生[12, 14]。
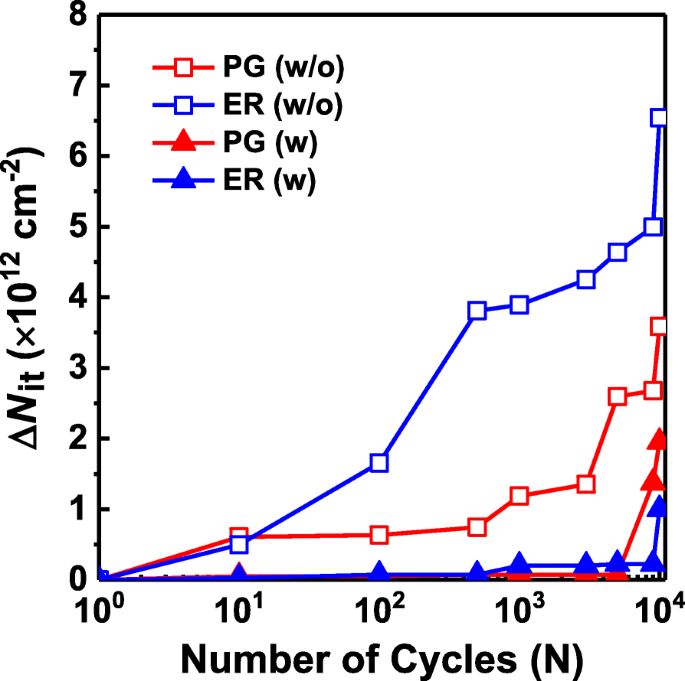
∆N 的演化 它与市盈率循环
图 6 显示了栅极漏电流特性 (I G–V 具有和不具有 ZrO2 种子层的 HZO 基 FeFET 的 G 曲线)以及 P/E 循环。对于没有额外结晶 ZrO2 晶种层的 FeFET,栅极漏电流从 P/E 循环的早期阶段开始急剧增加。然而,具有附加晶体 ZrO2 晶种层的 FeFET 的栅极漏电流几乎没有变化到 5 × 10 2 循环,并且它总是小于没有额外结晶 ZrO2 晶种层的 FeFET。据报道,栅极漏电流的增加可能与产生的界面陷阱有关 [28]。具有附加晶体 ZrO2 晶种层的 FeFET 的栅极漏电流随着循环的减少可能归因于界面陷阱产生的抑制。
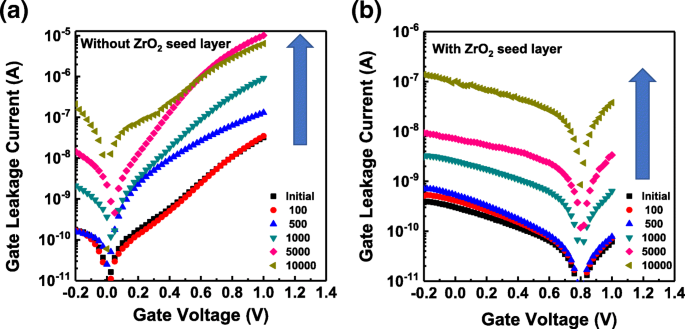
栅极漏电流特性的演变 (I G–V 基于 HZO 的 FeFET a 的 G 曲线 没有和 b 具有 P/E 循环的 ZrO2 种子层
V 从 I 中提取的编程和擦除状态的 TH 值 D–V 具有和不具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 G 曲线如图 7 所示。 ZrO2 种子层。此外,没有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 MW 从 P/E 循环的早期阶段开始明显降低,而具有额外晶态 ZrO2 晶种层的 HZO 基 FeFET 的 MW 略微降低至 1 × 10 3 循环。随着 P/E 循环次数的进一步增加,具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 I 斜率也显示出明显的退化。 D–V G 曲线和 MW,由于界面陷阱的生成增强。然而,具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 的 MW 仍然大于 0.9 V,最高可达 1 × 10 4 循环,这比没有额外结晶 ZrO2 晶种层的基于 HZO 的 FeFET 的循环 (0.4 V) 大约 2.3 倍。如前所述,获得更多饱和极化状态所需电场的减少可能是提高耐久性的原因。

V 的演变 TH与市盈率循环
结论
具有 TaN/HZO/SiO2/Si 和 TaN/HZO/ZrO2/SiO2/Si MFIS 栅极叠层的 HZO 基 FeFET 的 MW 以及保持力和耐久性方面的可靠性通过快速电压脉冲测量来表征。结果表明,具有额外结晶 ZrO2 晶种层的 HZO 基 FeFET 具有 1.4 V 的大初始存储窗口和 0.9 V 的外推 10 年保持率,大于 HZO-的初始存储窗口 (0.8 V)。基于 FeFET,没有额外的结晶 ZrO2 晶种层。此外,通过在 HZO 层和 SiO2/Si 衬底之间插入结晶 ZrO2 晶种层,可以提高基于 HZO 的 FeFET 耐久性的可靠性。具有 ZrO2 籽晶层的 HZO 基 FeFET 的 MW 和耐久性改进主要与 HZO 层的结晶质量提高以及由于获得更饱和极化状态所需的电场减少而抑制界面陷阱的产生有关。在此工作的基础上,预计采用直接晶体高k/Si栅堆叠将进一步提高HfO2基FeFET的MWs和可靠性,值得进一步研究和开发。
数据和材料的可用性
本文包含支持本文结论的数据集。
缩写
- CMOS:
-
互补金属氧化物半导体
- FeFET:
-
铁电场效应晶体管
- FeFET:
-
铁电场效应晶体管
- HKMG:
-
高k金属栅
- HZO:
-
Hf0.5Zr0.5O2
- I :
-
漏电流
- L:
-
长度
- MFIS:
-
金属/铁电/绝缘体/半导体
- MW:
-
内存窗口
- 市盈率:
-
编程/擦除
- P–V :
-
极化电压
- SS :
-
亚阈值摆动
- V :
-
栅极电压
- V :
-
阈值电压
- W:
-
宽度
- ΔN 它:
-
生成的接口陷阱
纳米材料
- ST:在低成本 SO-8 封装中具有丰富模拟和 DMA 的 8 位 MCU
- 具有高级农业化学活性的智能纳米材料和纳米复合材料
- 无合规性 ZrO2/ZrO2 − x /ZrO2 具有可控界面多态切换行为的电阻式存储器
- 氮化处理的基于 HfO2 的 RRAM 中的传导机制和改进的耐久性
- 螺旋型天线微桥结构太赫兹微测辐射热计的调频和吸收改进
- 具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
- 源极和漏极触点之间只有 2 纳米距离的高性能矩形栅极 U 沟道 FET
- 具有高 PSRR 的纳米级低功耗无电阻电压基准
- 原子层沉积基于 Hf0.5Zr0.5O2 的具有短/长期突触可塑性的柔性忆阻器
- 在 SiNx 钝化层中注入氟离子的高击穿电压和低动态导通电阻 AlGaN/GaN HEMT
- 低聚噻吩薄膜中单层型结构的相变和形成:结合原位 X 射线衍射和电测量的探索
- 具有嵌入式载流子复合结构的新型高保持电压 SCR,具有闩锁免疫和稳健的 ESD 保护


