氮化混合 2D-MoS2/3D-β-Ga2O3 异质结的能带对准研究
摘要
基于二维 (2D) 和传统三维 (3D) 材料的混合异质结为具有工程特征的纳米电子器件提供了一种有前途的方法。在这项工作中,我们研究了由转移的 MoS2 在 β-Ga2O3(\(2-\)01) 上经过氮化和不经过氮化组成的混合维异质结的能带排列。未氮化的 2D-MoS2/3D-β-Ga2O3 异质结的导带和价带偏移分别确定为 0.43 ± 0.1 和 2.87 ± 0.1 eV。对于氮化异质结,导带和价带偏移分别推导出为 0.68 ± 0.1 和 2.62 ± 0.1 eV。改变的能带排列可能是由跨异质结界面的电荷转移形成的偶极子引起的。氮化对III族氧化物和过渡金属二硫属化物之间能带排列的影响将为设计基于异质结的电子和光电器件提供可行的技术路线。
背景
β-氧化镓 (β-Ga2O3) 由于其优异的材料特性而引起了广泛的关注 [1, 2]。具有超宽带隙 (4.6–4.9 eV),理论击穿电场 (E C ) 估计约为 8 MV/cm [3, 4]。结合其较高的相对介电常数 (ε) 和电子迁移率 (μ),Baliga 的品质因数 (\( \upvarepsilon \upmu {E}_C^3 \)) 是 GaN 或 SiC 的三倍,从而降低了传导损耗显着 [1]。此外,通过熔体生长和外延技术合成的大块单晶的可用性为工业应用提供了显着优势 [5, 6]。到目前为止,β-Ga2O3 已在广泛的电子应用中得到很好的证明,包括发光二极管、气体传感器、光电探测器以及场效应晶体管 [7,8,9,10]。最近,混合异质结,即二维 (2D) 材料与三维 (3D) 材料的集成,由于其材料系统的互补特性而受到特别关注 [11]。
迄今为止,各种二维层状材料已堆叠在宽带隙半导体上,以构建具有不同功能的新型应用的混合异质结,例如 MoS2/GaN、WSe2/GaN、MoS2/SiC 等 [12,13,14,15 ]。在结构上,MoS2 晶体由夹在两个硫层之间的 Mo 原子层组成,形成二维六边形三层,通过弱范德华力与其相邻层结合 [16, 17]。与具有零带隙的石墨烯不同,带隙的厚度相关调制激发了 MoS2 在光学和电气设备中的探索 [18, 19]。基于 MoS2 的物理学,少层 MoS2 的态密度比单层 (SL) MoS2 高三个数量级,导致弹道极限内的高驱动电流。在这种情况下,与 SL MoS2 [18] 相比,少层 MoS2 可能为晶体管应用提供显着优势。因此,MoS2 与 β-Ga2O3 的集成对于结合已建立的 2D 和 3D 材料的各自优点具有重要意义。并且混合异质结的光学和电学性质本质上由界面能带排列主导。因此,非常需要具有可调谐带对齐以提高基于异质结的器件的性能。在这项工作中,我们通过X射线光电子能谱(XPS)表征和第一性原理计算研究了氮化处理和未氮化处理的2D-MoS2/3D-β-Ga2O3异质结的能带排列。
方法
SiO2/Si 衬底分别用丙酮和异丙醇超声处理 10 分钟,然后在去离子水中冲洗并用 N2 干燥。使用 MoO3(0.08 mg,99%,Alfa Aesar)和 S 粉末(1 g,99%)的前体,通过化学气相沉积 (CVD) 在 SiO2/Si 衬底上生长少层 MoS2 薄膜 [20, 21]。将 MoO3 和 S 粉末放入两个单独的坩埚中,石英管中带有 SiO2/Si 衬底,如图 1a 所示。在生长过程中,石英管保持在 800 °C 以在 5 分钟内生长 MoS2 薄膜。图 1b 显示了 SiO2/Si 衬底上均匀的 MoS2 薄膜的光学显微图像。在 MoS2 薄膜生长后,它将通过 PMMA 辅助方法转移到 β-Ga2O3(日本田村公司)衬底上,[22] 如图 1c 所示。在转移过程中,首先将 PMMA 旋涂在生长的 MoS2 薄膜上作为支撑层,然后将样品浸入 KOH 溶液中以蚀刻掉 SiO2 层。随后,带有 MoS2 薄膜的 PMMA 层将漂浮在溶液上,然后将样品在去离子水中冲洗 1 分钟以去除残留的 K + 并进一步转移到 β-Ga2O3 衬底上。最后,顶部的 PMMA 层将用丙酮去除。对于氮化的 MoS2/β-Ga2O3 异质结,在 MoS2 转移之前,在 3Pa 压力下用 50s N2 等离子体处理在 β-Ga2O3 表面上实施了氮化。 RF 功率和 N2 流速分别为 100 W 和 80 sccm。结果,制备了四个样品用于 XPS 测量:(1)未涂层的 β-Ga2O3 衬底(块状 β-Ga2O3),(2)SiO2/Si 衬底上的少层 MoS2 膜(少层 MoS2),(3) β-Ga2O3衬底上转移MoS2薄膜,(4)氮化β-Ga2O3衬底上转移MoS2薄膜。
<图片>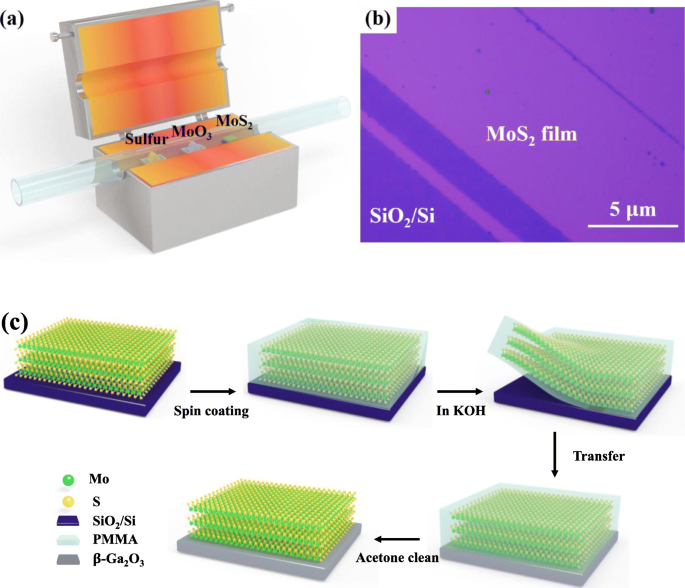
一 MoS2 CVD 生长的实验装置示意图。 b SiO2/Si 衬底上生长的少层 MoS2 薄膜的光学图像。 c PMMA辅助湿转移法制备MoS2/β-Ga2O3异质结的工艺流程
结果和讨论
拉曼光谱用于研究少层二硫化钼薄膜的质量以及检查相关层数。转移前后的 MoS2 薄膜的拉曼光谱如图 2 所示,由 RENISHAW inVia 拉曼光谱表征。在 381.91 cm −1 附近可以观察到两种特征拉曼模式 和 405.84 厘米 −1 , 对应于面内 (\( {E}_{2g}^1 \)) 模式和面外 (A 1g ) 模式,分别为 [23, 24]。与生长的 MoS2 薄膜相比,\( {E}_{2g}^1 \) 和 A 几乎没有拉曼位移 1g 转移过程后的模式,表明转移过程后 MoS2 未损坏。 412.99 cm −1 处的峰 后转移过程源于β-Ga2O3 衬底,与之前的报道一致[25]。 \( {E}_{2g}^1 \) 和 A 之间的频差 1g 推导出模式约为 23.93 cm -1 ,指定四层少层二硫化钼薄膜 [26]。此外,如图 2 的插图所示,通过高分辨率透射电子显微镜 (HRTEM) 证实 MoS2 膜的厚度约为 3 nm(大约四层),这与我们的拉曼光谱非常吻合。从图 3a 可以看出,从氮化物 β-Ga2O3 衬底检测到 N 1 s 的高强度峰,表明存在氮。图 3b 显示了带有氮化的 MoS2/β-Ga2O3 异质结的 SIMS 曲线,其中以 Mo、N 和 Ga 表示的主要成分的信号与深度作图。观察到 N 峰位于 MoS2/β-Ga2O3 界面,N 扩散到 β-Ga2O3 衬底中可能是由于在等离子体处理或初级束轰击过程中将 N 注入底层。 MoS2 层中的 Ga 分布比 β-Ga2O3 衬底高可能源于不同材料基质中的不同离子产率 [27]。此外,β-Ga2O3 中 Mo 的尾部可能归因于扩散或深度分辨率问题,这是由主光束轰击引起的 [28]。
<图片>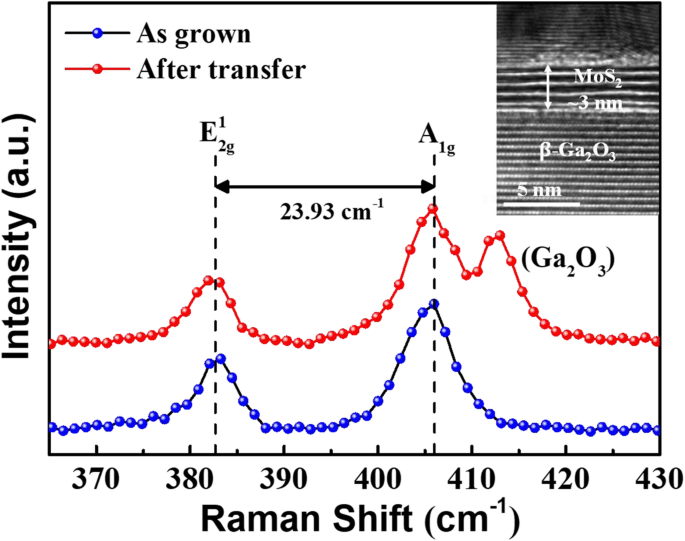
分别在 SiO2/Si 衬底上生长的 MoS2 和在 β-Ga2O3 衬底上转移的 MoS2 的拉曼光谱。插图显示了制备的 MoS2/β-Ga2O3 异质结的横截面透射电子显微镜 (TEM) 图像
<图片>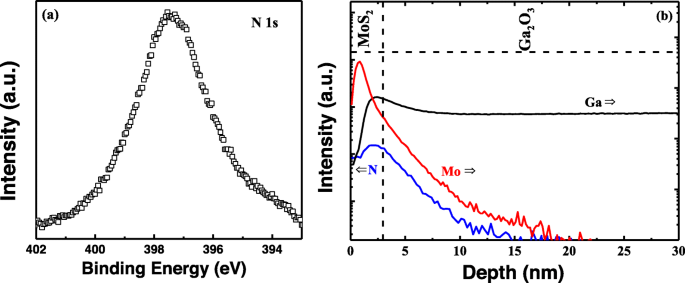
一 具有表面氮化的 β-Ga2O3 衬底的 N 1 s XPS 光谱。 b 制备的MoS2/β-Ga2O3异质结的SIMS深度剖面
为了获得 MoS2/β-Ga2O3 异质结的能带排列,在 VG ESCALAB 220i-XL 系统上使用单色 Al Kα X 射线源 (hv =1486.6 eV) 以 0.05 eV 的步长进行 XPS 测量。恒定通过能量设置为 20 eV。此外,标准 C 1 s (284.8 eV) 用于结合能 (BE) 校准 [29]。为了评估 MoS2/β-Ga2O3 界面处的价带偏移 (VBO),Mo 3d 和 Ga 3d 核心能级 (CLs) 分别用于几层 MoS2 和 β-Ga2O3 样品。图 4a 显示了来自少层 MoS2 [30] 的 Mo 3d 和价带光谱的 XPS 窄扫描。 Mo 3d5/2 的 CL 与 MoS2 的价带最大值 (VBM) 之间的结合能差 (BED) 计算为 228.59 ± 0.1 eV。如图 4b 所示,来自少层 β-Ga2O3 的 Ga 3d CL 和 VBM 的 BE 分别推导出为 20.25±0.05 和 3.23±0.05eV。相应的 BED 确定为 17.02 ± 0.1 eV,这与 Sun 等人报道的非常一致。 [31]。图 4c 描绘了 Mo 3d 和 Ga 3d CLs 的测量 XPS 光谱,用于 MoS2/β-Ga2O3 异质结,有/无氮化。值得注意的是,Mo 3d5/2 CL 从未氮化异质结的 228.95 ± 0.05 eV 移向氮化异质结的 229.60 ± 0.05 eV,而 Ga 3d CL 从 20.25 ± 0.05 移至 20.65 eV ± 0.05 eV。基于克劳特的方法,[32] 价带偏移(VBO,ΔE V ) 少层 MoS2/β-Ga2O3 异质结的计算公式如下:
$$ \Delta {E}_V=\left({E}_{Mo\ 3{d}_{5/2}}^{Mo{S}_2}-{E}_{VBM}^{Mo{ S}_2}\right)-\left({E}_{Ga\3d}^{Ga_2{O}_3}-{E}_{VBM}^{Ga_2{O}_3}\right)-{\ Delta E}_{CL} $$ (1)
一 Mo 3d CL 的 XPS 光谱和来自少层 MoS2 的价带。 b Ga 3d CL 的 XPS 光谱和 β-Ga2O3 衬底的价带。 c Mo 3d 和 Ga 3d CLs 的 XPS 光谱,用于制造有/没有表面氮化的 MoS2/β-Ga2O3 异质结。 d O 1 s CL能量损失的β-Ga2O3衬底有/无表面氮化的XPS光谱
其中 \( {E}_{Mo\ 3{d}_{5/2}}^{Mo{S}_2} \) 和 \( {E}_{VBM}^{Mo{S}_2} \ ) 是 Mo 3d5/2 CL 和来自 MoS2 的 VBM 的结合能,\( {E}_{Ga\ 3d}^{Ga_2{O}_3} \) 和 \( {E}_{VBM}^{Ga_2 {O}_3} \) 是 Ga 3d CL 和来自 β-Ga2O3 的 VBM 的结合能, \( {\Delta E}_{CL}=\Big({E}_{Mo\ 3{d}_{5 /2}}^{Mo{S}_2}-{E}_{Ga\ 3d}^{Ga_2{O}_3} \)) 是 Mo 3d5/2 和 Ga 3d CLs 对 MoS2/ 的结合能差β-Ga2O3 异质结。因此,∆E V 经 N2 等离子体处理和未经过 N2 等离子体处理后,β-Ga2O3 衬底上 MoS2 的含量分别为 2.62±0.1 和 2.87±0.1 eV。
图 4d 显示了氮化和未氮化的 β-Ga2O3 衬底的 O 1 s CL 能量损失光谱。值得注意的是,氮化处理后带隙保持不变,值为4.70±0.1 eV。因此,导带偏移可以提取如下,
$$ {\Delta E}_C={E}_g^{Ga_2{O}_3}-{E}_g^{Mo{S}_2}-{\Delta E}_V $$ (2)其中 \( {E}_g^{Ga_2{O}_3} \) 和 \( {E}_g^{Mo{S}_2} \) 分别是 β-Ga2O3 和少层 MoS2 的带隙。在这项工作中使用的带隙为 1.4 ± 0.1 eV 的少层 MoS2。 34 根据方程。 (2)、∆E C MoS2 和 β-Ga2O3 之间的氮化和未氮化分别推导出为 0.68 ± 0.1 和 0.43 ± 0.1 eV。图5(a)和图5(b)分别显示了无/有氮化异质结的计算能带图。
接下来,通过基于密度泛函理论 (DFT) [33,34,35] 的 Vienna ab initio 模拟包 (VASP) 进一步检查氮化和未氮化异质结的电子结构。 Perdew-Burke-Ernzerhof (PBE) 参数化的广义梯度近似 (GGA) 被用于交换相关函数 [36, 37]。我们使用 DFT-D3 色散校正方法来描述长距离范德华 (vdW) 相互作用 [38,39,40]。投影仪增强波 (PAW) 赝势方法用于描述核价相互作用,平面波扩展的动能截止值为 650 eV。我们采用 4 × 4 × 1 G 中心的 k 网格来实现晶胞的结构松弛,k 点之间的最小间距为 0.04 Å −1 ,这通过关于 k 点数量的收敛测试足够精确。收敛阈值设置为 10 −4 eV 表示系统和 10 −2 的能量差异 eV Å −1 为赫尔曼-费曼力。为了消除两个相邻原子层之间的人工相互作用,真空层的厚度设置为 ~ 15 Å。 Heyd-Scuseria-Ernzerhof (HSE06) 混合函数计算进一步验证了异质结的特征值,通过减少 PBE 和 Hartree-Fock (HF) 函数的定位和离域误差来提高特征值的精度 [41]。短程 HF 交换的混合比例为 25%。筛选参数为0.2 Å −1 .
<图片>
MoS2/β-Ga2O3异质结的能带图a 没有和 b 表面氮化
MoS2/β-Ga2O3 异质结的构造如图 6a 所示。通用结合能关系 (UBER) 方法为结合能与原子分离之间的关系提供了一种简单的通用形式,[42] 用于在电子结构计算之前确定能量稳定结构。考虑了各种层间距离和表面粘附能W 广告 对于异质结如下所示,
$$ {W}_{ad}=\frac{E_{Ga_2{O}_3}+{E}_{Mo{S}_2}-{\mathrm{E}}_{Ga_2{O}_3/ Mo {S}_2}}{A} $$ <图片>
β-Ga2O3-MoS2堆叠异质结构的原子结构和电荷密度分布a 没有和 b 从侧面看,在 4 × 4 × 1 超级电池中含有氮掺杂剂。 Ga (O) 原子为红色(灰色),Mo (S) 原子为蓝色(橙色)。 MoS2/β-Ga2O3异质结构的能带结构c 没有和 d 含氮掺杂
其中 A 是界面面积,\( {E}_{Ga_2{O}_3} \)、\( {E}_{Mo{S}_2} \) 和 \( {E}_{Ga_2{O }_3/ Mo{S}_2} \) 分别是β-Ga2O3、单层MoS2 和MoS2/β-Ga2O3 异质结的总能量。一旦 W 广告 达到最大值,就会得到最优的层间距离。结构优化后,一个氮原子被替换地掺杂在原始的 MoS2/β-Ga2O3 异质结中,如图 6b 所示。 DFT计算中氮的浓度约为4.17%,与实验中的(3.61%)接近。氮化和未氮化的 MoS2/β-Ga2O3 异质结的电子结构计算如图 6c 和 d 所示。可以看出,引入了中带隙态,这可能会增强 MoS2/β-Ga2O3 界面上的电荷转移,并且由此产生的界面偶极子有助于测量的结合能偏移。此外,计算出的导带偏移 ∆E C (\( \Delta {E}_C={E}_{CB}^{Mo{S}_2}-{E}_{CB}^{Ga_2{O}_3} \)) 用于未掺杂-和掺杂- β-Ga2O3/MoS2 异质结分别为 0.82 和 1.0 eV,与实验结果显示出相同的趋势。我们还使用 HSE06 方法计算了 \( {E}_{CB}^{Mo{S}_2} \) 和 \( {E}_{CB}^{Ga_2{O}_3} \) 的特征值进一步证实上述结论,发现修正后的ΔE C 未掺杂和掺杂的β-Ga2O3/MoS2异质结分别为0.87和1.08 eV。
结论
总之,相应的 MoS2 薄膜已转移到未氮化和氮化物 β-Ga2O3 上,用于构建 MoS2/β-Ga2O3 异质结。拉曼光谱用于研究转移的 MoS2 薄膜的质量,并进行 SIMS 研究以探测带有氮化的 MoS2/β-Ga2O3 异质结的元素深度分布。 XPS 测定的氮化 MoS2/β-Ga2O3 异质结的 VBO 分别为 2.62±0.1 eV 和未氮化的异质结的 VBO 分别为 2.87±0.1 eV。由此产生的 CBO 被推导出为 0.68 ± 0.1 和 0.43 ± 0.1 eV,这与 DFT 计算的趋势相同。这些发现表明带偏移可以通过表面氮化过程进行修改。本研究为基于 2D/3D 垂直异质结设计的电子器件的实现提供了广阔的前景。
数据和材料的可用性
支持本手稿结论的数据集包含在手稿中。
缩写
- β-Ga2O3:
-
β-氧化镓
- SL:
-
单层
- MoS2:
-
二硫化钼
- XPS:
-
X射线光电子能谱
- CBO:
-
导带偏移
- VBO:
-
价带偏移
- CVD:
-
化学气相沉积
- PMMA:
-
聚(甲基丙烯酸甲酯)
- HRTEM:
-
高分辨透射电子显微镜
- SIMS:
-
二次离子质谱
- 基础:
-
结合能
- 床:
-
结合能差
- CL:
-
核心层
- VBM:
-
价带最大值
- VASP:
-
Vienna ab initio 仿真包
- DFT:
-
密度泛函理论
- GGA:
-
广义梯度逼近
- PBE:
-
Perdew-Burke-Ernzerhof
- 爪子:
-
投影仪增强波
- 优步:
-
万能结合能关系
纳米材料
- 具有可控厚度的二硫化钼用于电催化析氢
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 用贵金属纳米粒子装饰的电纺聚合物纳米纤维用于化学传感
- 用于高性能硅/有机混合太阳能电池的具有溶剂处理的高导电 PEDOT:PSS 透明空穴传输层
- MoS2 纳米薄片在用于电催化的石墨烯纳米片上的温度依赖性结晶
- 具有电场辅助纳米碳填料排列的复合材料的电性能
- 具有分层多孔结构的单分散碳纳米球作为超级电容器的电极材料
- 用于平面异质结太阳能电池的连续气相生长混合钙钛矿
- 背面有黑硅层的晶体硅太阳能电池的研究
- 基于混合全介电-石墨烯超表面的可控双折射偏振转换器
- 基于纳米脂质体的双重给药系统的理化特性研究
- 制备具有可见光催化活性的 Cu2O-TiO2 NTA 异质结的简便方法


