具有原子层沉积 ZnO 电荷俘获的非晶 In–Ga–Zn–O 薄膜晶体管存储器的电压极性相关编程行为图层
摘要
非晶 In-Ga-Zn-O (a-IGZO) 薄膜晶体管 (TFT) 存储器在未来的面板系统应用中引起了许多兴趣;然而,它们通常表现出较差的擦除效率。在本文中,我们研究了具有原子层沉积 ZnO 电荷俘获层 (CTL) 的 a-IGZO TFT 存储器的电压极性相关编程行为。原始器件不仅在正栅极偏置下而且在负栅极偏置下都表现出电可编程特性。特别是后者可以产生比前者高得多的编程效率。在施加 +13 V/1 μs 的栅极偏置脉冲后,该器件的阈值电压偏移 (ΔVth) 为 2 V;对于 -13 V/1 μs 的栅极偏置脉冲,ΔVth 高达 -6.5 V。在 12 V/1 ms 编程 (P) 和 -12 V/10 μs 擦除 (E) 的情况下,可以在 10 3 实现高达 7.2 V 的存储器窗口 市盈率周期。通过将在 O2 或 N2 中退火的 ZnO CTL 与沉积的 CTL 进行比较,可以得出结论,与氧空位 (VO) 相关的缺陷在 TFT 存储器件的双极编程特性中占主导地位。为了在正栅极电压下编程,电子从 IGZO 通道注入 ZnO 层,并优先在单电离氧空位 (VO + ) 和双电离氧空位 (VO 2+ )。关于在负栅极电压下编程,由于浅施主和隧道返回通道,电子很容易从中性氧空位中解脱出来。这因此通过形成额外的带正电荷的电离氧空位导致高效擦除。
背景
基于非晶铟镓锌氧化物 (a-IGZO) 的薄膜晶体管 (TFT) 已被广泛研究用于柔性和透明电子系统 [1,2,3,4,5,6,7 ,8,9,10,11,12]。这归因于 a-IGZO 薄膜的一些特定特性,例如良好的均匀性、低加工温度、可见光透明度和高电子迁移率 [13]。除此之外,还提出了a-IGZO TFT非易失性存储器,其非易失性数据存储能力扩大了a-IGZO TFT器件的使用范围。作为非易失性存储器件的典型架构,浮栅a-IGZO TFT存储器近年来得到了深入研究。到目前为止,已经探索了各种材料作为浮栅(即电荷存储介质),例如电介质 [14, 15]、金属纳米晶体 [16, 17] 和半导体材料 [18,19,20,21] .由于a-IGZO是天然的n型半导体,负栅偏压下的a-IGZO TFT很难实现空穴反转,因此a-IGZO TFT存储器的擦除效率通常较差。换句话说,大多数 a-IGZO TFT 存储器无法通过从沟道注入空穴进行电擦除 [14,15,16]。尽管如此,张等人。 [21] 使用 a-IGZO 作为电荷俘获层 (CTL) 和沟道层制造了 TFT 存储器,其表现出电可编程和可擦除特性,以及良好的数据保留。与此同时,云等人。还研究了具有不同成分的 IGZO CTL 的 a-IGZO TFT 存储器的特性,揭示了在 CTL 溅射沉积过程中随着 O2 分压 (PO2) 增加而减小的存储器窗口 [18]。此外,巴克等人。报道了具有各种导电性 ZnO CTL 的 a-IGZO TFT 存储器的性能,并推断出 ZnO CTL 带隙结构的优化电子性质可能是实现高性能氧化物 TFT 存储器的最重要因素之一 [20]。上述基于氧化物半导体CTL的a-IGZO TFT存储器虽然表现出优异的电编程/擦除速度,但上述器件的双极编程特性尚未见报道,氧化物半导体CTL中不同电荷的相应捕获过程也未见报道。尚不清楚,特别是对于正电荷的捕获。
在这项工作中,通过使用原子层沉积的 ZnO 薄膜作为 CTL 制造了双极可编程 a-IGZO TFT 存储器。通过比较 TFT 存储器件与沉积态、O2 或 N2 退火的 ZnO CTL 的双极编程特性,讨论了 ZnO 层中不同电荷的捕获过程。结果表明,氧空位相关缺陷主导了a-IGZO TFT存储器件的双极编程特性。
方法
使用标准 RCA 清洁工艺清洁电阻率为 0.001-0.005 Ω cm 的 P 型 Si(100)晶片,并用作器件的背栅。然后,通过原子层沉积(ALD)在 250°C 和 200°C 下连续沉积 35-nm Al2O3 和 20-nm ZnO 薄膜,分别用作 TFT 存储器的阻挡层和 CTL。值得一提的是,ZnO 薄膜的均方根 (RMS) 粗糙度为 0.553 nm。随后,进行光刻和湿法蚀刻以定义 ZnO 的 CTL。之后,通过 ALD 生长 8 nm Al2O3 隧道层。二乙基锌 (DEZ)/H2O 和 TMA/H2O 的前体分别用于 ZnO 和 Al2O3 薄膜的生长。此后,使用 InGaZnO4 靶材,在室温下通过射频磁控溅射沉积 40nm 的 a-IGZO 膜作为沟道层。然后通过光刻和稀释的 HCl 蚀刻定义宽度 (W)/长度 (L) 为 100/10 μm 的有源通道。 Ti/Au (30 nm/70 nm) 的源极和漏极触点通过电子束蒸发和剥离工艺形成。最后,所有制造的器件在 O2 中在 250°C 下退火 5 分钟以提高其性能。通过使用半导体参数分析仪(Agilent B1500A)在室温下进行电气表征。阈值电压(Vth)定义为漏极电流等于W/L×10 −9 时的栅极电压 A. ZnO薄膜的载流子浓度在室温下从霍尔效应测量(Ecopia HMS-3000)中提取。
结果与讨论
图1分别显示了在正偏压和负偏压编程下制作的a-IGZO TFT存储器件的示意图。在电编程期间,在背栅上施加电脉冲,并且源电极和漏电极接地。图 2 显示了原始存储设备在不同条件下的编程特性。对于原始存储器件,它表现出开/关电流比 (I 在/我 关闭)的 1.5 × 10 7 , 场效应迁移率为 7.1 cm 2 V −1 s −1 ,以及 0.67 V/dec 的亚阈值摆幅 (SS)。就不同正偏置下的 80 ms 编程而言,I d–V g 曲线作为编程电压的函数在正偏压的方向上逐渐移动,例如,随着编程电压从 8 V 增加到 13 V,由此产生的相对于原始器件的 Vth 偏移 (ΔVth) 从 1.3 V 增加到 4.8 V,表现出编程在 12 V 时饱和,如图 2a 所示。如此显着的 ΔVth 表明来自 n 型 a-IGZO 通道的大量电子被注入 ZnO CTL。此外,当编程电压固定在 13 V 时,ΔVth 从 2 V 缓慢增加到 3.1 V,编程时间从 1 μs 延长到 30 ms,如图 2c 所示。有趣的是,当原始存储器件在负栅极偏压下编程时,Vth 表现出向负偏压的显着转变,如图 2b 所示。对于 80 ms 的恒定编程时间,随着编程偏置从 -8 V 增加到 -13 V,ΔVth 从 -5.2 V 增加到 -7.4 V。即使原始存储器件在 -13 V 下编程 1 μs,它也可以证明a ΔVth 大到 -6.5 V,如图 2d 所示。这意味着大量的电子从 CTL 中解脱出来,从而导致残留大量正电荷。
<图片>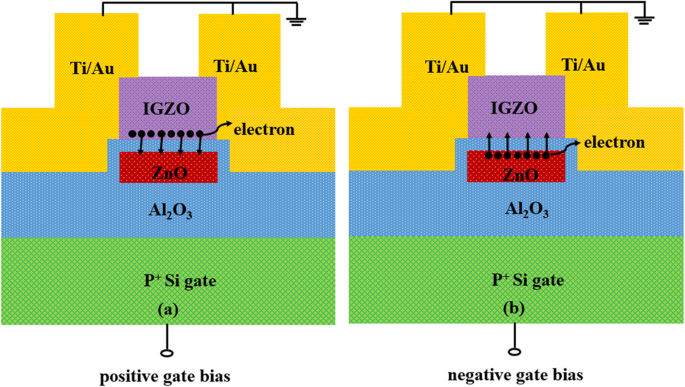
a-IGZO TFT存储器件在正栅偏压下编程的截面示意图(a ) 和负栅极偏置 (b ),分别。
<图片>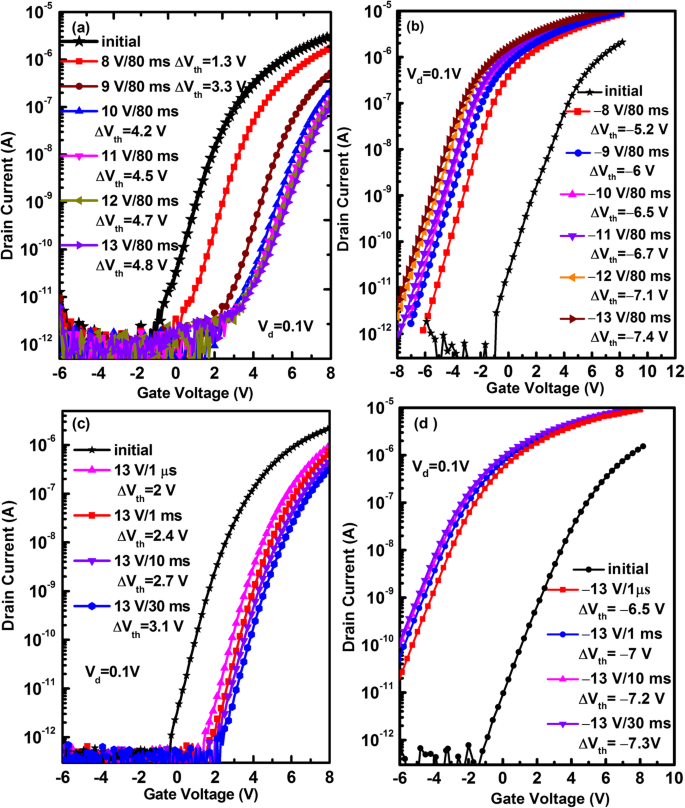
a-IGZO TFT存储器件的转移曲线和那些被编程的a 在 80 ms 的恒定时间内,在各种正栅极偏置下,b 在 80 毫秒的恒定时间内,在各种负栅极偏置下,c 在 13 V 下针对不同的编程时间,以及 d -13 V 用于各种编程时间。每个图形的所有传输曲线都是在同一台设备上测量的,所有的编程操作都是按顺序进行的。
为了了解 ZnO 层的电荷俘获效应,还制造了没有 ZnO CTL 的 a-IGZO TFT 作为控制器件进行比较。图 3 分别显示了在不同的正偏压和负偏压下编程时控制器件的传输特性。发现无论编程电压极性和幅度如何,器件都没有表现出可辨别的 ΔVth。这表明存储器件的上述不同 ΔVth 应归因于 ZnO CTL。另一方面,值得注意的是,IGZO 是一种天然的 n 型半导体,因此在正栅极偏压(例如.)下,IGZO 通道中的电子可以很容易地注入 ZnO CTL , +9 V)。然而,当对器件的栅电极施加负编程偏压时,a-IGZO沟道趋于耗尽,难以实现空穴传导[15]。在这种情况下,器件不能通过通道的空穴注入进行编程,因此通过在原始 ZnO CTL 中释放本征电子来实现电编程的独特可能性。事实上,我们的实验结果表明该器件可以在负栅极偏置下轻松编程,见图 2d。图 4 显示了作为编程/擦除 (P/E) 周期函数的存储器的耐久性特性。对于 10 3 ,该器件的内存窗口为 3.7 V 在 11 V/1 ms 编程和 -9 V/10 μs 擦除情况下的 P/E 周期。此外,在 10 3 时可以实现高达 7.2 V 的存储器窗口 相对于 12 V/1 ms 编程和 -12 V/10 μs 擦除的 P/E 周期。表 1 比较了各种 a-IGZO TFT 存储器的编程和擦除特性 [14, 22, 23]。与其他器件相比,我们的器件即使在较低的偏压(-12 V)和更短的时间(10 μs)下也表现出更高的擦除效率,尽管在编程效率方面没有显着优势。
<图片>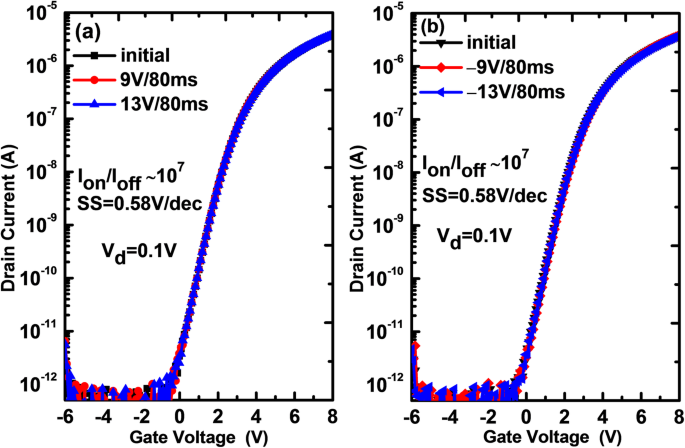
a-IGZO TFT器件和那些编程的a的转移曲线 在 80 ms 的恒定时间和 b 的不同正栅极偏置下 在不同的负栅极偏置下持续 80 ms 的恒定时间
<图片>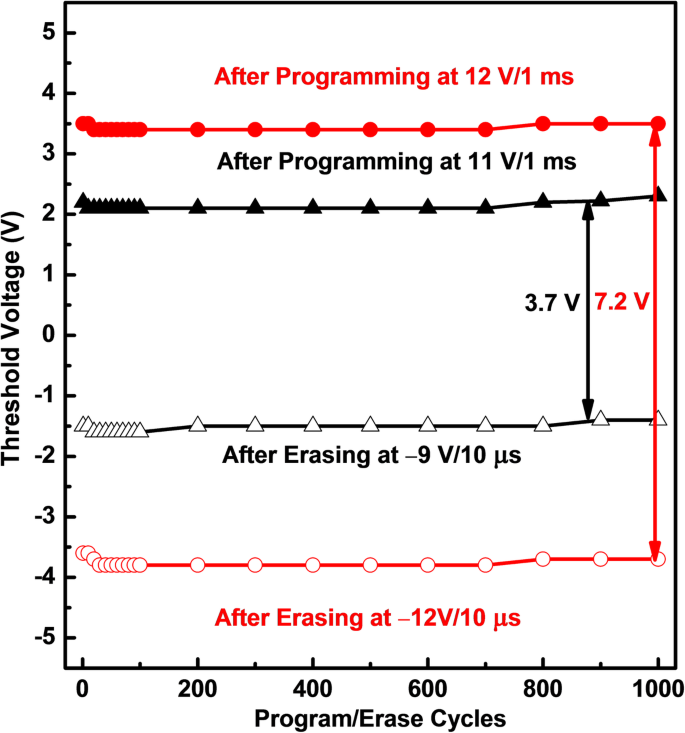
a-IGZO TFT 存储器件的耐久性特性与 P/E 周期的函数关系
为了阐明从原始 ZnO CTL 中释放出来的电子的来源,在 a-IGZO TFT 存储器件中比较了各种加工过的 ZnO CTL。图 5 显示了具有不同 ZnO CTL 的器件的 △Vth 的编程电压依赖性。观察到,对于具有沉积态和 N2 退火 ZnO CTL 的存储器件,尽管电压极性不同,但随着编程电压的升高,所得 ΔVth 表现出类似的增加趋势。然而,对于O2-annealed ZnO CTL的存储器件,在相同的编程条件下,ΔVth的绝对值显示出明显的下降,例如,在13的情况下,ΔVth的绝对值分别下降了2和3 V。 V/80 ms 和 −12 V/1 μs 编程脉冲。此外,在正负栅极偏置的情况下,观察到 O2 退火的 ZnO CTL 的饱和编程行为。这应该归因于 CTL 中的有限陷阱。总之,在O2中250°C的后退火减少了ZnO薄膜中陷阱中心的数量,从而导致电荷俘获能力下降。
<图片>
具有不同处理的 ZnO 电荷俘获层的 a-IGZO TFT 存储器件的阈值电压漂移作为 a 的函数 80 ms 和 b 恒定编程时间的正编程电压 1 μs 恒定编程时间的负编程电压。对于每个条件,测量了五个设备。
为了研究后退火对 ZnO 薄膜性能的影响,通过霍尔效应测量和 XPS 对沉积和加工后的 ZnO 薄膜进行表征。如图 6 所示,ZnO 薄膜在 250 °C 下在 N2 中退火,其载流子浓度为 4.4×10 19 厘米 −3 , 非常接近 (4.5 × 10 19 厘米 −3 ) 沉积的 ZnO 薄膜;然而,在 250 °C 下在 O2 中退火的 ZnO 薄膜表现出载流子浓度的显着降低,等于 1.8 × 10 18 厘米 −3 .据报道,n 型 ZnO 半导体薄膜中的本征施主是氧空位 [24]。权等人。还报道了随着沉积温度从 70°C 增加到 130°C,ALD ZnO 薄膜中的 O/Zn 原子比从 0.90 逐渐降低到 0.78 [25]。这揭示了 ALD ZnO 薄膜中存在氧空位。因此,O2 退火引起的载流子(电子)浓度的降低应该与 ZnO 膜中氧空位的减少有关。此外,还分析了沉积态 ZnO 薄膜和在 N2 或 O2 中退火的薄膜的高分辨率 O1s XPS 光谱,如图 7 所示。解卷积的三个峰集中在 530.0、531.6 和 532.4 eV,对应于 O 2− 与 Zn 2+ 结合的离子 (O1)、氧空位 (O2) 和化学吸附氧元素 (-OH 等) (O3) [26]。与沉积态 ZnO 薄膜相比,O2 中的后退火使 O2 的相对百分比降低了 2.1%。然而,对于在 N2 中退火的 ZnO 薄膜,O2 的相对百分比几乎没有变化。这些结果表明,O2 退火可以钝化 ZnO 薄膜中的氧空位,而 N2 退火不能。这进一步证实了氧空位与载流子浓度之间的相关性。
<图片>
沉积态ZnO薄膜和不同条件退火薄膜的载流子浓度。
<图片>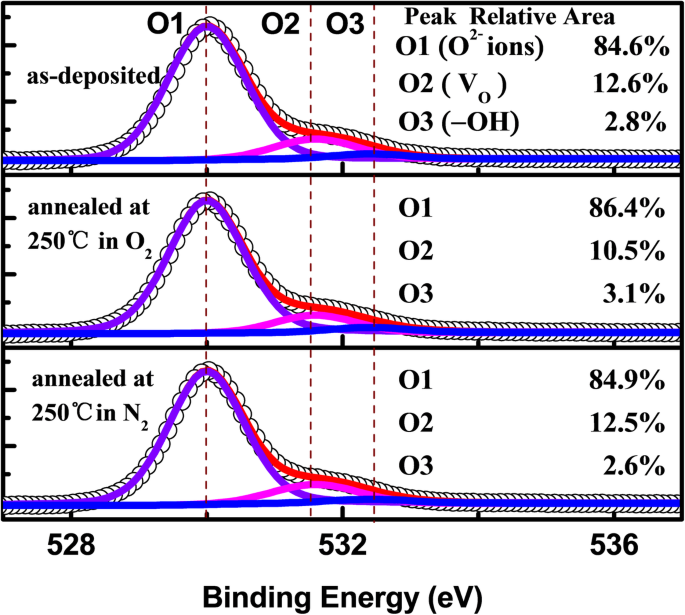
沉积态 ZnO 薄膜和分别在 O2 和 N2 中在 250°C 下退火的薄膜的高分辨率 O1s XPS 光谱。 O1 和 O2 对应于 O 2− 与 Zn 2+ 结合的离子 和氧空位,分别。 O3 归因于化学吸附的氧元素(-OH 等)。为了去除无意中的表面污染物,所有样品都用原位Ar离子轰击蚀刻
基于上述实验结果,可以得出结论,原始存储器件的编程特性受 ZnO CTL 中氧空位相关缺陷的浓度支配。换句话说,ZnO 薄膜中的氧空位主要用作俘获正电荷和负电荷的俘获中心。据报道,ZnO 中与氧空位相关的缺陷包括中性氧空位 (VO)、单电离氧空位 (VO + ) 和双电离氧空位 (VO 2+ ),其能级分别位于 0.02–0.04、0.3–0.45 和 0.61 eV,低于 ZnO 的导带最小值 [27, 28]。由于在我们的情况下沉积的 ZnO 薄膜显示出高电子浓度,作为浅供体的中性氧空位的浓度应远高于电离氧空位 (VO + 和 VO 2+ )。在正栅偏压下编程方面,a-IGZO 通道的累积层中的电子通过 Fowler-Nordheim (FN) 隧穿机制注入 ZnO 层,这通过增加的 ΔVth 和增强的编程电压来证明图 2a。同时,预计这些电子会优先被捕获在 VO + 的深能级 和 VO 2+ ,如图 8a 所示。这导致 Vth 向正偏置方向移动。当然,除了捕获电子的氧空位之外,其他缺陷也可以捕获电子。然而,我们的实验数据表明,氧空位在电子捕获和正电荷捕获中起着至关重要的作用,如图 5 所示。在负编程电压下,原始 ZnO CTL 中的中性氧空位主要提供电子,因为最浅的能级 [27, 28],并且释放的电子从 ZnO CTL 隧道进入通道,从而导致形成带正电荷的氧空位(例如,VO + ),如图 8b 所示。这导致 Vth 在负偏置方向上发生偏移,如图 2b 所示。此外,由于 ZnO 沉积的 CTL 中的中性氧空位 (VO) 浓度更高,原始存储器件在负栅极偏压下比在正栅极偏压下表现出更高的编程效率。例如,在-13 V编程1 μs后,ΔVth的绝对值高达6.5 V(见图2d);然而,在 13 V 编程 1 μs 后,ΔVth 等于 2 V(图 2c)。这是因为前者主要由VO的浓度决定,后者以VO + 的浓度为主 和 VO 2+ .
<图片>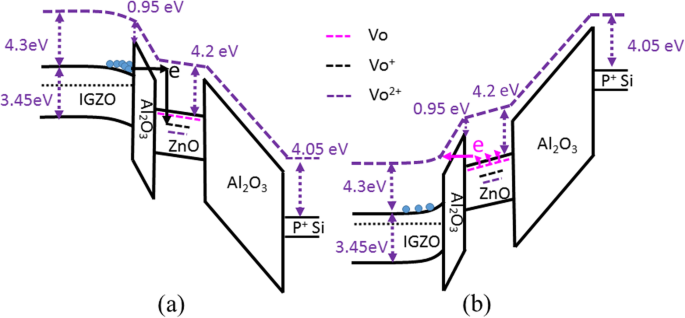
在 a 编程的 a-IGZO TFT 存储器件的能带图 正栅极偏置和 b 分别为负栅极偏置。 Vo, Vo + , 和 Vo 2+ 分别表示中性氧空位、单电离氧空位和双电离氧空位
结论
总之,我们制造了具有原子层沉积 ZnO CTL 的双极可编程 a-IGZO TFT 存储器。与正栅极偏压下的编程相比,负栅极偏压下的编程可以产生更高的效率。这是因为不同的氧空位缺陷在电压极性相关编程期间生效。即VO + 的深度缺陷 和 VO 2+ 在正偏压编程过程中对电子俘获起关键作用,而VO的浅缺陷主要在负偏压编程过程中提供电子,导致带正电的氧空位的产生。
数据和材料的可用性
支持本手稿结论的数据集包含在手稿中。
缩写
- a-IGZO:
-
无定形铟镓锌氧化物
- ALD:
-
原子层沉积
- CTL:
-
电荷俘获层
- TFT:
-
薄膜晶体管
- XPS:
-
X射线光电子能谱
纳米材料
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 通过超循环原子层沉积调节 ZnO 薄膜的费米能级
- 具有 CdSe QD/LiF 电子传输层的高效倒置钙钛矿太阳能电池
- 背面有黑硅层的晶体硅太阳能电池的研究
- 通过蚀刻停止纳米层使用清洁界面工艺增强 a-IGZO TFT 器件性能
- 通过氩等离子体处理插入 ZnO 降低金属和 n-Ge 之间的接触电阻
- 双层 CeO2−x/ZnO 和 ZnO/CeO2−x 异质结构和电铸极性对非易失性存储器开关特性的影响
- 原子层沉积 ZnO/β-Ga2O3 (\( \overline{2}01 \)) 异质结处的能带调查
- 具有增强型双栅极和部分 P 埋层的超低导通电阻横向双扩散金属氧化物半导体晶体管
- 具有高开/关比和极性可切换光电导性的 SnSe2 场效应晶体管
- 具有非晶 Si 钝化的高迁移率 Ge pMOSFET:表面取向的影响
- Python - 使用 C 进行扩展编程


