具有专门设计的超晶格 p 型电子阻挡层以实现高 Mg 掺杂效率的几乎无效率下降的基于 AlGaN 的紫外发光二极管
摘要
这项工作报告了一种几乎无效率下降的基于 AlGaN 的深紫外发光二极管 (DUV LED),其峰值波长为 270 nm。 DUV LED 采用专门设计的超晶格 p 型电子阻挡层 (p-EBL)。超晶格 p-EBL 可在 p-EBL 中实现高空穴浓度,从而相应地提高空穴注入多量子阱 (MQW) 的效率。 MQW 区域内提高的空穴浓度可以更有效地与电子复合,有利于辐射复合,从而降低电子泄漏电流水平。结果,所提出的DUV LED结构的外量子效率提高了100%,并通过实验获得了几乎没有效率下降的DUV LED结构。
背景
波长范围为 200 nm~280 nm 的紫外光束已在水净化系统中找到潜在的应用 [1, 2]。考虑到较低的直流驱动电压和与净水系统的兼容性,AlGaN 基深紫外发光二极管 (DUV LED) 被选为最佳候选。值得一提的是,处理大体积水需要净化系统提供大功率UVC光源。然而,此时发射波长小于 280 nm 的基于 AlGaN 的 DUV LED 的外部量子效率 (EQE) 并不满足 [3]。 EQE 差的主要限制因素部分源于富铝量子阱中的大穿透位错密度 (TDD) [2, 3]。一旦TDD在10 9 的数量级,内量子效率(IQE)迅速下降 cm −2 [3]。即使 TDD 减少到 10 8 的数量级 cm −2 可以使IQE达到60~80%,当注入电流密度超过80 A/cm时,效率下降的影响可能导致裸UVC LED的EQE低于5% 2 [4]。请注意,根据 FDTD 计算 [5],裸 UVC LED 芯片的光提取效率 (LEE) 为 ~ 10%。对基于 III 族氮化物的 LED 效率下降的主要解释之一是电子溢出到 p 型空穴注入层 [6]。富铝AlGaN p型空穴注入层的自由空穴浓度甚至低于1 × 10 17 厘米 −3 [7],往往会导致更严重的电子泄漏水平。梅恩克等人。已经测量了在 p 型空穴注入层中发生的寄生发射,寄生发射很好地归因于电子泄漏 [8]。为了减少多量子阱 (MQW) 的电子逃逸,可以通过在量子势垒中插入单个尖峰层来提高电子捕获率 [9]。尖峰层具有高于量子势垒的铝成分,因此尖峰层中的极化感应电场可以很好地降低电子的漂移速度。因此,仅当 DUV LED 沿 [0001] 方向生长时,才能提高捕获效率。另一种提高电子捕获率的有效方法是增加量子势垒和量子阱之间的导带偏移,这可以通过适当增加Al成分来实现[10],而量子势垒结构可以通过具有铝成分分级 [11]。如前所述,富铝 p 型 AlGaN 空穴注入层的自由空穴浓度较低,导致 MQW 区域的空穴注入能力较差。空穴注入不良也被认为是电子泄漏的原因[12]。增加穿过 p 型电子阻挡层 (p-EBL) 的空穴热电子发射的一种有前途的方法是通过采用电场储存器为空穴提供能量 [13]。如果具有阶梯状 Al 成分的基于 p-AlGaN 的空穴注入层用于 DUV LED [14],也可以促进空穴传输。阶梯状的 Al 成分可以进一步被 AlGaN 层的渐变 Al 成分替代,以提高空穴浓度 [15,16,17]。除了设计空穴注入层外,还建议使用替代的 p-EBL 来降低空穴阻挡效应,例如,插入具有较低 Al 成分的薄 AlGaN 层 [18]。 p-EBL 候选者的一个非常重要的结构是超晶格 p-EBL。为了探索 GaN/AlGaN 超晶格对 GaN 基蓝色 LED 的影响,已经进行了大量的研究工作 [19,20,21]。然而,蓝色 LED 的 AlGaN p-EBL 的 AlN 成分低于 20%,使得蓝色 LED 的空穴阻挡效应不如 DUV LED 严重。因此,即使蓝色 LED 采用 GaN/AlGaN 超晶格 p-EBL,EQE 的改善也小于 20%,效率下降仍然很明显。 DUV LED 采用富含铝的 p-EBL,从而产生更具挑战性的空穴注入问题 [1]。为了解决富铝 p-EBL 引起的空穴阻挡效应,还建议将超晶格 p-EBL 用于 DUV LED,例如,AlInGaN/AlGaN 超晶格 p-EBL [22] 和 AlGaN/AlGaN 超晶格 p-EBL [23]。然而,在此阶段,DUV LED 缺乏有助于获得高且几乎无效率下降的 EQE 的超晶格 p-EBL 的实验证明。因此,这项工作通过实验证明了专门设计的 AlGaN/AlGaN 超晶格 p-EBL 在增强 EQE 和显着抑制 DUV LED 的效率下降方面的有效性。增强的 EQE 很好地归因于改善的空穴注入到 MQW 区域,而降低的电子泄漏水平有助于显着抑制效率下降。详细机制将在后续工作中介绍。
方法/实验
本工作中的两个 DUV LED 架构(LED A 和 B,如图 1 所示)通过金属有机化学气相沉积 (MOCVD) 系统在 AlN 模板上生长。通过使用氢化物气相外延 (HVPE) 方法在 [0001] 取向的蓝宝石衬底上生长 4 μm 厚的 AlN 模板。我们在 AlN 模板上生长 20 周期 AlN/Al0.50Ga0.50N 超晶格,作为随后生长的外延层的应变释放层。 2 微米厚的 n-Al0.60Ga0.40N 层,电子浓度为 1 x 10 18 厘米 −3 生长以提供电子。 DUV 光子由具有 3 纳米厚 Al0.45Ga0.55N 量子阱和 12 纳米厚 Al0.56Ga0.44N 量子势垒的五周期 Al0.45Ga0.55N/Al0.56Ga0.44N MQW 产生。然后 MQW 被 10 纳米厚的基于 AlGaN 的 p-EBL 覆盖。在我们的实验中,我们分别为 LED A 和 B 设计和生长两种类型的 p-EBL。 LED A 具有基于 Al0.60Ga0.40N 的 p-EBL,而 LED B 具有基于五周期 1-nm Al0.45Ga0.55N/1-nm Al0.60Ga0.40N 的 p-EBL。请注意,我们的超晶格 p-EBL 回路在生长最后一个 Al0.56Ga0.44N 量子势垒后从 Al0.45Ga0.55N 薄层开始。通过这样做,最后一个量子势垒/超晶格 p-EBL 的界面通过产生负极化引起的片电荷来极化,这有助于耗尽最后一个量子势垒中的电子积累并进一步抑制电子泄漏。然后 p-EBL 之后是 50 nm p-Al0.40Ga0.60N/50 nm p-GaN 孔供应器。最后,p-GaN 层涂有 10 纳米厚的重掺杂 Mg 的 p + -GaN层。 DUV LED 晶片在 N2 环境中在 800°C 的温度下原位热退火 15 分钟以分裂 H-Mg 键。空穴浓度粗略估计为 1 × 10 17 厘米 −3 和 3 × 10 17 厘米 −3 分别为富铝 p-AlGaN 层和 p-GaN 层。
<图片>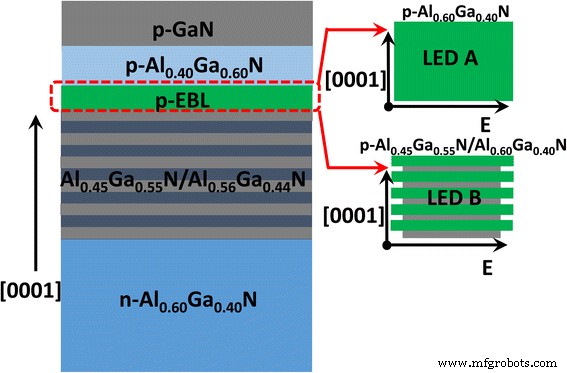
所研究的 LED 的结构示意图。还提供了两个 p-EBL 的草图能带图:LED A 具有基于 p-Al0.60Ga0.40N 的 EBL,LED B 具有 p-Al0.45Ga0.55N/Al0.60Ga0.40N 超晶格 EBL。 p-Al0.45Ga0.55N/Al0.60Ga0.40N 超晶格 EBL 是专门设计的,它启动了薄 p-Al0.45Ga0.55N 层,以便 p-Al0.45Ga0.55N/Al0.56Ga0 的界面.44N 最后一个量子势垒具有负极化界面电荷。 E 表示能量水平。
DUV LED 晶片按照标准的微制造工艺制成 DUV LED 芯片。台面通过电感耦合等离子体(ICP)蚀刻获得,台面尺寸为650 × 320 μm 2 . Ti/Al 金属叠层沉积在 n-Al0.60Ga0.40N 层上,然后在 N2 中在 900°C 的温度下退火 1 分钟。将 Ni/Au 电流扩展涂覆在台面表面上,然后在 550°C 的温度下在 O2 中退火 5 分钟。最后,我们在分别用作 n 电极和反射 p 电极的 Ti/Al 合金和 Ni/Au 电流扩展层上同时沉积 Ti/Al/Ni/Au 金属。 DUV LED芯片为倒装芯片,DUV光子通过积分球从蓝宝石一侧收集。
为了更好地揭示增强 EQE 和抑制效率下降的深层原因,使用 APSYS 包进行数值计算 [13, 18]。用于计算载流子复合事件和载流子损耗的重要物理参数包括肖克利-读霍尔 (SRH) 复合寿命、俄歇复合系数、AlGaN/AlGaN 界面的能带偏移比和 [0001 ] 取向的 III 族氮化物结构,设置为 10 ns,1 × 10 -30 厘米 6 s −1 、50:50 和 40%,分别 [13, 18]。对于具有 50 nm 厚吸收性 p-GaN 层的裸 DUV LED 芯片,LEE 设置为 10% [5]。
结果和讨论
LED A 和 B 在不同电流密度水平下的实验测量电致发光 (EL) 光谱如图 2a 所示。 EL 光谱是在占空比为 0.1% 的脉冲条件下收集的,以避免自热效应。图 2a 显示两种 DUV LED 器件的峰值发射波长均为 ~ 270 nm。由于消除了自热效应,峰值发射波长在测试电流范围内是稳定的。 LED B 的 EL 强度比 LED A 的强。图 2b 展示了光功率和 EQE 作为注入电流密度的函数,这说明 EQE 增强了~ 90%。此外,在 110 A/cm 2 的电流密度水平下,LED A 和 B 的效率下降水平为 ~ 24 和 ~ 4% , 分别 [droop =(EQE max − EQE J )/情商 最大值,其中 EQE 最大值和EQE J 表示最大 EQE 和 J 电流密度下的 EQE ]。图 2c 显示了数值计算的光功率密度和注入电流密度方面的 EQE。数值计算结果和实验测量结果相互吻合,因此 LED B 显示出增强的 EQE 和显着降低的效率下降水平。图 2b 和 2c 之间的一致性很好地验证了我们为计算设置的物理模型和参数。
<图片>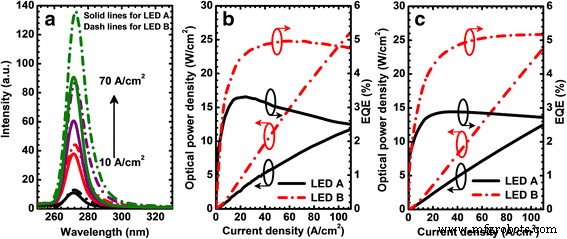
一 在 10、30、50 和 70 A/cm 2 的电流密度下测得的 EL 光谱 . b 测量的光功率和 EQE。 c 分别计算出 LED A 和 B 的光功率和 EQE
两个 DUV LED 仅在 p-EBL 上有所不同。因此,需要研究超晶格 p-EBL 在改善 LED B 光学性能方面的作用。图 3a 显示了 LED A 和 B 在 50 A/cm 的电流密度下跨越 MQW 区域的空穴浓度分布 2 .结果表明,LED B 的 MQW 内的空穴浓度水平高于 LED A。据报道,p-EBL 降低了电子泄漏水平,同时阻碍了空穴注入 [24]。减少空穴阻挡效应的一种有用方法是增加 p-EBL 区域内的空穴浓度,这有助于降低价带势垒高度 [25]。然后,图 3b 显示了 LED A 和 B 在电流密度为 50 A/cm 2 的 p-EBL 和 p-Al0.40Ga0.60N 层中的空穴浓度水平 . LED B 的超晶格 p-EBL 中的平均空穴浓度比 LED A 高两个数量级。超晶格 p-EBL 中较大的空穴浓度很好地归因于出色的空穴传输。有趣的是,如果我们进一步查看图 3b,我们发现 LED A 在 p-EBL/p-Al0.40Ga0.60N 界面处的空穴浓度变低,这也反映了通过超晶格 p-的更平滑的空穴注入效率。 LED B 用 EBL。
<图片>
数值计算的空穴浓度分布a 在 MQW 和 b 在分别用于 LED A 和 B 的 p 型空穴注入层中; c 在电流密度为 10、30、50 和 70 A/cm 2 下以半对数标度实验测量的 EL 光谱 分别用于 LED A 和 B; d LED A 和 B 的 p 型空穴注入层中电子浓度水平的数值计算。在 50 A/cm 2 的电流密度下收集数值计算数据
如前所述,LED 的效率与电子泄漏水平密切相关。因此,我们以半对数标度(见图 3c)显示 LED A 和 B 的测量 EL 光谱,以指示有关寄生发光的详细信息。寄生发光的峰值发射波长集中在~ 425 nm,这可能是由与 Mg 掺杂剂相关的深能级引起的 [26]。 LED B 的寄生发光强度比 LED A 强,推测更多的载流子在深能级复合。在我们的实验中,两种 DUV LED 架构的 p 型空穴注入层都没有经过设计,空穴注入层中的空穴浓度水平应该相似。因此,确定从 MQW 区域逸出的电子在 LED B 的空穴注入层中具有比 LED A 更高的浓度。图 3d 进一步支持了我们的建议,图 3d 显示了 p-中的电子浓度分布。电流密度为 50 A/cm 2 的 LED A 和 B 型空穴注入层 .这也意味着 LED B 的超晶格 p-EBL 显着降低了电子泄漏电流。
然后,我们展示了图 4 中 LED A 和 B 的辐射复合率的计算曲线,这些曲线是在 50 A/cm 2 的电流密度水平下收集的 .推测由于提出了超晶格p-EBL,LED B的辐射复合率比LED A强,这更有利于空穴注入MQW区域并同时抑制电子泄漏水平。
<图片>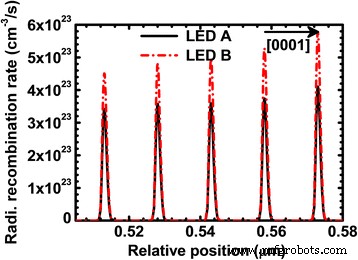
LED A 和 B 辐射复合率的数值计算分布图。数据是在 50 A/cm 2 的电流密度水平下收集的
图 5a 和 5b 显示了两种 DUV LED 器件在 p-EBL 附近的能带。能带是在 50 A/cm 2 的电流密度下计算的 .正如 Zhang 等人报道的那样。 [27],在最后一个量子势垒/p-EBL 界面处强极化诱导的正电荷可以显着吸引电子,从而产生高局部电子浓度。高局部电子浓度会降低有效导带势垒高度(Ø e ) 对于 LED A,p-EBL 为 ~ 295 meV。能带隙比最后一个 AlGaN 量子势垒小),最后一个量子势垒的导带向上倾斜(见图 5b),这有利于最后一个量子势垒中的电子耗尽,然后增加 Ø e 到 ~ 391 meV,并通过热电子发射实现更小的电子逃逸 [28]。此外,超晶格 p-EBL 促进了空穴的带内隧穿过程,因此 p-EBL 中的空穴浓度也变得更高(见图 3b) LED 的 p-EBL 中增强的空穴浓度趋于降低有效价带势垒高度 (Ø h ) [25],即Ø的值 h LED A 和 B 在电流密度为 50 A/cm 2 时分别为 ~ 324 meV 和 ~ 281 meV .更小的Ø h LED B 反过来有利于空穴的热电子发射。值得注意的是,超晶格 p-EBL 也可能导致电子的带内隧穿。幸运的是,MQW 中改进的空穴浓度可以通过辐射复合更好地消耗电子,这也有助于减轻电子泄漏 [12]。由于在 MQW 区域发生的辐射复合过程产生更有利的空穴注入和更强的复合电流,根据图 5c,LED B 的正向电压比 LED A 的正向电压小。
<图片>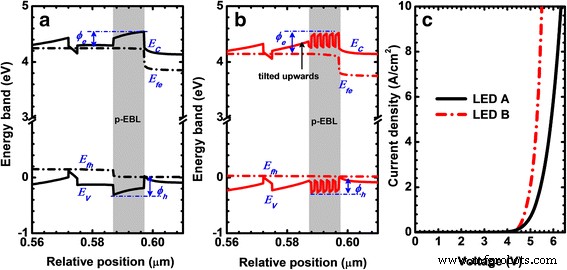
a 附近的数值计算能带剖面 用于 LED A、b 的块状 AlGaN 基 p-EBL LED B 和 c 的超晶格 p-EBL 根据 LED A 和 B 的施加偏压测量的电流密度。a 的数据 和 b 以 50 A/cm 2 的电流密度计算 . E C , EV, Ø e , 和 Ø h 分别表示导带、价带以及导带和价带的有效势垒高度
结论
总而言之,这项工作报告了一种用于 DUV LED 的特定超晶格 p-EBL,它可以保持提高的空穴注入效率和减少的电子泄漏到无源 p 型空穴注入层。因此,无论是数值上还是实验上,都获得了改进的 EQE 和显着抑制的效率下降。我们坚信所提出的 DUV LED 结构对于实现高效 DUV LED 非常有希望,并且这项工作揭示的器件物理特性为基于 III 族氮化物的光电社区带来了更多的理解。
缩写
- APSYS:
-
半导体器件的先进物理模型
- DUV:
-
深紫外发光二极管
- EL:
-
电致发光
- EQE:
-
外量子效率
- HVPE:
-
氢化物气相外延
- ICP:
-
电感耦合等离子体
- IQE:
-
内量子效率
- LEE:
-
光提取效率
- MOCVD:
-
金属有机化学气相沉积
- MQW:
-
多量子阱
- p-EBL:
-
p型电子阻挡层
- TDD:
-
穿透位错密度
纳米材料
- 电子倍增器发射层的设计
- 用于高性能硅/有机混合太阳能电池的具有溶剂处理的高导电 PEDOT:PSS 透明空穴传输层
- InP/ZnS 核/壳量子点的绿色合成在无重金属发光二极管中的应用
- 具有 CdSe QD/LiF 电子传输层的高效倒置钙钛矿太阳能电池
- 具有高拉伸性的导电 TPU 纳米纤维复合材料用于柔性应变传感器
- 采用高极性醇溶剂处理 PEDOT:PSS 作为空穴传输层的高亮度钙钛矿发光二极管
- 用于平面钙钛矿太阳能电池的低温处理 SnO2 电子传输层的紫外线处理
- 关于用于基于 AlGaN 的深紫外发光二极管的 p-AlGaN/n-AlGaN/p-AlGaN 电流扩展层
- 用于高能量转换效率的接触式摩擦纳米发电机理论系统
- 不同温度下量子阱宽度对 AlGaN 深紫外发光二极管电致发光特性的影响
- 通过原子层沉积制造的用于具有增强电容的超级电容器电极的 TiO2 纳米膜
- 集成环保钙钛矿用于高效白光发光二极管


