溶液处理纳米晶 p 型 CuAlO2 薄膜晶体管的制备和表征
摘要
p的发展 型金属氧化物薄膜晶体管 (TFT) 远远落后于 n 型对应。在这里,p 采用旋涂法沉积-型CuAlO2薄膜,并在氮气氛中不同温度下退火。系统地研究了后退火温度对薄膜的微观结构、化学成分、形貌和光学性能的影响。当退火温度高于 900°C 时,实现了从 CuAl2O4 和 CuO 的混合物到纳米晶 CuAlO2 的相转变,并且薄膜的透射率、光能带隙、晶粒尺寸和表面粗糙度随着温度的增加而增加。退火温度。接下来,底门 p 在 SiO2/Si 衬底上制造具有 CuAlO2 沟道层的 型 TFT。发现TFT性能强烈依赖于沟道层的物理性质和化学成分。优化后的纳米晶 CuAlO2 TFT 的阈值电压为 − 1.3 V,迁移率为 ~ 0.1 cm 2 V −1 s −1 , 电流开/关比 ~ 10 3 .这份关于解决方案处理的 p 的报告 型CuAlO2 TFTs代表了在低成本互补金属氧化物半导体逻辑电路方面取得的重大进展。
背景
在过去的几十年中,金属氧化物薄膜晶体管 (TFT) 因其优异的电性能和优异的电性能而被广泛研究用于下一代有源矩阵液晶显示器、有机发光二极管显示器和其他新兴电子电路应用。出色的光学透明度 [1, 2]。然而,迄今为止报道的大多数金属氧化物 TFT 都集中在 n 型材料 [3]。 p 型氧化物半导体通常以局部氧2p为特征 具有大电负性的轨道、氧空位的自补偿以及氢作为无意供体的结合。因此,很难实现有效的空穴掺杂[4]。到目前为止,只有几个p 型氧化物材料(Cu2O、CuO、SnO 等)被证明适用于 TFT 应用 [5, 6],但它们的性能远远落后于 n 型对应。这限制了所有氧化物 p-n 的发展 结和互补金属氧化物半导体(CMOS)逻辑电路。
获得良好的p 型金属氧化物,改变能带结构并降低氧离子对空穴施加的库仑力至关重要。从而激发了一组 p 的发现 型铜铁矿氧化物,例如 CuMO2(M=Al、Ga、In)和 SrCu2O2 [7, 8]。其中,CuAlO2 具有~ 3.5 eV 的宽带隙,其价带最大值由氧轨道与 3d 10 的大杂化决定 Cu 1+ 中的电子 封闭壳,导致色散价带。同时,封闭壳的阳离子 (d 10 s 0 ) 有利于实现高光学透明度,因为这种电子结构可以避免从所谓的 d-d 跃迁中吸收光。因此,它自 1997 年首次制造以来就引起了相当大的关注 [9]。然而,只有少数报告关注p 型 TFT 使用 CuAlO2 作为沟道层。主要困难是结晶度差和杂质相,例如 Cu2O、CuO、Al2O3 和 CuAl2O4。首次报道采用磁控溅射法制备CuAlO2 TFT,该器件的电流开/关比为8 × 10 2 以及 0.97 cm 2 的空穴迁移率 V −1 s −1 [10]。然而,磁控溅射需要严格的高真空环境和复杂的操作工艺。相比之下,溶液处理方法具有明显的优势,例如简单、低成本、可调成分和大气处理。在这项工作中,我们提出了一种制备 CuAlO2 薄膜的溶液途径。系统研究了退火温度对薄膜微观结构、化学成分、形貌和光学性能的影响。最后,使用获得的纳米晶 CuAlO2 薄膜作为沟道层制造底栅 TFT,它们的迁移率约为 0.1 cm 2 V −1 s −1 ,阈值电压为- 1.3 V,电流开/关比为~ 10 [3]。
方法/实验
前体制备和薄膜制造
以三水合硝酸铜(Cu(NO3)2·3H2O)和九水合硝酸铝(Al(NO3)3·9H2O)为原料,通过旋涂法制备了CuAlO2薄膜。两种金属盐的摩尔比为1:1,每种盐在乙二醇甲醚中的浓度为0.2mol/L;加入乙酰丙酮以形成深绿色的稳定溶液。整个混合过程在搅拌下在 80°C 水浴中进行。在薄膜沉积之前,用丙酮、乙醇和去离子水在每种溶液中超声清洗基材 5 分钟。然后,最终前体以 500 rpm 的低转速旋涂 9 秒,然后以 5000 rpm 的高转速旋涂 30 秒。旋涂后,基板在 350°C 下退火 20 分钟。从涂覆到退火的过程重复四次,直到达到所需的膜厚度(~ 40 nm)。最后,将沉积后的薄膜在氮气气氛中在 700-1000°C 下退火 2 小时,然后在相同气氛下冷却至室温。
CuAlO2 TFT 的制造
具有底栅结构的 CuAlO2 TFT 制作在 SiO2/Si 衬底上。三百纳米厚的 SiO2 作为栅极电介质。在 CuAlO2 薄膜沉积之后,50 nm 金源/漏电极通过阴影掩模热蒸发到沟道层上。蒸发速率为 0.08 nm/s,通道宽度 (W) 和长度 (L) 分别为 1000 μm 和 100 μm。最后在Si衬底上焊接一层铟层作为背栅电极。
薄膜和 TFT 表征
通过X射线衍射(XRD,DX2500)和CuKα辐射(λ =0.154 纳米)。拉曼光谱由 Renishaw-1000 用固态激光器 (633 nm) 测量。用扫描电子显微镜(SEM,JSM-5600LV,JEOL)和 Veeco Dimension Icon 原子力显微镜(AFM)测量表面形态。 X 射线光电子能谱 (XPS) 在 Thermo Scientific Escalab 250 Xi 光谱仪上进行。在将膜表面蚀刻约 3 nm 以最小化表面污染后收集 XPS 光谱。通过紫外-可见分光光度计(Varian Cary 5000)测量光学透射率。电气特性由半导体参数分析仪(Keithley 2612B)测量。
结果与讨论
图 1a 显示了在不同温度下退火的 CuAlO2 薄膜的 XRD 图案。对于在 700°C 下退火的薄膜,仅在 35.8° 和 38.9° 处观察到微弱的 CuO 相衍射峰,表明 700°C 不足以形成 CuAlO2 相 [11]。在 800°C 退火后观察到分别属于 CuAlO2 和 CuAl2O4 相的 31.7° 和 37.1° 处的两个新峰。当温度达到 900°C 时,CuO 峰的强度降低,CuAl2O4 相峰消失。在 36.8°、42.5°、48.5°、57.5° 和 31.7° 处的几个新峰属于 CuAlO2 相,主导了薄膜 [9, 12]。温度进一步升高到 1000°C,峰强度增加,得到单一的 CuAlO2 相。结晶度的提高可能是由于更高的退火温度下更多的能量吸收加速了微晶的生长。
<图片>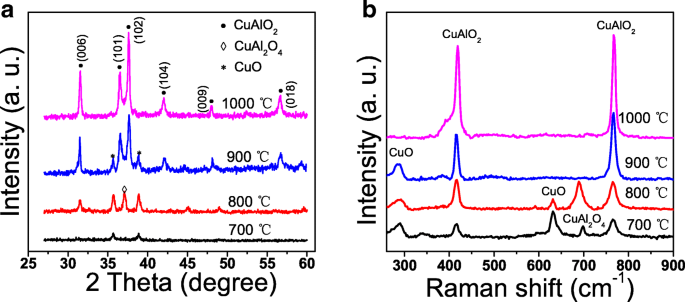
一 XRD 图。 b 不同温度退火CuAlO2薄膜的拉曼光谱
图 1b 显示了 CuAlO2 薄膜的拉曼光谱。铜铁矿结构 CuAlO2 的四原子原胞导致 12 个正常模式,但只有 A1g (416 cm -1 ) 和 Eg (771 cm −1 ) 模式是拉曼激活的。如图 1b 所示,很明显,所有薄膜都存在两种拉曼振动模式 A1g 和 Eg [13]。与XRD的体分析不同,拉曼散射起源于分子振动和晶格振动,可以检测到拉曼活性分子在很小的浓度下振动。这解释了在 700 °C 退火膜中存在 CuAlO2 相的原因,这在 XRD 光谱中是无法观察到的。其他峰值在 798 cm −1 , 297 厘米 −1 , 和 632 cm −1 还观察到它们分别属于 CuAl2O4 的 F2g 模式、Ag 和 CuO 的 Bg 模式 [14]。 CuO和CuAl2O4相的峰随着退火温度从700°C升高到1000°C而降低,并且在1000°C退火后两相均转化为CuAlO2相,这与XRD结果一致。
为了了解在不同温度下退火的 CuAlO2 薄膜的化学成分,进行了 XPS 测量,Cu 2p 核心能级光谱如图 2a 所示。典型的 Cu 2p3/2 峰可以拟合为位于 ~ 932.8 和 ~ 934.2 eV 的两个峰,这可以归因于 Cu + 和 Cu 2+ , 分别。类似地,拟合的 Cu 2p1/2 解卷积两个峰集中在 ~ 952.6 (Cu + ) 和 ~ 954.1 eV (Cu 2+ ),分别[15]。由于 Cu 2p 的自旋轨道分裂为 ~ 19.8 eV,2p3/2 和 2p1/2 峰在拟合过程中不受面积比的限制。尽管如此,Cu 2p3/2 峰和Cu 2p1/2 峰的面积比为~ 1.90,接近由电子态密度确定的理想值2 [14]。在 ~ 932.8 eV (Cu + ) 和 ~ 952.6 eV (Cu + ) 表明 Cu 阳离子主要存在于 Cu + 在 CuAlO2 晶格中形成。注意 Cu 2+ 在所有薄膜中都呈现出状态,即使通过 XRD 在高温退火样品中也没有检测到 CuO 峰。同时,从 941.2 到 944.4 eV 观察到的卫星峰也暗示了 CuO 的存在。然而,高温退火后的卫星峰几乎可以忽略不计,这与上述XRD观察结果一致。 XPS 光谱的定量分析得到 Cu + /[Cu + +Cu 2+ ] 在 700、800、900 和 1000 °C 下退火的 CuAlO2 薄膜的原子比分别为 62.5%、68.9%、73.7% 和 78.9%,表明 Cu 2+ 的还原 随着退火温度的升高[10, 16]。 XPS O 1s 峰如图 2b 所示。有趣的是,结合能表现出对称的主峰,以 ~ 529.8 eV 为中心,表明大部分氧原子与最近的相邻金属离子 (Cu + , 铝 3+ , 或 Cu 2+ ) 格中。应该注意的是,由于与氧相关的缺陷,在 ~ 531.3 eV 处的峰值几乎无法区分。这一结果可以通过引入表面蚀刻工艺和高结晶质量来解释。
<图片>
一 铜 2p。 b 不同温度退火CuAlO2薄膜的O 1s XPS光谱
通过 SEM 观察 CuAlO2 薄膜的表面形貌,如图 3a 所示。所有薄膜均表现出连续、光滑、致密的结构形态,无明显微裂纹。晶粒尺寸均匀,随着退火温度的升高而增大。逐渐增大的晶粒尺寸将导致更少的晶界,这些晶界充当俘获点并显着降低纳米晶 CuAlO2 薄膜的迁移率 [17]。因此,在高温下退火的 CuAlO2 薄膜有利于电荷传输,并可能产生高性能的 TFT [18]。表面粗糙度是另一个会严重影响氧化物 TFT 电气性能的因素 [19]。为了获得均方根 (RMS) 粗糙度,通过 AFM 研究了 CuAlO2 薄膜,如图 3b 所示。在 700°C、800°C、900°C 和 1000°C 下退火的薄膜的 RMS 粗糙度分别为 0.92、1.82、2.12 和 2.96 nm。显然,RMS随着退火温度的增加而增加。通常,粗糙的表面会导致存在电气缺陷或捕获位点,从而导致设备性能不佳 [20]。因此推测晶粒尺寸与表面粗糙度之间存在竞争关系,从而影响纳米晶氧化物TFT的性能。
<图片>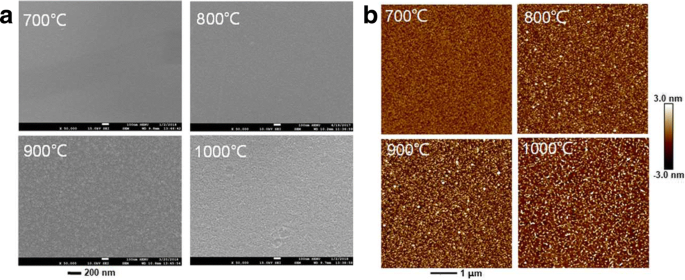
一 扫描电镜。 b 不同温度退火CuAlO2薄膜的AFM
在 200 到 800 nm 波长范围内测量熔融石英上 CuAlO2 薄膜的光透射光谱,如图 4 所示。观察到所有薄膜都有陡峭的吸收边和强烈的紫外线吸收,这表明薄膜的良好结晶度。可见光区域的平均透射率计算为~ 60 到~ 80%,随着退火温度的升高而增加。 Tauc 的关系 αhν =A (h ν − E g ) 1/2 进行计算光学带隙,其中α 是吸收系数,A 是直接转换的常数,h 是普朗克常数,ν 是光子频率 [21]。 Eg 的价值 由 (αhν) 的图的线性外推给出 2 对比 hν 到能量轴,如图 4 的插图所示。E g 对于在 700°C、800°C、900°C 和 1000°C 下退火的 CuAlO2 薄膜,计算结果分别为 3.25 eV、3.40 eV、3.60 eV 和 3.80 eV。
<图片>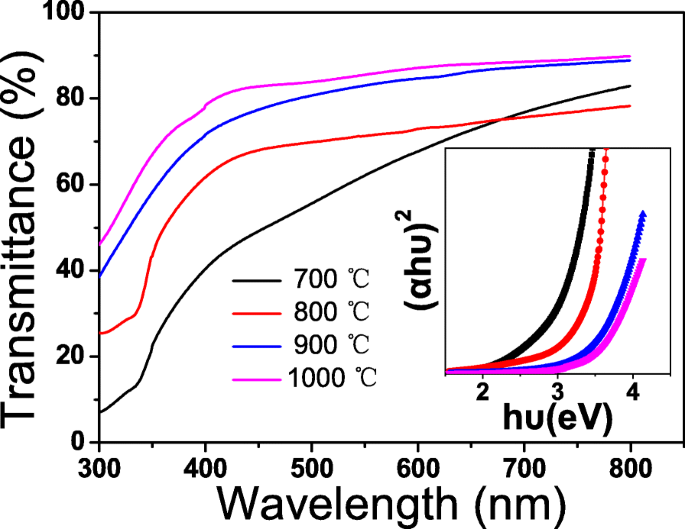
CuAlO2薄膜在不同温度下退火的光透射光谱。插图显示了 (α hν) 2 与影片的hν对比
最后,我们在 SiO2/p-Si 衬底上制造了底栅顶接触 TFT,以研究 CuAlO2 作为沟道层的电性能。装置示意图如图 5a 所示。 CuAlO2 TFTs 在栅源电压 (V - 50 V 的 GS) 如图 5b 所示。它清楚地指示通态电流 (I on)随着退火温度的升高而增加。这主要归因于类绝缘体CuAl2O4相的消除和纳米晶CuAlO2相的增强。转移曲线如图 5c-f 所示,CuAlO2 TFT 表现出典型的 p - 类型的行为。所有器件都显示出中等的开/关电流比 (I 在/我 off) of ~ 10 3 这也许可以通过优化沟道厚度、阳离子掺杂或改变源极/漏极材料来进一步改进 [22,23,24]。阈值电压 (V T) 被确定为 I 线性拟合的水平轴截距 DS 1/2 -V GS 曲线。 V T 随着退火温度的升高而向正值偏移。场效应迁移率 (μ FE)、亚阈值斜率 (SS) 和界面陷阱密度 (N t) 可以通过以下等式 [25, 26] 计算:
$$ {I}_{\mathrm{DS}}=\frac{1}{2}{\mu}_{\mathrm{FE}}{C}_{\mathrm{OX}}\frac{W} {L}{\left({V}_{\mathrm{GS}}-{V}_{\mathrm{T}}\right)}^2 $$ (1) $$ \mathrm{SS}={ \left(\frac{d\left({\log}_{10}{I}_{\mathrm{DS}}\right)}{d{V}_{\mathrm{GS}}}\right) }^{-1} $$ (2) $$ {N}_{\mathrm{t}}=\left[\frac{\mathrm{SSlog}(e)}{kT/q}-1\right] \left(\frac{C_{\mathrm{ox}}}{q}\right) $$ (3) <图片>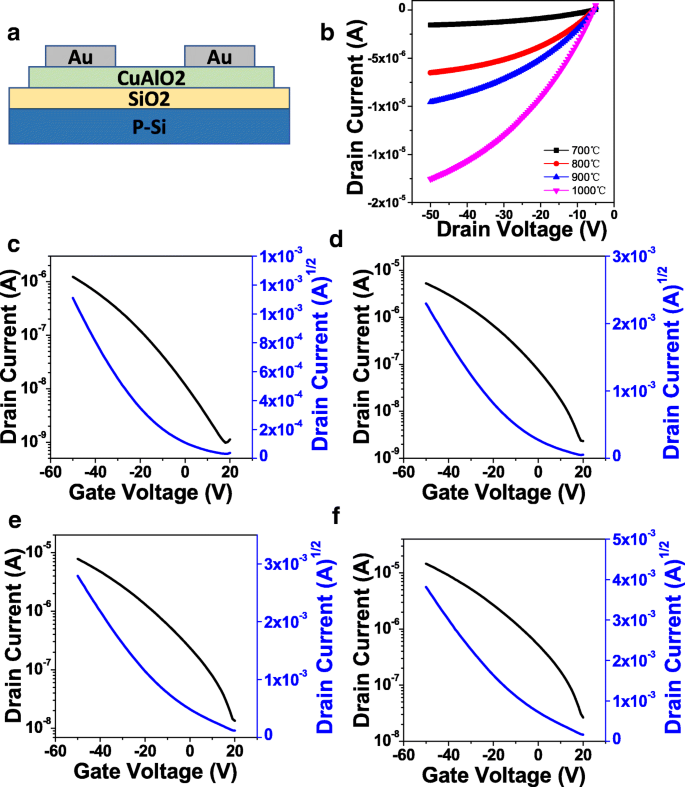
一 CuAlO2 TFT 的示意图。 b 总结输出曲线。 c –f 分别在 700°C、800°C、900°C 和 1000°C 下退火的 CuAlO2 TFT 的转移曲线
其中 k 是玻尔兹曼常数,T 是温度,q 是电子的基本电荷,C ox 是栅极绝缘体的面积电容 [27]。器件的关键电气参数列于表 1。可以看出 SS 值,大大高于报告的 n 型器件,随着退火温度的升高而降低,与V的趋势一致 T. 结果可以通过通道/电介质界面处陷阱的减少来解释[28]。 μ FE 值从 0.006 增加到 0.098 cm 2 V −1 s −1 随着退火温度从 700°C 增加到 1000°C,这表明由于从混合物到纳米晶 CuAlO2 的相转变和晶粒尺寸的增大,空穴传输得到改善。 μ FE 低于 Nie 等人 [16] 报道的溶液处理的 CuCrO2 TFT。原因可能是铜铁矿纳米晶CuAlO2 结构比CuCrO2 缺乏Cu-O-Cu 晶格含量[29]。尽管器件的退火温度对于实际应用来说很高,但这是关于溶液处理的 CuAlO2 TFT 的首次报道。目前正在通过紫外/臭氧光化学反应和/或燃烧合成进一步降低退火温度[23,30,31]。
结论
总之,溶液处理的 CuAlO2 薄膜是在不同温度下在氮气气氛中制备和退火的。随着温度从 700°C 升高到 1000°C,膜结构相从 CuAl2O4 和 CuO 的混合物转变为纳米晶 CuAlO2,并且膜的光学透射率、能带隙、晶粒尺寸和表面粗糙度增加。 p 型 CuAlO2 TFT 的性能在很大程度上取决于沟道层的物理性质和化学成分。优化后的纳米晶 CuAlO2 TFT 的阈值电压为 - 1.3 V,迁移率为 ~ 0.1 cm 2 V −1 s −1 , 电流开/关比 ~ 10 3 .与基于真空的磁控溅射相比,我们的工作展示了一种低成本、溶液处理的 CuAlO2 TFT,这代表了互补金属氧化物半导体逻辑电路发展的重要进展。
缩写
- 原子力显微镜:
-
原子力显微镜
- C 牛:
-
栅极绝缘体的面积电容
- I 在/我 关闭:
-
通断电流比
- k :
-
玻尔兹曼常数
- L :
-
通道长度
- N :
-
界面陷阱密度
- q :
-
电子的基本电荷
- SEM:
-
扫描电镜
- SS:
-
亚阈值斜率
- T :
-
绝对温度
- TFT:
-
薄膜晶体管
- V :
-
阈值电压
- W :
-
通道宽度
- XPS:
-
X射线光电子能谱
- XRD:
-
X射线衍射
- μ 费:
-
场效应移动
纳米材料
- 钴掺杂 FeMn2O4 尖晶石纳米粒子的制备和磁性
- 走向 TiO2 纳米流体——第 1 部分:制备和性质
- Sb/坡缕石 (PAL) 纳米颗粒的制备和增强催化氢化活性
- 中空结构LiNb3O8光催化剂的制备和光催化性能
- 通过孔隙率表征设计纯碳纳米管材料
- 钯(II)离子印迹聚合物纳米球的制备及其从水溶液中去除钯(II)
- 用于薄膜晶体管的氧化铟纳米膜的原子层沉积
- ITO/PtRh:PtRh 薄膜热电偶的制备和热电特性
- 通过多元醇介导工艺制备和表征 ZnO 纳米夹
- 组合条纹图案的 FeCoBSi 薄膜的厚度相关磁和微波共振表征
- 基于生物羟基磷灰石的含锶微晶玻璃复合材料的开发和表征
- 低聚(乙二醇)二丙烯酸-甲基丙烯酸热敏聚合物纳米凝胶的制备及其性能表征


