使用 Co(EtCp)2 作为金属前驱体的钴膜的等离子体增强原子层沉积
摘要
对于先进的 Cu 互连技术,由于对 Cu 的润湿性比 Ta 更好,Co 薄膜已被广泛研究用作衬垫和种子层的替代物。在本文中,使用 Co(EtCp)2 作为前驱体,通过等离子体增强原子层沉积法生长 Co 薄膜,并详细研究了工艺参数对 Co 薄膜特性的影响。结果表明,工艺窗口为 125-225°C,增长率为 ~ 0.073 Å/周期。也就是说,Et 基团与 Cp 配体的连接可以使薄膜在 125°C 下稳定生长,而就 Co(Cp)2 和 Co(MeCp)2 而言,相应的温度必须高于 200°C。除了主要的 Co 和 C 之外,沉积的薄膜还含有 N 和 O 元素。此外,NH3 脉冲时间的延长显着提高了 Co 薄膜的导电性,并且在 40 s 的 NH3 脉冲时间下可以实现 117 μΩ cm 的低电阻率.均方根粗糙度随沉积温度的变化较小,并保持在 ~ 0.3 nm 的低值,表明 Co 膜平坦。
背景
考虑到高速超大规模集成电路中传统的铜互连工艺,TaN 等势垒层对于防止铜原子扩散到周围的层间电介质 (ILD) 中是必不可少的 [1]。除了阻挡层之外,还需要像Ta这样的衬垫层来增强阻挡层与Cu之间的附着力。此外,由于Cu原子在Ta表面的弱成核,Cu线难以直接通过电镀沉积在衬层上。因此,在电镀铜之前,需要在衬垫层上涂覆铜种子层。也就是说,ILD和Cu线之间必须插入一叠TaN/Ta/Cu籽晶层。此外,该叠层被涂覆在 ILD 上,该 ILD 被图案化为沟槽和通孔。随着器件特征尺寸的缩小,Cu互连线可用的体积稳步下降。为了实现较低的铜互连电阻,已广泛研究无籽阻挡/衬垫层 [2,3,4,5,6]。例如,TaN 仍然用作阻挡层,而 Co 代替 Ta 作为衬垫层。由于Co对Cu的润湿性比Ta好,可以直接在Co表面电镀Cu。传统上,阻挡/衬垫层是通过物理气相沉积工艺生长的。然而,高质量阻挡/衬垫层的沉积具有挑战性,因为 PVD 在高深宽比的沟槽和通孔中具有较差的阶梯覆盖率。相反,由于自限生长特性,原子层沉积(ALD)技术可以获得超薄、连续和良好的阶梯覆盖薄膜[7]。
在 ALD Co 薄膜方面,大量的 Co 前驱体,尤其是基于环戊二烯基配体 (Cp) 的 Co 前驱体,已得到广泛研究,例如双环戊二烯基钴 (CoCp2) [8,9,10,11,12, 13,14]、双(η-甲基环戊二烯基)钴 [Co(MeCp)2] [15] 和环戊二烯基异丙基乙酰氨基钴 [Co(CpAMD)] [16]。使用 CoCp2 可以生长出低电阻率和高纯度的 Co 薄膜;然而,稳定的薄膜生长仅限于超过 250°C 的温度。通过向 Cp 配体添加甲基,可以在 200°C 下实现较低的温度生长,这归因于与 Cp 配体相比,NH3 自由基对 MeCp 配体的反应性更高。在 CoCp2 和 Co(MeCp)2 作为前驱体的 Co 薄膜生长的基础上,工艺窗口可以移动到较低的温度,即如果乙基连接到 Cp 配体,则<200°C。
在这项工作中,使用双(乙基环戊二烯基)钴 [Co(EtCp)2] 和 NH3 等离子体作为前体,通过等离子体增强 ALD(PE-ALD)生长 Co 薄膜。详细研究了不同工艺参数对 Co 薄膜特性的影响。结果,成功实现了 125-225°C 的工艺窗口。此外,Co 薄膜表现出较低的电阻率(~ 130 μΩ cm)。
方法
通过 PE-ALD 在 200 nm SiO2 薄膜上生长各种 Co 薄膜,该薄膜通过热氧化沉积在 p 型硅基板上。 Co(EtCp)2 用作金属前体,将其储存在 70°C 的容器中,并用 N2 载气转移到沉积室中。 NH3 等离子体由远程等离子体发生器在 2800 W 的功率下产生,作为还原剂。在薄膜生长过程中,N2 的流速保持在 50sccm,工作压力为 ~ 1000 Pa。为了研究沉积温度对薄膜生长的影响,基板温度在 100 到 270°C 之间变化,步长为 25°C。此外,为了优化工艺参数,还分别改变了 Co(EtCp)2 和 NH3 等离子体的脉冲时间。此外,为了研究后退火对 Co 薄膜性能的影响,在不同温度下沉积的样品在合成气体 (N2/4%-H2) 中在 400°C 下退火 30 分钟。
通过X射线反射推导出薄膜的厚度和密度,并在Cu Kα辐射的衍射仪(Bruker D8 Discover)上通过掠入射X射线衍射(XRD)确定薄膜的微观结构。用原子力显微镜(AFM)(Bruker Icon)和扫描电子显微镜(SEM)(Zeiss SIGAMA HD)观察薄膜的表面形貌。通过X射线光电子能谱(XPS)(Kratos Axis Ultra DLD)分析薄膜的元素组成和化学键。采用四点探针测量薄膜的薄层电阻,根据薄膜厚度和薄层电阻计算薄膜电阻率。
结果与讨论
ALD 工艺参数的优化
图 1a 显示了 Co 膜的生长速率与衬底温度的函数关系。发现随着衬底温度升高到 125°C,生长速率增加,然后在 125 和 225°C 之间获得相对稳定的生长速率 0.073 ± 0.02 埃/周期。然而,当基板温度上升到 250°C 或更高时,生长速度会增加。因此,125-225°C 的温度范围可被视为合适的工艺窗口。与 Co(Cp)2 和 Co(MeCp)2 相比,将 Et 基团添加到 Cp 配体使工艺窗口移动到较低的沉积温度,表明 EtCp 配体与 NH3 等离子体的反应性更高。这种在 125°C 下的低温生长有利于减少热预算。对于低于 125°C 的基板温度,相对较慢的薄膜生长应归因于缺乏足够的化学反应活化能 [7]。在≥ 250°C 时如此高的生长速率与金属前体的热分解有关 [17]。为了研究 Co(EtCp)2 脉冲时间对沉积膜生长速率的影响,Co(EtCp)2 的脉冲时间从 1 秒逐渐增加到 4 秒,步长为 1 秒,而其他工艺参数不变。如图 1b 所示,随着 Co(EtCp)2 脉冲时间从 1 秒增加到 2 秒,增长率从 ~ 0.06 增加到 ~ 0.073 Å/周期,然后保持相对稳定的值。这表明 Co(EtCp)2 的表面吸附在 2 秒的脉冲时间达到饱和。图 1b 还说明了 NH3 等离子体脉冲时间对薄膜生长速率的影响。生长速率随着NH3-等离子体脉冲时间的延长而增加;然而,当等离子体脉冲时间超过 20 s 时,生长速率达到~ 0.12 Å/cycle 的饱和值。
<图片>
ALD薄膜生长速率对a的依赖性 基材温度,b Co(EtCp)2和NH3脉冲时间
沉积共膜的特征
图 2 显示了在 175°C 下沉积的薄膜的调查 XPS 光谱。沉积的薄膜由 Co、N、O 和 C 元素组成。值得一提的是,为了完全去除表面污染,在收集 XPS 光谱之前,所有样品都用 Ar 离子轰击原位蚀刻 6 分钟。表 1 列出了在 175°C 下随着蚀刻时间沉积的薄膜的元素百分比,并且 C 和 O 含量在蚀刻 6 分钟后保持不变,表明表面污染被完全去除。表 2 列出了分别在 100 和 175°C 下生长的薄膜的元素原子比,这些是从高分辨率 XPS 光谱中提取的。随着基板温度从 100°C 增加到 175°C,C 的相对含量从 40% 减少到 32%,而 N 的元素百分比从 14% 增加到 18%。此外,O 的相对百分比从 5% 到 7% 略有增加。较高的 C 含量应归因于部分去除 EtCp 配体 [15, 16]。由于前驱体中没有O元素,沉积薄膜中的O原子很可能来源于反应室中的氧气。
<图片>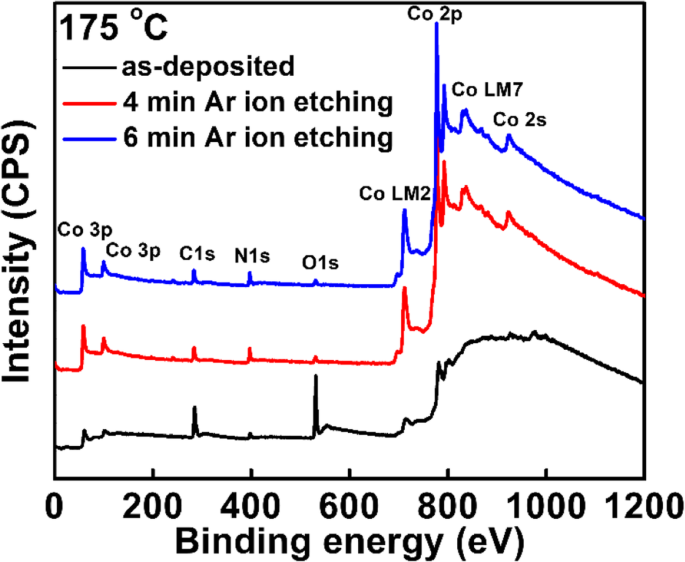
100℃下不同刻蚀时间沉积的Co薄膜的测量光谱
图 3a 显示了在不同温度下沉积的薄膜的高分辨率 C 1s 光谱。 C 1s 光谱可以很好地分为四个分量,分别为 283.2、284.7、286.1 ± 0.1 eV 和 288.9 eV,分别来自 C-Co [12]、CC [12, 18]、CN [15, 19] 和CO [12] 键,分别。随着温度从 100°C 升高到 175°C,C-C 键的相对含量从 61% 降低到 56%,而 C-Co、C-N 和 C-O 的相对含量分别增加了 1%、2% 和 2%。这表明更多的 EtCp 配体在更高的温度下分解,从而导致薄膜中 C 的相对百分比降低。图 3b 显示了在不同温度下沉积的薄膜的高分辨率 N 1s 光谱。使用 Gaussian-Lorentzian 函数可以将每个 N 1s 谱很好地分成两个分量。位于 397.8 eV 的峰应与 N-Co 键相关 [13],位于 399.2 eV 的峰应对应于 N-C [20, 21] 键。随着基板温度从 100°C 增加到 175°C,N-Co 的相对含量从 72% 减少到 69%。这是因为在较高温度下,氮从薄膜中的解吸增强,导致形成较少的 N-Co 键。图 3c 显示了在不同温度下沉积的 Co 薄膜的高分辨率 Co 2p3/2 XPS 光谱。关于 C-Co 和 N-Co 键的存在,如图 3a、b 所示,Co 2p3/2 光谱可以分成三个分量是合理的,它们位于 778、778.9 和 780.86分别为 ± 0.34 eV。最小结合能的峰值应归因于 Co-Co 键 [12, 22]。此外,由于 C (2.55) 的鲍林电负性小于 N (3.04),因此与 N 键合的 Co 上的正电荷密度大于与 C 键合的 Co 上的正电荷密度。因此,峰值在 778.9 和 780.86 ± 0.34 eV 应分别来自 Co-C 和 Co-N 键。当沉积温度从 100°C 增加到 175°C 时,Co-N 键的相对含量从 48% 减少到 32%,这与图 3b 中 N-Co 键的演变一致。
<图片>
高分辨率a Co 2p3/2, b C 1s 和 c 分别在 100°C 和 175°C 沉积的薄膜的 N 1s XPS 光谱
Co 膜的晶体特性由 TEM 表征,如图 4 所示。分别在 100 和 250°C 下沉积的 Co 膜均结晶。图 5 显示了在不同温度下生长的 Co 薄膜的 AFM 图片。随着沉积温度从 100°C 增加到 250°C,均方根 (RMS) 粗糙度显示出较小的变化并保持 ~ 0.3 nm 的低值,表明 Co 膜平坦。
<图片>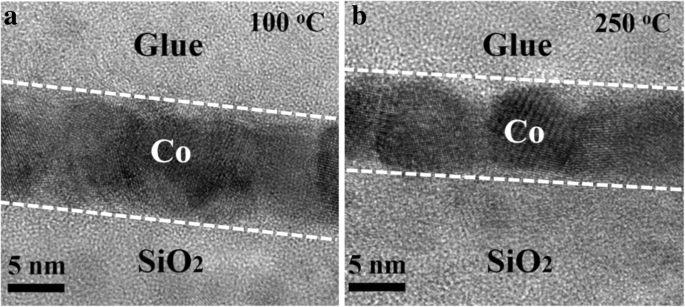
在 a 沉积的 Co 薄膜(1200 次循环)的横截面 TEM 图像 100 °C 和 b 分别为 250°C
<图片>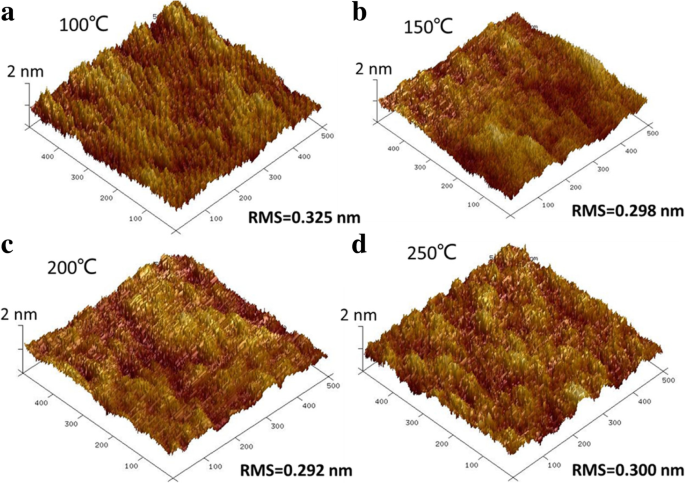
在不同温度下以 2 秒的 Co(EtCp)2 脉冲时间和 10 秒的 NH3 等离子体脉冲时间沉积的 Co 薄膜(1200 次循环)的 AFM 图像:a 100°C; b 150°C; c 200°C; d 250°C
图 6a、b 显示了 Co 膜的电阻率对基板温度和 NH3 脉冲时间的依赖性。薄膜电阻率从 652 Ω cm 显着降低到 130 Ω cm,然后随着沉积温度从 100 ℃ 增加到 275 °C 保持恒定。结果应归因于膜中金属Co的相对含量的增加。随着 NH3 脉冲时间从 10 秒增加到 40 秒,Co 膜的电阻率从 158 到 117 μΩcm(见图 6b)。图 7 显示了使用不同 NH3 等离子体时间沉积的 Co 薄膜的 Co 2p3/2 XPS 光谱。随着 NH3 等离子体时间从 10 秒延长到 40 秒,Co-Co 键的相对百分比从 31% 增加到 34%,Co-C 键的相对含量从 40% 减少到 31%。此外,随着 NH3 等离子体脉冲时间从 10 秒增加到 40 秒,碳含量降低了 22%。这表明EtCp配体的去除逐渐增加,从而有助于Co膜电阻率的降低。
<图片>
Co 膜的电阻率与生长温度的函数关系 (a ) 和 NH3 脉冲时间 (b ),分别
<图片>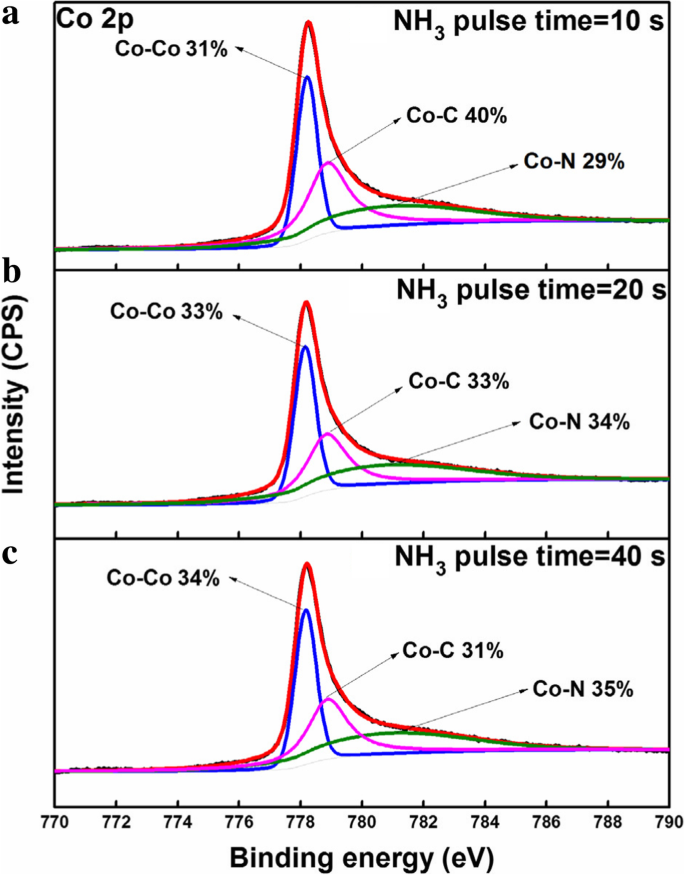
不同NH3等离子体时间Co薄膜的XPS光谱:a 10 秒; b 20 秒; c 40 秒
表 3 显示了由不同前体生长的 Co 膜的性能比较。与 CoCp2 和 Co(MeCp)2 相比,Co(EtCp)2 能够在较低温度下实现 Co 薄膜的原子层沉积。此外,使用 Co(EtCp)2 的金属前体导致更小的生长速率。理论上,ALD工艺是单层一层一层的生长。事实上,前体的空间位阻效应和表面吸附都会影响薄膜的生长。就空间位阻效应而言,它是指化学吸附的金属前体物种的配体可以屏蔽部分表面,并阻止其他金属前体物种完全吸附在基材表面上。由于与 CoCp2 和 Co(MeCp)2 相比,Co(EtCp)2 具有更大的配体,因此假设在 ALD 过程中会发生显着的空间位阻效应。这会导致亚单层的生长,从而导致较小的生长速率。另一方面,由于 Co 衬垫层应该沉积在 TaN 阻挡层上以备将来的实际应用,因此在 125°C 下在 ALD TaN 膜上生长了 1200 个周期的 Co 膜。图 8 显示了沉积在 TaN 表面上的 Co 膜的横截面 TEM 图像。观察到 Co 膜是连续且均匀的,显示出优异的生长行为。此外,发现沉积在ALD TaN薄膜上的Co薄膜的厚度(约10nm)与生长在SiO2表面的Co薄膜相似。
<图片>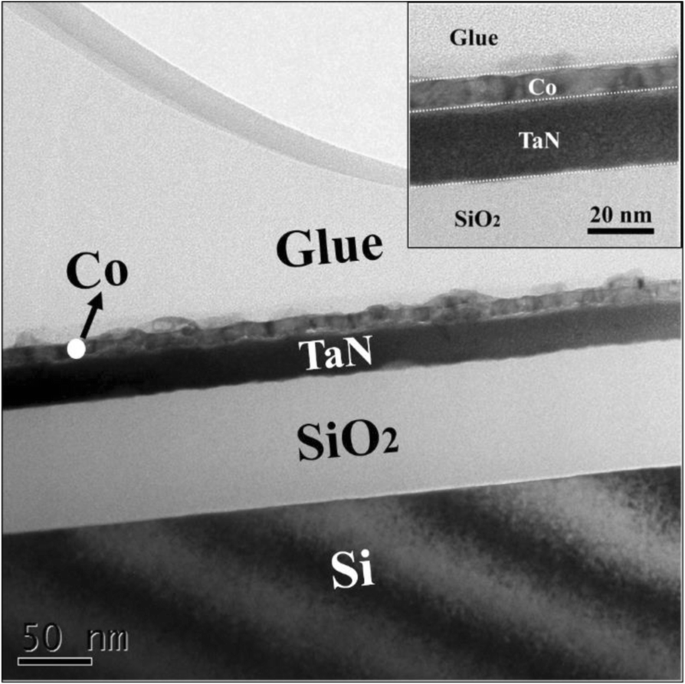
在 125°C 下沉积在 ALD TaN 表面上的 Co 膜(1200 次循环)的横截面 TEM 图像,插图为放大图
结论
使用 Co(EtCp)2 前驱体通过 PE-ALD 促进 Co 薄膜的生长,并研究了工艺参数对 Co 薄膜特性的影响。将 Et 基团添加到 Cp 配体使工艺窗口移动到 125°C 的较低沉积温度。此外,Co 薄膜由 Co 和 C 元素以及一些 N 和 O 元素组成。随着沉积温度的升高,EtCp 配体被更充分地去除,C 的相对元素百分比降低。结果,沉积的 Co 膜的电阻率从 652 降低到 130 μΩ cm,然后在衬底温度从 100 ℃ 增加到 275 °C 时保持稳定值。对于 125°C 的沉积温度,随着 NH3 脉冲时间的延长,电阻率逐渐降低,当使用 40 s 的 NH3 脉冲时间时,可以获得 117 μΩcm 的低电阻率。均方根粗糙度随沉积温度的变化较小,并保持在 ~ 0.3 nm 的低值,表明 Co 膜平坦。
缩写
- 原子力显微镜:
-
原子力显微镜
- ALD:
-
原子层沉积
- Co(CpAMD):
-
环戊二烯基异丙基乙酰氨基钴
- Co(EtCp)2 :
-
双(乙基环戊二烯基)钴
- Co(MeCp)2 :
-
双(η-甲基环戊二烯基)钴
- CoCp2:
-
双环戊二烯钴
- Cp:
-
环戊二烯基
- ILD:
-
层间电介质
- PE:
-
等离子增强
- RMS:
-
均方根
- SEM:
-
扫描电子显微镜
- XPS:
-
X射线光电子能谱
- XRD:
-
X射线衍射
纳米材料
- 用于 Micro-LED 和 VCSEL 的高级原子层沉积技术
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 使用铁改性生物炭纳米复合材料研究重金属离子吸附
- 通过原子层沉积和水热生长制备的抗菌聚酰胺 6-ZnO 分层纳米纤维
- 通过等离子体增强原子层沉积制备的 Co3O4 涂层 TiO2 粉末的光催化性能
- 在 p-GaN 上两步沉积 Al 掺杂的 ZnO 以形成欧姆接触
- 通过超循环原子层沉积调节 ZnO 薄膜的费米能级
- 使用纳米尺寸的苯二胺薄膜提高电流传感器的选择性
- 使用二氧化碳的低温等离子体增强原子层沉积 SiO2
- 使用显微镜测量层厚
- 使用合金的优点


