嵌入多量子阱的自上而下制造的 AlGaN 纳米棒阵列的光学性能
摘要
深紫外 AlGaN 基纳米棒 (NR) 阵列是通过纳米压印光刻和自上而下的干蚀刻技术从全结构 LED 晶片制造的。通过扫描电子显微镜和透射电子显微镜证实了高度有序的周期性结构特性和形态。与平面样品相比,阴极发光测量显示 NR 样品显示出 1.92 倍的光提取效率 (LEE) 增强和 12.2 倍的内量子效率 (IQE) 增强,用于从多量子阱发射约 277 nm。 LEE 增强可归因于空气和外延层之间制作精良的纳米结构界面。此外,减少的量子限制斯塔克效应是IQE大幅提高的原因。
介绍
近十年来,AlGaN基UV LED因其在水净化、杀菌、生化检测等方面的应用前景而受到广泛关注。 [1,2,3]。与传统的汞紫外线灯相比,基于 AlGaN 的紫外线 LED 坚固、紧凑且环保,无需预热步骤即可开启。然而,AlGaN 多量子阱 (MQW) 中存在强压电场,导致电子和空穴的空间分离,称为量子限制斯塔克效应 (QCSE),显着降低内量子效率 (IQE) [4] .另一个问题是光提取效率 (LEE) [5] 低,这不仅是由外延层界面处的内部全反射引起的,而且是由主要的横向磁 (TM) 偏振光引起的 [6]。先前的研究表明,能带工程是降低 QCSE 从而提高 IQE 的有效方法 [7]。另一方面,界面工程,例如结合光子晶体 [8, 9]、图案化衬底 [10, 11]、分布式布拉格反射器 [12] 和表面等离子体 [13,14,15,16] 等结构,可以提高深紫外 LED 的 LEE。然而,这些方法的结合相对困难。
制造基于 AlGaN 的深紫外纳米结构 LED 可以成为同时克服 QCSE 和低 LEE 问题的替代方法。通常,纳米结构的 LED 是通过纳米级掩模和自上而下的干蚀刻技术制造的。掩模是通过退火的金属纳米粒子,如镍 (Ni) 或金 [17, 18]、纳米球光刻 [19,20,21]、电子束光刻 (EBL) [22] 和聚焦离子束铣削 [23] 制备的.同时,已经开发了几种选择性区域外延方法来获得基于 InGaN 的纳米线 LED [24, 25]。然而,每种方法都有其自身的缺点,例如价格昂贵、形态不可控、不均匀、与微电子工艺不兼容以及耗时。为了克服这些缺点,我们开发了一种软紫外光固化纳米压印光刻(NIL)技术,以制备大面积可控掩模,具有高均匀性和低缺陷密度[26, 27]。
在这项工作中,我们成功地制备了从平面 AlGaN LED 晶片嵌入 MQW 的 AlGaN 纳米棒 (NR) 阵列。与平面 (PLA) 样品相比,已证明 1.92 倍 LEE 增强和 12.2 倍相对 IQE 增强。阴极发光 (CL)、扫描电子显微镜 (SEM) 和透射电子显微镜 (TEM) 测量表明,增强的 LEE 可归因于空气和外延层之间界面质量的改善。拉曼测量表明,MQWs的应变从0.42%降低到0.13%,有利于提高IQE。
方法
AlGaN LED 晶片通过金属有机化学气相沉积 (MOCVD) 在 2 in. c 平面蓝宝石衬底,定义为 PLA 样品。外延包括 900 nm 未掺杂 AlN 缓冲层、400 nm 渐变 Al 成分 AlGaN 层、1.4 μm 厚 Si 掺杂 n-Al0.5Ga0.5N 和 5 个周期的 Al0.35Ga0.65N/Al0。 45Ga0.55N MQWs,阱和势垒厚度分别为3和10 nm,然后是100-nm Mg掺杂的p-GaN接触层。
已采用软 UV 固化 NIL 和生长后蚀刻方法来获得 AlGaN NR 阵列 [26,27,28]。如图 1a-h 所示,NIL 工艺从使用等离子体增强化学气相沉积 (PECVD) 方法沉积 200 纳米厚的二氧化硅 (SiO2) 开始(图 1b)。然后,在外延层上直接旋涂一层 300 nm 厚的 SU8 光刻胶和一层 80 nm 厚的紫外光固化抗蚀剂(图 1c),在紫外光固化抗蚀剂上进行软紫外光固化 NIL (图 1d)。为了去除 UV 抗蚀剂残留物并将纳米图案复制到 SU8 光刻胶层,利用氧 (O2) 等离子体通过反应离子蚀刻 (RIE) 程序蚀刻 SU8 光刻胶(图 1e)。之后,通过物理气相沉积(PVD)沉积 30 nm 厚的 Ni 层,然后进行剥离工艺,在 SiO2 层的表面形成周期性的 Ni 岛,作为硬掩模(图 1f) .制备的 Ni 硬掩模用于通过另一个 RIE 工艺将图案转移到 SiO2 层(图 1g)。随后,这些 SiO2 纳米棒阵列被用作第二掩模,通过电感耦合等离子体 (ICP) 蚀刻工艺蚀刻 AlGaN LED 晶片。最后,通过 HF 溶液去除这些 SiO2 纳米棒阵列掩模,并获得如图 1h 所示的 AlGaN NR 阵列。使用这种 NIL 技术的纳米结构在 2 in. 晶片上的产量超过 98%,这与 EBL 方法相当,但 NIL 技术要便宜得多。详细信息可以在我们之前的报告中找到[27]。在干蚀刻过程中不可避免地在纳米棒的侧壁上产生表面态,其可能作为非辐射复合中心并抑制 AlGaN MQW 的发光。因此,所有NR样品都在90 °C的水浴中通过使用KOH和稀酸溶液进行化学处理以去除表面状态。
<图片>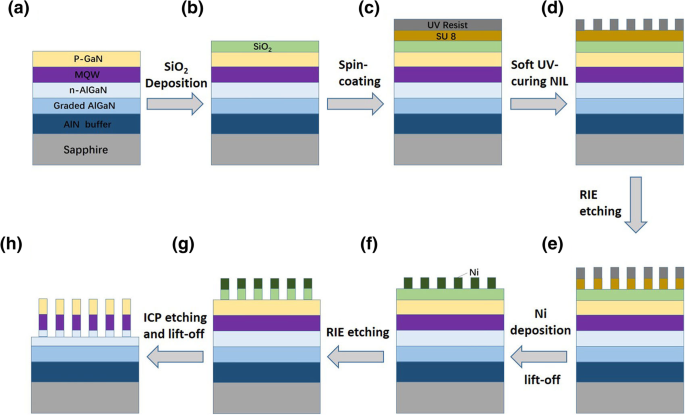
嵌入 MQW 的 AlGaN NR 阵列的制造示意图。 一 原始的基于 AlGaN 的深紫外 LED 晶圆。 b SiO2 沉积。 c SU8光刻胶和UV固化光刻胶的旋涂工艺。 d 软 UV 固化 NIL 工艺。 e SU8光刻胶的RIE工艺。 f Ni在丙酮中的沉积和剥离过程。 g 通过 RIE 将 Ni 图案转移到 SiO2 层。 h ICP技术从SiO2转移图案到AlGaN基LED晶圆
制造的 AlGaN NR 阵列的形态在蔡司 SIGMA 高分辨率场发射 SEM 系统中表征。 TEM 图像由 FEI Titan 80-300 TEM 系统收集,电子束在 200 kV 下运行。 CL 光谱由电子束-光纤探针系统收集,电子束在 10 kV 和 922 pA 下工作。通过使用 514 nm 激光作为激发源,在具有背向散射配置的共焦拉曼光谱成像系统 (WITec alpha 300RA) 中获得拉曼散射光谱。拉曼测量由标准单晶硅样品校准,光学声子模式为 520.7 cm -1 .
结果与讨论
图 2a、a 和 b 中的插图显示了制造的具有良好均匀性和光滑侧壁的 AlGaN NR 阵列的典型顶视图、标题和横截面 SEM 图像。可以看到 NR 处于高度有序的六边形阵列中。 NRs的直径、周期和长度分别约为350 nm、730 nm和1300 nm。如图 2c 和 d 所示,在 NR 制造后可以清楚地观察到嵌入 NR 中的 MQW。井区和障碍区分别以暗区和亮区呈现,界面依然清晰、平坦、陡峭。
<图片>
顶视图 (a )、标题(a 中的插图)和横截面 (b ) AlGaN NR 阵列的 SEM 图像。 c , d 分别为单个NR和AlGaN MQWs的TEM图像
图 3a 和 b 分别显示了 NR 样品的室温 (RT; 300 K) 和低温 (LT; 10 K) CL 光谱。图 3c 和 d 分别显示了 PLA 样品的 RT 和 LT CL 光谱。实线和虚线是实验拟合曲线(高斯)。高斯拟合表明所有光谱都由两个发射峰组成。无论是 PLA 还是 NR 样品,在 LT 下测量的 CL 发光强度与 RT 下的相比都有很大的增强。这可归因于 LT 处的微弱热活化能。因此,载流子不能迁移到载流子可以非辐射复合的缺陷,这意味着载流子只进行辐射复合,IQE可以认为是大约100%。考虑到外延层的结构,短(峰值 1)和长(峰值 2)波长的峰值分别归因于 n 型层和 MQW 的发射。从高斯分峰获得的详细参数如表 1 所示。对于 NR 样品,n 型层的积分发射强度约为 2.89 [I 1(NR300K)/I 1(PLA300K)] 和 2.78 [I 1(NR10K)/I 1(PLA10K)] 分别比 PLA 样品在 RT 和 LT 下的高。然而,在室温下,NR 样品的 MQW 发射的积分强度约为 5.81 [I 2(NR300K)/I 2(PLA300K)] 倍于 PLA 样品,而比率仅为 0.48 [I 2(NR10K)/I 2(PLA10K)] 在 LT。
<图片>
一 , b NR 样品在 300 K 和 10 K 下的 CL 光谱,分别由电子束(10 kV,992 pA)激发。 c , d PLA 样品分别在 300 和 10 K 时的 CL 光谱,由电子束(10 kV,992 pA)激发。实线和虚线分别对应实验曲线和高斯拟合曲线
与 PLA 样品相比,NR 样品的侧壁暴露在空气中,如图 4a 所示,导致空气和外延层之间的总界面面积显着增加。因此,可以增强 n 型层和 MQW 发射的 LEE。 n 型层发射的 LEE 增强估计约为 2.8 [I 1(NR)/I 1(PLA)]。此外,根据从图 2a 获得的几何结构,PLA 样品的 MQW 面积大约是 NR 样品的 4 倍。通过假设 PLA 和 NR 样品在 10 K 时的 IQE 为 1,相对光提取增强可以获得大约 1.9 [4 × I 2(NR10K)/I 2(PLA10K)]。显然,n型层发射的LEE增强高于MQW发射。
<图片>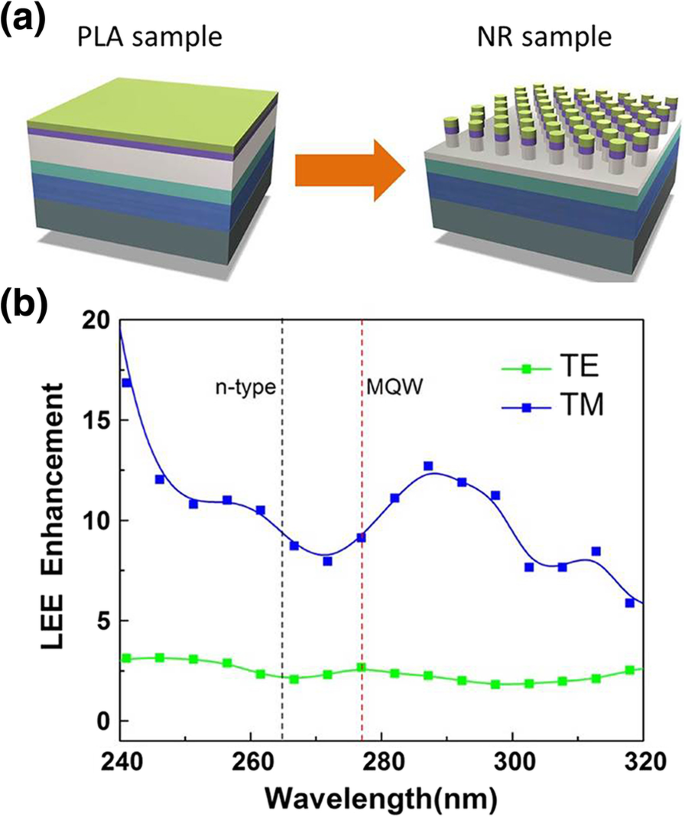
一 PLA和NR样品的结构图。 b 通过FDTD模拟计算的TE和TM偏振态下NR样品与PLA样品相比的LEE增强。黑色和红色虚线分别对应n型AlGaN层和AlGaN MQWs的发射波长
执行有限差分时域 (FDTD) 模拟以阐明 AlGaN NR 阵列的 LEE 增强。 NR 阵列的直径、周期和长度分别设置为 350 nm、730 nm 和 1300 nm,以与制造的 NR 阵列一致,如图 4a 所示。其他模拟参数类似于我们之前的报告[29]。监测器采集的场用于积分从顶面逸出的功率P0,偶极子源功率定义为PS,因此LEE为η =P 0/P S .并且提取增强可以通过E计算 n =η r/η p,其中 η p, η r 分别是 PLA 和 NR 样品的 LEE。图 4b 显示了 NR 阵列在横向电 (TE) 和 TM 偏振态下与 PLA 样品相比的光提取增强。可以看到,对于大约 265 nm 处的 n 型层发射,TE 和 TM 偏振态的 LEE 增强比分别约为 2.4 和 9.2。先前的研究表明,即使对于压缩生长的 AlGaN MQW,也可以在短至 240 nm 的波长下观察到强 TE 偏振发射 [30]。因此,TE 和 TM 状态混合的 LEE 增强约为 2.8 是合理的。然而,在大约 277 nm 处,TE 和 TM 偏振态的 LEE 增强比分别约为 2.6 和 9.1。从实验数据计算出的 MQW 发射的 LEE 增强比约为 1.9,这小于 TE 和 TM 偏振态的模拟 LEE 增强比。这可能是由于图 2a 所示实验制造的 NR 阵列的部分不规则形状或 NIL 工艺引起的损坏层的重新吸收。
另一方面,降低的 QCSE 可以提高 NR 样品的 MQW 发射的 IQE。在 300 K 时 n 型层发射的 IQE 可以估计为大约 1.96% [I 1(PLA300K)/I 1(PLA10K)] 和 2.03% [I 1(NR300K)/I 1(NR10K)] 分别用于 PLA 和 NR 样品。它们彼此非常接近,因为 n 型层中不存在 QCSE。然而,MQW 发射在 300 K 时的 IQE 约为 1.32% [I 2(PLA300K)/I 2(PLA10K)] 和 16.1% [I 2(NR300K)/I 2(NR10K)] 分别用于 PLA 和 NR 样品。因此,与 PLA 样品相比,NR 样品的 MQW 发射的 IQE 增强率为 12.2。相对 IQE 的这种大幅提高应归因于 NR 样品的 QCSE 降低。根据蓝/绿 LED 中的一些类似工作 [27, 31],由于 NR 制造引起的大应变松弛将降低 QCSE 效应。 QCSE降低会增加电子和空穴的波函数重叠,导致IQE增加。
进行拉曼测量以确认 NR 样品中的应变松弛。图 5 显示了 PLA 和 NR 样品的拉曼光谱。 E 2(高)声子模式通常用于表征外延层中的应力状态。值得注意的是,三个 E 2(高)声子模式显示在 PLA 和 NR 样品的拉曼光谱中,对应于 GaN 接触层、n 型层和 AlN 缓冲层。显然,与无应力 E 相比,PLA 和 NR 样品的峰位移是不同的 2(高)声子模式,表明在将 PLA 样品制成 NR 样品后应力状态发生了变化。通常,外延层的面内应力由下式[29]表示:
$$ {\omega}_{{\mathrm{E}}_2\left(\mathrm{high}\right)}-{\omega}_0=C\sigma, $$ (1)其中 C 是应力转移率 (− 3.4 cm −1 /GPa, − 3.1 cm −1 /GPa,和 − 3.25 cm −1 /GPa 分别为 GaN、AlN 和 Al0.5Ga0.5N)[29]。 \( {\omega}_{{\mathrm{E}}_2\left(\mathrm{high}\right)} \) 和 ω 0 是 E 的拉曼位移 分别为我们研究中相应外延层和无应力材料的 2(高)模式。 ω 据报道,GaN 和 Al0.5Ga0.5N 的 0 值分别为 567.0 和 586.0 cm -1 分别在 RT [32]。外延层的应变可以表示为[33]:
$$ {\sigma}_{\mathrm{xx}}=\left[{C}_{11}+{C}_{12}-2\frac{C_{13}^2}{C_{33} }\right]{\varepsilon}_{\mathrm{xx}}, $$ (2)其中 σ xx 是面内应力; ε xx 是面内应变,C ij 是先前报告中给出的 GaN 和 AlN 的弹性常数 [34],即 GaN 的比例因子为 478.5 GPa,Al0.5Ga0.5N 的比例因子为 474.5 GPa。
<图片>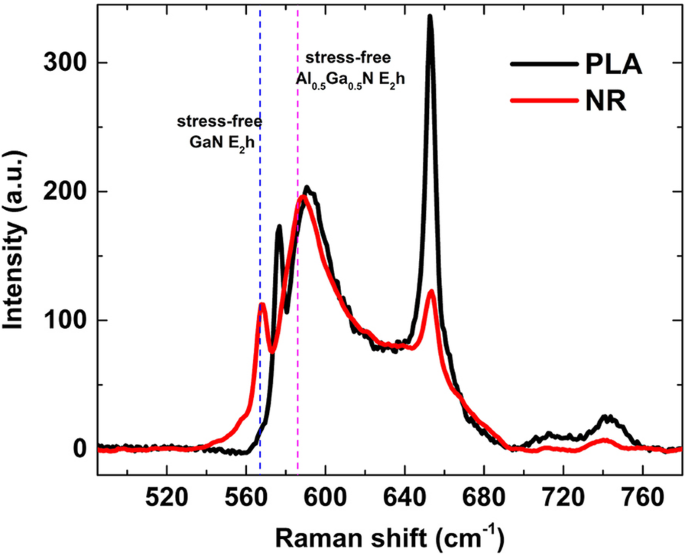
PLA 和 NR 样品在室温下由 514 激光激发的拉曼光谱。黑色和红色曲线分别代表 PLA 和 NR 样品。蓝色和粉色虚线对应于 E 无应力GaN和Al0.5Ga0.5N分别为2h峰
使用方程(1, 2),拉曼位移、应力和应变列在表 2 中。值得注意的是,GaN 接触层中的应变大大降低。通过简单地考虑不同 Al 含量外延层中应变和应力的线性插值,对于 PLA 和 NR,具有 35% Al 含量的 MQW 中的应力/应变可以为 1.99 GPa/0.42% 和 0.59 GPa/0.13%样,分别。因此,NR样品的MQWs层松弛了69%的应变。
根据之前的调查[35],极化场E 量子阱中的 w 可以表示为
$$ {E}_{\mathrm{w}}=\frac{l_{\mathrm{b}}\left({P}_{\mathrm{b}}-{P}_{\mathrm{w} }\right)}{l_{\mathrm{w}}{\upvarepsilon}_{\mathrm{b}}+{l}_{\mathrm{b}}{\upvarepsilon}_{\mathrm{w}} }, $$ (3)其中 l w, l b、P w, P b, 和 ε b、ε w 分别是阱和势垒的宽度、总极化和介电常数。因此,不仅应考虑压电极化,还应考虑自发极化。压电极化的计算公式为 \( {P}_{\mathrm{pz}}=2\left({e}_{31}-{e}_{33}\frac{C_{13}}{C_{ 33}}\right){\varepsilon}_{\mathrm{xx}} \) [36],其中 e 31、e 33、C 31、C 33是由GaN和AlN的相关参数线性插值得到的[37, 38],应变ε xx 是使用线性插值法通过拉曼光谱计算的。自发极化是通过线性插值从 GaN 和 AlN 的自发极化获得的 [37, 39]。因此,通过使用阱的介电常数和从 GaN ε 的介电常数线性插值获得的势垒 GaN =8.9和AlNε AlN =8.5 [40],极化场可以由方程计算。 (3).表 3 列出了 PLA 和 NR 样品在量子阱中的自发极化、压电极化、总极化和极化场;可以清楚地看到NR制备后极化场降低。
结论
总之,通过 NIL 和自上而下的蚀刻技术已经成功地制造了高度均匀的、嵌入了 MQW 的 AlGaN NR 阵列。通过 NR 和 PLA 样品在 300 K 和 10 K 的 CL 测量观察到与 n 型层(较高能量)和 MQW(较低能量)发射相对应的两个峰。对于 n 型层发射,已经观察到超过 2 倍的 LEE 增强,而 IQE 几乎没有通过 NR 制造增强。对于 MQW 发射,LEE 增强率可以估计为 1.9 左右,并且实现了 12.2 倍的 IQE 增强。拉曼光谱表明,NR 制造使应变从 0.42% 降低到 0.13%,这表明 QCSE 降低的有力证据。结果表明,对于晶体质量不高的样品,QCSE引起的电子和空穴的空间分离是IQE降低的重要因素。
缩写
- CL:
-
阴极发光
- EBL:
-
电子束光刻
- FDTD:
-
有限差分时域
- ICP:
-
电感耦合等离子体
- LEE:
-
光提取效率
- LT:
-
低温
- MOCVD:
-
金属有机化学气相沉积
- MQW:
-
多量子阱
- Ni:
-
镍
- 无:
-
纳米压印光刻
- NR:
-
纳米棒
- PECVD:
-
等离子体增强化学气相沉积
- PLA:
-
平面
- PVD:
-
物理气相沉积
- QCSE:
-
量子限制的斯塔克效应
- RIE:
-
反应离子刻蚀
- RT:
-
室温
- SEM:
-
扫描电镜
- TE:
-
横向电动
- TEM:
-
透射电子显微镜
- TM:
-
横磁
- 紫外线:
-
紫外线
纳米材料
- 嵌入式固件提示:如何使用信号波形和其他文件数据在 C 中初始化数组
- NiCo2S4@NiMoO4 核壳异质结构纳米管阵列在镍泡沫上生长作为无粘合剂电极,显示出高容量和高电化学性能
- 三态电致变色器件的浸涂工艺工程和性能优化
- 通过金属辅助化学蚀刻制造的金封盖 GaAs 纳米柱阵列
- 具有增强光催化性能的新型 Bi4Ti3O12/Ag3PO4 异质结光催化剂
- TiO2 纳米管阵列:由软硬模板制造和场发射性能的晶粒尺寸依赖性
- 与 Talbot 腔集成的锥形量子级联激光阵列
- 具有结构彩色微纤维的光开关图案的制造
- 具有可微调光学特性的二维 Ruddlesden–Popper 钙钛矿量子点的简便合成
- 具有增强有效光吸收的针结纳米锥阵列太阳能电池的光伏性能
- 具有改良表面结构的高性能有机-纳米结构硅混合太阳能电池
- Au/SiO2 三角形阵列在反射 Au 层上的光学特性和传感性能


