原子层沉积 AZO/β-Ga2O3 (\( \overline{2}01 \)) 异质结的能带研究
摘要
Al 掺杂对 ZnO/β-Ga2O3 界面带偏移的影响通过 X 射线光电子能谱表征并通过第一性原理模拟计算。导带偏移从 1.39 到 1.67 eV,价带偏移从 0.06 减少到 - 0.42 eV,表现出与从 0 到 10% 变化的 Al 掺杂率几乎线性相关。因此,在 ZnO/β-Ga2O3 异质结的界面形成 I 型能带排列,而 AZO/β-Ga2O3 界面具有 II 型能带排列。这是因为将Al掺入ZnO中会由于Al和O电子的强混合而打开带隙,从而导致导带和价带边缘向较低能级移动。
背景
近年来,氧化物半导体Ga2O3以其带隙大、饱和电子速度高、耐高温等独特的特性引起了广泛的兴趣[1]。 Ga2O3 有 5 种异构体:α、β、γ、δ 和 ε,其中 β-Ga2O3 可以更容易地生长并且已被广泛研究 [2]。特别是β-Ga2O3比传统的第三代半导体材料如SiC和GaN具有更大的击穿电场[3]。 n 型导电性能可以通过掺杂 Sn [4] 或 Si [5] 来调节。因此β-Ga2O3基器件[6, 7]在信息技术、节能减排等领域具有广阔的应用前景。然而,基于 β-Ga2O3 的器件有一个共同的限制:β-Ga2O3 与大多数金属之间的接触往往是肖特基的,因为宽带隙和有限的载流子浓度引起的大势垒。近年来,在Ga2O3与金属之间插入中间层,如ITO[8]和AZO[9],被证明是降低β-Ga2O3与金属之间能垒的有效方法。
掺铝氧化锌 (ZnO) 由于电阻率低且制造成本低于 ITO [10],因此备受关注。特别是,高热稳定性、高迁移率和载流子浓度使其成为中间半导体层 (ISL) 的有希望的候选者 [11]。到目前为止,Al掺杂的ZnO薄膜可以通过以下技术生长:分子束外延(MBE)[12]、磁控溅射[13]、化学气相沉积(CVD)[14]和原子层沉积(ALD)[ 15]。特别是,ALD 是一种著名的制备纳米厚度薄膜的方法,由于自限性表面反应包括自限化学吸附和自限序反应 [16],它表现出大面积优异的均匀性和每个循环的统一生长速率。此外,ALD可以通过改变生长周期比来减少界面无序,更精确地调节Al掺杂浓度。
请注意,导带偏移 (CBO) 决定了电子传输的能垒,因此较小的 CBO 有利于形成欧姆接触。基于我们之前的工作 [17],通过增加 Al 掺杂浓度,Al 掺杂的 ZnO 薄膜从多晶性质变为非晶性质,其带隙也变宽。然而,不同Al掺杂ZnO/β-Ga2O3异质结的能带偏移尚未得到广泛研究。在这项工作中,具有不同 Al 掺杂比例的 ZnO 薄膜分别通过 ALD 沉积在 β-Ga2O3 衬底上。结果表明,VBO和CBO几乎与Al掺杂比呈线性相关。
方法
衬底为体 β-Ga2O3 (\( \overline{2}01 \)),掺杂浓度约为 3 × 10 18 /cm 3 . Ga2O3 衬底的清洗过程在丙酮和异丙醇中进行超声波清洗,每 10 分钟重复 3 次。随后,用去离子水冲洗 Ga2O3 衬底。然后,通过ALD(无锡MNT Micro Nanotech Co.,LTD,China)将Al掺杂的ZnO薄膜生长到Ga2O3衬底上。制备了三种样品。首先,使用 Zn (C2H5)2 (DEZ) 和 H2O 的前体在 200 o 下通过 ALD 生长未掺杂的 ZnO 薄膜 C. 其次,在基板温度为 200 o C 在 ALD 期间。第三,还制备了比例为 9:1(表示为 10% Al 掺杂)的 Al 掺杂 ZnO 薄膜。 ZnO 和 Al2O3 的生长速率分别为 0.16 和 0.1 纳米/周期。每种薄膜包括两种不同的厚度,即厚膜和薄膜分别为 40 nm 和 10 nm。此外,β-Ga2O3 衬底用于研究大块材料。 Ga 2p , Zn 2p CLs 和价带最大值 (VBM) 是通过 X 射线光谱 (XPS)(AXIS Ultra DLD,Shimadzu)测量的,分辨率 XPS 光谱的步长为 0.05 eV。为了避免在从 ALD 到 XPS 室的转移过程中样品的表面污染,在 XPS 测量之前进行了 Ar 离子蚀刻。请注意,充电效应可以使 XPS 光谱发生偏移,C 1s 的 BE 峰值校准为 284.8 eV 以解决问题。
结果和讨论
Al掺杂ZnO/β-Ga2O3异质结的价带偏移量(VBO)可由下式得到[18]:
$$ \Delta {E}_V=\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_{ \mathrm{VBM}}^{{\mathrm{Ga}}_2{\mathrm{O}}_3}\right)-\left({E}_{\mathrm{Zn}\ 2p}^{\mathrm{ AZO}}-{E}_{\mathrm{VBM}}^{\mathrm{AZO}}\right)-\left({E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga }}_2{\mathrm{O}}_3}-{E}_{\mathrm{Zn}\ 2p}^{\mathrm{AZO}}\right) $$ (1)
其中\( {E}_{\mathrm{Ga}\ 2p}^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) 是指Ga 2
随后,基于E g 和 ∆E V ,Al掺杂ZnO/β-Ga2O3界面处的CBO可由下式计算:
$$ \Delta {E}_C={E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3}-{E}_g^{\mathrm{AZO}}-\Delta {E }_V $$ (2)其中\( {E}_g^{{\mathrm{Ga}}_2{\mathrm{O}}_3} \) 是Ga2O3 的带隙和\( {E}_g^{\mathrm{AZO}} \)是 Al 掺杂的 ZnO 的带隙。未掺杂、5% Al 掺杂 ZnO、10% Al 掺杂 ZnO 和 β-Ga2O3 的带隙分别为 3.20 eV、3.25 eV、3.40 eV 和 4.65 eV [17, 19]。带隙随着Al掺杂比的增加而增加,与下一部分的模拟吻合。
图 1 显示了块状 β-Ga2O3、厚未掺杂和 5% 和 10% Al 掺杂的 ZnO 薄膜的 Ga 和 Zn 元素 CLs 和 VBM。从 VBM 谱拟合线性区域和平带区域可以推导出 VBM [20]。图 2 显示了 Ga 2p 和 Zn 2p 来自各种薄铝掺杂 ZnO/β-Ga2O3 异质结的 CL。 Ga 2p的BE差异 和 Zn 2p 获得未掺杂、5% Al 掺杂 ZnO/β-Ga2O3 和 10% Al 掺杂 ZnO/β-Ga2O3 的 CL 分别为 96.12 eV、96.16 eV 和 95.94 eV。然后,对于未掺杂、5% Al 掺杂 ZnO/β-Ga2O3 和 10% Al 掺杂 ZnO/β-Ga2O3 样品,界面处的 VBO 被确定为 1.39 eV、1.52 eV 和 1.67 eV。
<图片>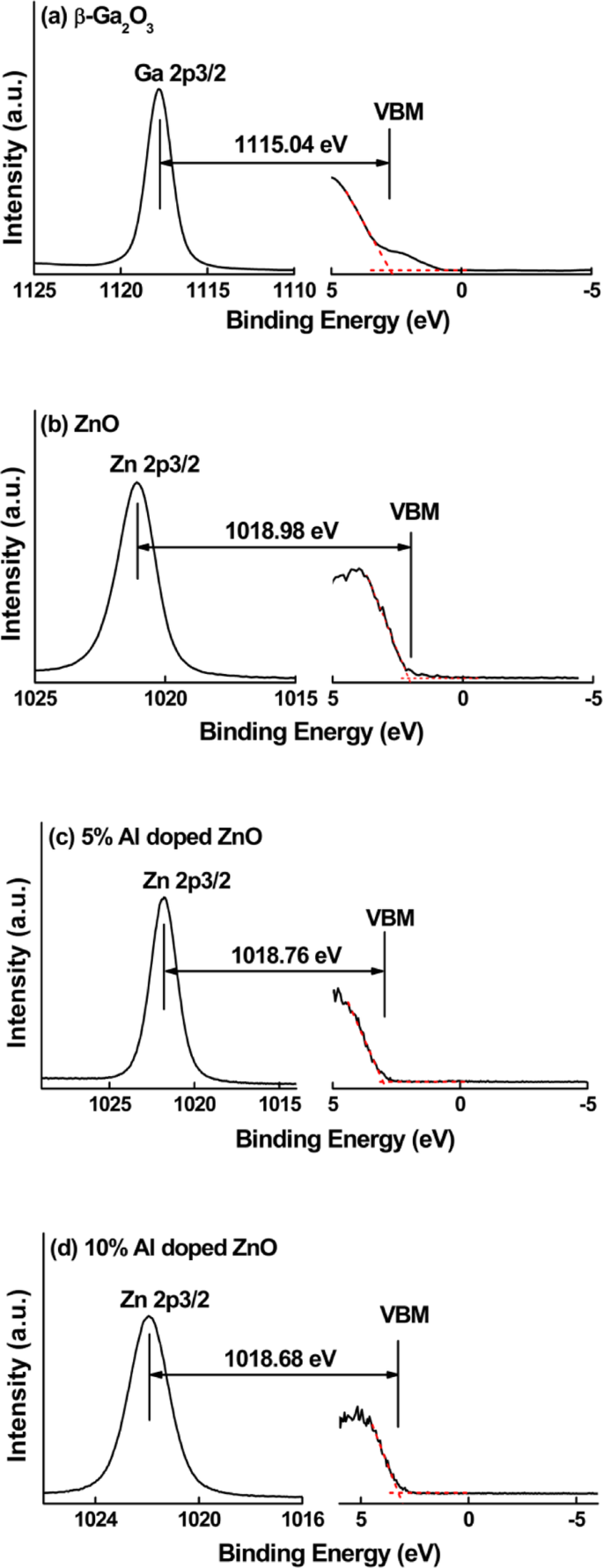
a 的核心能级和价带最大值 (VBM) 的高分辨率 XPS 光谱 Ga 2p 来自裸 β-Ga2O3 的核心能级谱和 VBM,b 锌 2p 来自厚纯 ZnO/β-Ga2O3,c 的核心能级光谱和 VBM 锌 2p 来自厚 5% Al 掺杂的 ZnO/β-Ga2O3 和 d 的核心能级光谱和 VBM 锌 2p 厚 10% Al 掺杂 ZnO/β-Ga2O3 的核心能级谱和 VBM
<图片>
Ga 2p的核心能级谱 和 Zn 2p 从 a 的高分辨率 XPS 光谱中获得 薄的 ZnO/β-Ga2O3,b 薄的 5% Al 掺杂的 ZnO/β-Ga2O3 和 c 薄的10% Al掺杂ZnO/β-Ga2O3
0%、5%和10% Al掺杂ZnO/β-Ga2O3异质结的系统能带排列由上述方程计算,如图3所示。未掺杂ZnO/β-Ga2O3异质结的能带偏移属于到 I 型。而 5% 和 10% Al 掺杂的 ZnO/β-Ga2O3 异质结都具有 II 型带偏移。图 4 描绘了 Al 掺杂的 ZnO/β-Ga2O3 界面的能带排列与 Al 掺杂浓度具有相似的线性关系。随着铝掺杂浓度从 0% 增加到 10%,CBO 从 1.39 eV 变化到 1.67 eV。而随着铝掺杂浓度从 0 增加到 10%,VBO 从 0.06 减少到 - 0.42 eV。值得注意的是,溅射 AZO/β-Ga2O3 的 CBO 和 VBO 分别为 0.79 eV 和 0.61 eV [9]。在这项工作中,导带和价带都向下移动,这可能是由于沉积方法引入了不同的组成比和晶体结构。
<图片>
a的能带对准示意图 纯 ZnO/β-Ga2O3,b 5% Al 掺杂的 ZnO/β-Ga2O3 和 c 10%掺铝ZnO/β-Ga2O3
<图片>
不同Al掺杂比制备的原子层沉积AZO/β-Ga2O3异质结的导带和价带偏移
除此之外,Vienna Ab-initio Simulation Package (VASP) [21,22,23,24] 进行了第一性原理模拟,以研究掺铝 ZnO/Ga2O3 异质结的电子能带结构和能带排列。在计算过程中,电子-离子相互作用采用超软赝势处理,波函数和势势采用平面波基进行扩展[25]。此外,实现了由 Perdew、Burke 和 Ernzerhof (PBE) 提出的广义梯度近似 (GGA) 来描述交换相关能量 [26]。在开始模拟之前,进行了收敛测试。结果表明,平面波基和 3 × 3 × 3 的平面波基和 k 空间网格的截止能量为 450 eV,使用 Monkhorst Pack 方案得到了很好的收敛结果。在结构优化中,采用共轭梯度法,释放残余力,直至小于 0.01 eV/Å。此外,实现了基于半局部 PBE 近似的混合密度函数。为了纠正被低估的带隙,35% 的 PBE 交换被替换为确切的 [27]。为了识别随着 Al 掺杂水平变化的能带边缘偏移,计算平均静电势 (AEP) 并将其与缩放到 0 V 的真空水平对齐。因此,VBM 和导带最小值 (CBM) 与基于波段图的 AEP [28]。在这项工作中,使用了在超级电池中具有 16 个 O 原子和 16 个 Zn 原子的块状 ZnO。为了引入Al掺杂,超胞中的1或2个Zn原子被Al原子取代,形成掺杂浓度分别为3.21%和6.25%的Al掺杂结构。
图 5a-c 分别显示了未掺杂、3.21% Al 掺杂 ZnO 和 6.25% Al 掺杂 ZnO 结构的计算能带图。它清楚地表明 ZnO 是带隙为 3.42 eV 的直接带隙半导体,并且 CBM 和 VBM 位于布里渊区的 Γ 点。这些理论模拟结果与实验值非常吻合[29]。通过 Al 掺杂,可以发现费米能级向上移动到导带,这将纯 ZnO 转化为 n 型半导体。同时,对于 3.21% Al 掺杂 ZnO 和 6.25% Al 掺杂 ZnO,带隙也分别增加到 4.83 eV 和 5.42 eV。尽管此处掺杂 ZnO 的带隙高于我们的实验结果;然而,这可能是由于忽略了界面缺陷状态以及其他晶体缺陷。
<图片>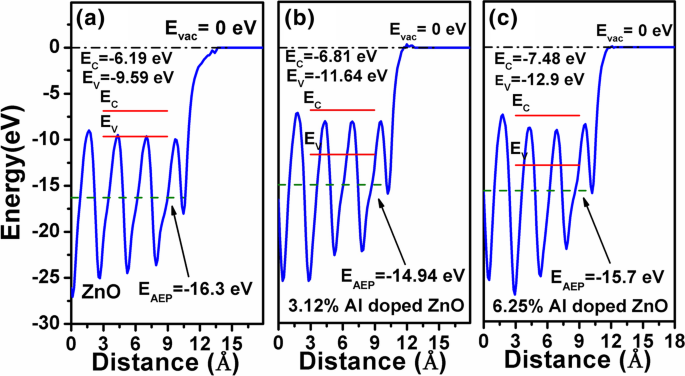
a的计算能带图 未掺杂的氧化锌,b 3.21% Al 掺杂的 ZnO 和 c 6.25% Al 掺杂的 ZnO 结构。费米能级设置为 0 eV
图 6 a-c 显示了未掺杂的、3.21% Al 掺杂的 ZnO 和 6.25% Al 掺杂的 ZnO 与真空水平的能带排列。对于材料的导带,由于 Al 和 O 元素之间的强电子混合,可以发现能级从 ZnO 的 - 6.19 eV 降低到 3.21% Al 掺杂的 ZnO 的 - 6.81 eV( ΔE =0.62 eV) 并且对于 6.25% Al 掺杂的 ZnO (ΔE =1.29 eV)。同时,由于带隙的打开,还可以发现价带边缘从 ZnO 的 - 9.59 eV 向下移动到 3.21% Al 掺杂的 ZnO 的 - 11.64 eV(ΔE =2.05 eV) 和 - 12.9 eV 对于 6.25% Al 掺杂的 ZnO (ΔE =3.31 eV)。总之,由于强的 Al 和 O 电子混合,可以理解在 ZnO 中加入 Al 会打开带隙。此外,当与真空能级对齐时,它会使导带和价带边缘都向较低能级移动。
<图片>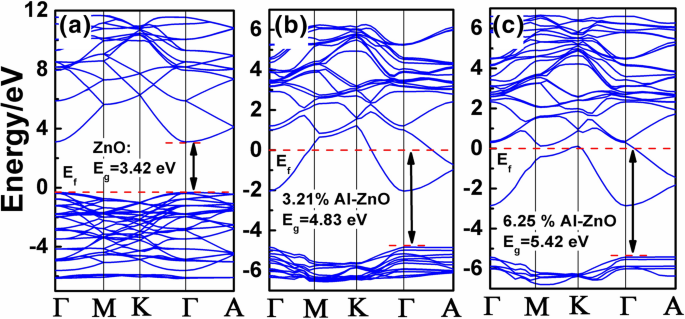
AZO/β-Ga2O3异质结与a的能带排列 未掺杂,b 3.21% 和 c 6.25% Al 掺杂的 ZnO。真空度被缩放到 0 eV
结论
总之,XPS研究了不同Al掺杂的ZnO/β-Ga2O3(\(\overline{2}\)01)界面的能带排列。在 ZnO/β-Ga2O3 异质结的界面形成 I 型能带排列。而 AZO/β-Ga2O3 界面具有 II 型能带排列。 CBO 从 1.39 到 1.67 eV,VBO 从 0.06 减少到 - 0.42 eV,Al 掺杂浓度从 0 增加到 10%。此外,密度函数计算表明,当 Al 与 ZnO 结合时,由于强的 Al 和 O 电子混合,带偏移会发生变化。这些结果表明纯ZnO是降低势垒高度和促进电子传输的有效ISL。
数据和材料的可用性
支持本手稿结论的数据集包含在手稿中。
缩写
- AEP:
-
平均静电势
- ALD:
-
原子层沉积
- 基础:
-
结合能
- CBM:
-
导带最小值
- CBO:
-
导带偏移
- CL:
-
核心层
- CL:
-
核心层
- CVD:
-
化学气相沉积
- DEZ:
-
锌(C2H5)2
- Ga2O3 :
-
氧化镓
- 氮化镓:
-
氮化镓
- GGA:
-
广义梯度逼近
- ISL:
-
中间半导体层
- PBE:
-
Perdew、Burke 和 Ernzerhof
- 碳化硅:
-
碳化硅
- TMA:
-
三甲基铝
- VASP:
-
维也纳从头算模拟包
- VBM:
-
价带最大值
- VBO:
-
价带偏移
- XPS:
-
X射线光谱
- 氧化锌:
-
氧化锌
纳米材料
- 固体能带理论
- 用于 Micro-LED 和 VCSEL 的高级原子层沉积技术
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 通过等离子体增强原子层沉积制备的 Co3O4 涂层 TiO2 粉末的光催化性能
- 通过超循环原子层沉积调节 ZnO 薄膜的费米能级
- 背面有黑硅层的晶体硅太阳能电池的研究
- 在 c 面 GaN 上沉积的 AlN 原子层中界面和电特性的厚度依赖性
- 原子层沉积 ZnO/β-Ga2O3 (\( \overline{2}01 \)) 异质结处的能带调查
- 研究二硫化钼和 ZrO2 异质结处的能带
- 使用二氧化碳的低温等离子体增强原子层沉积 SiO2
- 原子层沉积基于 Hf0.5Zr0.5O2 的具有短/长期突触可塑性的柔性忆阻器
- 通过原子层沉积制造的基于 Ru 的 RRAM 器件中的负差分电阻效应


