四元 InGaNBi 的结构和电子特性的组成依赖性
摘要
为了实现可行的能带结构工程并因此提高发光效率,InGaNBi 是一种有吸引力的合金,可用于可见光和中红外光子器件。在目前的研究中,通过使用第一性原理计算,研究了 InGaNBi 与 In 和 Bi 成分的结构、电子特性,如带隙、自旋轨道分裂能和衬底应变。随着 In 和 Bi 成分的增加,晶格参数几乎呈线性增加。通过铋掺杂,四元 InGaNBi 带隙可以覆盖从 3.273 到 0.651 eV 的宽能量范围,Bi 高达 9.375%,In 高达 50%,对应于 0.38-1.9 µm 的波长范围。计算出的自旋轨道分裂能对于 3.125% 约为 0.220 eV,对于 6.25% 约为 0.360 eV,对于 9.375% Bi 约为 0.600 eV。我们还展示了 InGaNBi 在 GaN 上的应变;这表明通过调整In和Bi的成分,可以在可接受的应变下在GaN上设计InGaNBi。
介绍
近年来,纤锌矿(WZ)In x 嘎 1-x N 合金和 InGaN/GaN 量子阱 (QW) 因其在开发太阳能电池、高效发光二极管 (LED) 和激光二极管 (LD) 方面的巨大潜力而引起了广泛关注 [1-10]。常用的面向[0001]的In x 嘎 1-x N/GaN QW 承受由 In 的双轴压应力引起的强烈内建电场 x 嘎 1-x N 层 [11],这导致电子 - 空穴对的 QW 发射能量和振荡器强度降低。此外,In中存在高密度的几何缺陷 x 嘎 1-x N 合金,包括堆垛层错和螺纹位错 (TDs) [12];这些 TD 与非辐射复合中心有很大的相关性。缺陷、电子泄漏和俄歇复合是In效率下降的三个来源 x 嘎 1-x N个LED,其中Auger复合是主要原因[13]。
同样,对于基于砷化镓的红外二极管,已经有人提出铋合金化是降低带隙的有效方法(E g ) 以及增强自旋轨道 (SO) 分裂以实现对俄歇复合过程的抑制 [14]。铋中最大的 V 族元素显示出对铋化物合金物理性能的有吸引力的影响。对于不同的三元合金材料,如 AlNBi [15]、GaNBi [16, 17]、GaSbBi [18, 19]、InPBi [20, 21]、和 InSbBi [19, 22-24]。带隙主要由 InPBi 中高浓度的大 Bi 原子诱导应变改变。由于 Bi 杂质态与重/轻空穴带和自旋轨道分裂带的相互作用,Bi 的掺入会扰乱价带 (VB) [21]。最近,四元铋化物合金(例如,GaAsNBi [25-27]、InGaAsBi [28, 29]、GaAsPBi [30])也引起了广泛的关注。 P 和 Bi 原子周围的局部畸变对 GaAsPBi 的带隙修改有显着贡献。 Ga As 的成分要求 1-x -y P 是 Bi x 获得比 GaAs 更低的俄歇复合率 [30]。结合铋和其他 III 或 V 原子增加了能带结构工程的范围,包括带隙控制、自旋轨道分裂、传导 (CB) 和价带偏移以及应变 [25]。因此,描述 Bi 取代对 [0001] In 的影响具有重要意义。 x 嘎 1-x N/GaN,调整结构和电子特性,从而调整发光效率。在目前的研究中,使用第一性原理计算 [31],结构、电子特性,如带隙、自旋轨道分裂能 (Δ 所以 ),并研究了 InGaNBi 与 In 和 Bi 成分的衬底应变。考虑到 InGaN 样品 [32] 中 In 含量高于 55-60% 时存在较大的晶格失配和质量差以及铋在稀释的铋合金中的低溶解度,In 和 Bi 的浓度控制在 50% 和分别为 9.375%。本文的结构如下。在“方法”部分,我们介绍了详细的计算方法。 “结果和讨论”部分提供了结构、电子特性和衬底应变。最后总结了一个简短的总结。
方法
我们的理论计算基于在 VASP 代码 [33, 34] 中实现的密度泛函理论 (DFT) [31]。在结构特性的计算中,电子-离子和交换-相关相互作用用投影仪增强波方法 (PAW) [35, 36] 和 Perdew-Burke-Ernzerhof (PBE) 的广义梯度近似 (GGA) 处理[37],分别。 In、Ga、N 和 Bi 原子的价电子构型用作 4d 10 5s 2 5p 1 , 3d 10 4s 2 4p 1 , 2s 2 2p 3 , 和 5d 10 6s 2 6p 3 , 分别。为了克服对电子特性带隙上 PBE 电位的低估,我们采用改进的 Becke-Johnson 交换电位与局部密度近似相关 (MBJLDA) [38] 相结合。铋具有很大的自旋轨道耦合 (SOC) 效应,因此,SOC 包含在电子计算中。在所有的计算中,结构都是松弛的,直到每个原子上的力小于 0.02 eV/Å 并且最大能量变化约为 10 -4 EV。设置了 450 eV 的平面波截止值以确保计算的准确性。一个 4×4×4k 的 Monkhorst-Pack 第一布里渊区采用点网格。
结果与讨论
结构属性
超胞由 4×2×2 的 WZ-GaN 原胞组成,包括 64 个原子。我们研究了 I 的 36 种成分 n 是 嘎 1-y N 1-x Bi x 0≤x ≤0.09375,0≤y ≤0.5 基于最近的实验,其中 InGaN 样品表现出大的晶格失配和质量差的 In 含量高于 55-60% [32] 以及铋在稀释的铋合金中的低溶解度。考虑一种代表性配置,其中 In 和 Bi 原子均匀分布。我们总结了三元In的计算晶格参数 是 嘎 1-y N 和四元 In 是 嘎 1-y N 1-x Bi x 合金以及图 1 中的其他理论和实验数据。对于原始 GaN,晶格参数 a =3.211,c =5.235 Å,这与其他理论计算a非常吻合 =3.155,3.22 Å, c =5.144,5.24 Å [39–41] 和 a 的实验数据 3.19 Å , c 为 5.19 Å [42]。晶格参数 (a , c ) 的 In 是 嘎 1-y 当 In 组成增加时,N 上升并显示出近乎线性的变化,如图 1a 所示。目前的计算预测 a =3.304 Å,c In =5.365 Å 0.25GaN 和 a =3.397 Å,c In =5.509 Å 0.5GaN,均与之前a的结果一致 =3.33 Å,c In =5.39 Å 0.25GaN 和 a =3.43,3.485 Å, c =5.55,5.488 Å 对于 I n 0.5GaN [39, 40, 43, 44]。对于四元合金In 是 嘎 1-y N 1-x Bi x ,就我们而言,结构特性没有实验和理论值。在图 1b 中,获得的晶格参数也随着 In 和 Bi 成分的增加几乎线性增加。由于In和Bi的离子半径大于Ga和N原子,In取代Ga和Bi取代N导致InGaNBi晶格参数增强。
<图片>
a 的晶格参数 三元合金In 是 嘎 1-y N , 0≤y ≤0.5 和 b 四元合金In 是 嘎 1-y N 1-x Bi x , 0≤x ≤0.09375, 0≤y ≤0.5。为了比较,我们添加了一些来自参考文献的其他计算和实验数据。 [39-44] 在图 1a 中。实线代表a 虚线是 c
In 和 Bi 的掺入将打破晶体周期性并在重合金结构中引入几何变形。我们选择In 0.25氮化镓 Bi 0.0625 以四个化学键统计为例,如图 2 所示; Ga-N、In-N、Ga-Bi 和 In-Bi 键的平均长度分别为 2.009、2.195、2.592 和 2.704 Å。请注意,原始块状 GaN 中的 Ga-N 键长为 1.970 Å。 In-N 键长比 Ga-N 大,说明 In 原子显着地将 N 原子推开。类似地,Ga-Bi 的键长大于 Ga-N 意味着 Bi 原子将 Ga 原子推开,与 Ga (1.22 Å)、In (1.42 Å)、N (0.71 Å) 的共价半径顺序具有良好的一致性,和 Bi (1.48 Å) [45]。其他配置显示类似的行为。主体与掺杂剂之间的晶格变形和电负性差异对电子和光学性质有相当大的影响。
<图片>
In 中键长的直方图 0.25GaNBi 0.0625。面板中的数值表示四种键的平均长度
电子属性
已经表明,函数或校正电位和 SOC 效应极大地影响了 III-V 合金带隙能量、价带和自旋轨道分裂能的预测精度。因此,我们使用 MBJLDA 势验证我们的结果,并与其他理论计算和实验进行比较。图 3 是带隙能量与 In 中 In 成分的关系图 是 嘎 1-y N 以及对数据的拟合。还绘制了一些通过实验获得的带隙值、理论 HSE06、mBJ 和 LMTO-CPA-MBJ 泛函。 GaN 的预测带隙为 3.273 eV,与目前的计算和实验非常吻合,mBJ [40] 为 3.33 eV,HSE06 [39, 46] 为 3.261、3.23 eV,实验 [47-] 为 3.40-3.50 eV 49]。正如在 I 中观察到的 n 是 G 一 1-y N,我们的 DFT 结果证实 E g I 的值 n 是 G 一 1-y N随着y不断减小 从 0 增加到 50%。 E g 从 3.273 eV 平稳下降到 1.546 eV。这与理论(HSE06,mBJ电位)[39, 40, 46]和实验结果[50, 51]的结果相吻合。
<图片>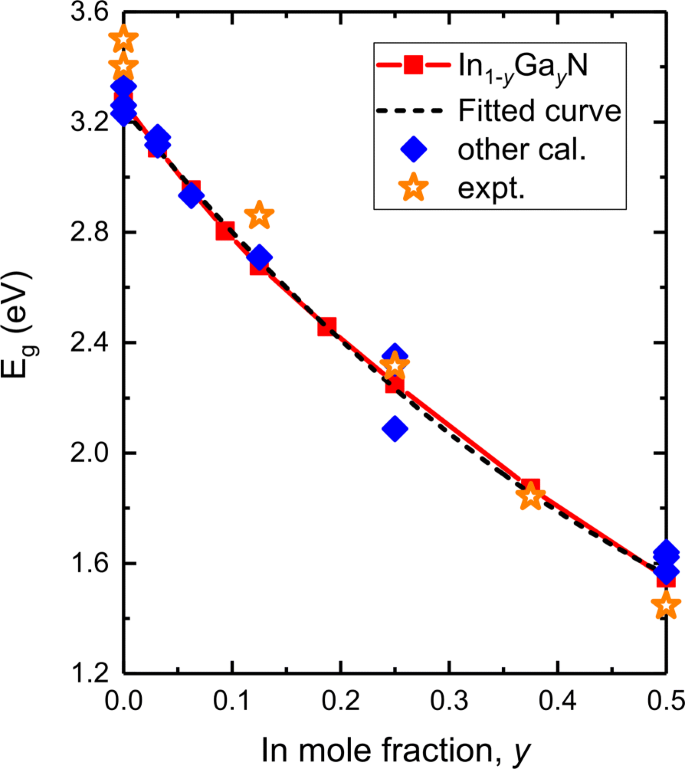
预测带隙能量 (E g ,红色实线)作为 I 中 In 组成的函数 n 是 G 一 1-y N 以及对数据的拟合(黑色虚线)。还绘制了其他理论 [39, 40, 46] 和实验 [47-51] 结果
四元I带隙的等高线图 n 是 G 一 1-y N 1-x B 我 x 合金如图 4 所示。四元合金的带隙显示出作为组成函数的非线性趋势,随着 In 和 Bi 含量的增加而减小。从结果中,我们发现 InGaNBi 带隙可以覆盖从 3.273 到 0.651 eV 的宽能量范围,Bi 高达 9.375%,In 高达 50%,对应于 0.38 至 1.9 µm 的波长范围,表明它们在光电领域的潜在应用可见光和中红外范围。
<图片>
I 的带隙值的等值线图 n 是 G 一 1-y N 1-x B 我 x 合金,作为 Bi(x ) 和 In(y ) 组成
与 InGaN 相比,Bi 的掺入导致带隙减小的幅度更大。但除此之外,Δ 的显着增加 所以 是由于铋的强 SOC 效应而获得的,其中电子自旋和轨道角动量之间的高级相互作用降低了 SO 带能量。此外,由双族合金的价带反交叉效应引起的价带边缘的改善也大大提高了Δ 所以 [28]。我们计算的 Δ 所以 3.125% 的值分别约为 0.220 eV、6.25% 的 0.360 eV 和 9.375% Bi 的 0.600 eV,其随铟含量的变化不显着。先前的研究表明,不同的 Bi 排列对铋化物合金的能带结构有很大影响,包括自旋轨道分裂能 [21, 52]。目前的结果表明 I n 0.5G 一 N B 我 0.09375 带隙值 (0.651 eV) 非常接近 Δ 所以 (0.577 eV)。由于 InGaN 样品在 In 含量高于 55-60% [32] 时表现出较大的晶格失配和较差的质量以及铋在稀释的铋合金中的低溶解度,我们将 In 的含量设置为高达 50%,Bi 的含量高达9.375%。我们相信更高的铟或铋含量将实现Δ 所以>E g 在四元 InGaNBi 样品中提高 InGaNBi 基 LED 和 LD 的效率。
原始 GaN 的投影能带结构和总态密度 (TDOS),I n 0.25GaN 和 I n 0.25G 一 N B 我 0.03125 合金如图 5 所示。In 和 Bi 的贡献用颜色突出显示:蓝色(红色)对应于源自 In(Bi)的状态。 I 中的 In 替换 n 0.25GaN 对导带和价带都有很大影响,其中导带最小值 (CBM) 被推到费米能级的较低能量并反映更窄的能隙。与在费米能级附近的禁带中引入缺陷带的铋不同,In 原子显示出与 VB 的深能级的杂化。对于四元合金I n 0.25G 一 N B 我 0.03125,可以清楚地看出带隙的减小是由向上的价带最大值(VBM)和向下的CBM造成的,与I相比,CBM变化更显着 n 0.25GaN,这是由于添加铋导致 InGaNBi 中更大的压缩应变。红色突出显示的缺陷能级与 VB 边缘有很强的相互作用,这主要来自 Bi 和附近 Ga 原子之间的杂化。图 5e 中的 TDOS 也反映了 -1.0 到 -0.5 eV 的局部缺陷水平。
<图片>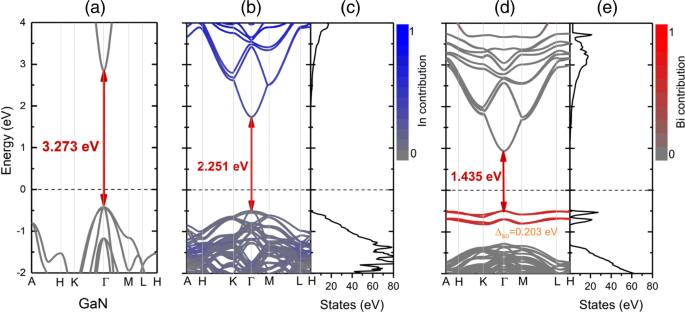
a 的投影能带结构及其相应的总态密度 (TDOS) 氮化镓,b , c 我 n 0.25G 一 N , 和 d , e 我 n 0.25G 一 N B 我 0.03125。黑色虚线代表费米能级,设置为零。 In和Bi的相对贡献用颜色突出显示:蓝色(红色)对应于源自In(Bi)的状态
GaN 上的 InGaNBi 应变
面向[0001]的I n 是 G 一 1-y N/GaN 应变量子阱广泛应用于当前的 LED 和 LD 器件中,其中 I n 是 G 一 1-y N层承受双轴压应力。 In 和 Ga 原子的局部组成波动和不同的共价半径导致 I 中的应变 n 是 G 一 1-y N层[53]。图 6 显示了 InGaNBi 在 GaN 衬底上的应变。由于铟原子比镓原子大,铋原子比氮原子大;因此,在 InGaNBi 中加入 In 和 Bi 原子会在 GaN 上产生压缩应变 InGaNBi。结果表明,在 In 含量为 50% 和 Bi 含量为 9.375% 的情况下,InGaNBi 处于 8.5% 的高压缩应变下。对于6.25%以内的In分数和2.8%以内的Bi分数,GaN上InGaNBi的应变在1%以内。也就是说,通过调整 In 和 Bi 的成分,可以在可接受的应变下在 GaN 上设计 InGaNBi。
<图片>
GaN 衬底上 InGaNBi 合金在不同 In (0-0.5) 下的应变与 Bi 分数的函数关系。应变为正值表示 InGaNBi 处于压缩应变
结论
基于密度泛函理论研究了 InGaNBi 在 GaN 上的结构、电子特性和应变与 In 和 Bi 成分的关系。 InGaNBi 的晶格参数随着 In 和 Bi 成分的增加几乎线性增加。由于 In 和 Bi 原子的原子半径大于 Ga 和 N 原子的原子半径,因此 In-N 和 Ga-Bi 键长大于 Ga-N 的键长。对于电子特性,我们已经展示了四元 I 带隙的等高线图 n 是 G 一 1-y N 1-x B 我 x 合金。四元合金带隙可以覆盖从 3.273 到 0.651 eV 的宽能量范围,Bi 高达 9.375%,In 高达 50%,对应于 0.38 到 1.9 µm 的波长范围。计算出的Δ 所以 3.125% 的值分别约为 0.220 eV、6.25% 的 0.360 eV 和 9.375% Bi 的 0.600 eV,其随铟含量的变化不显着。我们相信更高的铟或铋成分将实现Δ 所以>E g 在四元 InGaNBi 样品中,以提高基于 InGaNBi 的 LED 和 LD 的效率。能带结构分析表明,铟对 CB 和 VB 都有很大影响,铋与 VB 边缘有很强的相互作用。最后,我们研究了 InGaNBi 在 GaN 上的应变。通过调整In和Bi的成分,可以在可接受的应变下在GaN上设计InGaNBi。
纳米材料
- 用于结构汽车和电子元件的碳纤维增强 PPA
- 过渡金属掺杂高岭石纳米粘土的结构和电子特性
- 垂直电场对 ML-GaS 的电子和光学各向异性特性的调制
- 接触非平衡等离子体对 Mn Х Fe3 − X О4 尖晶石结构和磁性能的影响
- 飞秒激光诱导硫超掺杂硅 N+/P 光电二极管的光学和电子特性
- 用于有色冷色颜料的 Cr 掺杂 TiO2 的结构和可见近红外光学特性
- 探测 Ag n V (n =1-12) 簇的结构、电子和磁特性
- 纳米粒子毒性对其物理和化学性质的依赖性
- InSe 纳米带的电子结构和 I-V 特性
- 钒原子在清洁和石墨烯覆盖的 Cu(111) 表面吸附的电子特性
- 汽车 PCB 特性和设计注意事项
- 生铁的性质和成分


