飞秒激光诱导硫超掺杂硅 N+/P 光电二极管的光学和电子特性
摘要
硅中杂质介导的近红外 (NIR) 光响应对光伏器件和光电探测器非常感兴趣。在本文中,我们制作了一系列 n + 通过离子注入和飞秒脉冲激光制备的具有超掺杂硅的 /p 光电探测器。这些器件在 NIR 波长处的吸收和光响应方面表现出显着增强。植入剂量为10 14 的器件 离子/厘米 2 表现出了最好的表现。该方法为制造低成本宽带硅基光电探测器提供了一种方法。
背景
由于硅的光学带隙 (1.12 eV) 的限制,传统的硅基器件无法显示出理想的 NIR 光响应 [1],并且已经进行了许多尝试来提高硅材料的吸收率,尤其是在 NIR 波长下 [2,3, 4,5,6,7,8,9]。在 SF6 气氛中通过激光照射制造的硫属元素过饱和硅的发现证明了一种增强子带隙吸收的方法 [10, 11]。在这个过程中,材料可以掺杂超过溶解度极限 [12]。此外,硅表面独特的尖锥结构引起的光捕获效应也提高了光吸收效率[13]。在本文中,我们通过离子注入和飞秒脉冲激光制备了超掺杂硅。进行霍尔测量以测量超掺杂硅的电性能。基于 n + 的光电探测器 /p 结在 NIR 吸收和光响应方面均表现出高性能。
方法
用 1.2 keV 32 离子注入电阻率为 8-12 Ω cm 的一侧抛光 p 型硅 [100] 晶片(300 μm) S + 在室温下进入大约 40 纳米的深度。注入剂量为1 × 10 14 , 1 × 10 15 , 和 1 × 10 16 离子/厘米 2 .脉冲激光熔化 (PLM) 是通过 1 kHz 的 100 fs、800 nm 飞秒激光脉冲串进行的,能量密度为 0.5 J/cm 2 .然后,直径为 200 μm 的激光光斑聚焦在硅和图案化正方形区域上,最大尺寸为 10 mm × 10 mm。快速热退火 (RTA) 在 600°C 和 N2 气氛中进行 30 分钟。
我们确定了吸收率 (A ) 通过测量反射率 (R ) 和透射率 (T ) 使用配备积分球检测器的 UV-Vis-NIR 分光光度计 (UV3600, Shimadzu, Tokyo, Japan) [3]。吸收率由A计算 =1-R -T .载流子的浓度和迁移率在室温下由霍尔效应测量系统测量(通过范德堡技术)[14]。为了研究由硅中的硫杂质形成的杂质/中间带 (IB) 是否增强了子带隙光响应,我们采用了参考文献中描述的傅里叶变换光电流光谱法。 [15, 16],其中斩波FTIR全局光源聚焦到样品上,产生的光电流然后通过外部锁相放大器解调,最后反馈到FTIR的外部端口。
结果与讨论
图 1 显示了以不同剂量注入的硅样品的吸收率。用 PLM 处理的样品在可见光和 NIR 波长下显示出最高的吸收率,而植入后的样品显示出最低的吸收率。然而,退火过程降低了光谱的 NIR 区域的吸收。微结构硅的高 Vis-NIR 吸收率归因于以下原因:超掺杂诱导的杂质带和微结构表面产生的光捕获效应。如图 1d 所示,由掺杂剂引起的杂质带在硅中形成,它负责子带隙吸收 [17]。因此,超掺杂硅在 NIR 范围内显示出高吸收率。同时,激光熔化重建硅表面并产生导致多次反射和吸收的锥体阵列 [13],如图 1e、f 所示。加工退火明显降低了NIR波长范围内的吸收率,这主要是由两个方面造成的:(1)消灭了硅表面的纳米结构,降低了光捕获效应[18]; (2) 导致硅基体内的键重排,使硫杂质光学失活[11]。
<图片>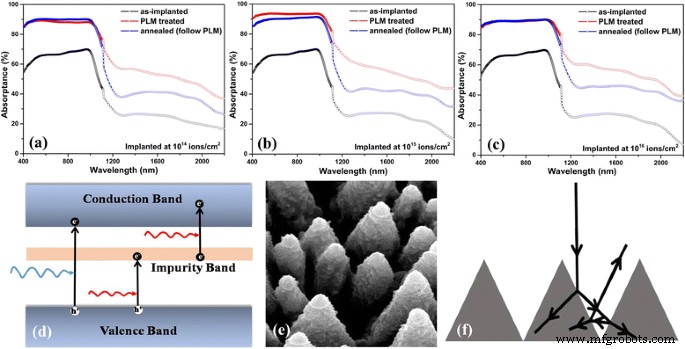
一 –c 吸收率对不同注入剂量的不同制造工艺的依赖性。 d 位于 Si 带隙内的杂质带促进了参与低能量光子吸收的载流子的产生。 e 硅尖峰的扫描电子显微照片。 f 微结构表面光路示意图
由于相同激光参数产生的相似表面结构,NIR 范围内的吸收强度主要取决于掺杂剂的杂质水平 [19]。过去,我们已经说明了与光响应光谱特征相对应的可能的 S 相关能级 [20]。它表明在 NIR 区域观察到的大幅增强取决于 S 相关能级(~ 614 meV),这大大增强了子带隙吸收率。在退火过程之前,吸收相对于掺杂剂量没有显着变化,如图 2a 所示。具有10 16 的微结构硅 和 10 15 离子/厘米 2 注入剂量显示出相似的吸收率,样品注入时间为10 14 离子/厘米 2 显示出不明显的下降。我们认为 NIR 范围内退火样品的较低吸收率可归因于两个方面。 M. A. Sheehy 等人。 [21]提出退火过程后带隙以下的吸收减少归因于晶粒从晶粒扩散到过饱和掺杂剂和缺陷的晶界。这些缺陷包括空缺、悬空债券和浮动债券。一旦缺陷扩散到晶界,它们将不再对 Si 中的杂质带做出贡献,从而减少带隙以下辐射的吸收。此外,文献 [22] 报道,直到退火温度达到 650°C,S 才发生显着的重新分布。在此过程中,S 似乎与缺陷簇复合,这意味着 S 原子将在 Si 晶片表面相互结合。这种现象导致活性掺杂浓度降低。
<图片>
一 吸收率对不同离子注入剂量的依赖性。所有样品均通过 PLM 进行微结构化。 b 退火前和退火后不同离子注入剂量的参比硅和微结构硅的电子特性
具有不同离子注入剂量的微结构硅的载流子密度和迁移率如图 2b 所示。很明显,片密度随着离子注入剂量的增加而增加,而迁移率随着离子注入剂量的增加而降低。根据Shockley-Read-Hall (SRH)复合效应,在间接带隙半导体如Si和Ge中,载流子寿命随着掺杂浓度的增加而降低[23, 24]。迁移率的降低导致复合概率的增加,因此迁移率的下降导致电子寿命的下降,迁移率随着掺杂剂量的增加而下降,这与SRH复合效应是一致的。退火后,如前所述,由于热扩散效应,薄片载流子密度急剧下降。
图 3 显示了不同掺杂剂量下的光响应,插图显示了 n+/p 光电探测器的图。 NIR 范围内的光响应表明杂质介导带的出现。大约 960 nm 处的显着峰对应于硅衬底中电子-空穴对的产生,这些电子-空穴对被 n + 的内置电位隔开 /p 结并在顶部和底部 Al 触点处收集。这种现象被称为硅器件中的异质结理论[25]。
<图片>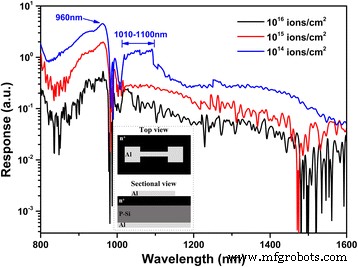
具有不同离子注入剂量的 n+/p 探测器的光响应。插图显示了该装置的俯视图和剖视图。浅灰色显示微结构表面的叉指接触和背面的所有站立接触
在 NIR 中观察到的光响应归因于超掺杂硅中的硫杂质水平。这种杂质水平有利于上述带隙以下的吸收。吸收的 NIR 光转化为电子-空穴对,从而增强 NIR 范围(1100 ~ 1600 nm)的光响应 [20]。植入剂量为10 14 的装置 离子/厘米 2 在 1010-1100 nm 的波长范围内显示出最高的光响应。由于飞秒激光加工硅中的深硫水平,已经研究了宽峰 [20, 26]。此外,我们发现带有 10 14 的设备 离子/厘米 2 表现出比 10 15 更高的光响应 和 10 16 离子/厘米 2 .霍尔测量表明样品在 10 14 离子/厘米 2 总浓度为 10 19 离子/厘米 3 .正如 SRH 复合效应所证明的那样,载流子寿命取决于硅中的掺杂浓度。 E. Mazur 得出的结论是,具有 10 19 的样本 离子/厘米 3 预计掺杂浓度将显示出比 10 20 更长的载流子寿命 和 10 21 离子/厘米 3 [23]。我们的霍尔测量结果,样品在 10 14 注入 离子/厘米 2 表明流动性最高,与结论一致。基于这一理论,尽管掺杂剂量较高的样品显示出更大的吸收率,但在光吸收和载流子迁移率之间仍然存在平衡。如图 3 所示,具有 10 14 的设备 离子/厘米 2 最有可能表现出最高的光响应,这与参考文献中报道的结论一致。 [23].
结论
我们测量了基于具有不同离子注入剂量的微结构硅的光电探测器的响应。杂质的掺入显着提高了 NIR 波长下的吸收率和光响应。并在 10 14 植入设备 离子/厘米 2 表现出最高的光响应。 PLM 与离子注入相结合,展示了一种用于制造 NIR 检测器的重要技术。该技术可能为制造低成本宽带硅基光电探测器提供一种可行的方法。
纳米材料
- 过渡金属掺杂高岭石纳米粘土的结构和电子特性
- 垂直电场对 ML-GaS 的电子和光学各向异性特性的调制
- 小型硒纳米晶体和纳米棒的简便合成和光学特性
- 掺杂氧的纳米晶体的电子态和由 ns-Laser 制备的黑硅上的可见光发射
- 化学蚀刻制备的硅纳米线的光学和电学特性
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- 用于有色冷色颜料的 Cr 掺杂 TiO2 的结构和可见近红外光学特性
- 使用分子束外延法制备锗铋薄膜及其光学特性
- 探测 Ag n V (n =1-12) 簇的结构、电子和磁特性
- 具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
- Al-Doped ZnO 薄膜在红外区域的光学特性及其吸收应用
- 汽车 PCB 特性和设计注意事项


