具有啁啾超晶格电子减速层的基于 AlGaN 的深紫外发光二极管的性能增强
摘要
基于 AlGaN 的深紫外 (DUV) 发光二极管 (LED) 存在电子溢出和空穴注入不足的问题。在本文中,提出了具有超晶格电子减速层 (SEDL) 的新型 DUV LED 结构来减速注入有源区的电子并改善辐射复合。已经通过实验和数值研究了几种啁啾 SEDL 对 DUV LED 性能的影响。 DUV LED 已经通过金属有机化学气相沉积 (MOCVD) 生长并制成 762 × 762 μm 2 芯片,在 275 nm 处表现出单峰发射。在正向电流为 40 mA 时测得的外量子效率为 3.43%,工作电压为 6.4 V,表明壁插效率为 2.41% 的 DUV LED 具有上升的铝含量啁啾 SEDL。通过理论模拟研究了导致这种改进的机制。由于载流子注入促进,在L50处测量具有上升Al含量啁啾SEDL的DUV LED的寿命超过10,000 h。
介绍
近年来,基于 AlGaN 的深紫外 (DUV) 发光二极管 (LED) 的光谱归属于 UVB (320 nm–280 nm) 和 UVC (280 nm–100 nm),因其应用而备受关注。用于植物照明、光疗、水净化以及空气和表面消毒 [1,2,3,4,5,6]。然而,最先进的基于 AlGaN 的 DUV LED 的光输出功率 (LOP) 随着光发射波长的缩短而显着下降 [7, 8]。这些 DUV LED 的内部量子效率 (IQE)、光提取效率 (LEE) 和载流子注入效率 (CIE) 较低 [9,10,11,12,13]。通常,IQE 不足是由大密度缺陷和穿透位错引起的,而 LEE 不足是由于 AlGaN 材料的极化和不透明 p-GaN 接触层的吸收 [14,15,16,17,18]。此外,电子溢出是导致CIE不良的主要原因,这是由于AlGaN材料中空穴密度不足以及电子和空穴迁移率显着不平衡[19, 20]。
传统上,高Al含量的p型AlGaN电子阻挡层(EBL)用于抑制电子溢出。但是只有少数空穴可以通过 EBL 引入的价带中的势垒注入有源区,甚至更少的空穴可以穿过有源区的势垒并传输到 n 型层附近的量子阱,因为Mg 掺杂剂的激活效率和空穴的小迁移率 [21]。已经进行了各种尝试来改善电子和空穴注入,例如空穴势垒层、专门设计的最后势垒、EBL 和多量子阱结构 [22,23,24,25,26]。尽管如此,DUV LED的性能并没有得到实质性的改善。
在这项工作中,我们提出了一种具有超晶格电子减速层 (SEDL) 的新型 DUV LED 结构,以在不影响空穴注入的情况下减速电子注入并抑制电子溢出。我们已经通过实验和数值研究了几种 SEDL 对 DUV LED 性能的影响。 DUV LED 已经通过金属有机化学气相沉积 (MOCVD) 生长并制成 762 × 762 μm 2 芯片,在 275 nm 处表现出单峰发射。在 40 mA 的正向电流下测得的外量子效率 (EQE) 为 3.43%,工作电压为 6.4 V,表明壁插效率为 2.41% 的 DUV LED 具有上升的铝含量啁啾 SEDL。在 L50 处测量具有上升的铝含量啁啾 SEDL 的 DUV LED 的寿命超过 10,000 h。此外,通过理论模拟研究了性能增强的机制。经验证,啁啾SEDLs能够平衡电子和空穴注入有源区,促进n型层附近前几个量子阱的辐射复合。
方法和实验部分
MOCVD 外延
使用垂直冷壁 MOCVD 系统生长基于 AlGaN 的 DUV LED 异质结构。对于整个结构的外延,分别使用三甲基铝 (TMA)、三甲基镓 (TMG) 和氨 (NH3) 作为 Al、Ga 和 N 源。 H2用作载气。图 1a 说明了带有啁啾 SEDL 的 DUV LED 结构的示意图。使用 2.7 微米厚的 AlN 开始生长,使用具有初始 AlN 梯度夹层的生长方法进行生长模式修改 [27],然后是 3 微米厚的掺硅 Al0.6Ga0.4N n 型接触层,其中该n型层的电子浓度和迁移率测量为4.5 × 10 18 厘米 −3 和 52 cm 2 /V s,分别由霍尔系统。紧随其后的是 40 纳米厚的未掺杂 SEDL。图 1b-e。显示了传统 DUV LED 和三个提议的具有 SEDL 的 DUV LED 的能带结构,分别命名为样品 A、B、C 和 D。如图 1c 所示,样品 B 具有 20 周期均质 Al0.65Ga0.35N/Al0.5Ga0.5N 超晶格的均匀 SEDL。样品C和D的啁啾SEDL由四组具有不同高Al含量层的5周期超晶格组成,即0.7、0.65、0.6和0.55,而低Al含量层的Al成分为保持恒定为 0.5。对于样品C,高Al含量层的Al成分从下到上逐渐上升,这与样品D相反,如图1d和e所示。 SEDL 的每一层的厚度稳定地设置为 1 nm。 DUV LED 的有源区由用于电流传播的 Al0.6Ga0.4N:Si 包覆层组成,然后是 5 周期多量子阱,使用 14 纳米厚的 Al0.57Ga0.43N 势垒和 2 纳米厚Al0.45Ga0.55N 阱。然后,依次生长 Al0.7Ga0.3N:Mg EBL 和 GaN:Mg p 型接触层。 p-GaN的空穴浓度和迁移率测量为3.6 × 10 17 厘米 −3 和 15 cm 2 /V s,分别由霍尔系统。
<图片>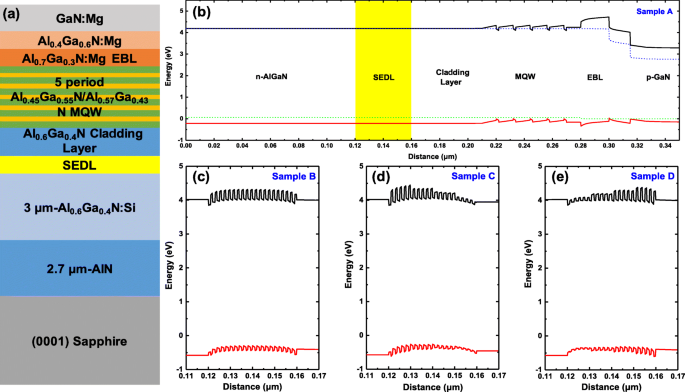
带有和不带有 SEDL 的 DUV LED 设计结构的仿真。 一 带有啁啾 SEDL 的 DUV LED 结构示意图。在n型AlGaN层和AlGaN电流扩展包覆层之间插入具有不同Al成分的20周期SEDL。 b 常规样品的全能带结构(a ) 没有 SEDL。突出显示的区域是指要插入 SEDL 的指定区域。 c 样品的 SEDL 能带结构 (b ),即 20 周期均质 Al0.5Ga0.5N/Al0.65Ga0.35N 超晶格。 SEDL 的每一层为 1 nm。 d 样品的 SEDL 能带结构 (c ),这是四组具有不同高Al含量层的5周期递减Al含量SEDL超晶格,即0.7、0.65、0.6和0.55。 e 样品的 SEDL 能带结构 (d ),即高含铝层数不同的4组5周期升铝SEDL超晶格,分别为0.55、0.6、0.65和0.7
设备制造
在 MOCVD 生长之后,DUV LED 用标准加工技术制造。首先,通过在掺硅 Al0.6Ga0.4N n 型接触层顶部下方干蚀刻至 150 nm,然后进行 900 °C 退火以修复蚀刻损坏,形成具有方形和指状几何形状的台面结构。然后,Ti/Al/Ni/Au n 接触金属叠层被沉积并在氮气氛中在 850 °C 下退火。随后,在250 °C下蒸发并退火ITO薄膜以使用p-contact,然后进行厚电极蒸发,钝化层沉积,焊盘蒸发和隐形切割成762 × 762 μm 2 芯片。
模拟
为了阐明深紫外 LED 性能增强的机制,通过自洽求解薛定谔方程、泊松方程、载流子传输方程和电流连续性方程,模拟了该结构的能带图、光学特性和载流子传输特性Crosslight APSYS(半导体器件的高级物理模型)程序 [28]。除了 p 型插入层为 1 ns 之外,所有层的肖克利读取霍尔 (SRH) 复合时间都设置为 1.5 ns,因为 SRH 寿命取决于掺杂水平 [29]。内部损失为 2000 m −1 [30]。弓形参数 b 为 1 eV,AlGaN 材料的带偏移比假定为 0.7/0.3 [31]。俄歇复合系数设为1 × 10 −30 厘米 6 /s 以适应实验 [32]。在该模拟中,基于 Fiorentini 等人提出的方法计算了由于自发极化和压电极化引起的内置界面电荷。 [33]。此外,考虑到缺陷的筛选,假设表面电荷密度为计算值的40%[34]。
结果与讨论
由于四个样品具有相同的 AlN 和 n 型 AlGaN 模板,因此通过高分辨率 X 射线衍射 (HR-XRD) 测量了样品 A、B、C 和 D 的结晶质量。如表 1 所示,对两层进行了沿对称 (002) 平面和非对称 (102) 平面的 X 射线摇摆曲线 (XRC)。结果表明,四个样品的XRC半峰全宽(FWHM)和螺纹位错密度(TDD)几乎相同,表明晶体质量不是器件性能提升的主要原因。此外,可以发现 AlGaN 层中的穿透位错密度 (TDD) 高于 AlN 层中的穿透位错密度 (TDD),这是由混晶特性、界面缺陷和 Si 掺杂杂质造成的 [35]。根据 Ban 等人的研究。关于IQE和TDD之间的相关性,本工作中所有样本的IQE约为30-40%[36]。
为了证实新结构的成功生长,我们以典型样品 B 为代表进行了横截面明场扫描透射电子显微镜 (BF-STEM) 测量,如图 2 所示。可以看出 TDDs在图 2a 中 2.7 微米厚的 AlN 的整个生长过程中减少。图 2b 表明在每个 SEDL 周期中具有良好的周期性和近 1 纳米厚的层。此外,在图2c中识别出具有不同界面的五个周期的多个量子阱,其中势垒为14 nm,阱约为2.1 nm。
<图片>
典型样品B的形貌表征。a AlN 模板的横截面 STEM 图像。 b SEDL 20 个周期区域内的横截面 STEM 图像。 c 有源区横截面 STEM 图像
为了研究器件性能,将 DUV LED 芯片共晶键合在 AlN 陶瓷基板上,以最大限度地减少热效应。然后,通过焊膏将基板安装在六角形铝板上。然后,使用配备 30 厘米直径积分球的 ATA-1000 光电分析系统进行电学和光学测量 [37]。图 3a 显示了光输出功率 (LOP) 与注入电流的变化。随着Al含量SEDL的升高,样品D的LOP在40 mA时为6.17 mW,100 mA时为14.99 mW,360 mA时为44.975 mW,是没有SEDL的常规样品A的三倍。这表明 SEDL 有利于电子溢出抑制和空穴注入。同时,在高偏置下操作时,可以观察到四个样品的轻微 LOP 饱和,这与加热效应和俄歇复合 [38] 相关。图 3b 中描绘了针对注入电流的 EQE。样品 D 在 40 mA 时的最大 EQE 为 3.43%,而样品 A 的 EQE 峰值仅为 1.17%。降低铝含量的 SEDL,这表明样品 D 中的辐射复合更有效。所有样品的测量电流 - 电压特性如图 3c 所示。可以认识到,由于高铝成分 SEDL 的电阻率增加,SEDL 的加入将工作电压从样品 A 的 40 mA 时的 5.13 V 增加到样品 B 的 40 mA 时的 7.09 V。此外,可以看出样品C和D的工作电压低于样品B。 根据单层样品的结构设计和透射率测量,样品C和样品的势垒的平均Al成分D SEDL 为 62.5%,而样品 B 的 SEDL 为 65%。较高的Al含量导致较低的掺杂效率和较高的电阻,导致工作电压增加。值得一提的是,样品 D 的电压在 40 mA 时为 6.4 V,因此最大壁插效率 (WPE) 为 2.41%。 10 mA 处的电致发光光谱如图 3d 所示。 4个样品的发射峰均在275 nm附近,峰强度变化趋势与LOP相同。这也表明,Al含量上升的啁啾SEDL可用于提高DUV LED器件的性能。
<图片>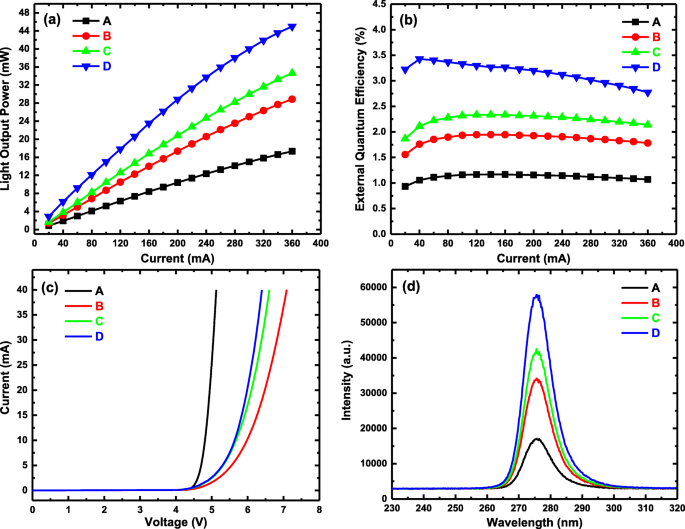
具有不同 SEDL 的样品在室温下的电学和光学特性。 一 CW 偏置下 LOP 对注入电流的依赖性。 b CW 偏置下 EQE 对注入电流的依赖性。 c 注入电流对工作电压的依赖性。 d 所有样品在10-mA注入电流下的EL光谱,其峰值发射在275 nm附近
为了阐明导致这种改进的机制,通过APSYS程序进行了理论模拟,结果如图4所示。200 mA下有源区附近的电子电流密度和空穴电流密度分布如图4所示。 4 a 和 b。可以发现有SEDL的样品的电子注入电流密度略低于没有SEDL的样品A,而空穴注入电流的情况则相反,说明SEDL能够将电子从n型减速AlGaN 电子注入层并相应地促进空穴注入。图 4c 计算了所有样品的辐射复合率。随着不同SEDLs的掺入,n型层附近量子阱中的辐射复合率明显增加。同时,从样品A到样品D,五个量子阱中的辐射复合率逐渐趋于均匀,这与样品D的Al含量啁啾SEDL几乎相同。这进一步表明,SEDL 可以平衡电子和空穴载流子注入有源区,同时促进 n 型层附近前几个量子阱中的辐射复合。结果,四个样品的 IQE 被模拟并绘制在图 4d 中。样本 D 的 IQE 最高,这与图 4b 中的 EQE 一致。更重要的是,使用SEDL的样品中的效率下降明显改善。在整个注入电流范围内,样品A、B、C和D的效率下降分别为70.33%、59.79%、48.93%和36.26%,定义为效率下降 =(IQEmax − IQE250 mA) /IQEmax。效率下降通常被认为是由电子泄漏和空穴注入不足引起的 [39]。效率下降的改善阐明了SEDL可以平衡载流子传输到有源区并促进量子阱中的辐射复合,最终提高器件性能。
<图片>
理论模拟和分析。 一 注入电流为 200 mA 时有源区的电子电流密度。 b 注入电流为 200 mA 时有源区的空穴电流密度。 c 注入电流为 200 mA 时多量子阱中的辐射复合率。 d 计算出的 IQE 对注入电流的依赖性
器件的寿命是在 20 mA 和室温下测量的。对于每个样品,为保证结果的准确性,随机选取了10个芯片,其在不同应力时间下的相对LOP的平均值如图5所示。如图5所示,与样品A相比,样品的寿命与 SEDL 明显扩展。 LED 器件的退化部分与缺陷积累、欧姆导电通道和载流子注入不足有关 [40]。寿命的提高进一步验证了 SEDL 可以平衡电子和空穴传输并促进载流子注入有源区。此外,样品D在L50时具有递增Al含量啁啾SEDL的平均工作寿命超过10,000 h,足以满足实际应用。
<图片>
在 20 mA 和室温下,所有样品的相对 LOP 作为老化时间的函数。当相对 LOP 低于 50% 时,老化停止。黑、红、绿、蓝曲线代表样本a , b , c , 和 d , 分别。样品D随着铝含量上升的啁啾SEDL在L50时寿命超过10,000 h
结论
通过实验和数值研究了啁啾超晶格电子减速层对 DUV LED 的影响。结果表明啁啾SEDLs能够平衡电子和空穴注入有源区,这促进了n型层附近的前几个量子阱中的辐射复合。辐射复合的增加进一步导致DUV LED器件性能的增强。基于AlGaN的DUV LED已被制成762 × 762 μm 2 芯片,在 275 nm 处表现出单峰发射。在 40 mA 的正向电流下测得的外量子效率为 3.43%,工作电压为 6.4 V,表明壁插效率是具有上升铝含量啁啾 SEDL 的 DUV LED 的 2.41%。由于载流子注入促进,具有上升的铝含量啁啾 SEDL 的 DUV LED 的寿命在 L50 处测量超过 10,000 h。通过引入激光剥离、表面粗糙化、反射电极和封装,可以期待进一步的改进。总的来说,所设计的带有啁啾SEDL的DUV LED表现出令人满意的电学性能、良好的光学性能和良好的可靠性,有望用于高效水净化和表面杀菌。
数据和材料的可用性
手稿中的所有数据和材料都可用。
缩写
- APSYS:
-
先进的半导体器件物理模型
- BF-STEM:
-
明场扫描透射电子显微镜
- CIE:
-
载流子注入效率
- DUV:
-
深紫外线
- EBL:
-
电子阻挡层
- EQE:
-
外量子效率
- FWHM:
-
半高全宽
- HR-XRD:
-
高分辨率X射线衍射
- IQE:
-
内量子效率
- LED:
-
发光二极管
- LEE:
-
光提取效率
- LOP:
-
光输出功率
- MOCVD:
-
金属有机化学气相沉积
- SEDL:
-
超晶格电子减速层
- SRH:
-
肖克利-雷德-霍尔
- TDD:
-
螺纹位错密度
- TMA:
-
三甲基铝
- TMG:
-
三甲基镓
- WPE:
-
插墙效率
- XRC:
-
X射线摇摆曲线
纳米材料
- 电子倍增器发射层的设计
- 紫外线照射对 4H-SiC PiN 二极管特性的影响
- LiNi0.8Co0.15Al0.05O2/碳纳米管的机械复合材料具有增强的锂离子电池电化学性能
- 用于高性能硅/有机混合太阳能电池的具有溶剂处理的高导电 PEDOT:PSS 透明空穴传输层
- 具有 CdSe QD/LiF 电子传输层的高效倒置钙钛矿太阳能电池
- 具有增强光催化性能的新型 Bi4Ti3O12/Ag3PO4 异质结光催化剂
- 具有专门设计的超晶格 p 型电子阻挡层以实现高 Mg 掺杂效率的几乎无效率下降的基于 AlGaN 的紫外发光二极管
- 采用高极性醇溶剂处理 PEDOT:PSS 作为空穴传输层的高亮度钙钛矿发光二极管
- 具有增强有效光吸收的针结纳米锥阵列太阳能电池的光伏性能
- 关于用于基于 AlGaN 的深紫外发光二极管的 p-AlGaN/n-AlGaN/p-AlGaN 电流扩展层
- 不同温度下量子阱宽度对 AlGaN 深紫外发光二极管电致发光特性的影响
- 具有增强型双栅极和部分 P 埋层的超低导通电阻横向双扩散金属氧化物半导体晶体管


