通过 InAlAs 中间层改变 GaAsSb 封端的 InAs 量子点的光学特性
摘要
在这项工作中,我们通过高分辨率 X 射线衍射 (HRXRD) 研究了覆盖有复合 In0.15Al0.85As/GaAs0.85Sb0.15 应变减少层 (SRL) 的 InAs 量子点 (QD) 的光学特性和 77 K 的光致发光 (PL) 光谱。In0.15Al0.85As 薄层,厚度 t =20 Å、40 Å 和 60 Å 被插入到 QD 和 60 Å 厚的 GaAs0.85Sb0.15 层之间。在 GaAs0.85Sb0.15 封端的 InAs QD 中观察到的 II 型发射被 In0.15Al0.85As 夹层的插入所抑制。此外,发射波长蓝移t =20 Å 并红移 t ≥ 40 Å 分别由增加的限制电位和增加的应变引起。对于 t,基态和激发态能量分离增加,达到 106 meV =60 Å 与仅用 GaAsSb SRL 封盖的 QD 的 64 meV 相比。此外,对于具有 40 和 60 Å 厚 In0.15Al0.85As 夹层的样品,In0.15Al0.85As 层的使用显着缩小了 QD 光谱线宽,从 52 到 35 meV。
背景
在过去的几十年中,使用 Stranski-Krastanov 技术合成的自组织量子点 (QD) 引起了极大的关注。由于它们在光电器件中的潜在应用,它们的光学和电子特性已被深入研究 [1]。广泛研究的 InAs/GaAs QD 系统已在一系列光电器件中用作活性材料。在这些纳米结构的生长过程中,QD 的尺寸和形状会发生显着变化。这个过程非常复杂,涉及混合、分离或应变增强扩散 [2]。使用纯 GaAs 覆盖层将 QD 发射限制为小于 1300 nm。为了缓解这个问题,已经使用了由 (Ga, In)(As, Sb, N) 制成的应变减少层 [2,3,4,5,6,7]。特别是,三元 GaAsSb 受到了特别的关注,因为通过改变 Sb 含量 [8, 9] 以及其将发射波长扩展到 C 波段以外的能力,可以将其最终的波段排列调整为 I 型或 II 型[10]。然而,当 GaAsSb 用作应变降低层 (SRL) [11] 时,基态和激发态之间的能量差异被限制在 60-75 meV。这种能量分离并不能阻止载流子从 QD 中热逸出。对于需要长载流子寿命的应用,在 InAs QD 和 GaAsSb 之间插入薄势垒将是有益的,因为它会增加 QD 和 GaAsSb 量子阱 (QW) 之间的载流子分离。例如,使用 GaAs 中间层可将太阳能电池的功率效率提高 23% [12]。 InAlAs 层的使用可能对设计辐射复合的类型感兴趣。对于 II 型跃迁,InAlAs 的插入将增加载流子寿命 [13] 以及基本和第一激发态之间的能量分离 [14,15,16]。此外,在 InAs QD 和 GaAsSb 之间插入 InAlAs 层有望减少 In 偏析并抑制 InAs QD 和 GaAsSb SRL 之间的 In 和 Ga 原子混合,并进一步降低 QD 应变 [17]。 InAlAs/InGaAs 复合 SRL 已被用于覆盖 InAs QD,导致长波长发射和基态和激发态之间的良好能量分离,高达 104 meV [16, 18]。
在本文中,我们通过光致发光 (PL) 光谱报告了使用 In0.15Al0.85As 夹层对 InAs/GaAs0.85Sb0.15 QD 光学特性的影响的首次研究。特别是对发射波长的变化、光发射的类型、光谱线宽以及基态和第一激发态之间的能量分离进行了详细研究。
方法
本研究中研究的样品在 Veeco Gen20A 分子束外延系统中生长在外延就绪的四分之一 2 英寸 p 型 GaAs (001) 衬底上。阀门裂解装置用于生成 As2 和 Sb2 二聚体。在 590 °C 下生长 GaAs 缓冲层后,然后将衬底温度降低到 ~ 485 °C,以生长标称 2.5-ML 厚的 InAs QD。在 As2 通量下短暂暂停后,立即沉积复合 In0.15Al0.85As/GaAsSb SRL,然后在相同温度下生长 5 nm 厚的 GaAs,然后将生长温度提高到 570 °C 进行生长38-nm GaAs 阻挡层。 GaAsSb 的厚度固定在 60 Å,而 In0.15Al0.85As 的厚度在 20 到 60 Å 之间变化。 60 埃厚的 GaAsSb SRL 是通过使用 As2/Sb2 通量比实现的,Sb 含量为 15%,如参考样品的 X 射线衍射测量所确定的。所有层均使用 0.5ML/s 的固定 Ga 生长速率。四个样品分别表示为 A、B、C 和 D,其 In0.15Al0.85As 厚度 t 分别设置为 0 Å、20 Å、40 Å 和 60 Å。基于 Krijn [19] 使用的程序并使用 [20] 中的参数,已经估计了导带和价带的相对位置,并且生长结构的示意图及其相应的能带图如图 1 所示。
<图片>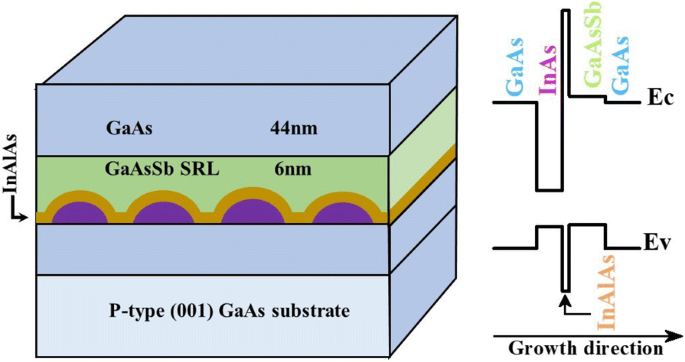
用复合材料 In0.15Al0.85As /GaAs0.85Sb0.15 覆盖的 InAs QD 的生长结构示意图和相应的能带图。 In0.15Al0.85As厚度t =0 Å、20 Å、40 Å和60 Å分别为样品A、B、C和D
使用 Panalytical X 射线衍射仪通过高分辨率 X 射线衍射 (HRXRD) 表征样品的晶体质量。使用连接到 Vertex 80 傅立叶变换红外仪器(Bruker Optics GmbH)的 PL 模块并使用热电冷却的高增益 InGaAs 检测器,通过 77 K 的 PL 光谱法评估生长样品的光学特性[21]。样品采用连续532nm固态激光源激发。
结果与讨论
通过记录 004 原子平面的衍射图案,使用摇摆曲线扫描的 HRXRD 表征生长样品的晶体质量。图 2a 显示了样品 A、B、C 和 D 的衍射图,分别对应于 0、20、40 和 60 Å 的 InAlAs 厚度。观察到由 InAs/InAlAs/GaAsSb 产生的清晰卫星峰表明生长的样品具有良好的晶体质量。模拟的 X 射线摇摆曲线与实验数据一起包含在图 2a 中。得到的参考样品 A 中的平均 Sb 含量为 13%,GaAsSb 的厚度为 66 Å。这些值用于样品 B、C 和 D,以确定 InAlAs 夹层的 In 含量和厚度。模拟结果表明,样品B、C和D的平均In含量为13.5%,InAlAs中间层的厚度分别为22 Å、44 Å和65 Å,接近标称厚度。
<图片>
一 高分辨率ω /2θ 扫描样品 A、B、C 和 D。b 在 77 K 和 100 mW 激发下获得的样品 A 的 PL 光谱。 c 样品 A 在 77 K 时的功率相关 PL。d 前两个光跃迁对应的能量峰值与 Pex 1/3 在 77 K
首先使用功率相关 PL 技术在 77 K 下研究参考样品 A 的光学特性。图 2b 显示了 100 mW 激发功率的 PL 光谱。 PL 光谱可以由三个以 1004 meV、1068 meV 和 1113 meV 为中心的高斯峰拟合,这可以识别为基本和激发的光学跃迁。基态和第一激发态的半峰全宽 (FWHM) 分别为 52 和 58 meV。为了理解观察到的前两个光学跃迁的起源,激发功率从 1 到 100 mW 变化,并获得相应的 PL 光谱,如图 2c 所示。对于每个激发功率,使用多高斯函数拟合提取前两个峰值的能量,并将其绘制为激发功率立方根的函数,如图 2d 所示。基本跃迁的能量随着激发功率的降低而降低,这与 II 型跃迁一致,表明发射是位于 QD(E0QD)中基本电子态的电子和位于 GaAsSb QW 中的空穴复合的结果( H0QW)。对于 InAs/GaAsSb II 型能带排列,QD 和 GaAsSb SRL 中电子和空穴的定位分别引起电场产生的能带弯曲效应,该效应主要沿生长方向 [22]。正如 Jin 等人 所证明的那样,预计 II 型跃迁能与激发功率的三次方成正比增加。 [22]。同样,第一激发态跃迁的能量随着激发功率的降低而降低,这种跃迁很可能是 QD 中第一激发态电子 (E1QD) 和 GaAsSb QW (H0QW) 中空穴复合的结果) 因为 GaAsSb QW 中的态密度远大于 QD 中的态密度。前两个光学跃迁如图 3a 所示。我们还注意到,随着激发功率的降低,基本激发态和第一激发态之间的能量分离 ΔE 几乎保持恒定在 64 meV,这证明电荷积累产生的电场垂直于生长方向 [22],即,GaAsSb 中的孔位于 QD 上方。由于 GaAsSb 中的 Sb 含量为 13%,预计样品 A 中会出现 II 型发射,接近从 I 型到 II 型发生转变的成分 [23, 24]。对于所考虑的 Sb 含量,QD 和 GaAsSb QW 之间应该存在小的价带偏移,有利于 GaAsSb QW 中空穴的定位以及随后的 II 型发射 [25, 26]。
<图片>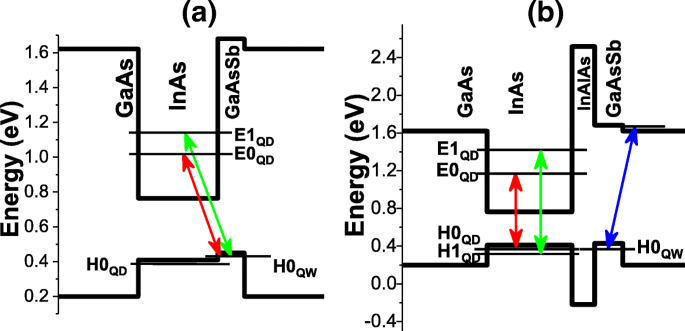
样本 A (a ) 和样本 B、C 和 D (b ) 及其相应的重组通道
图 4a 显示了对应于具有不同 In0.15Al0.85As 厚度且激发功率范围为 1 到 100 mW 的样品的 PL 发射。对于包含 In0.15Al0.85As 夹层的所有样品,可以识别出三个主峰。我们注意到相对于参考样品 A 的不同辐射通道的能量峰值位置发生了变化。 在 100 mW 的激发功率下,基本跃迁的能量、FWHM 和能量分离 ΔE 被提取并与样品进行比较A. 图 4b 中报告了提取的值。
<图片>
一 InAs/In0.15Al0.85As/GaAsSb QD 在 77 K 时的功率相关 PL。b 相应的峰值能量、FWHM 和 ΔE 与 InAlAs 厚度和 c 样品 B、C 和 D 的光跃迁通道峰值能量随激发功率立方根的函数变化
样品 A 的基态跃迁发生在 1004 meV,FWHM 为 52 meV,能量分离 ΔE 为 64 meV。插入 20 Å 的 In0.15Al0.85As(样品 B)会导致基态跃迁蓝移 52 meV。蓝移与当复合 InAlAs/InGaAs 用于在几乎相同的生长温度下生长的 QD 时观察到的一致 [27]。样品 B 中 InAs QD 的基态跃迁能量蓝移是由于增加的限制电位 [15]。随着电子和空穴的势垒增加,电子和空穴的能级分离应该增加,导致观察到的发射蓝移。众所周知,由于 In 偏析和 In-Ga 混合,用 GaAs 覆盖 InAs 会导致 QD 高度降低 [28]。在 GaAs 覆盖层中引入 Sb 通过抑制应变驱动的 In-Ga 混合来减少 QD 分解 [29]。 InAlAs 中间层的插入有望进一步抑制因 Al 吸附原子不活动而导致的 In 偏析和 In-Ga 混合。事实上,Jun 等人。 [17] 通过 STEM 表明,使用 InAlAs/InGaAs 组合层作为覆盖层可以强烈抑制 In 偏析,以及 InAs QD 在覆盖过程中沿生长方向的 In-Ga 混合,导致增加纳米结构的高度和封盖后 InAs QD 中更高的 In 浓度。考虑到 QDs 的低生长温度,即 485 °C,由于 Al 吸附原子的非活性,预计 QDs 和 InAlAs 夹层之间的铟偏析和界面混合不显着。
FWHM 和 ΔE 分别降低和增加到 39 meV 和 92 meV。进一步将 In0.15Al0.85As 的厚度增加到 40 Å 和 60 Å(分别是样品 C 和 D)会导致发射波长发生红移。这种红移可能是由 InAs QD 中应变的改变驱动的,因为复合 InAlAs/GaAsSb SRL 的总厚度随着 InAlAs 厚度的增加而增加 [30]。这可能会改变 QD 的结构尺寸,从而改变电子和空穴的能级。对于样品 C 和 D(分别为 40 Å 和 60 Å),应变效应似乎支配了限制电位效应。样品 D 分别获得了 35 meV 的最低 FWHM 和 35 meV 和 106 meV 的最高能量分离 ΔE。大的 ΔE 是由于使用较厚的 InAlAs 层和可能增加的 QD 高度造成的 [31, 32]。能量分离与使用复合 InAlAs/InGaAs SRL 时获得的能量分离相当 (104 meV) [16, 33]。 FWHM 的减少可以理解为减少 In0.15Al0.85As 和 QD 之间的混合,从而保留 QD 分布。提取的参数汇总在表 1 中。
样品 B 和 C 的 PL 强度与样品 A 相比有所增加;然而,观察到样品 D 的 PL 强度显着降低,即与样品 C 相比降低了 5 倍。 PL 强度降低是由于载流子从 GaAsSb 层注入 QD 的减少所致。事实上,在照明过程中,会产生大量载流子,并且 In0.15Al0.85As 夹层的插入为载流子创造了屏障,并可能限制它们在 QD 中的注入。载流子可能通过隧穿过程转移到 QD,并且具有更薄 In0.15Al0.85As 势垒的样品的 PL 强度更高 [34]。样品 D 显示出最低的 PL 强度,因为穿过 60 Å In0.15Al0.85As 的隧道效应大大降低,这可以通过 GaAsSb QW 的 PL 发射增加来证明,如图 4a 所示。隧穿过程的减少有利于并增强了GaAsSb QW中电子和空穴的辐射复合。
对于图 4a 中所示的样品 B、C 和 D,在 77 K 处的功率相关 PL 的主要观察结果是前两个峰的固定能量位置,随着激发功率的增加,与样品 A 中观察到的相反。这是 I 型发射的特征,其中电子和空穴都位于 QD 内。前两个发射峰是由量子点(E0QD-H0QD 和 E1QD-H1QD)中基本和第一激发态中电子和空穴的复合引起的。我们认为,第三个峰源自由 GaAs 内的电子和位于 GaAsSb QW 中的空穴复合引起的 II 型发射。实际上,对应于这种跃迁的能量随着激发功率的增加而增加,如图 4a 和图 4c 所示,这是 II 型跃迁的特征。此外,我们看到其强度随着 In0.15Al0.85As 层厚度的增加而增加。这与基本跃迁的 PL 强度降低一致,因为较厚的 In0.15Al0.85As 层减少了从 GaAsSb 到 QD 的载流子隧穿,并有利于从位于 GaAs 中的电子和空穴的复合获得的 II 型发射和分别为 GaAsSb。样品 B、C 和 D 的重组通道示意图如图 3b 所示。 II型发射的抑制可以理解如下。 20 埃 In0.15Al0.85As 层的插入增加了 QD 和 GaAsSb QW 之间的载流子分离,结果,电子和空穴波函数重叠减少。此外,事实上 GaAsSb 含量中的 Sb 含量接近 I 型 II 型交叉,In0.15Al0.85As 夹层将使 QW 中的受限能级(H0QW)低于 QD 中的第一个量子化能级( H0QD),如图 3b 所示,因此 QW 中捕获的空穴可能会隧道穿过 InAlAs 层,从而降低 II 型发射的可能性。对于较厚的 In0.15Al0.85As 中间层(40 Å 和 60 Å),隧道效应进一步减少,但电子和空穴波函数重叠显着减少,有利于 GaAs 中的电子与 GaAsSb 中的空穴复合 [13]。 InAs/GaAsSb QD 的光学跃迁可以根据需要短寿命或长寿命的应用类型进行定制。在我们的研究中,我们考虑了 GaAsSb 中 13% 的 Sb 含量,这接近于 I 型到 II 型转变。 InAlAs 夹层的插入抑制了 II 型发射并增加了基本和第一激发态之间的能量分离,这对于需要短载流子寿命的应用来说是可取的。本研究还可以针对需要长载流子寿命的应用进行定制。事实上,在 GaAsSb 层中使用更高的 Sb 含量和插入 InAlAs 夹层的组合有望保持薄 InAlAs 夹层的 II 型发射,同时显着增加载流子寿命。同时,基态和第一激发态之间增加的能量分离将减少载流子热逃逸。
结论
生长并表征了覆盖有具有不同 In0.15Al0.85As 厚度的复合材料 In0.15Al0.85As/GaAs0.85Sb0.15 SRL 的 InAs QD。我们的分析表明,In0.15Al0.85As 层的插入抑制了从 InAs/GaAs0.85Sb0.15 QD 获得的观察到的 II 型发射。此外,发射波长蓝移 t =20 Å 并红移 t ≥ 40 Å 分别由增加的限制电位和增加的应变引起。对于具有 60 埃厚 In0.15Al0.85As 夹层的样品,获得了 106 meV 的大能量分离 ΔE。此外,In0.15Al0.85As中间层的引入显着降低了FWHM,从52 meV降至最低35 meV。
缩写
- FWHM:
-
半高全宽
- HRXRD:
-
高分辨率X射线衍射
- PL:
-
光致发光
- 量子点:
-
量子点
- QW:
-
量子阱
- SRL:
-
应变减少层
纳米材料
- H2/NH3 混合气体中基于 GaN 的多量子阱的原子重排以改善结构和光学性能
- N,N-二甲基甲酰胺调节 MXene 量子点的荧光,用于灵敏测定 Fe3+
- 检测自组织 InAs/InGaAs 量子点超晶格中的空间局域激子:提高光伏效率的一种方法
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- InP/ZnS 核/壳量子点的绿色合成在无重金属发光二极管中的应用
- 水溶性硫化锑量子点的合成及其光电特性
- 石墨烯/Ag3PO4 量子点复合材料的简便一步声化学合成和光催化性能
- 消除 InAs/GaAs 量子点中的双峰尺寸,用于制备 1.3-μm 量子点激光器
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- 利用柠檬汁通过水热反应制备的荧光碳量子点的材料和光学特性
- Al-Doped ZnO 薄膜在红外区域的光学特性及其吸收应用
- 水溶性蓝色发光锰合金碲化碲化镉量子点的合成和性质


