RF-ICP 离子源增强的活性氮等离子体气氛引起的 Ti-Al-N 薄膜微观结构和机械性能的变化
摘要
获得Ti-Al-N薄膜的最佳生长条件,气体气氛特别是反应等离子体对材料微观结构和力学性能的影响仍然是一个基本而重要的问题。在这项研究中,Ti-Al-N 薄膜是通过射频电感耦合等离子体离子源 (RF-ICPIS) 增强溅射系统反应沉积的。在进入离子源时采用不同的氮气流速来获得氮等离子体密度并改变沉积气氛。发现薄膜中的氮元素含量受氮等离子体密度的影响较大,在高气流环境下最大值可达67.8%。 XRD 谱和 FESEM 图像表明低等离子体密度有利于薄膜结晶和致密的微观结构。此外,通过调节氮气气氛,硬度和摩擦学性能等力学性能相互提高。
介绍
由于高硬度、抗腐蚀和优异的抗氧化性等可观的机械性能,Ti-Ai-N 作为机床的表面保护膜在干切削和高速切削中引起了广泛的关注 [1,2,3]。如今,已经开发出多种技术来制造 Ti-Al-N 薄膜,包括化学气相沉积 [4]、电弧蒸发 [5]、离子镀 [6] 和反应性 DC/RF 溅射 [7]。在 Ti-Al-N 薄膜沉积过程中,气体气氛非常重要和复杂 [8,9,10,11,12]。例如,在反应溅射沉积中,非平衡氮等离子体不仅取决于氩或氮离子浓度,还受二次电子密度或总气压的影响,加剧了理解反应性氮气氛诱导的难度。 Ti-Al-N 薄膜性能的变化。郑等人。已经报道了受氮气流速影响的 Ti-Al-N 薄膜的生长形态 [13]。伊鲁达亚拉吉等人。已经发现沉积的 Ti-Al-N 薄膜的沉积速率、晶粒尺寸和 Ti 与 Al 的浓度比随着 N2 流量的增加而降低 [14]。由于获得有价值的知识对于选择最佳生长条件的重要性,氮气氛,特别是反应等离子体密度对 Ti-Al-N 材料元素含量和相应的显微组织和力学性能的影响仍有待进一步探索.
在我们之前的工作中,射频电感耦合等离子体离子源 (RF-ICPIS) 已被证实通过降低氩气电离温度和增加电离速率来增强 Ti-Al-N 沉积 [15]。在本文中,我们在放电的 RF-ICPIS 腔中直接电离氮气,然后将密集的氮等离子体束直接引入反应室参与反应沉积。与传统的 RF/DC 溅射系统相比,RF-ICPIS 提供的氮等离子体密度可以通过改变 RF 功率或气体流速来轻松控制。研究和讨论了氮等离子体变化对Ti-Al-N薄膜的元素含量、显微组织、表面形貌以及力学性能的影响。
方法
薄膜沉积
通过RF-ICP离子源增强磁控溅射系统在Si(100)和镜面抛光不锈钢上沉积Ti-Al-N薄膜,生长温度为200°C。将基板放置在旋转样品架 (20 rpm) 上,样品架垂直于纯度为 99.9% 的 TiO.5Al0.5 化合物靶。将溅射室抽至低于1.0×10 -4 的基础压力后 用氩离子对Pa和靶表面进行清洁,然后通过DC溅射在衬底上沉积Ti-Al缓冲层。随后,RF-ICPIS 产生的氮等离子体被引入基板附近,以参与 Ti-Al-N 薄膜的反应沉积。 RF-ICPIS功率控制在50 W,进入离子源的氮气流速从5到25sccm变化,以改变氮等离子体密度,获得不同的溅射和沉积气氛。同时,直流溅射电流固定在0.4 Å,溅射室总气压保持在0.5 Pa,详细生长参数见表1。
特征化
元素含量通过能谱仪(EDS,Oxford X-Max 50)表征,Ti-Al-N 薄膜的晶体结构通过 X 射线衍射(XRD,Bruker D8 Advance)与 Cu Kα 辐射(λ =1.54056 Å)。通过场发射扫描电子显微镜(FESEM,ZEISS Ultra 55)测量薄膜的表面形貌和横截面微观结构。应用原子力显微镜(AFM,Asylum Research)来测量表面均方根(RMS)。纳米压痕试验采用金字塔形金刚石压头,硬度采用MTS Nano Indenter XP测量,采用Oliver-Pharr压痕法计算。对每个样品进行十个单独的点测量,以获得平均硬度值。采用滑动速度为0.2 m/s、载荷为10 N的传统球盘磨损仪测量摩擦系数。
结果与讨论
图 1 显示了在不同氮气流速下沉积的 Ti-Al-N 薄膜中的 Ti、Al 和 N 元素含量。 Ti-Al-N薄膜中的N含量随着进入离子源的氮气流量的增加而单调提高。在低氮气流量区域 (5–15 sccm) 内,N 含量保持在 45–50%,且 (Ti + Al)/N 比率与 (Ti, Al) N 结构相似。当氮气流量从 15sccm 进一步提高到 25sccm 时,Ti-Al-N 薄膜中的 N 含量迅速增加。在 25 sccm 处获得 67.8% 的最大值,超过了普通 (Ti, Al) N 或 TixAl1-xN 微观结构中的 50%,这表明相变发生在 S4 和 S5。作为氮气流速的函数,Ti-Al-N 薄膜中的 Ti 和 Al 含量都表现出与 N 元素相反的趋势。对于所有薄膜,Al 含量均高于 Ti,这与在增强等离子体气氛下沉积的 Ti-Al-N 薄膜的结果相似。 Al和Ti元素的含量差异可归因于轻质Al原子与Ti原子的溅射产额不同。此外,Al原子容易渗入薄膜表面区域,这也可能导致检测到的Al含量略高于薄膜内部的实际值[16]。
<图片>
不同氮气流量下制备的Ti-Al-N薄膜的元素含量
对沉积在 Si (100) 晶片上的样品进行 XRD。如图 2 所示,S1-S5 表现出典型的 NaCl 型面心立方 (fcc) 结构,具有多个取向在 (111)、(200)、(220) 和 (311) 的衍射平面,除了 (311) ) 用于在高气体流速下沉积的 S4 和 S5 样品 [17]。对于 f.c.c Ti-Al-N 结构,(111) 是具有最低表面能的密集堆积平面,而 (200) 和 (220) 紧随其后。在 S1-S5 中,所有沉积的 Ti-Al-N 都表现出 (220) 优先取向而不是 (111)。在我们之前的研究中,我们发现 RF-ICPIS 增强型溅射系统的薄膜沉积速率得到了提高。这导致吸附原子在基板上的迁移时间减少,并有利于具有更高表面能的 (220) 晶面的生长,但以牺牲其他晶面为代价,因为它具有更高的边缘密度,然后扩散距离更短,到相对较低的能量位点 [13] ]。此外,由高浓度 Al 原子引起的晶格畸变也有助于 (220) 优先生长,而不是 (111) [18]。 (220) 峰的强度和 FWHM 也揭示了结晶对氮气流速的依赖性。在低气体流量范围内(5-15 sccm),随着氮气流量的增加,强度和 FWHM 得到改善,这表明薄膜中的 Ti-Al-N 晶粒尺寸减小,薄膜结晶质量提高。 19]。对于 S4 和 S5,降低的峰值强度和增大的 FWHM 可能验证高气体流速(20-25 sccm)对 Ti-Al-N 薄膜质量不利。
<图片>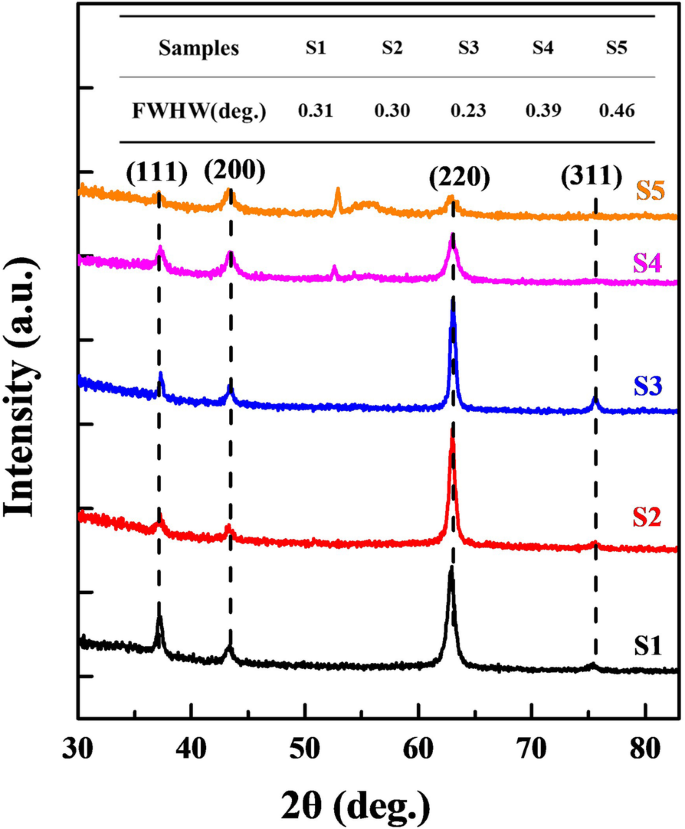
S1-S5 样品的 XRD 谱。插入表是S1-S5的(220)的FWHW值
在高氮气流速下退化的 Ti-Al-N 晶体质量是源自 RF-ICPIS 的氮等离子体变化的结果。当增加进入离子源的氮气流速时,更多的氮原子可以被电离,并且相应的溅射室中的等离子体密度也增加。基板附近的电子浓度由朗缪尔探针测量。计算结果表明,平均电子浓度为 1.5 × 10 16 到 2.7 × 10 16 厘米 −3 随着氮气流速从 5 sccm 增加到 25 sccm。改善的电子浓度表明在沉积过程中等离子体密度得到改善。此外,在沉积期间具有 0.4 A 固定溅射电流的溅射源的电压分别为 482、461、443、408 和 376 V,分别为 5、10、15、20 和 25 sccm。衬底和目标之间阻抗的减小也反映了等离子体气氛的增强。高等离子体密度改善了原子之间的碰撞,导致溅射金属原子的平均自由程和薄膜沉积速率降低。其次,吸附在基材上的原子有更多的时间迁移和成核并有助于薄膜的结晶。当氮气流量超过某个阈值时,虽然等离子体密度进一步提高,但在 50 W 的固定离子源功率下,更多的氮原子不会完全电离 [20]。与完全电离的氮原子相比,未完全电离的原子更靠近衬底,直接参与薄膜的成核生长。因此,Ti-Al-N薄膜中的氮含量远远超出了化学计量比。
图 3 显示了通过 FESEM 观察到的 Ti-Al-N 薄膜的平面和横截面微观形貌。 Ti-Al-N 表面形貌表现为典型的三方锥体晶粒 [21]。与图 3a、b 相比,我们可以发现在低氮等离子体密度(S3)下沉积的薄膜比在高等离子体密度下沉积的 S5 具有更小的晶粒尺寸和更致密的表面,这也与 XRD 结果一致。在低等离子体密度气氛中,完全电离的氮原子和足够的吸附原子迁移时间促进了 Ti-Al-N 的生长和结晶,并有助于形成更致密的表面。还研究了对比样品 CS3 的微观结构,该样品通过传统的氩气电离方法沉积并具有与 S3 相同的实验参数(见补充材料)。与 S3 相比,CS3 显示出更松散和更粗糙的平面,并且在晶界之间出现了许多空隙。同时,CS3的膜厚小于S3。其原因主要是由于这两种气体电离方法的沉积气氛不同。通过在RF-ICPIS中直接电离氮气,可以有效降低气体电离温度,获得高密度的氮等离子体。因此,衬底上的吸附原子具有较高的迁移能,有利于 Ti-Al-N 薄膜的生长和结晶。在横截面 FESEM 图像中,可以清楚地观察到以 15 和 25 sccm 沉积的 Ti-Al-N 薄膜的柱状结构,薄膜的厚度分别为 1.002 和 1.561 μm。在高等离子体密度的情况下,成膜率提高50%。结果不同于增强的原子散射引起的低沉积速率,主要是由于与那些未完全电离的氮原子相关的弱键合氮化物的快速生长。同时,S3 的柱状结构表现出颗粒状和致密的纳米结构,而 S5 样品则显示出柱状结构,在整个薄膜中具有空隙和边界。进一步表明,高氮等离子体密度不利于Ti-Al-N薄膜的结晶质量。
<图片>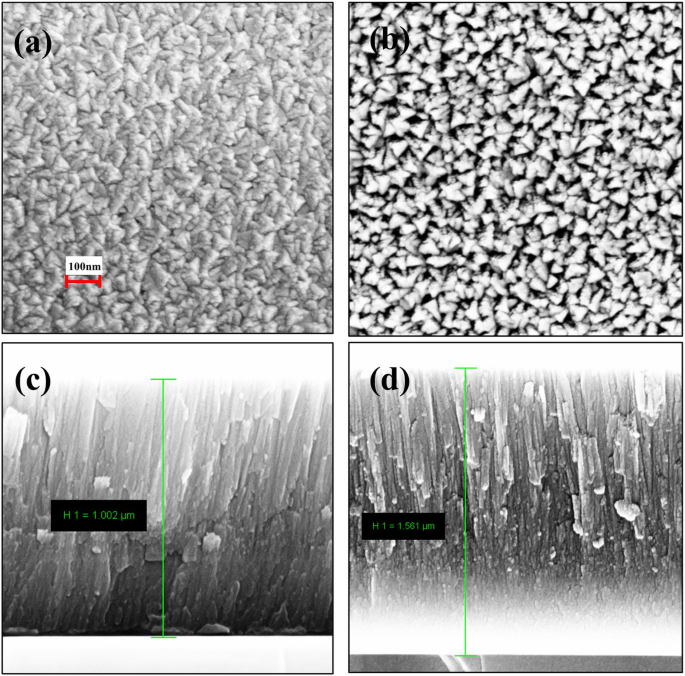
S3 (a , c; 15 sccm) 和 S5 (b , d; 25sccm)
此外,通过原子力显微镜研究了在不同氮气流量下沉积的 Ti-Al-N 薄膜的粗糙度,均方根 (RMS) 粗糙度值绘制在图 4 中。粗糙度先减小后增大随着氮气流量的增加,在15sccm处得到最小值3.932 nm。同时,如图 4c 所示,我们可以发现 S5 样品的薄膜表面充满了膨胀的颗粒,颗粒之间的沟壑非常深。 S5 较粗糙的表面可归因于较差的晶体质量和稀疏的表面。在 Ti-Al-N 晶体结构中,Al/Ti 比也是 Al 原子占据 Ti 原子的晶格位置并引入晶格缺陷影响微观结构和机械性能的重要因素 [18, 22]。对于 S1-S5,基于 EDS 测试计算的 Al/Ti 比率分别为 1.66、1.54、1.43、1.60 和 1.85。出色的晶体质量和低的 Al/Ti 比有助于以 1 sccm 沉积的 Ti-Al-N 样品的表面最光滑。高Al/Ti比加剧了S5薄膜的晶格畸变结构缺陷并加剧了表面粗糙度。
<图片>
一 Ti-Al-N 薄膜的 RMS 粗糙度值与氮气流速的函数关系。插入表为Al/Ti配比值; b 和 c 分别是S3和S5样品的AFM图像
不同氮气流量下在不锈钢基体上沉积的Ti-Al-N薄膜的硬度如图5所示。在5、10、15、20和25sccm得到的Ti-Al-N薄膜的硬度分别为分别为 33.1、33.3、34.6、29.1 和 26.4 GPa。在低氮流量范围内,Ti-Al-N 薄膜的硬度远高于传统的 Ti-N 材料。 Ti-Al-N 硬度的提高主要源于通过引入 Al 含量使 Al 原子占据 Ti 原子的部分晶格位点导致晶格失败并增加薄膜内应力的显微组织演变。此外,由于 RF-ICPIS 技术可以在反应溅射过程中降低气体电离温度并增加电离速率,因此 S1-S5 样品的 Al/Ti 比高于在传统溅射系统中制造的 Ti-Al-N 材料,转换金属颗粒的溅射产率 [23]。引起晶格畸变的高 Al/Ti 比率也会导致位错运动阻力和难以滑动,这共同有助于在低氮流速下沉积的 Ti-Al-N 薄膜的优异硬度性能。同时,优化的结晶和减小的晶粒尺寸进一步促进了硬度在 15 sccm 时达到最大值 34.6 GPa。
<图片>
不同氮气流量下沉积的Ti-Al-N薄膜的硬度
Ti-Al-N薄膜的摩擦性能也通过球盘磨损装置进行了研究,Ti-Al-N薄膜的平均摩擦系数绘制在图6中。摩擦系数随氮气的变化而变化流速与 RMS 粗糙度相似。显然,在低氮气流速下沉积的 Ti-Al-N 薄膜的光滑表面和致密的横截面纳米结构有利于表面摩擦学性能。同时,S1-S3 的平均摩擦系数小于 CS3(见补充材料)。
<图片>
在不同氮气流速下沉积的 Ti-Al-N 薄膜的平均摩擦系数。嵌件分别为S3和S5的摩擦系数曲线
结论
总之,研究了在不同氮等离子体气氛下沉积的 Ti-Al-N 薄膜的微观结构和机械性能。发现Ti-Al-N薄膜中的元素含量受氮等离子体密度的影响很大。低等离子体密度有利于薄膜结晶质量和微观结构,这得到 XRD 光谱和 FESEM 的支持。此外,可以在适当的等离子体密度范围内进一步优化表面粗糙度和机械性能,如硬度和摩擦系数。在高等离子体密度下,薄膜中过多的氮含量会诱导亚稳态氮化物相,并导致微观结构松散和机械性能恶化。该研究结果为进一步了解Ti-Al-N薄膜沉积气氛相关的生长机制提供了有效途径。
数据和材料的可用性
所有数据完全可用,不受限制。
缩写
- RF-ICPIS:
-
射频电感耦合等离子体离子源
- DC:
-
直流电
- EDS:
-
能谱仪
- XRD:
-
X射线衍射
- FESEM:
-
场发射扫描电镜
- 原子力显微镜:
-
原子力显微镜
- FWHM:
-
半高全宽
- RMS:
-
均方根
纳米材料
- 接触非平衡等离子体对 Mn Х Fe3 − X О4 尖晶石结构和磁性能的影响
- 水对微晶和纳米纤维素结构和介电性能的影响
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 石墨烯和多壁碳纳米管对 Cu/Ti3SiC2/C 纳米复合材料的微观结构和机械性能的协同作用
- 通过蒸发诱导自组装和增强的气敏特性简便合成虫孔状介孔氧化锡
- 通过原子力显微镜研究聚苯乙烯薄膜的附着力和玻璃化转变
- 使用分子束外延法制备锗铋薄膜及其光学特性
- 探测 Ag n V (n =1-12) 簇的结构、电子和磁特性
- 具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
- 天然和合成纳米材料的电化学、生物医学和热特性的比较研究
- Al-Doped ZnO 薄膜在红外区域的光学特性及其吸收应用


