基于微柱中 InAs 双层量子点的 1.3 μm 明亮单光子源
摘要
研究了波长为 1.3 μm 的单光子发射的显着高计数率,能够从 InAs/GaAs 双层量子点与分布式布拉格反射器的微柱(直径 ~3 μm)腔耦合进行基于光纤的量子通信,其光子提取效率达到了3.3%。在显微光致发光光谱中可以清楚地观察到腔模式和珀塞尔增强。在 Hanbury-Brown 和 Twiss 设置的检测端,两个雪崩单光子计数模块记录的总计数率约为 62,000/s;时间符合计数测量表明单光子发射,具有多光子发射的可能性,即 g 2 (0),只有 0.14。
背景
基于光纤的量子信息需要真正的电信频段单光子源(SPS)来代替基于强衰减脉冲激光器的传统伪SPS。自组装单个量子点 (QD) 有可能发射真正的单光子,因此引起了极大的兴趣 [1,2,3,4]。将分布式布拉格反射器 (DBR) 腔集成到单个 QD 将增强其定向发射。与在发射 ~1.55 μm 的 InAs QD 上生长的 InAs QD 和在低温下生长的晶格匹配的富铟材料(如 DBR [5, 6])相比,在 GaAs 衬底上生长的 InAs QD 在晶格匹配的易于集成方面具有优势高品质 GaAs/Al0.9Ga0.1As DBR。为了在电信频段实现 InAs/GaAs QD SPS,它们的发射波长必须从通常的 ~0.9 扩展到 1.3 或 1.55 μm,并且它们的密度必须保持低至 10 7 –10 8 cm −2 在微区域中实现单量子点。为了通过分子束外延 (MBE) 制造低密度 InAs QD,已经提出了一些建设性的方案,例如超低生长速率 [3]、高生长温度 [7,8,9] 和沉积量的精确控制 [10] ] 的量子点和通过在台面/孔图案衬底上生长 [11] 或蚀刻到微柱中来隔离量子点 [12, 13]。为了延长它们的发射波长,已经开发了几种技术,例如 QD 的应变工程 [14]、变质结构 [2] 和应变耦合双层 QD (BQD) 结构 [15,16,17]。 GaAs 衬底上的 BQD 结构可有效实现 1.3 μm 以上的发射。高密度 BQD 已应用于在室温下运行的 ~1.5 μm 激光二极管 [15, 16]。由于它避免了在有源层中使用变质层和超低生长速率,这可能会降低晶体质量 [2],因此也需要 BQD 结构在电信波长中生长低密度 QD。在我们之前的工作中已经获得了发射 1.3 μm 的低密度 InAs/GaAs BQD [18]。为了在基于光纤的应用中实现 1.3 μm 的高单光子计数率 [2, 19],必须提高单个 QD 的光子提取效率。在这封信中,通过进一步优化 BQD 结构的生长条件和制造微柱结构,我们大大提高了从 1.3 μm 发射的单个 InAs/GaAs BQD 的光子提取。考虑到共焦显微镜光谱设置的光子收集效率,InGaAs 单光子计数模块的单光子计数率已达到 62,000 次/秒或第一个物镜的 3.45 M 次/秒。这是第一次使用 InAs/GaAs BQD 报告在电信波长下单光子发射的高计数率。通过在 BQD 层附近引入 n 型 δ 掺杂层以产生带电子的激子 [13],可以进一步增强发射强度。
方法
研究的样品是通过固体源 MBE(VEECO Gen930 系统)在半绝缘 (100) GaAs 衬底上生长的。样品结构依次由 300 nm 厚的 GaAs 缓冲层、25.5 对波长匹配的 Al0.9Ga0.1As (113.7 nm)/GaAs (98.6 nm) 底部 DBR、一个 λ - 厚的未掺杂 GaAs 腔,以及 8 对 Al0.9Ga0.1As/GaAs 上 DBR 具有相同的周期。在 GaAs 腔的中心,用于电信发射的有源层,即带有 InGaAs 应变降低层的 BQD 结构,以 Stranski-Krastanov 生长模式在 470°C 下生长,这低于我们之前使用的温度工作。更多的增长细节在参考文献中报告。 [18]。在这项工作中,特别是通过光刻和电感耦合等离子体 (ICP) 蚀刻与氯 (Cl2) 和氩 (Ar) 混合气体在 DBR 腔耦合 BQD 样品上制造了微柱阵列。如图 2a 中的扫描电子显微镜 (SEM) 图像所示,微柱的直径约为 3 μm,高度为 7.75 μm,侧壁非常光滑。样品在无制冷剂的恒温恒温槽中冷却,温度从 4 到 50 K 微调,并由波长为 633 nm 的 He-Ne 激光器激发。具有物镜 (NA, 0.65) 的共聚焦显微镜设置将激光聚焦成直径为 2 μm 的光斑,并将发光有效地收集到光谱仪中,从而能够扫描微区域以搜索单个 QD 激子谱线。微光致发光 (μPL) 光谱由 0.3 米长焦距单色仪检测,该单色仪配备有用于光谱仪的液氮冷却 InGaAs 线阵检测器。对于反射率测量,使用分光光度计 (PerkinElmer 1050),扫描步长为 2 nm,光斑为 3 mm × 3 mm。为了研究激子的辐射寿命,时间相关单光子计数 (TCSPC) 板和钛:蓝宝石脉冲激光器(脉冲宽度,~100 飞秒;重复频率,80 兆赫;波长,740 纳米)用于时间分辨 μPL 测量。测量二阶自相关函数g (2) (τ ),QD 谱线发光被发送到光纤耦合的 Hanbury-Brown and Twiss (HBT) 装置 [20] 并由两个 InGaAs 雪崩单光子计数模块(IDQ 230;时间分辨率,200 ps;暗计数率)检测,~80 次/秒;死区时间,30 微秒)和时间重合计数模块。
结果与讨论
图 1a、b 分别显示了在 480 和 470°C 下生长的 BQD 的 AFM 图像。对于 480°C 的样品,BQD 的平均直径为 61 nm,高度约为 10 nm。对于 470 °C 的样品,平均直径为 75 nm,高度为 13 nm,比在 480 °C 下生长的样品更高更大。较低的温度有助于增加 QD 尺寸和纵横比 [21]。为了提高光子收集效率,将 BQD 嵌入 λ - 厚的 GaAs 腔体,夹在 25.5 个下部和 8 个上部 DBR 堆栈之间。除了 BQD 的生长温度外,这两个样品都相同。如图 1c 所示,我们观察到的两个样品中最亮的 BQD 在 PL 光谱中完全不同。在较低的生长温度下,PL 强度大大增强,这可归因于 BQD 周围的应变弛豫和位错减少 [21]。图 1d 显示了底部 DBR 的测量反射率光谱,在 1310-1380 nm 范围内的反射率值约为 99%,表明是一个很好的反射镜,可以反射 QD 发射。
<图片>
1 × 1 μm 2 在 a 生长的未加帽 BQD 的原子力显微镜 (AFM) 图像 480 和 b 470°C。 c 嵌入 DBR 腔中的 BQD 的 μPL 光谱,在 480°C 下生长(红色 ) 和 470 °C (黑色 ),在 4 K 下测量。d 底部DBR的反射光谱,在室温下测量
图 2 显示了微柱的 SEM 图像和嵌入其中的典型 BQD 的 μPL 光谱。图 2d 显示了作为温度函数的 μPL 光谱。 BQD 的发射在 30 K 时达到最大强度,表明存在腔共振;另请参见图 2c。微柱腔的品质因数 (Q) 估计约为 361。低 Q 归因于电信波长中 GaAs 和 Al0.9Ga0.1As 之间的小反射率偏移,并且这里使用的 DBR 对少于传统 DBR 与发射 <1 μm 的 QD 耦合 [12, 22]。
<图片>
一 微柱结构的 SEM 图像(直径 ~3 μm)。 b 4 K 时微柱中单个 BQD 的典型 PL 光谱。d 微柱和 c 中典型 BQD 的温度相关 μPL 光谱 其积分 PL 强度作为激发功率 ~2 μW 下激子-腔失谐的函数,红线 :洛伦兹拟合
通过使用连续波 (cw) He-Ne 激光器进行带上激发,研究了微柱中 InAs/GaAs BQD 的激发功率相关 μPL 光谱,如图 3a 所示。它们显示了 1325.6 nm 处的激子线 (X) 和 1327.1 nm 处的带电激子线 (X*)。这些发射线的识别由它们的各种功率依赖性支持。在图 3b 中,X 线在 1325.6 nm 处的积分 PL 强度在低功率区域显示出与激发功率的线性相关性,并在高激发功率下饱和。实线是对双对数图中数据的线性拟合。 1327.1 nm 处的 X* 线显示非饱和激发功率依赖性 [23]。后续调查均在X线上进行。
<图片>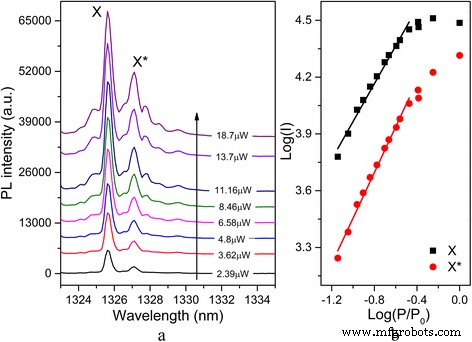
一 与激发功率相关的 μPL 光谱 (T =4 K) 微柱中典型的 BQD。 b 激子 (X) 和带电激子 (X*) 的积分 PL 强度作为对数-对数标度中的激发功率的函数。 彩色线条 :实验数据的线性拟合
进行时间分辨 PL 测量以确定 Purcell 增强。 BQD X 线在 QD 腔共振和远失谐时的自发发射衰减如图 4a 所示。共振的拟合辐射寿命为 0.66 ns,远失谐为 1.25 ns,对应的 Purcell 增强因子为 1.9。为了确认 X 线在 1325.6 nm 处的单光子发射,我们测量了二阶相关函数 g (2) (τ ) 在 cw 引用和饱和脉冲激励下使用 HBT 设置。图 4b 显示了 X 线的测量二阶相关函数作为延迟时间 τ 的函数 在 cw 激励下。数据可以用以下表达式拟合:g (2) (τ ) =1 − [1 − g (2) (0)]exp(-|τ |/T ) [24]。 g 中的拟合结果 2 (0) =0.14,证明单光子发射器在零时延下对多光子发射具有很强的抑制作用。在检测器上测得的计数率作为泵浦功率的函数示于图 4c。它在弱泵浦状态下表现出线性相关性,并在强泵浦状态下变得饱和。在饱和状态下,两个 InGaAs 单光子探测器的计数率约为 62,000 次/秒,还包括两个探测器的暗计数。为了推导出在第一个透镜中收集的相应光子数,我们使用 1320 nm 的连续激光器校准所有光损耗。包括显微镜物镜、长通滤波器、反射镜和透镜以及单色器、透镜和光纤之间连接器的效率在内的传输损耗为 10.46 dB。死区时间为 30 μs 的 InGaAs 探测器的探测效率和暗计数率分别为 18% 和 ~150 counts/s。基于 InGaAs 单光子探测器的计数率和修正的光子计数率 [1−g (2) (0)] 1/2 [25],我们估计补偿多光子发射和暗计数的贡献后的净单光子检测率为3.45 × 10 6 在第一个物镜的饱和泵浦功率下计数/秒。为了评估微柱结构的光子提取效率,还进行了脉冲激发下的测量。在图 4d、e 中,我们在具有 g 的饱和泵浦功率下观察到单光子探测器的计数率为 48,000/s 2 (0) =0.19,在 80 MHz 重复率激光激发下,在补偿多光子发射的贡献并考虑检测装置的效率后,光子提取效率为 3.3%。我们认为,由于 InGaAs 探测器的非共振激发过程 [12, 26] 和低探测效率和较长的死区时间,单光子的观测计数率可能被低估。
<图片>
一 (白色圆圈上的时间分辨测量值 ) 和关闭(黑色圆圈 ) 微柱中 X 线的共振,揭示了 F 的 Purcell 因子 p =1.9。 b , d 二阶相关函数g (2) (τ ) 用于连续激发下的 X 线和饱和泵浦功率下的 80 MHz 脉冲激光激发。 c , e 分别在 cw 和脉冲激发下 1325.6 nm 处激子峰值的泵浦功率相关 PL 强度。 黑圈 在 c 和 e 表示 InGaAs 探测器记录的计数率
结论
总之,我们通过在微柱 Al0.9Ga0.1As/GaAs DBR 腔中使用单个应变耦合双层 InAs/GaAs QD 提供了 1325.6 nm 的明亮单光子源。通过优化 QD 生长温度和制造微柱结构,确实增强了单光子发射。检测到的单光子速率达到 62,000 次/秒,对应于第一个物镜处的单光子发射速率为 3.45 MHz。光子提取效率估计约为 3.3%,具有 Q ~300 的微柱腔。使用 InGaAs 单光子计数模块的二阶自相关测量产生 g (2) (0) =0.14,即使在高计数率下也显示出单光子发射。这是首次在电信频段使用单InAs/GaAs双层QD实现如此高的单光子发射率。
缩写
- 原子力显微镜:
-
原子力显微镜
- BQD:
-
双层量子点
- cw:
-
连续波
- DBR:
-
分布式布拉格反射器
- HBT:
-
Hanbury-Brown 和 Twiss
- ICP:
-
电感耦合等离子体
- MBE:
-
分子束外延
- 量子点:
-
量子点
- SEM:
-
扫描电子显微镜
- SPS:
-
单光子源
- TCSPC:
-
时间相关单光子计数
- μPL:
-
显微光致发光
纳米材料
- 具有半极性 InxGa1−xN/GaN 多量子阱的紫外 GaN 基光子准晶纳米锥结构的多色发射
- S、N 共掺杂石墨烯量子点/TiO2 复合材料用于高效光催化制氢
- 检测自组织 InAs/InGaAs 量子点超晶格中的空间局域激子:提高光伏效率的一种方法
- 变质 InAs/InGaAs/GaAs 量子点异质结构光电压的双极效应:光敏器件的表征和设计解决方案
- 对核/壳 CdSe/ZnS 量子点薄膜光激发发光的可逆电化学控制
- 纳米线/量子点混合纳米结构阵列太阳能电池的光伏性能
- 消除 InAs/GaAs 量子点中的双峰尺寸,用于制备 1.3-μm 量子点激光器
- 介观四(对磺基苯基)卟啉对半胱氨酸包覆的 CdSe/ZnS 量子点发光的刺激
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- 在硅衬底上设计用于中红外直接带隙发射的应变工程 GeSn/GeSiSn 量子点
- 通过生长掺杂方法实现双发射和颜色可调的 Mn 掺杂 InP/ZnS 量子点
- InAs/GaAs 量子点双模分布式反馈激光器面向大调谐范围连续波太赫兹应用


