共同加入臭氧和去离子水作为通过原子层沉积生长 ZnO 薄膜的氧化剂前体
摘要
研究了在使用和不使用三脉冲臭氧 (O3) 作为氧化剂前体和沉积后热退火 (TA) 的情况下,蓝宝石衬底上原子层沉积 (ALD) 生长的 ZnO 薄膜的特性。 ZnO 外延层的沉积温度和厚度分别为 180 °C 和 85 nm。沉积后热退火在氧气 (O2) 环境中以 300 °C 进行 1 小时。使用强氧化剂 O3 和后沉积 TA 生长 ZnO,本征应变和应力分别降低至 0.49% 和 2.22 GPa,背景电子浓度极低(9.4 × 10 15 厘米 −3 )。这是由于在光致发光 (PL) 光谱的积分强度的热猝灭分析中,热激活缺陷的密度较低。 TA进一步促进再结晶形成更多无缺陷晶粒,进而降低应变和应力状态,从而显着降低电子浓度和改善表面粗糙度。
介绍
几种氧化剂用于 ZnO 的生长。它们包括水 (H2O)、过氧化氢 (H2O2)、氧气 (O2) 和臭氧 (O3) [1,2,3,4,5,6]。 H2O 是通过原子层沉积 (ALD) 生长 ZnO 中常用的氧化剂。 ALD 是一种逐层自限生长机制。特定表面配体通过相应前体的顺序脉冲交换反应。当表面的反应位点完全耗尽时,表面反应停止并饱和。薄膜的 ALD 生长具有以下优点,例如在表面和侧面区域上具有优异的保形沉积、边缘的阶梯覆盖出色、大面积上的高均匀性、层厚控制精度以及适合低沉积温度 [7,8,9] .
强氧化剂不仅会影响材料结构,还会影响 ALD 沉积的 ZnO 的光电特性。 H2O2 氧化剂比常用的 H2O 前驱体提供了更多的富氧条件来钝化缺陷氧空位 (VO) 和锌间隙 (Zni ) 在 ALD 生长的 ZnO 薄膜中,在 80 到 150 °C 的低生长温度下。当氧化剂的使用从 H2O 变为 H2O2 [2] 时,会出现具有 (002) 优先取向生长平面的柱状表面形态。与在 200 °C 下使用 ALD 生长的 ZnO 的 O3 气体反应物相比,H2O2 氧化剂将生长速率提高了大约 70%。薄膜生长表面上羟基 (OH) 基团密度的增加是导致生长速率增加的原因 [3]。也有报道称使用纯O2代替H2O作为氧化剂可使ZnO的生长速率提高约60%[4]。
O3 是 ALD 生长的氧化物材料中的有效氧化剂。 O3 的高电化学势在低生长温度下产生快速反应速率。 O3 比 H2O、H2O2 和 O2 更易挥发,更容易吹扫。因此,可以缩短每个循环中的吹扫时间。 O3 分子中不存在氢导致生长中氢和羟基污染较少。当生长温度为 200 °C 时,由于 ZnO 的复合表面损失,厚度不均匀,暴露时间为 10 s O3 [5]。与使用 H2O 氧化剂的样品相比,ALD 制备的具有 O3 氧化剂的未掺杂 ZnO 薄膜显示出双倍的热电功率因数。 H2O 和 O3 生长的 ZnO 薄膜具有相同的 VO 缺陷水平,但与 Zn 相关的缺陷水平不同。 O3 的足够氧化能力导致较低的天然 Zni 含量 因此具有更大的热电功率因数。 O3 的强氧化作用提高了未掺杂的 ZnO 薄膜的热电性能 [6]。 O3 和 H2O 的共同添加可以提高 ZnO 薄膜的均匀性和保形性,以用于适当的 ALD 工艺 [5]。
在蓝宝石衬底上自然生长的 ZnO 薄膜中存在固有和外部应变。固有应变源于 ZnO 中的高密度晶体缺陷。晶体缺陷包括氢配合物、锌间隙 (Zni )、氧空位 (VO)、螺纹位错 (TD) 和晶界 (GB) [10,11,12,13,14,15,16,17,18,19,20,21]。外部应变是由 ZnO 外延层和蓝宝石衬底之间的晶格常数和热膨胀系数的大不匹配产生的。施加各种方式来减少蓝宝石上 ZnO 材料的内在和外在应变。薄的 MgO 缓冲层可以减少外在应变,将表面粗糙度降低 58.8%,并抑制蓝宝石上 ZnO 薄膜的表面裂纹 [22]。蓝宝石上 ZnO 的外在应变完全松弛,厚度达到 30 nm,通过磁控溅射沉积在 550°C [23]。随着玻璃基板温度从 350°C 升高到 450°C,通过喷雾热解法沉积的 ZnO 薄膜的压缩应力从 1.77 松弛到 1.47 GPa [24]。
在 180 °C 下用单脉冲前驱体(DEZn 和 H2O)生长的 ALD ZnO 显示背景电子浓度高达 ~ 10 18 厘米 −3 即使使用后沉积 TA [25]。 ALD 工艺中常用的单脉冲 H2O 前体不会产生理想的单层氧原子。三脉冲前驱体(DEZn 和 H2O)可以产生前驱体分子与表面配体的多次碰撞或碰撞,以提高在 100°C 低温下生长的 ALD ZnO 的反应概率。选择“三个”脉冲有助于确保反应物正确定位开放的化学吸附或反应位点。极低的背景电子浓度 8.4 × 10 14 厘米 −3 , 高电子漂移迁移率 62.1 cm 2 /Vs,以及具有合适缓冲层和 RTA 条件的三脉冲前驱体 ZnO 的近带隙边缘 (NBE) 光致发光 (PL) 的显着增强 [26]。一些报告显示,通过热退火可以提高 ZnO 薄膜和 ZnO/ZnMgO 多量子阱的材料质量 [27, 28]。在本报告中,每个 ALD 循环使用三脉冲 O3 和随后的单脉冲 H2O 作为氧化剂在 180°C 下生长 ZnO 薄膜。沉积后热退火 (TA) 用于提高样品的结晶质量。研究了ALD生长的ZnO薄膜的材料微纳米结构、光致发光和霍尔效应特性。
实验方法
ZnO 外延层通过 Cambridge NanoTech Savannah 100 ALD 系统沉积在传统的 c 面蓝宝石 (c-Al2O3) 衬底上。在 ALD ZnO 薄膜的生长中,使用了包括去离子 (DI) H2O、O3 和二乙基锌 (DEZn, Zn(C2H5)2) 在内的前体。表 1 展示了 A、B 和 C 三个样品的 O3 脉冲数和沉积后 TA 的条件。样品每个 ALD 循环的脉冲序列随时间的示意图如图 1 所示。在该图中,一个ALD 循环包含六个连续步骤。第一步是将单脉冲去离子 (DI) H2O 注入米级反应器中,以在蓝宝石上形成羟基 (OH) 封端的表面或与悬空的乙基 (C2H5) 反应形成锌-氧 (Zn– O) 在 Zn 表面与羟基表面基团桥接。产生一个原子层氧 (O)。第二步是吹扫高纯度氮气 (N2) 以去除过量的前体分子和挥发性副产物,并防止每次反应物暴露后后续前体的混合。第三步是将三脉冲 O3 注入反应器,以促进减少天然缺陷。第四步是用 N2 气体吹扫腔室。第五步是将单脉冲 DEZn 注入反应器,在氧层上产生一层锌 (Zn) 原子层。最后一步也是用 N2 气体吹扫腔室。前体通过腔室压力为 4 × 10 -1 的载气 N2 脉冲进入反应室 托。反应物 DI H2O、O3 和 DEZn 的最佳暴露时间条件分别为 0.01、0.5 和 0.015 s。腔室抽真空的脉冲时间为5 s。 ZnO 薄膜的厚度为 85 nm,每个样品进行 500 次 ALD 循环。其他有利的沉积参数条件见之前的报告 [29]。样品 C 在 300 °C 和 O2 环境中进行 1 h 的后沉积 TA 处理。
<图片>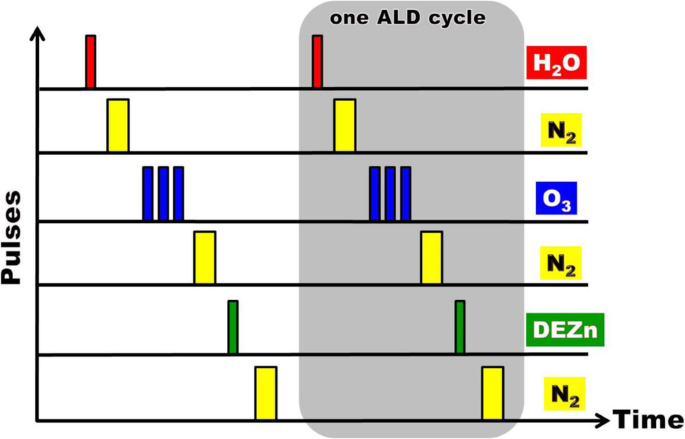
以去离子水、O3和Zn(C2H5)2为前驱体,在蓝宝石衬底上ALD生长ZnO薄膜,脉冲序列为H2O/N2/O3/N2/DEZn/N2
样品的材料结构、光学和电学特性通过以下测量进行。 X 射线衍射 (XRD) 图案是用衍射角 (2θ ) 范围从 33 到 38°,波长为 0.154 nm 的铜 Kα 辐射,使用仪器 D2 移相器(布鲁克公司)。霍尔效应测量采用Ecopia HMS-3000系统,将试样切割成面积为0.7×0.7 cm 2 的正方形 .样品的四个角由小铟团焊接,显示范德堡配置中的欧姆接触。测量薄膜的片载流子密度、迁移率和电阻率。光致发光 (PL) 光谱在 10 到 300 K 范围内进行,激发波长为 325 nm,He-Cd 激光的功率为 55 mW。分析了PL光谱积分强度随温度升高的热猝灭现象。用Veeco Dimension 3100仪器拍摄的原子力显微镜(AFM)高分辨率图像检测样品的表面纹理和粗糙度。
结果与讨论
图 2 通过 XRD 图案的测量展示了样品的结晶性质。两个布拉格衍射峰 (002) 和 (101) 对应于 ZnO 的六方纤锌矿结构。将 XRD 图案的最强峰强度归一化以比较样品之间的峰强度。顶部水平轴上指示的两个绿色箭头分别显示 (002) 和 (101) 的衍射角 34.4° 和 36.2°,从粉末衍射联合委员会组织发布的材料数据集中获得的无应变块状 ZnO标准 (JCPDS)。图中可以观察到样品B和C中的(002)和(101)峰接近并进一步接近无应变块体ZnO的(002)和(101)衍射角。
<图片>
晶体取向沿样品的 (002) 和 (101) 方向的 ZnO 薄膜的 XRD 图案。箭头分别表示块体ZnO的(002)和(101)衍射角分别为34.4°和36.2°
沿 c 的双轴应变 与无应变块状 ZnO 相比,外延层的 - 轴可以通过 XRD 图案沿(002)的移动获得。平均应变 (ε z ) 在 ZnO 薄膜的晶格中,使用以下表达式从晶格参数估计。
$$ {\varepsilon}_z=\frac{c-{c}_0}{c_0}\times 100\% $$ (1)其中 c 和 c 0 是沿 c 的晶格常数 -轴由 ZnO 薄膜和块体的 (002) 峰的布拉格衍射角计算。平均应力 (σ ) 在薄膜平面内可以使用双轴应变模型计算:
\( \sigma =\frac{2{c}_{13}^2-{c}_{33}\left({c}_{11}+{c}_{12}\right)}{c_ {13}}\times {\varepsilon}_z=-453.6\times {\varepsilon}_z\left(\mathrm{GPa}\right) \) (2)where c 11 =209.7 GPa,c 12 =121.1 GPa,c 13 =105.1 GPa 和 c 33 =210.9 GPa 是块状 ZnO 的弹性刚度常数。在表 1 中,应变/应力 (ε z /σ A、B 和 C 样品的 ) 分别为 1.08%/4.90 GPa、0.74%/3.37 GPa 和 0.49%/2.22 GPa。样品 B 和 C 中的应变/应力降低并进一步降低。
样品在 10 到 300 K 的不同温度下的 PL 光谱如图 3 所示。在所有样品的 PL 光谱中,具有约 3.34 eV 光谱峰值能量的激子的强近带边缘辐射复合占主导地位。在样品的 PL 光谱的较低能肩处观察到纵向光学 (LO) 声子辅助光发射。在图 4a-c 中,它展示了 PL 光谱积分强度与温度倒数的阿伦尼乌斯图。 PL积分强度随温度升高的热猝灭可由以下Arrhenius公式拟合。
$$ I(T)=\frac{A}{1+{D}_{nr1}\exp \left(\frac{-{E}_{A1}}{k_{\mathrm{B}}T} \right)+{D}_{nr2}\exp \left(\frac{-{E}_{A2}}{k_{\mathrm{B}}T}\right)} $$ (3)其中我 (T ) 表示积分 PL 强度。 A 是一个常数。 D nr 1 和 D nr 2 是与非辐射复合中心密度相关的常数。 E A 1 和 E A 图 2 分别是供体结合激子在低温下和游离激子在高温下的非辐射复合过程对应的活化能。 k B 是玻尔兹曼常数。利用回归分析中的最小二乘法拟合显示D参数的数据 nr 1、D nr 2、E A 1, 和 E A 2 与表 2 和图 4a-c 中的红色拟合曲线。拟合结果表明D的变化 nr 1、E A 1, 和 E A 样品中的2个是轻的。 D nr 图2分别是样品A、B和C的132.7、153.6和110.8,显示缺陷密度量的大差异。 D 的最小值 nr 2 表明样品 C 中热激活缺陷的最低密度。
<图片>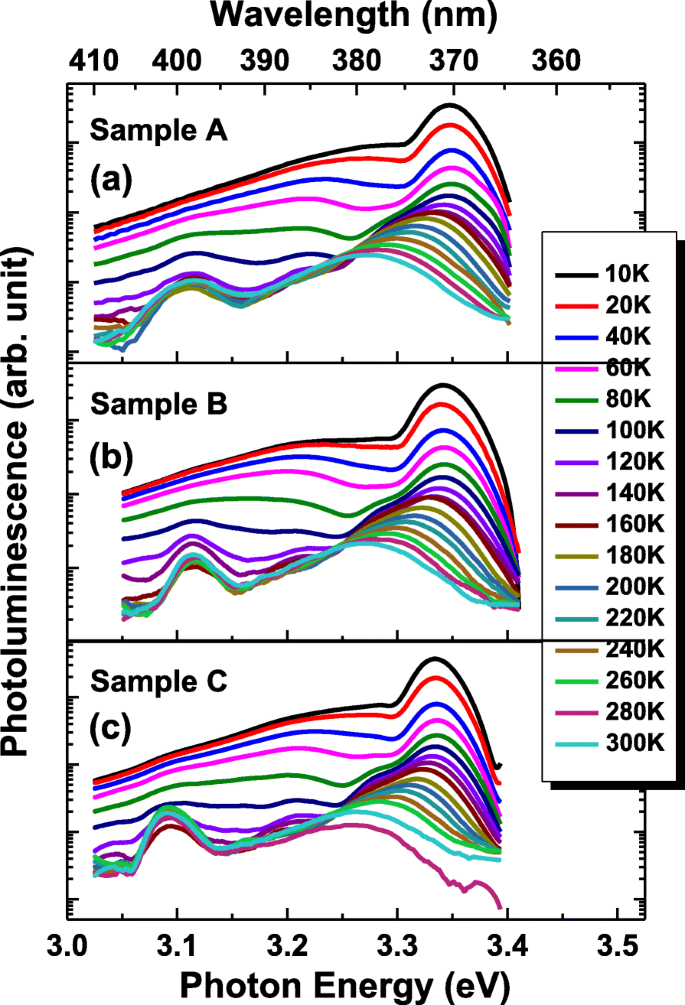
一 –c 样品随温度变化的PL光谱
<图片>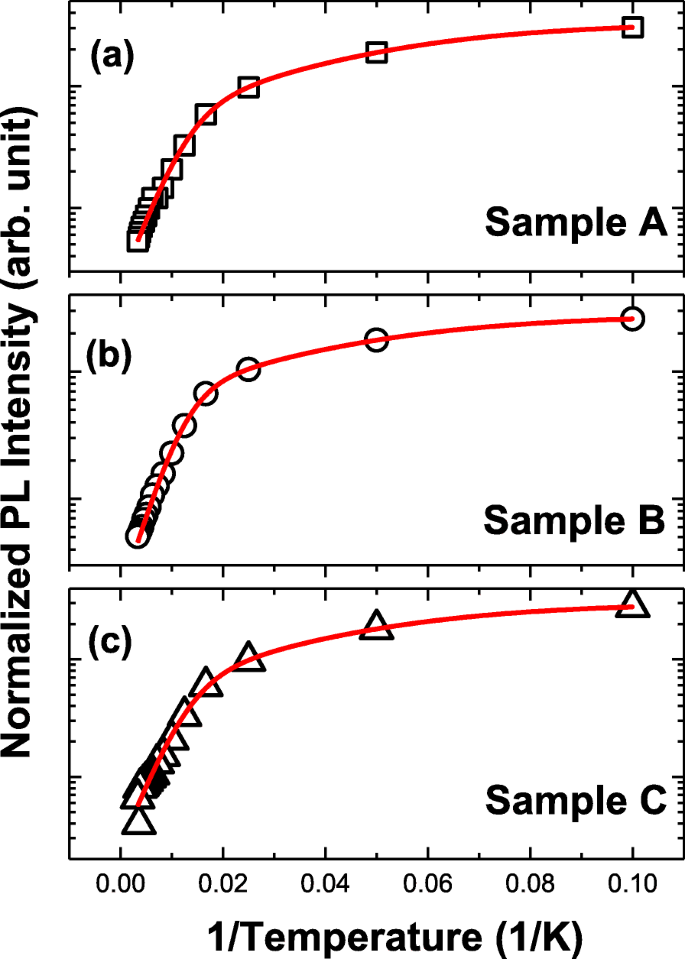
一 –c PL光谱积分强度热猝灭阿伦尼乌斯图与样品红色拟合曲线
样品的霍尔效应测量的背景电子浓度、迁移率和电阻率列于表 2。在样品 B 中,与样品 A 相比,载流子浓度随着迁移率的降低而降低了两个数量级。载流子浓度进一步大幅降低到最低值 9.4 × 10 15 厘米 −3 流动性上升到 6.1 cm 2 与样品 B 相比,样品 C 中观察到 /Vs。最少的电子浓度是由于样品 C 中应变/应力状态的最大弛豫和自然缺陷密度的显着降低。
图 5a-c 和 d-f 是样本的 2D 和 3D AFM 图像。 A、B和C的均方根(RMS)粗糙度分别为1.92、4.30和2.18 nm,如表2所示。样品A的表面纹理粗糙度最低。样品B中使用O3前驱体, 表面粗糙度增加。 ALD ZnO 薄膜空间均匀性的降低是由于 O3 的表面损失 [21]。 O3 的表面损失与从反应限制生长到复合限制生长的转变有关,并且可以构成主要的原子损失通道,破坏薄膜,导致厚度均匀性差。这与图 2 中样品 B 中沿 (002) 的衍射峰强度降低有关。通过对样品 C 中的后沉积 TA 进行处理,表面均匀性得到改善。同时,实现了背景电子浓度的显着降低和迁移率的增加。热退火导致晶格迁移;因此,发生冶金再结晶。再结晶伴随着应变/应力强度和固有晶格缺陷的降低;因此,获得了更好的 ZnO 薄膜质量。这一结果与样品 C 中 XRD 图中两个衍射峰强度的增强是一致的。值得注意的是,电子的迁移率会受到杂质、晶格和缺陷等散射源的影响。散射源可以改变平均电子速度。一般而言,缺陷密度的降低以及因此电子浓度的降低导致迁移率的升高。在本报告中,由于加入臭氧前体的作用,表面纹理的粗糙度增加可能导致样品 C 中的电子迁移率低于 A。在图 6 中,包含三个不同颜色三角形的金字塔图说明了三个关键的生长和获得高质量 ALD ZnO 外延层的工艺条件。
<图片>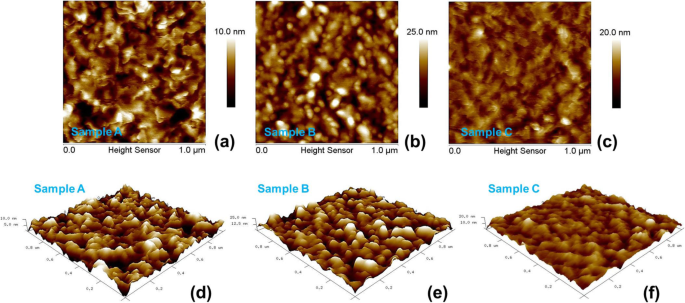
一 –c 2D 和 d –f 样品的 3D AFM 图像。二维图像中的高度比例显示在右侧的颜色条上
<图片>
金字塔图。在金字塔中,四个三角形用不同的颜色表示。金字塔边缘的三个三角形显示了 ZnO 的关键生长和加工条件。生长中这三个关键成分的组合提高了金字塔中心三角形所示的ALD ZnO外延层的质量
结论
ALD 工艺中的单脉冲 H2O 和三脉冲强氧化剂 O3 前驱体可以减少应变/应力,从而显着降低 ZnO 薄膜中的电子浓度,但会增加表面粗糙度。在氧气 (O2) 环境中,在 300 °C 下沉积 TA 1 小时可以进一步促进形成更多具有更低应变/应力、更低背景电子浓度和表面粗糙度的无缺陷晶粒的形成。使用三脉冲 O3 前体。最低应变/应力和背景电子浓度分别为 0.49%/2.22 GPa 和 9.4 × 10 15 厘米 −3 , 分别是由于 ALD 生长的 ZnO 薄膜的本征缺陷显着减少。
数据和材料的可用性
支持本研究结果的数据可应合理要求从通讯作者(Yung-Chen Cheng)处获得。
缩写
- ALD:
-
原子层沉积
- O3:
-
臭氧
- 助教:
-
热退火
- O2:
-
氧气
- PL:
-
光致发光
- H2O:
-
水
- H2O2:
-
过氧化氢
- 哦:
-
羟基
- Zni :
-
锌间隙
- 画外音:
-
氧空位
- TDs:
-
螺纹错位
- GB:
-
晶界
- NBE:
-
近带隙边缘
- c-Al2O3:
-
C面蓝宝石
- DI:
-
去离子
- C2H5:
-
乙基
- N2:
-
氮气
- 锌:
-
锌
- XRD:
-
X射线衍射
- 原子力显微镜:
-
原子力显微镜
- RMS:
-
均方根
纳米材料
- 用于 Micro-LED 和 VCSEL 的高级原子层沉积技术
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 通过原子层沉积和水热生长制备的抗菌聚酰胺 6-ZnO 分层纳米纤维
- 通过等离子体增强原子层沉积制备的 Co3O4 涂层 TiO2 粉末的光催化性能
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 通过超循环原子层沉积调节 ZnO 薄膜的费米能级
- 通过原子力显微镜研究聚苯乙烯薄膜的附着力和玻璃化转变
- ITO/PtRh:PtRh 薄膜热电偶的制备和热电特性
- 一种通过 PECVD 沉积低缺陷密度 nc-Si:H 薄膜的便捷有效方法
- 在 c 面 GaN 上沉积的 AlN 原子层中界面和电特性的厚度依赖性
- 双层 CeO2−x/ZnO 和 ZnO/CeO2−x 异质结构和电铸极性对非易失性存储器开关特性的影响


